

半导体膜厚测量丨光谱反射法基于直接相位提取的膜厚测量技术
描述
在现代半导体和显示面板制造中,薄膜厚度的精确测量是确保产品质量的关键环节。传统方法如扫描电子显微镜(SEM)虽可靠,但无法用于在线检测;椭圆偏振仪和光谱反射法(SR)虽能无损测量,却受限于计算效率与精度的矛盾。近期,研究人员提出了一种创新方法——直接相位提取技术,成功打破了这一技术瓶颈。FlexFilm单点膜厚仪结合相位提取技术通过将复杂的非线性方程转化为线性问题,在保证纳米级精度的同时,将计算速度提升数百倍,为工业检测带来了革命性突破。
1
光谱反射法的原理与挑战
flexfilm
光谱反射法(SR)的核心原理是通过分析光在薄膜表面的反射光谱来推算厚度。当光入射到薄膜表面时,会在薄膜与基底之间发生多次反射,这些反射光因路径差异产生干涉,形成特定的光谱振荡模式。通过数学模型(如Fresnel方程)可建立反射率与薄膜厚度、折射率等参数的关系。
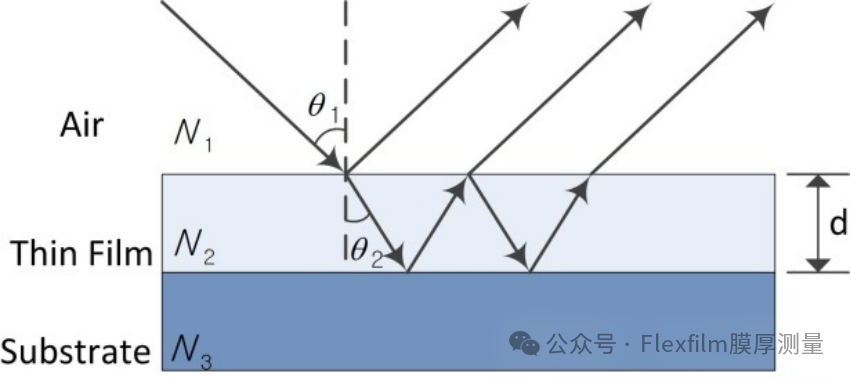
光在薄膜中的传播图
然而,反射率与厚度之间呈高度非线性关系,这使得传统分析方法面临两大难题:
1.非线性拟合算法(如Levenberg-Marquardt算法)需通过迭代逼近最优解,计算耗时,尤其在大规模像素分析(如成像光谱反射法ISR)中效率极低。
2.峰值检测法虽速度快,但对薄膜厚度敏感度低,无法测量1微米以下的薄膜,且误差较大。
这种速度与精度的矛盾,制约了光谱反射法在工业在线检测中的应用。
2
相位提取技术:
化非线性为线性的关键
flexfilm

(a)待分析的反射率随波长变化的曲线;(b)从(a)中反射率提取出的相位曲线;(c)实线为提取的相位,虚线为解缠后的相位结果
研究团队发现,若能将反射信号中的相位信息直接提取出来,即可将复杂的非线性方程转化为线性问题。这一思路基于以下物理规律:
相位与厚度的线性关系
根据Fresnel方程,光在薄膜中传播的相位变化(β)与厚度(d)成正比:

其中,N2为薄膜折射率,θ2为折射角。若能提取β,即可通过线性方程直接计算d。
相位提取的数学实现
研究团队提出一个关键假设:薄膜材料的消光系数极低(如二氧化硅、氮化硅等常见工业材料)。在此条件下,折射率为实数,Fresnel反射系数简化为实数,从而将反射率方程拆解为相位相关的线性组合。通过数学变换,最终推导出相位提取公式:

其中,A和B为反射系数的实部与虚部,X为与反射率相关的中间变量。
相位解包裹(Phase Unwrapping)
由于反三角函数的多值性,提取的相位可能存在周期性跳变。研究团队通过相位解包裹算法消除跳变,最终得到连续的相位-波长曲线,进而直接计算薄膜厚度。
3
性能验证:仿真与实验
flexfilm
为验证方法的可靠性,团队通过仿真和两类实验(单点光谱反射仪SR与成像光谱反射仪ISR)进行了全面测试。
仿真结果
在100 nm至4 µm的厚度范围内,仿真误差始终低于0.01%。尤其值得注意的是,误差不随厚度增加而累积,表明该方法在宽范围内均具备高稳定性。

相位提取技术仿真结果图
单点SR实验
SR 系统由反射探针和光谱仪组成,使用商用椭偏仪标定的二氧化硅样品(厚度2918–20775 Å)进行对比测试。结果显示:
相位提取法最大误差小于40 Å(约0.13%),与非线性拟合法精度相当。
峰值检测法对3000 Å以下薄膜完全失效,且最大误差超过600 Å。

光谱反射计系统原理图
成像ISR实验
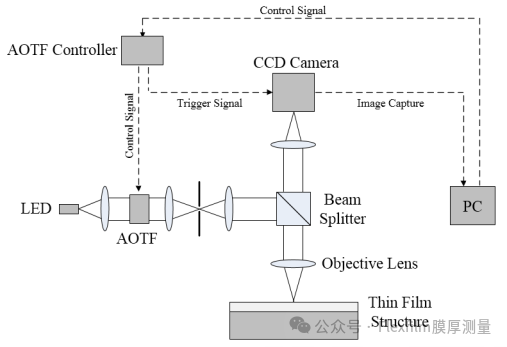
成像光谱反射计系统示意图
体积厚度由ISR 测量,以验证计算速度。该实验的 ISR 系统的硬件配置如上图所示,主要用于测量薄膜的体积厚度。
采用相机和声光可调滤波器(AOTF)进行面扫描测量。结果显示:
计算时间仅需2.6秒,比非线性拟合(320秒)快120倍,与峰值检测法(2.4秒)相当。
厚度分布图清晰呈现了850–900 nm的台阶结构,水平剖面线误差在±1 nm以内。
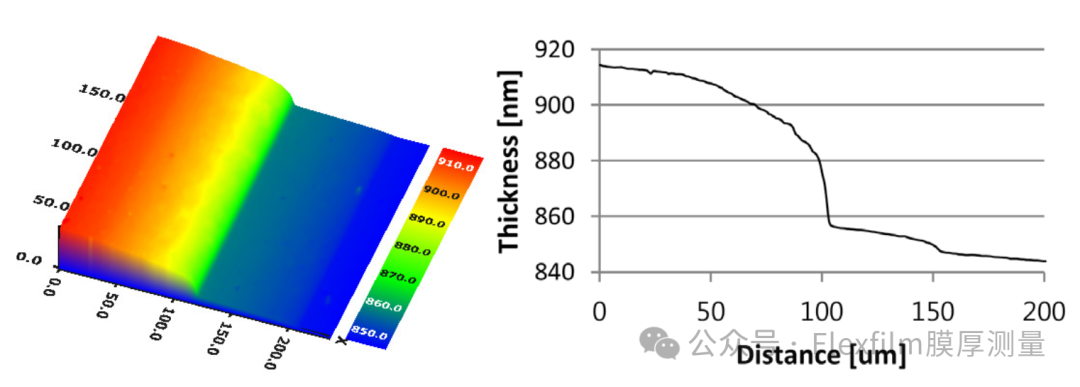
薄膜厚度在水平方向上的变化图
4
薄膜厚度检测技术的工业化潜力
flexfilm
速度与精度兼得:解决了传统方法的“鱼与熊掌”难题,尤其适用于需要快速面扫描的ISR系统。
无需初始参数:摆脱了非线性拟合对初始值的依赖,避免局部最优陷阱。
适用性广:支持从100 nm至数微米的厚度测量,覆盖半导体、显示面板等主流工艺需求。
本文通过提取光谱相位计算薄膜厚度,将非线性方程线性化,计算速度大幅提升,仿真和实验验证其在宽厚度范围高精度。在 ISR 系统中优势明显,计算简单快速且精度高,还避免局部极小值问题。总体而言,该方法是显示和半导体行业薄膜厚度测量的有用工具。
FlexFilm单点膜厚仪
flexfilm

FlexFilm单点膜厚仪 是一款专为纳米级薄膜测量设计的国产高精度设备,采用光学干涉技术实现无损检测,测量精度达±0.1nm,1秒内即可完成测试,显著提升产线效率。
1.高精度测量:光学干涉技术,精度±0.1nm,1秒完成测量,提升产线效率。
2.智能灵活适配:波长覆盖380-3000nm,内置多算法,一键切换材料模型。
3.稳定耐用:光强均匀稳定(CV<1%)年均维护成本降低60%。
4.便携易用:整机<3kg,软件一键操作,无需专业培训。
FlexFilm单点膜厚仪可结合相位提取技术为精密制造提供了一把“快而准的尺子”,在半导体制造过程中实时监测薄膜的沉积和生长厚度。搭建各种光谱实验平台,实现对各种材料的光学特性、膜厚、材料的反射率、透过率等光谱特性的测试和分析实验。
原文出处:《Fast Analysis of Film Thickness in Spectroscopic Reflectometry using Direct Phase Extraction》
*特别声明:本公众号所发布的原创及转载文章,仅用于学术分享和传递行业相关信息。未经授权,不得抄袭、篡改、引用、转载等侵犯本公众号相关权益的行为。内容仅供参考,如涉及版权问题,敬请联系,我们将在第一时间核实并处理。
-
厚膜集成电路的技术原理相关资料分享2021-05-26 2209
-
膜厚测试仪的测量范围 膜厚测试仪的操作注意事项2024-12-19 2042
-
白光干涉仪的膜厚测量模式原理2025-02-08 508
-
芯片制造中的膜厚检测 | 多层膜厚及表面轮廓的高精度测量2025-07-21 687
-
聚焦位置对光谱椭偏仪膜厚测量精度的影响2025-07-22 869
-
台阶仪精准测量薄膜工艺中的膜厚:制备薄膜理想台阶提高膜厚测量的准确性2025-09-05 622
-
光学膜厚测量技术对比:光谱反射法vs椭偏法2025-12-22 1074
全部0条评论

快来发表一下你的评论吧 !

