

半导体薄膜厚度测量丨基于光学反射率的厚度测量技术
描述
在半导体制造中,薄膜的沉积和生长是关键步骤。薄膜的厚度需要精确控制,因为厚度偏差会导致不同的电气特性。传统的厚度测量依赖于模拟预测或后处理设备,无法实时监测沉积过程中的厚度变化,可能导致工艺偏差和良率下降。为此,研究团队开发了一种基于激光反射率的光学传感器,能够在真空环境下实时测量氧化膜(SiO₂)、氮化膜(Si₃N₄)和多晶硅(p-Si)的厚度。
FlexFilm单点膜厚仪可方便搭建各种光谱实验平台,实现对各种材料的光学特性、膜厚、材料的反射率、透过率等光谱特性的测试和分析实验。
1
光学原理
flexfilm

激光在薄膜界面反射和折射的光路图
入射光束(I)在薄膜上表面反射为(I₁),另一部分折射后在下表面反射并再次折射为(I₂)。
光程差公式:Δp = 2ndcosθ₁(n为折射率,d为厚度,θ₁为折射角)。
相位差(ΔΦ)导致干涉,影响反射光强度,从而关联到薄膜厚度。
2
薄膜厚度测量装置
flexfilm
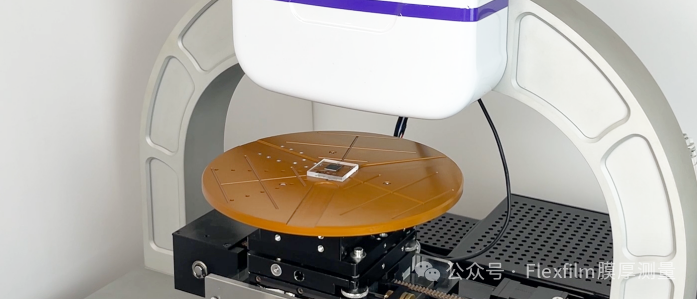

激光入射角设置为30°、45°、60°,反射光信号转换为电压值(参考入射光电压8.14 V)。
测量原理:通过测量反射光的强度,并结合薄膜的光学性质,计算出薄膜的反射率,进而推导出薄膜的厚度。
测量目标:验证基于光学反射率的薄膜厚度测量方法的可行性和准确性。
3
材料制备与表征
flexfilm

三种不同类型薄膜厚度的测量结果
氧化物薄膜的测量误差在1.2%以内,显示出较高的测量精度。
氮化物薄膜的测量误差在1.6%到2.2%之间,整体误差也较小。
多晶硅薄膜的测量误差在-0.2%到3.6%之间,其中150 nm厚度的薄膜误差最大,可能与其光学性质与硅片相似有关。

氧化物、氮化物、多晶硅和单晶硅的光学性质
氧化物和氮化物薄膜:折射率分别为1.47和2.02,消光系数均为0,表明这些薄膜是透明的,没有吸收。
多晶硅薄膜:折射率为4.05,消光系数为0.05,表明多晶硅薄膜具有一定的吸收特性。
单晶硅薄膜:折射率为3.88,消光系数为0.019,表明单晶硅薄膜的吸收较小。
4
理论模型
flexfilm

多层薄膜结构中第N层薄膜的折射和反射过程
多层薄膜结构:展示了多层薄膜的折射和反射过程,特别关注第N层薄膜的行为。
光程差和相位差:通过计算光程差和相位差,可以推导出反射光的强度变化,进而用于薄膜厚度的测量。
反射率计算:反射率是反射光强度与入射光强度的比值,通过反射率的变化可以推导出薄膜的厚度。
5
入射角依赖性分析
flexfilm

不同角度下的反射率曲线
反射率的周期性变化:
氧化物和氮化物薄膜的反射率随厚度变化呈现出明显的周期性波动,这与薄膜的干涉效应有关。
多晶硅薄膜的反射率变化较为复杂,周期性不明显,主要由于其吸收特性。
入射角度的影响:
在较小的入射角度(45°和60°)下,反射率的变化较为明显,对薄膜厚度的变化更为敏感。
在较大的入射角度(80°、85°和89°)下,反射率的变化逐渐趋于平缓,但仍能观察到厚度对反射率的影响。
薄膜类型的差异:
氧化物和氮化物薄膜的反射率变化较为相似,主要由于它们都是透明薄膜,消光系数为零。
多晶硅薄膜的反射率变化较为复杂,主要由于其吸收特性。
6
反射率与厚度关系
flexfilm
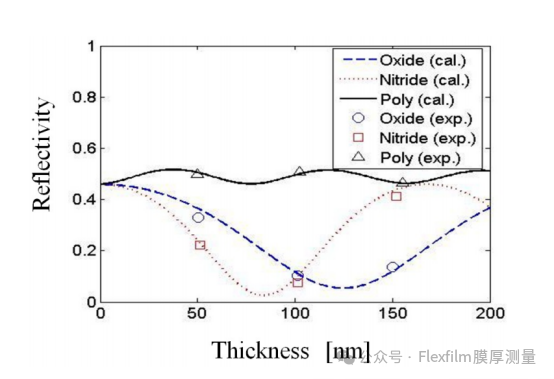
三种薄膜的实测与理论反射率对比
薄膜厚度测量:
通过分析反射率的变化,可以精确测量薄膜的厚度,特别是对于透明薄膜(如氧化物和氮化物)。
对于半透明薄膜(如多晶硅),虽然反射率变化复杂,但仍然可以通过选择合适的波长和入射角度进行测量。
实验装置的设计提供了理论基础,帮助优化半导体制造工艺中的薄膜沉积和生长过程,确保薄膜厚度在控制范围内。
7
多角度测量验证
flexfilm

氧化物、氮化物、多晶硅三种薄膜反射率随厚度的变化

材料光学特性决定测量效果:
透明/半透明材料(氧化膜、氮化膜)因干涉效应显著,反射率与厚度强相关。
不透明材料(多晶硅)因光吸收(k≠0)导致干涉失效,反射率无厚度信息。
入射角选择策略:
高折射率材料(如氮化膜)适合低角度(30°),低折射率材料(如氧化膜)适合高角度(60°)。
8
对比度分析
flexfilm

氧化物、氮化物和多晶硅薄膜的对比度
通过对比度的分析,展示了不同薄膜类型在不同入射角度下的反射率变化的明显程度。对比度越高,反射率的变化越明显,薄膜厚度的测量越容易。从而优化测量方法,提高薄膜厚度测量的精度和可靠性。
一种基于光学反射率的薄膜厚度测量方法,能够在半导体制造过程中实时监测薄膜的沉积和生长厚度。通过激光反射率测量技术,成功实现了氧化膜(SiO₂)和氮化膜(Si₃N₄)薄膜厚度的实时、高精度监测,误差可控制在10 nm以内,最小误差低至0.68%。
该技术不仅为半导体行业提供了一种高效、低成本的厚度测量方案,也为光学薄膜表征领域的发展提供了新的思路,具有重要的工程应用价值和科学研究意义。
FlexFilm单点膜厚仪
flexfilm

FlexFilm单点膜厚仪 是一款专为纳米级薄膜测量设计的国产高精度设备,采用光学干涉技术实现无损检测,测量精度达±0.1nm,1秒内即可完成测试,显著提升产线效率。
1.高精度测量:光学干涉技术,精度±0.1nm,1秒完成测量,提升产线效率。
2.智能灵活适配:波长覆盖380-3000nm,内置多算法,一键切换材料模型。
3.稳定耐用:光强均匀稳定(CV<1%)年均维护成本降低60%。
4.便携易用:整机<3kg,软件一键操作,无需专业培训。
FlexFilm单点膜厚仪可基于光学反射率的薄膜厚度测量方法,在半导体制造过程中实时监测薄膜的沉积和生长厚度。搭建各种光谱实验平台,实现对各种材料的光学特性、膜厚、材料的反射率、透过率等光谱特性的测试和分析实验。
*特别声明:本公众号所发布的原创及转载文章,仅用于学术分享和传递行业相关信息。未经授权,不得抄袭、篡改、引用、转载等侵犯本公众号相关权益的行为。内容仅供参考,如涉及版权问题,敬请联系,我们将在第一时间核实并处理。
-
椭偏仪在半导体的应用|不同厚度c-AlN外延薄膜的结构和光学性质2025-12-26 1467
-
椭偏术精准测量超薄膜n,k值及厚度:利用光学各向异性衬底2025-12-08 651
-
椭偏仪在半导体薄膜厚度测量中的应用:基于光谱干涉椭偏法研究2025-09-08 2373
-
椭偏仪与DIC系统联用测量半导体超薄图案化SAM薄膜厚度与折射率2025-08-11 1102
-
薄膜质量关键 | 半导体/显示器件制造中薄膜厚度测量新方案2025-07-22 1888
-
薄膜厚度高精度测量 | 光学干涉+PPS算法实现PCB/光学镀膜/半导体膜厚高效测量2025-07-21 1984
-
半导体晶圆形貌厚度测量设备2024-01-18 1407
-
一文读懂半导体晶圆形貌厚度测量的意义与挑战2024-01-16 3331
-
应用于光学测量的高性能薄膜厚度检测设备2023-12-16 2123
-
薄膜厚度对异质结电池光电转换率的影响2023-12-12 1460
-
塑料薄膜厚度测量仪应用领域2021-10-14 2355
-
薄膜厚度的检测技术有哪些2019-05-11 10554
全部0条评论

快来发表一下你的评论吧 !

