

传统封装与晶圆级封装的区别
描述
文章来源:半导体与物理
原文作者:jjfly686
本文主要讲述芯片制造中的从传统封装到晶圆级封装。
在芯片制造的最后环节,裸片(Die)需要穿上“防护铠甲”——既要抵抗物理损伤和化学腐蚀,又要连接外部电路,还要解决散热问题。封装工艺的进化核心,是如何更高效地将硅片转化为功能芯片。
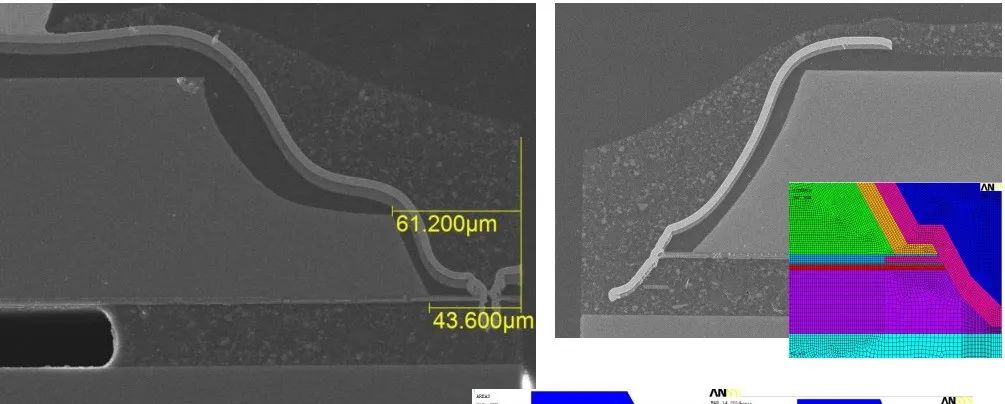
一、传统封装:先切割,后穿衣
核心流程:Wafer → Dicing → Packaging
晶圆切割(Dicing)
用金刚石刀片或激光将晶圆切成独立裸片
芯片粘接(Die Attach)
银胶或DAF薄膜(Die Attach Film)将裸片固定在基板
互联工艺
金线键合(Wire Bonding):用25μm金线(比头发细1/3)连接芯片焊盘与基板
模塑封装(Molding)
环氧树脂模塑料(EMC)注入模具,高温固化形成保护壳

晶圆级封装(WLP):先穿衣,后切割
核心流程:Wafer → Packaging → Dicing
晶圆级加工
重布线层(RDL):在整片晶圆上光刻出铜导线,重新排布焊盘位置
植球(Solder Bumping):通过电镀在焊盘上制作锡球或铜柱凸块
整片封装
整片晶圆涂覆保护层(PI/BCB介电材料);部分工艺增加硅通孔(TSV)实现3D堆叠
切割分离
完成所有封装步骤后切割晶圆,单片芯片直接可用

技术对比
| 特性 | 传统封装 | 晶圆级封装(WLP) |
|---|---|---|
| 流程顺序 | 先切后封 | 先封后切 |
| 处理对象 | 单个芯片 | 整片晶圆(批量处理) |
| 厚度 | 0.8-1.2mm | 0.3-0.5mm(减薄60%) |
| I/O密度 | ≤500 pin/cm² | ≥2000 pin/cm² |
| 生产速度 | 每小时数千颗 | 每小时数万颗 |
| 典型应用 | 家电MCU、功率器件 | 手机射频芯片、传感器、MEMS |
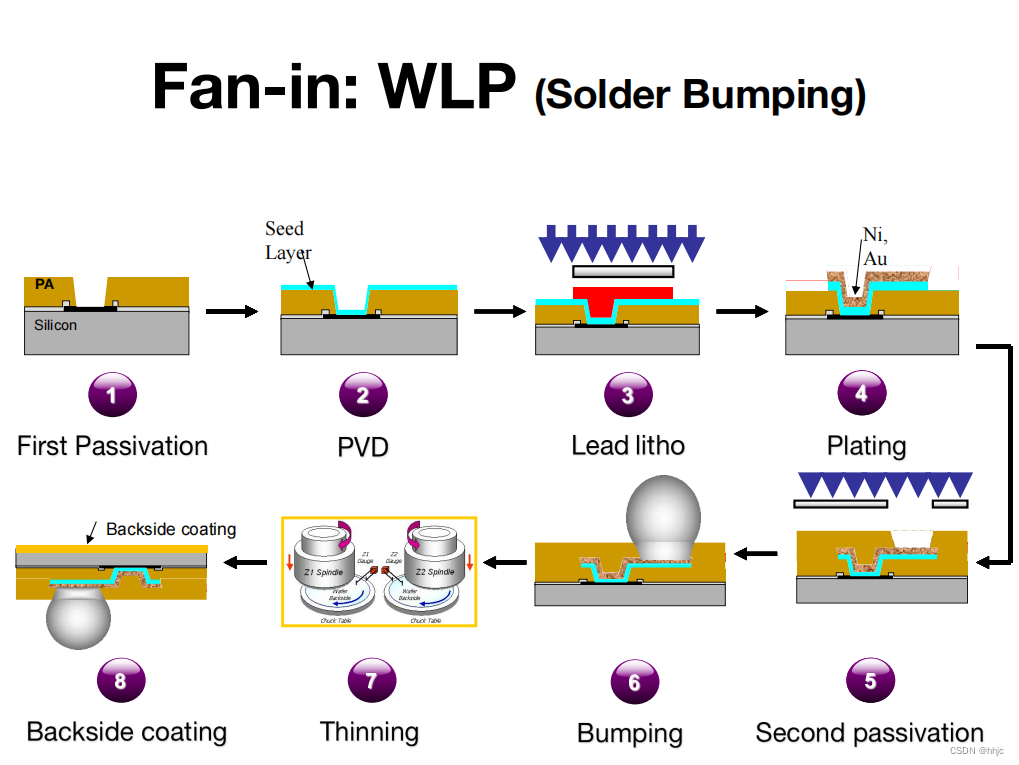
声明:本文内容及配图由入驻作者撰写或者入驻合作网站授权转载。文章观点仅代表作者本人,不代表电子发烧友网立场。文章及其配图仅供工程师学习之用,如有内容侵权或者其他违规问题,请联系本站处理。
举报投诉
-
晶圆级封装的基本流程2023-11-08 12161
-
HRP晶圆级先进封装替代传统封装技术研究(HRP晶圆级先进封装芯片)2023-11-30 4406
-
什么是晶圆级封装?2011-12-01 16837
-
晶圆级芯片封装有什么优点?2019-09-18 5717
-
晶圆级封装的方法是什么?2020-03-06 3896
-
用于扇出型晶圆级封装的铜电沉积2020-07-07 2906
-
晶圆级三维封装技术发展2020-12-28 4456
-
晶圆封装有哪些优缺点?2021-02-23 6784
-
晶圆级封装产业(WLP),晶圆级封装产业(WLP)是什么意思2010-03-04 47034
-
什么是晶圆级封装2022-04-06 12548
-
晶圆级芯片封装技术上市公司有哪些 晶圆级封装与普通封装区别在哪2023-08-30 6435
-
HRP晶圆级先进封装替代传统封装技术研究2023-11-18 999
-
【科普】什么是晶圆级封装2023-12-07 3234
-
一文看懂晶圆级封装2024-03-05 4098
-
晶圆级封装技术的概念和优劣势2025-05-08 3219
全部0条评论

快来发表一下你的评论吧 !

