

扫描白光干涉术在高精度表面测量中的应用
描述
扫描白光干涉术(SWLI)是目前最精确的表面形貌测量技术之一,被广泛应用于工业与科研领域。从发明至今的三十余年间,在精密光学、半导体、汽车及航天等先进制造领域的需求牵引下,该技术不断取得新的进展与突破。本文将详细介绍SWLI技术的工作原理、技术特点及其在多个领域的广泛应用,探讨美能光子湾如何通过其技术革新引领行业进步。
Part.01
扫描白光干涉技术(SWLI)
扫描白光干涉技术(scanning white light interferometry,SWLI)是用于测量材料表面形貌最精确的技术之一,属于反射式干涉显微术的一种类型。
还有许多其他技术和扫描白光干涉技术拥有相同或相似的工作原理,例如相干雷达(coherence radar),垂直扫描干涉术(vertical scanning interferometry),白光相移干涉术(white light phase shifting interferometry),全视场时域光学相干层析术(full-field time-domain optical coherence tomography)以及相干扫描干涉术(coherence scanning interferometry,CSl)。
其中,CSI被ISO-25178标准推荐作为白光干涉这类技术在表面测量学领域的术语。
Part.02
相干扫描干涉测量技术(CSl)
相干扫描干涉测量技术(CSl)是工业材料表面形貌测量中精度最高的技术之一。CSI是一种反射模式干涉显微镜,通过成像物镜的焦平面沿光轴扫描物体,可以获得三维(3D)图像作为二维(2D)图像的叠加。
 左图:典型CSI系统模式;右图:轴向扫描获得的三维图像叠加和典型CSI信号记录
左图:典型CSI系统模式;右图:轴向扫描获得的三维图像叠加和典型CSI信号记录
除了机械扫描操作,CSI和传统宽视场显微镜的一个主要区别是CSI采用了一个干涉物镜,通常有一个内置的Mirau或Michelson。
Michelson物镜主要用于低数值孔径(NA),低倍率系统(10倍及以下),而Mirau物镜在更高的NA和更高的倍率(10倍至100倍)下更有用。
这也是扫描白光干涉术的一个鲜明技术特点:横向分辨率与纵向测量精度的相对独立性。
此外,CSI的另一个特点在于:与激光移相干涉法(PSI)不同。
因为它使用宽带光源,例如发光二极管(LED)或卤素光源。这类光源的相干长度远小于激光光源的相干长度。
当通过CSI系统的焦点扫描一个表面时,干涉条纹只会在表面周围几微米的(轴向)窗口内形成,对应于干涉仪的零光程长度差。该窗口的轴向尺寸(即相干包络)与相干长度相关,相干长度由照明的时间和空间相干度决定。这种现象也被称为“低相干干涉”。
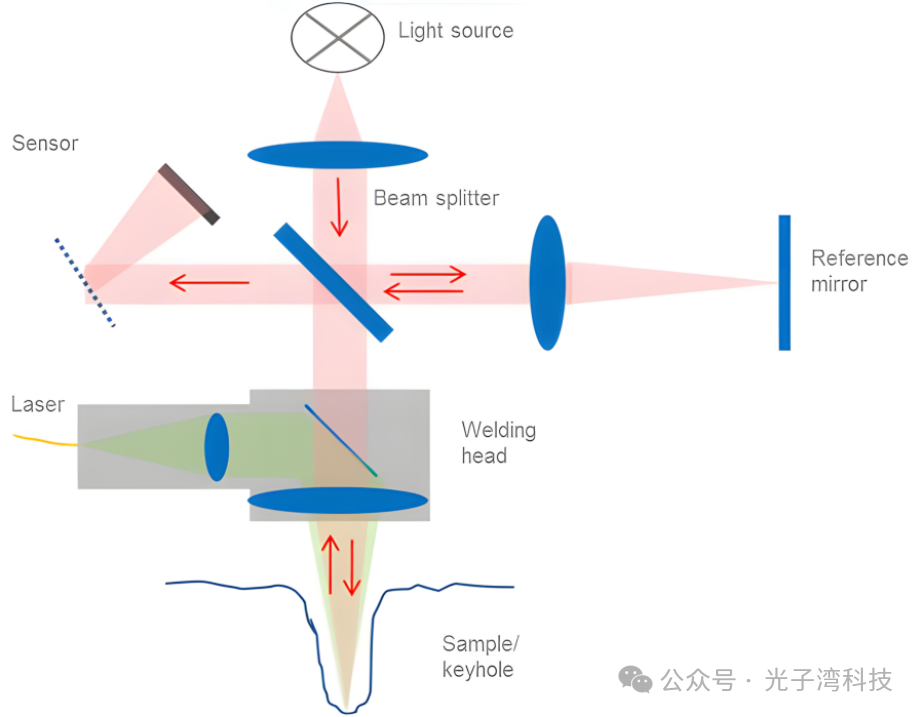
低相干干涉测量原理图
因此,扫描白光干涉仪的干涉信号被快速衰减的相干包络调制,仅在探测光和参考光的光程差接近零时出现。通过判断相干包络峰值的位置,可以在亚微米级不确定度范围内计算出待测表面的高度。如果结合条纹的相位信息,可以把表面高度测量不确定度降低至亚纳米量级。值得注意的是,相干包络的形状并不是只由光源光谱决定的,也取决于成像系统的数值孔径(NA)及空间相干度。
扫描白光干涉术中相干包络的峰值位置可以用于确定条纹级次,找出零级条纹,实现绝对距离的测量,既可以避免使用相位解包裹技术,又可以消除激光干涉术中常见的2π混淆(2π ambiguity)现象。
这一特性赋予了扫描白光干涉术大跨度的应用场景,包括测量平整光滑的表面、含有台阶和断层的表面、粗糙表面以及具有复杂曲率和斜率变化的表面。已经被广泛应用于半导体、光学、汽车、航空航天、医疗设备和能源等制造领域。
应用.01
表面纹理参数表征
扫描白光干涉技术结合正弦调制移相技术可以提高信噪比(SNR),并将噪声密度降低到0.1nm/根号下Hz水平,适用于测量超光滑表面的粗糙度。测量的表面类型多种多样,从测量得到的表面形貌图可以计算分析表面微观纹理的参数,例如表征标准质量的316不锈钢的表面纹理、测量涡轮机叶片表面形貌、检测毛玻璃表面质量和亚表面缺陷。

表面粗糙度测量
应用.02
高斜率表面测量
当待测表面是完美镜面时,如果其倾斜角度β大于arcsin(NA),则反射光线将超出物镜可接受的圆锥范围(如下图所示),这种情况下扫描白光干涉仪可以测到的最大表面斜率由物镜NA决定。

扫描白光干涉仪测量倾斜镜面的NA圆锥极限,(a)倾斜角度为0°;(b)倾斜角度β大于θ
随着技术进步,最先进的扫描白光干涉仪能够测量斜率超出传统NA圆锥极限的非镜面表面,这是因为物镜收集了来自倾斜表面微观纹理的背向散射光,并通过高动态范围(high dynamic range,HDR)测量技术或信号过采样技术提高散射信号的信噪比,获得足以重构表面的干涉条纹。

3D台阶高度测量
应用.03
增材制造表面测量
表面形貌可以看作是增材制造工艺流程的“指纹”特征。通过研究金属粉末床熔合(powder bedfusion,PBF)工艺中的焊接轨迹、焊接波纹、附着颗粒和表面凹陷等表面纹理特征,可以提取有用的信息来优化增材制造工艺,从而提高产品质量并减少能源和材料的消耗。但是,增材制造的表面形貌通常非常复杂,包含大量局部高斜率和松散颗粒状的表面结构。无论是接触式还是非接触式方法,精确测量增材制造表面是一项非常挑战的任务。使用扫描白光干涉仪可以测量出增材制造表面。

通过扫描白光干涉仪测量的增材制造表面示例。(a)PBF AI-Si-10Mg样品实物图(来自诺丁汉大学Helia Hooshmand博士);(b)激光PBF A1-Si-10Mg样品表面;(c)激光PBF Ti-6A1-4V样品表面:(d)电子束PBF Ti-6A1-4V样品表面
应用.04
膜层测量
很多材料表面覆盖有功能型膜层,例如光学元件表面的增透和增反膜,以及金属表面的陶瓷保护膜。通常,膜层上表面与空气接触,其折射率差异能够产生足够清晰的干涉条纹。膜层的下表面与衬底材料接触,二者折射率差异决定了白光干涉条纹的对比度。测量亚表面界面还需要仪器具有足够高的光学层析能力,一般来说,这种层析能力主要取决于白光干涉仪相干包络的宽度。
研究表明,扫描白光干涉仪适用于测量透明或半透明的膜层,例如二氧化硅单层膜上下表面的形貌和厚度、硅晶圆上的膜层、透明软质光刻胶薄膜、半透明粗糙羟基磷灰石层、氧化钛和氧化锆等导电氧化物薄膜、薄膜光伏材料、硅材料上的碳和陶瓷涂层、多层薄膜、结品高分子薄膜以及具有复杂形貌金属表面的陶瓷膜层。

(A)74.9nm SiNx薄膜,RMS粗糙度为1.51nm;(b)97.4nm SiCNy薄膜,RMS粗糙度为1.78nm
Photonx Bay
美能光子湾白光干涉轮廓仪

美能光子湾白光干涉轮廓仪可以简单快速地非接触测量从粗糙到超光滑,包括薄膜、陡坡和大台阶等各种表面的2D和3D特征。针对各行业高精度,高可靠性及重复性计量需求,提供计量解决方案。
扫描白光干涉技术以其卓越的测量精度和广泛的应用范围,已经成为现代工业和科研中不可或缺的技术之一。从超光滑表面的粗糙度测量到增材制造表面的复杂形貌分析,再到膜层厚度的精确测定,SWLI技术展现了其在精密测量领域的强大潜力。美能光子湾白光干涉轮廓仪将继续在高精度测量领域扮演着不可或缺的角色,为未来的技术革新和应用提供坚实的基础,同时也为工业和科研的发展贡献着重要的力量。, 乔潇悦, 简振雄, 张政, 温荣贤, 陈成, 任明俊, 朱利民. 用于表面形貌测量的扫描白光干涉技术进展[J]. 激光与光电子学进展, 2023, 60(3): 0312005. Rong Su, Jiayu Liu, Xiaoyue Qiao, Zhenxiong Jian, Zheng Zhang, Rongxian Wen, Cheng Chen, Mingjun Ren, Limin Zhu. Advances in Scanning White Light Interferometry for Surface Topography Measurement[J]. Laser & Optoelectronics Progress, 2023, 60(3): 0312005.苏榕, 刘嘉宇, 乔潇悦, 简振雄, 张政, 温荣贤, 陈成, 任明俊, 朱利民. 用于表面形貌测量的扫描白光干涉技术进展[J]. 激光与光电子学进展, 2023, 60(3): 0312005. Rong Su, Jiayu Liu, Xiaoyue Qiao, Zhenxiong Jian, Zheng Zhang, Rongxian Wen, Cheng Chen, Mingjun Ren, Limin Zhu. Advances in Scanning White Light Interferometry for Surface Topography Measurement[J]. Laser & Optoelectronics Progress, 2023, 60(3): 0312005.苏榕, 刘嘉宇, 乔潇悦, 简振雄, 张政, 温荣贤, 陈成, 任明俊, 朱利民. 用于表面形貌测量的扫描白光干涉技术进展[J]. 激光与光电子学进展, 2023, 60(3): 0312005. Rong Su, Jiayu Liu, Xiaoyue Qiao, Zhenxiong Jian, Zheng Zhang, Rongxian Wen, Cheng Chen, Mingjun Ren, Limin Zhu. Advances in Scanning White Light Interferometry for Surface Topography Measurement[J]. Laser & Optoelectronics Progress, 2023, 60(3): 0312005.*特别声明:本公众号所发布的原创及转载文章,仅用于学术分享和传递行业相关信息。未经授权,不得抄袭、篡改、引用、转载等侵犯本公众号相关权益的行为。内容仅供参考,如涉及版权问题,敬请联系,我们将在第一时间核实并处理。
-
探索扫描白光干涉术:校准、误差补偿与高精度测量技术2025-08-05 1642
-
白光色散干涉:实现薄膜表面轮廓和膜厚的高精度测量2025-07-22 1941
-
白光干涉仪中的VSI和PSI以及VXI模式的区别2025-02-06 541
-
为什么说白光干涉的扫描高度受限2025-01-21 461
-
白光干涉仪测量原理及干涉测量技术的应用2024-12-13 2696
-
白光干涉仪在半导体封装中对弹坑的测量2023-11-06 9300
-
白光干涉仪只能测同质材料吗?2023-08-21 10657
-
白光干涉仪可以测曲面粗糙度吗?2023-05-23 9185
-
白光干涉仪测量曲面粗糙度2023-05-22 1517
-
白光干涉仪的原理和测量方法2023-05-15 6589
-
如何验证白光干涉仪精度丨科普篇2023-04-07 2194
-
白光干涉仪测三维形貌2022-06-02 2141
-
白光干涉仪是什么?2021-11-01 2818
-
白光干涉仪你问我答,为你解惑!2017-12-13 9221
全部0条评论

快来发表一下你的评论吧 !

