

热发射显微镜下芯片失效分析案例:IGBT 模组在 55V 就暴露的问题!
电子说
描述
在半导体器件检测中,芯片失效分析一直是工程师关注的重点。尤其是 IGBT失效分析,因为它直接关系到功率器件的寿命与可靠性。本文分享一个在热发射显微镜下(Thermal EMMI) 芯片失效分析案例,展示我们如何通过 IV测试 与 红外热点成像,快速锁定 IGBT 模组的失效点。
一、样品背景
本次我们测试的对象是一颗 表面灌注硅凝胶的 IGBT 模组。客户要求进行 C-GE 测试(集电极 C 接正极,栅极 G 与发射极 E 短接为负极),电压最大允许达到 700V,同时电流需尽量控制在 80μA 以内。这类条件在功率器件失效分析中还是比较常见的。
二、IV 测试验证
由于客户未明确告知样品的电性状态,仅提示可承受最高 700V,因此致晟光电失效分析测试工程师首先选择 低电压范围(0~200V) 进行 IV 曲线扫描,避免样品短路风险。
 致晟光电IV 0~200V@0.08mA
致晟光电IV 0~200V@0.08mA
根据IV 测试结果来看,当电压升至 约 55V 时,电流就已达到 80μA,表现出明显的 漏电状态这意味着无需施加更高电压,仅在 200V 以下 就能判断出其失效特征。
三、热点成像分析
由于表面覆盖硅凝胶,红外成像最初较为模糊。但在经过调试优化后,芯片分布依然可以清晰呈现。随着测试推进,我们获得了以下热点结果:
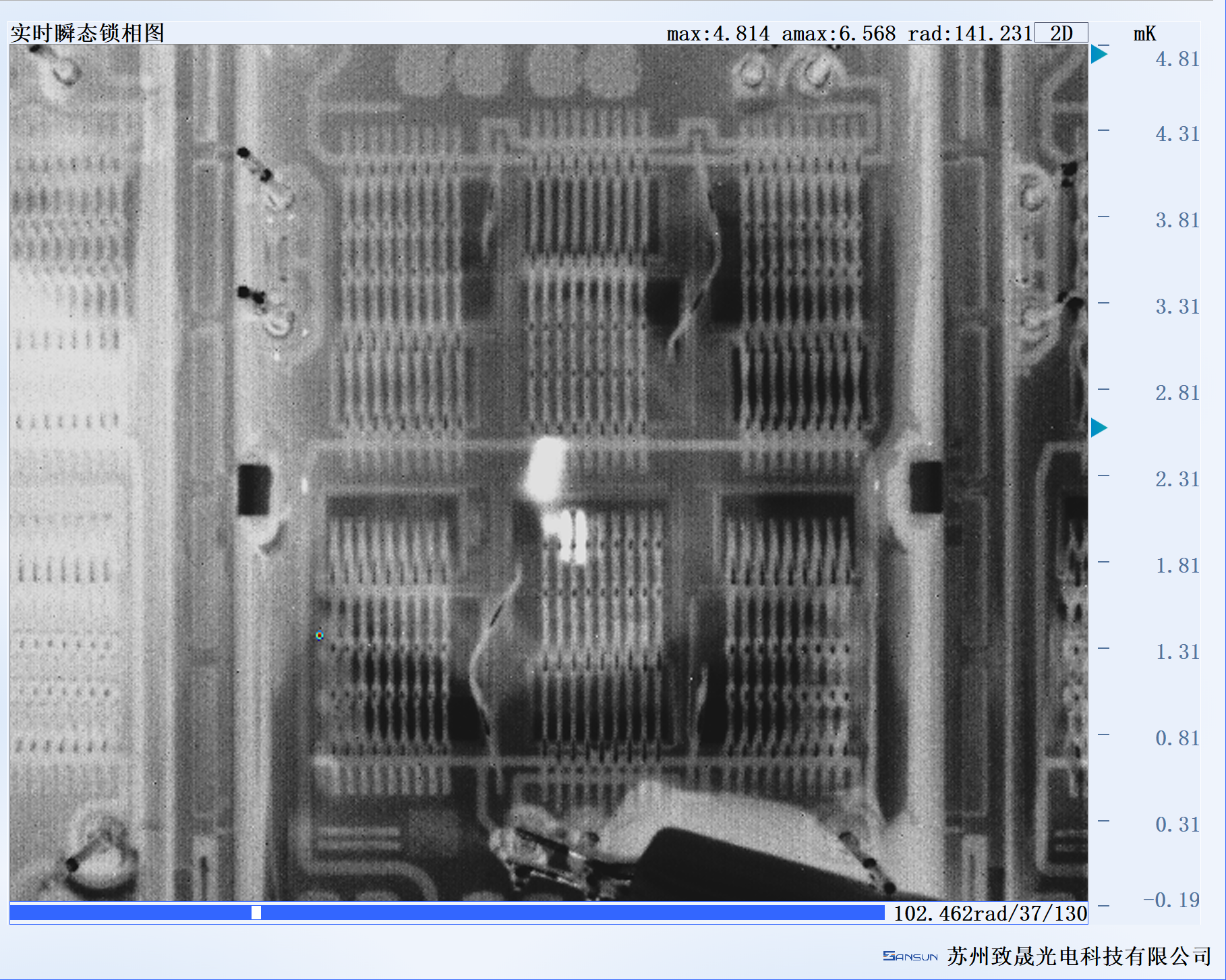 致晟光电 0.2倍相位合成图/0.2 倍镜头下:热点集中在 IGBT 芯片终端环。
致晟光电 0.2倍相位合成图/0.2 倍镜头下:热点集中在 IGBT 芯片终端环。  0.8 倍镜头放大后:热点位置更为聚焦。
0.8 倍镜头放大后:热点位置更为聚焦。  3 倍镜头进一步观察:热点几乎完全锁定在终端环处。
3 倍镜头进一步观察:热点几乎完全锁定在终端环处。
最终结论:该 IGBT 模组的失效点位于 芯片终端环区域。
四、总结
通过 IV 曲线验证 与 红外热点成像 的结合,我们不仅快速确认了器件的漏电特征,还精准定位了失效点。本案例也再次证明了:低电压预判+多倍率红外成像 是功率器件失效分析中非常高效的手段。
写在最后
很多工程师在调试 IGBT 时,可能也遇到过“电压没上去,电流先失控”的情况。你们在实际测试中,会优先采用 高压直测,还是像致晟光电失效分析测试工程师们这样先做低电压预判 呢?欢迎各位大佬在评论区交流你的经验~要是对我们致晟光电thermal emmi设备感兴趣的话,也可以访问我们门户网站~
审核编辑 黄宇
-
显微镜下芯片PAD面发蓝2024-08-23 5808
-
选购显微镜的一些常见问题2016-08-31 3939
-
Cyclops Micro高清数字显微镜2018-10-31 2304
-
微光显微镜 (EMMI)的应用范围?2019-03-05 6971
-
金相显微镜的应用及可观察什么?2019-04-26 3790
-
浅谈一下失效分析2019-10-11 2939
-
显微镜倍率如何计算?2020-02-06 7418
-
显微镜分析经验---放大倍率计算2020-03-23 3572
-
失效分析方法累积2020-03-28 2729
-
显微镜放大倍数是怎么得出来的?2020-04-26 3891
-
红外发光显微镜在集成电路失效分析中的应用2012-03-15 1250
-
扫描电子显微镜(SEM)在失效分析中的应用2022-08-18 6411
-
显微镜在芯片失效分析中的具体应用场景及前景2024-11-26 2128
-
晶背暴露的MOS管漏电怎么查?热红外显微镜Thermal EMMI 热点分析案例2025-10-31 1770
-
共聚焦显微镜、光学显微镜与测量显微镜的区分2026-01-20 461
全部0条评论

快来发表一下你的评论吧 !

