

基于传输线法(TLM)的多晶 In₂O₃薄膜晶体管电阻分析及本征迁移率精准测量
描述
氧化物半导体(如In₂O₃)因其高电子迁移率(>10 cm²/Vs)和低漏电流特性,成为下一代显示技术和三维集成器件的理想候选材料。然而,传统场效应迁移率(μFE)的测量常因寄生电阻(Rs/d)和通道尺寸偏差(ΔL/ΔW)导致低估本征迁移率(μFEi)。本文通过传输线法(TLM),结合Xfilm埃利TLM接触电阻测试仪,在多晶In₂O₃-TFT中分离通道电阻Rch与Rs/d,成功提取了μFEi,验证了其超过100 cm²/Vs的高迁移率特性,为高迁移率氧化物半导体的性能评估提供了新方法。
实验方法与器件制备
/Xfilm

(a) TFT器件结构示意图(b) In₂O₃-TFT的俯视光学显微镜图像(c) In₂O₃-TFT的截面扫描透射电镜(STEM)图像器件结构设计
采用顶接触/底栅极结构,以SiO₂/n⁺-Si为衬底,5 nm厚非晶In₂O₃通过射频磁控溅射沉积(功率密度1.81 W/cm²,Ar:O₂=19.4:0.6 sccm),经450°C退火形成多晶通道。源/漏电极(Pt/W: 20/80 nm)通过光刻与湿法刻蚀集成。Ga₂O₃钝化层(50 nm)覆盖通道,经350°C氮气退火优化界面。
- 电学表征
对器件的输出特性和转移特性进行测量,得到了μFE、阈值电压Vth和亚阈值摆幅(SS)等参数,并验证了器件的稳定性,为 TLM 分析提供了基础。
电学特性与迁移率分析
/Xfilm

(a) In₂O₃-TFT的输出特性曲线(b) In₂O₃-TFT的转移特性曲线(c) 基于120个器件计算的电学参数统计(d) 不同设计通道长度对转移特性的影响(e) 不同设计通道宽度对转移特性的影响
基本性能
- 输出特性:线性区(Vd=0.1 V)显示欧姆接触特性,漏电流Id与Vd呈正比。
- 转移特性:线性区μFE=83.6±2.2 cm²/Vs,Vth=-0.51±0.22 V。
- 通道尺寸影响:Ldes/Wdes=5-25 μm时,Id与通道长度成反比,验证器件稳定性。

(a) TFT通道宽度结构设计(b) 恒定源漏金属宽度下,通道欠覆盖长度对归一化转移特性的影响(c) 不同Ws/d下,表观场效应迁移率随总Ludl的变化关系(d) 漏极电导随设计通道宽度的变化关系
通道设计对迁移率的影响
- Ws/d与Wch匹配设计:避免通道欠覆盖(Wch>Ws/d)导致的μFE高估。
- TLM修正ΔW:通过漏极电导(gd=∂Id/∂Vd)与Wdes关系,确定ΔW=3.4 μm,有效宽度Weff=Wdes-ΔW。

传输线法(TLM)提取本征迁移率
/Xfilm

(a) In₂O₃-TFT的归一化转移特性曲线与表观μFE计算值对比(b) 不同Vg–Vth下,RtotalWeff随设计通道长度的TLM曲线(c) RchWeff、Rs/dWeff及传输长度随Vg–Vth的变化关系(d) 通道电阻率倒数随Vg–Vth的变化曲线
- TLM模型与参数分离
总电阻(Rtotal)由通道电阻(Rch = rsh·Ldes/Weff)和寄生电阻(Rsd)串联组成。通过不同Ldes器件的Rtotal-Weff-Ldes曲线,分离出rsh和Rsd。
- 本征迁移率提取
通道电阻率rch = 1/(μFEi·Cox·Weff·(Vg-Vth))的倒数与(Vg-Vth)呈线性关系,斜率计算得到μFEi=107.0 cm²/Vs。实验数据与理论曲线吻合,验证了Rsd(8.1 kΩ·μm)对短通道器件μFE的抑制效应。通过TLM成功提取多晶In₂O₃-TFT的μFEi(>100 cm²/Vs),消除了寄生电阻和尺寸偏差的影响。高迁移率表明多晶In₂O₃在短通道和纳米片器件中具有应用潜力。未来优化接触电阻(ρc=1.1×10⁻⁵ Ω·cm²)以进一步提升性能。结合界面工程与材料设计,探索多晶氧化物的电子输运机制。
Xfilm埃利TLM电阻测试仪
/Xfilm
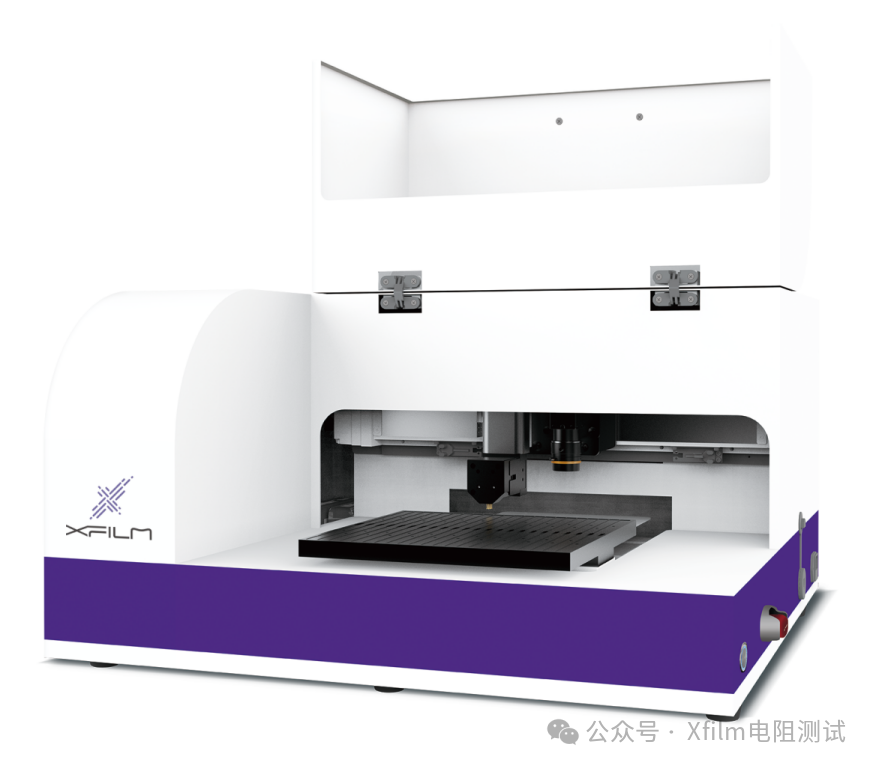
Xfilm埃利TLM接触电阻测试仪用于测量材料表面接触电阻或电阻率的专用设备,广泛应用于电子元器件、导电材料、半导体、金属镀层、光伏电池等领域。■ 静态测试重复性≤1%,动态测试重复性≤3%■ 线电阻测量精度可达5%或0.1Ω/cm■ 接触电阻率测试与线电阻测试随意切换■ 定制多种探测头进行测量和分析本研究通过Xfilm埃利TLM接触电阻测试仪的高精度测量能力,系统分析了多晶In₂O₃-TFT的本征迁移率,揭示了寄生电阻对传统迁移率测量的影响。实验证明多晶In₂O₃的μFEi可达107 cm²/Vs,为高性能氧化物半导体器件的设计与评估提供了重要参考。
原文出处:《Intrinsic field-effect mobility in thin-film transistor with polycrystalline In2O3 channel based on transfer length method》
*特别声明:本公众号所发布的原创及转载文章,仅用于学术分享和传递行业相关信息。未经授权,不得抄袭、篡改、引用、转载等侵犯本公众号相关权益的行为。内容仅供参考,如涉及版权问题,敬请联系,我们将在第一时间核实并处理。
-
台阶仪在薄膜晶体管的应用 | 精准表征有源层厚度均匀性2026-04-03 179
-
基于传输线模型(TLM)的特定接触电阻率测量标准化2025-10-23 2488
-
基于改进传输线法(TLM)的金属 - 氧化锌半导体界面电阻分析2025-09-29 930
-
液态金属接触电阻精确测量:传输线法(TLM)的新探索2025-07-22 1878
-
MXene范德华接触在氮化镓高电子迁移率晶体管中的应用2023-05-25 2579
-
TFTLCD薄膜晶体管液晶显示器简介2022-03-02 6236
-
紫外辅助清洗对非晶氧化物半导体薄膜晶体管稳定性的影响2022-01-14 1144
-
薄膜晶体管(TFT)阵列制造技术2021-04-15 1657
-
CMPA801B025F氮化镓(GaN)高电子迁移率 基于晶体管2020-12-03 1057
-
薄膜晶体管液晶显示器技术2008-10-29 2772
全部0条评论

快来发表一下你的评论吧 !

