

四探针薄膜测厚技术 | 平板显示FPD制造中电阻率、方阻与厚度测量实践
描述
平板显示(FPD)制造过程中,薄膜厚度的实时管理是确保产品质量的关键因素。传统方法如机械触针法、显微法和光学法存在破坏样品、速度慢、成本高或局限于特定材料等问题。本研究开发了一种基于四探针法的导电薄膜厚度测量仪,其原理是通过将已知的薄膜材料电阻率除以方阻来确定厚度,并使用XFilm 平板显示在线方阻测试仪作为对薄膜在线方阻实时检测,以提供数据支撑。旨在实现非破坏性、快速精准的定点测量,并显著降低设备成本。
四探针法原理
/Xfilm
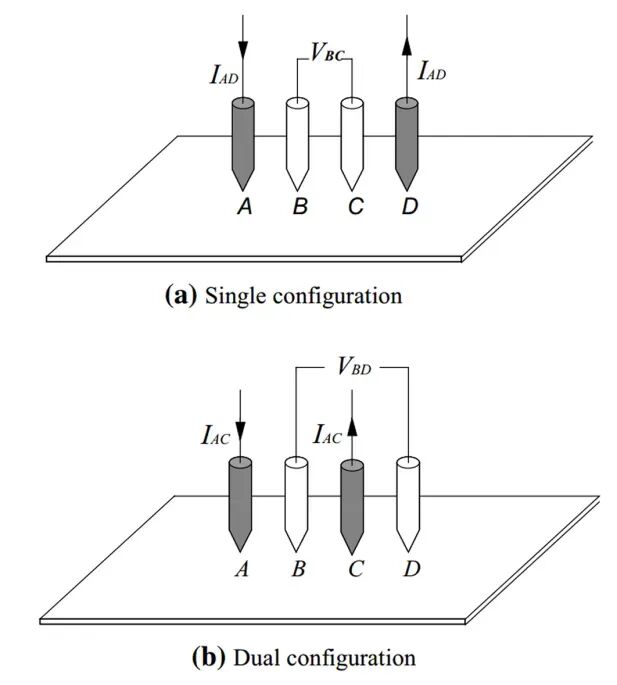
四探针法:(a) 单配置;(b) 双配置
四点探针法通过测量电流与电压计算薄膜的方阻(RS),结合材料电阻率(ρ)推导厚度(t=ρ/RS)。本仪器支持两种配置:单配置模式:
通过外侧探针施加电流(IAD),内侧探针测量电压(VBC),计算电阻 Rs = VBC / IAD,结合修正因子 ks 得方阻 Rss = ks × Rs。其中 ks 整合了样品尺寸(F (d/S) )、厚度(F(t/S))、温度(F(T))及探针间距(F(S))四类修正。双配置模式:
采用交叉电流注入(IAC)与电压检测(VBD),通过比例系数 kd 自动消除边缘效应,特别适用于小尺寸样品。
薄膜厚度测量仪设计
/Xfilm
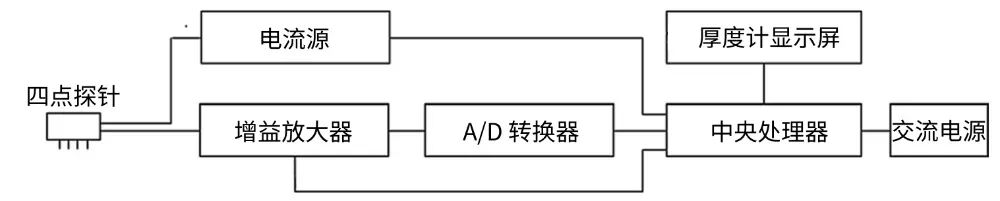
薄膜测厚仪系统框图
系统组成:仪器集成电源、CPU、显示器、A/D转换器和增益放大器,支持单/双配置模式切换,具备自动/手动测量、校准、金属电阻率输入等功能。探针台与四点探针:为最小化测量薄膜厚度时探针抖动引起的接触电阻影响,本研究设计并制造了专用探针台。该装置通过上下控制旋钮固定探针,使其垂直接触样品表面以测量薄膜厚度。传统四探针法(FPP)因使用四探针接触被视为破坏性方法,但通过优化探针形状与半径可实现非破坏测量。
薄膜测厚仪的电阻与方阻特性
/Xfilm
本研究通过标准电阻溯源法严格验证薄膜测厚仪的电学性能:电阻测量
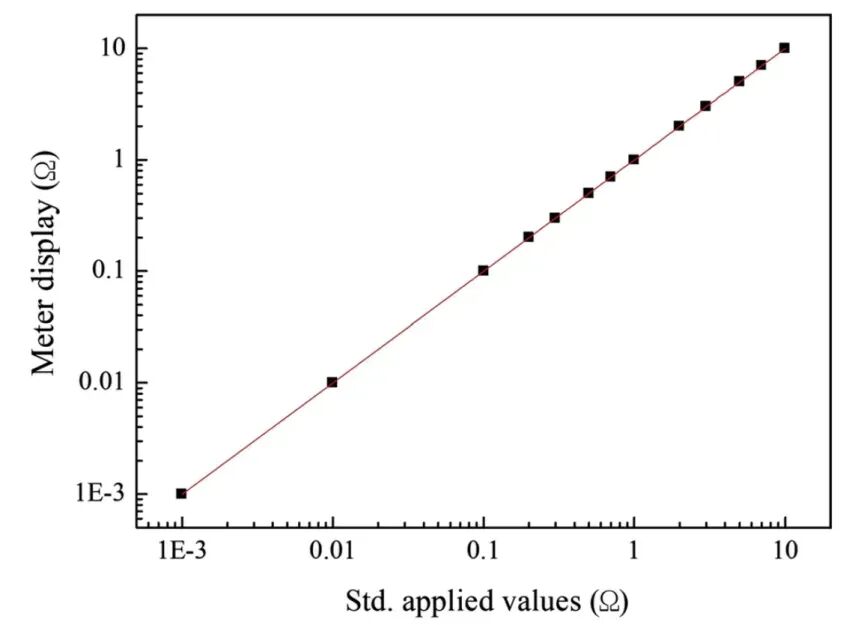
电阻测量线性度
- 量程:1 mΩ–10 Ω
- 线性误差<0.1%,阶跃响应误差≤0.001 Ω
- 不确定度:0.1–0.2%(k=2),稳定性达±1 digit(3½位显示)
方阻测量单配置:
理论值 Rss =4.532 Ω/□(基于四修正因子),全量程扩展为4.532 mΩ/□ – 45.32 Ω/□双配置:
理论值 RSd=2.605 Ω/□(比例常数法),全量程为2.605 mΩ/□–26.05 Ω/□实测偏差:单/双配置均<0.1%测厚仪的电阻与方阻测量功能在宽量程(1 mΩ–10 Ω)内均实现≤0.1%的高精度,且重复性、稳定性优异。这一性能为厚度换算公式 t=ρ/RSS 提供了可靠基础,确保薄膜厚度测量的准确性。尤其通过双配置设计有效抑制边缘效应,解决了小尺寸样品测量难题,凸显其在微纳薄膜表征中的实用价值。
厚度测量准确性验证
/Xfilm
测量原理:存储多种材料电阻率(如Al、Cu等),用户选择材料后,探针接触样品表面,仪器通过t=ρ/RSS计算厚度并实时显示。
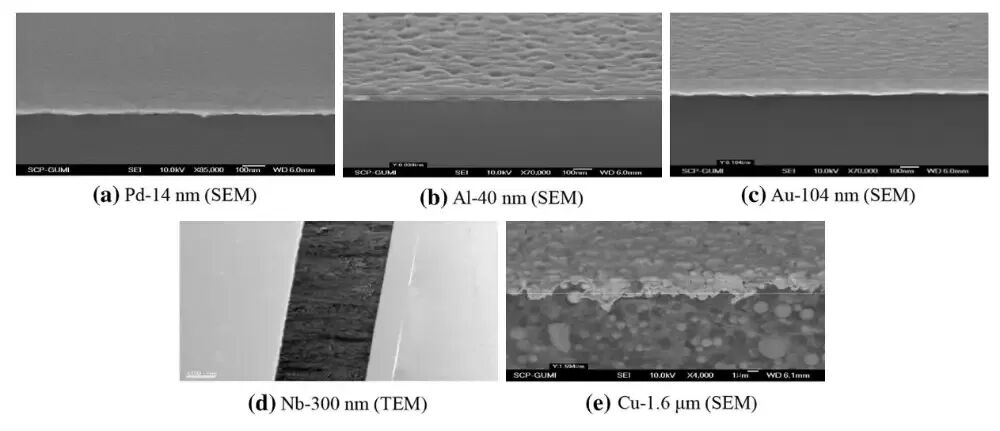
五种样品厚度对比
实验验证:制备Pd、Al、Au、Nb、Cu薄膜样品(沉积于75 mm硅片),测量中心10 mm范围内厚度,并与SEM/TEM观测截面厚度对比。结果显示,测量值与显微观测值在14 nm–1.6 μm范围内误差小于0.1%,差异源于SEM/TEM的观测误差。本研究开发了一种用于平板显示(如触摸屏和触控面板)制造过程中薄膜厚度管理的薄膜厚度测量仪。该仪器基于四探针法,通过已知薄膜材料的电阻率与测得的方阻值计算厚度,理论量程为1 nm–1 mm,使用Pd、Al、Au、Nb、Cu五种薄膜样品(沉积于75 mm硅片)验证性能,实现薄膜样品任意位置的快速精准测量。
xfilm平板显示在线方阻测试
/Xfilm

平板显示在线方阻测试仪专为高精度智能制造设计,全面支持金属薄膜(ITO)、硅基材料(LTPS)与氧化物半导体(IGZO)的在线检测。
- 测试仪自检功能
- 最小0.1mm测量分辨率
- 测试范围:1m~10M Ω/sq
- 玻璃基板定位(搜索)功能
XFilm 平板显示在线方阻测试仪与本研究开发的四探针薄膜测厚仪形成完整的薄膜表征解决方案:前者通过在线实时监测方阻数据,为产线提供动态电阻分布反馈;后者则基于方阻与厚度的换算关系,实现薄膜厚度的精准溯源。
原文参考:《Development of a Thickness Meter for Conductive Thin Films Using Four‑Point Probe Method》
*特别声明:本公众号所发布的原创及转载文章,仅用于学术分享和传递行业相关信息。未经授权,不得抄袭、篡改、引用、转载等侵犯本公众号相关权益的行为。内容仅供参考,如涉及版权问题,敬请联系,我们将在第一时间核实并处理。
-
如何用四探针测量半导体电阻率2026-05-19 88
-
四探针 vs 双探针的电池极片电阻率测试方法对比2026-05-12 342
-
四探针法测量电阻率:原理与不确定度分析2026-03-17 786
-
源表应用拓展:四探针法测电阻率2026-03-16 479
-
金属小样品电阻率的四探针高精度测量方法2026-03-03 317
-
基于四探针法的碳膜电阻率检测2026-01-22 385
-
四探针法测量Ti-Al-C薄膜的电阻率2026-01-15 486
-
二探针与四探针电阻测量法的区别2026-01-08 540
-
四探针法在薄膜电阻率测量中的优势2025-12-18 719
-
面向5G通信应用:高阻硅晶圆电阻率热处理稳定化与四探针技术精准测量2025-09-29 1068
-
四探针法精准表征电阻率与接触电阻 | 实现Mo/NbN低温超导薄膜电阻器2025-07-22 870
-
美能FPP230A扫描四探针方阻仪:光伏电池片材料电阻率测量的专业解决方案2024-05-28 2000
-
吉时利四探针法测试系统实现材料电阻率的测量2020-10-19 5219
-
电阻率与霍尔电压的测量2011-07-05 3309
全部0条评论

快来发表一下你的评论吧 !

