

基于传输线法TLM与隔离层优化的4H-SiC特定接触电阻SCR精准表征
描述
4H-碳化硅(4H-SiC)因其宽禁带(3.26 eV)、高热导率(4.9 W·cm⁻¹·K⁻¹)和高击穿场强(2.5 MV·cm⁻¹),成为高温、高功率电子器件的核心材料。然而,其欧姆接触的精准表征面临关键挑战:商用衬底的高掺杂特性导致电流扩散至衬底深层,使得传统传输线法(TLM)测得的特定接触电阻(SCR)显著偏离真实值。本研究结合Xfilm埃利TLM接触电阻测试仪,通过TCAD模拟与实验验证,提出一种基于隔离层的优化结构,为SCR的准确测定提供了新方案。
TLM测量原理
/Xfilm
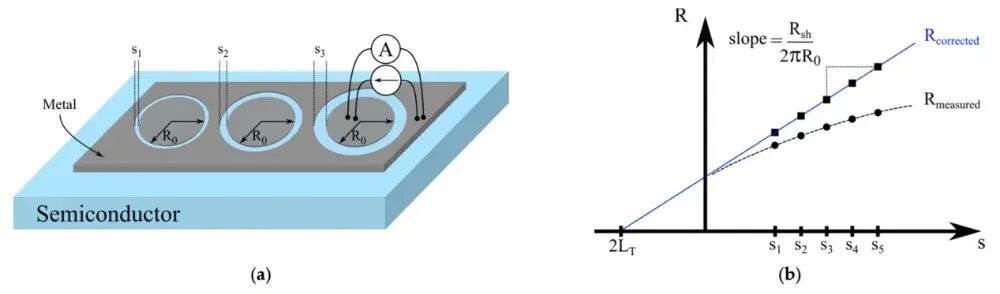
(a) 圆形c-TLM方法示意图(b) 欧姆接触电阻随电极间距变化的典型曲线
TLM模型:通过测量不同间距s电极的电阻R,结合修正因子Cₛ(R₀为内电极半径) 可提取转移长度 LT 与SCR,Rₛₕ为薄层电阻。
可提取转移长度 LT 与SCR,Rₛₕ为薄层电阻。 

商用衬底的测量瓶颈
/Xfilm

激光退火Ti/4H-SiC接触的I-V特性曲线(b) 校正后电阻随间距的变化
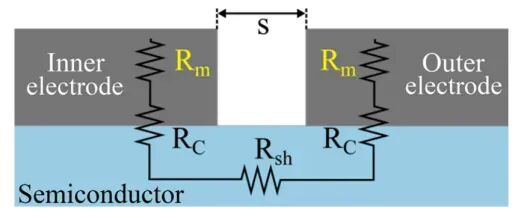
金属-半导体结构中的电阻组成示意图实验采用
激光退火制备Ti/4H-SiC接触,I-V曲线虽呈线性,但修正电阻-间距曲线线性度差(相关系数0.46),且电阻值极低(150-180 mΩ)。仿真重现该结构发现,350μm厚衬底中电流深入扩散,导致总电阻Rtotal=Rm+RC+Rsh中Rsh占比过小,间距变化对电阻影响微弱,难以准确提取SCR。
高掺杂衬底对SCR测定的影响
/Xfilm

直接制备于350 µm厚4H-SiC衬底上的c-TLM结构图(b) 1 V偏压下电流密度分布(c) 横截面视图(d) 不同间距的模拟I-V曲线(e) 电阻随间距的变化
厚衬底(350μm)仿真
- 电流分布:电子主要沿电极间流动,但显著向衬底深处扩散。
- 电阻特性:不同间距下电阻集中分布在150-180 mΩ,间距依赖性弱,与实验结果一致。
- 问题根源:高掺杂(1×10¹⁸ cm⁻³)衬底电阻率低,电流无法局域化。

(a) 2 µm薄衬底上c-TLM结构的模拟I-V曲线(b) 电阻随间距显著变化薄衬底(2μm)仿真
- 电流局域化:超薄衬底强制电流集中在接触附近,I-V曲线间距依赖性显著,电阻随间距线性增加(1.3-3.5Ω)。
- 局限性:实际工艺难以实现2μm厚SiC衬底加工。
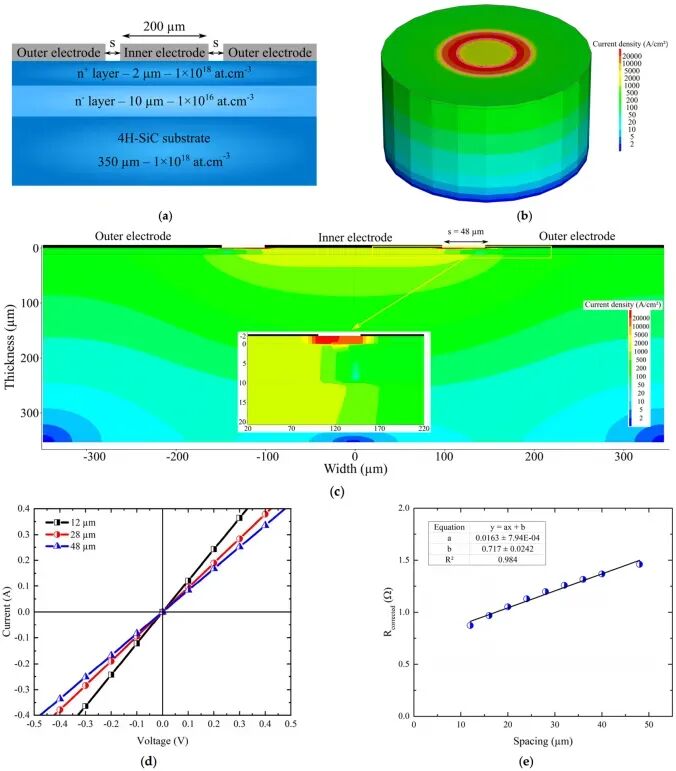
(a) 含隔离层的结构示意图(b)-(c) 1 V偏压下电流密度的3D与横截面分布(d) 不同间距的I-V曲线(e) 电阻随间距变化
结构设计:在衬底与n⁺层间插入低掺杂隔离层,通过调节其厚度(1‒40 μm)与掺杂浓度(5×10¹³‒1×10¹⁶ cm⁻³)优化电流限制效果。 关键结论:
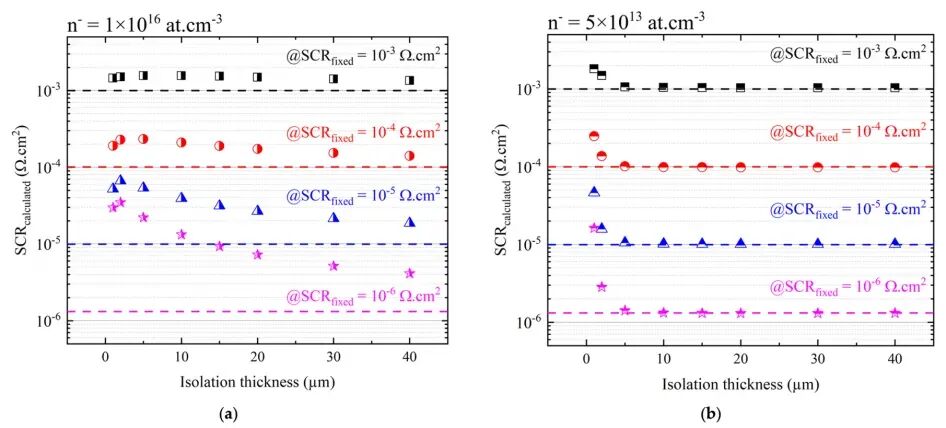
(a) 隔离层掺杂为1×10¹⁶ at⋅cm⁻³时,SCR计算值随厚度的变化;(b) 隔离层掺杂为5×10¹³ at⋅cm⁻³时的变化;虚线:2 µm厚理想隔离层的参考SCR值
- 掺杂浓度:隔离层需≤5×10¹³ cm⁻³。若掺杂为1×10¹⁶ cm⁻³,SCR测定误差可达5.5倍(如SCR真实值1×10⁻⁶ Ω·cm²时,测得值5.5×10⁻⁶ Ω·cm²)。
- 厚度:厚度≥5 μm时,SCR误差<7%。例如,5 μm/5×10¹³ cm⁻³隔离层可将SCR=1×10⁻⁶ Ω·cm²的误差降至1.07倍。
- 物理机制:低掺杂隔离层显著提升电阻率,迫使电流集中于顶部n⁺层。
实验验证与性能对比
/Xfilm

(a) 激光退火Ti/4H-SiC接触的I-V特性;(b) 校正后电阻随间距的变化
钛(Ti)接触实验:
- 结构参数:5.6 μm厚隔离层(5×10¹³ cm⁻³) + 2.6 μm n⁺层(1.9×10¹⁸ cm⁻³)。
- 工艺:100 nm Ti溅射 + 激光退火(5.0 J·cm⁻²) + 离子束刻蚀c-TLM图案。
- 结果:I-V曲线线性,SCR=1×10⁻⁴ Ω·cm²,电阻-间距曲线相关性显著提升(R² ≈ 1)。
镍(Ni)接触对比:相同结构下,SCR进一步降至2.4×10⁻⁵ Ω·cm²,验证了方案的普适性。 本研究通过系统模拟与实验,揭示了高掺杂衬底对特定接触电阻(SCR)测定的干扰机制,并提出了一种基于传输线法(TLM)-隔离层的优化方案。掺杂的隔离层可有效限制电流分布,将特定接触电阻(SCR)测定误差降至7%以内,为4H-SiC功率器件的欧姆接触优化提供了可靠表征方法。
Xfilm埃利TLM电阻测试仪
/Xfilm
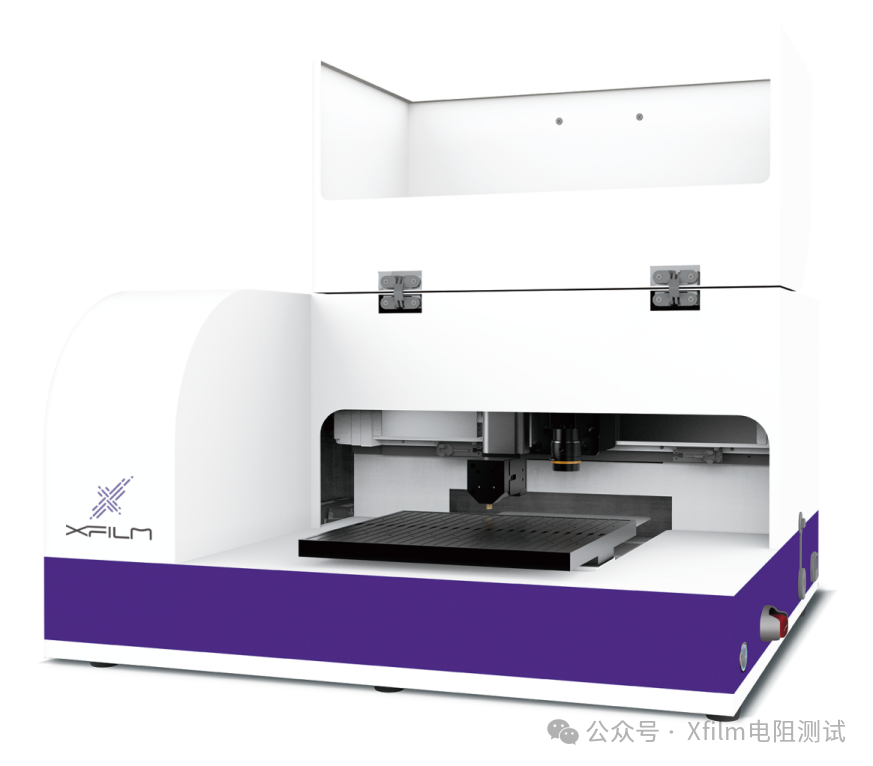
Xfilm埃利TLM接触电阻测试仪用于测量材料表面接触电阻或电阻率的专用设备,广泛应用于电子元器件、导电材料、半导体、金属镀层、光伏电池等领域。■ 静态测试重复性≤1%,动态测试重复性≤3%■ 线电阻测量精度可达5%或0.1Ω/cm■ 接触电阻率测试与线电阻测试随意切换■ 定制多种探测头进行测量和分析本文提出的隔离层-传输线法(TLM)联合方案,结合Xfilm埃利TLM接触电阻测试仪的高精度测量能力,为4H-SiC功率器件的欧姆接触工艺优化提供了标准化测试流程。
原文参考:《How to Accurately Determine the Ohmic Contact Properties on n-Type 4H-SiC》
*特别声明:本公众号所发布的原创及转载文章,仅用于学术分享和传递行业相关信息。未经授权,不得抄袭、篡改、引用、转载等侵犯本公众号相关权益的行为。内容仅供参考,如涉及版权问题,敬请联系,我们将在第一时间核实并处理。
-
精确表征有机异质界面:解析传输长度法TLM中的几何偏差与接触电阻物理关联2026-03-12 210
-
锂电池嵌入电极颗粒的传输线法TLM 模拟研究2025-11-13 494
-
基于传输线模型(TLM)的特定接触电阻率测量标准化2025-10-23 2488
-
基于传输线法(TLM)的多晶 In₂O₃薄膜晶体管电阻分析及本征迁移率精准测量2025-09-29 1571
-
液态金属接触电阻精确测量:传输线法(TLM)的新探索2025-07-22 1878
-
掺杂分布对太阳能电池薄膜方阻和接触电阻的影响2024-08-30 2041
-
光伏太阳能电池性能评估的利器:美能TLM接触电阻测试仪2024-05-22 4809
-
太阳能电池接触电阻测试中的影响因素2024-01-14 2358
-
4H-SiC缺陷概述2023-12-28 5611
-
美能TLM接触电阻测试仪,看它如何作用于电池生产!2023-11-18 2392
-
4H-SiC离子注入层的欧姆接触的制备2009-02-28 1396
全部0条评论

快来发表一下你的评论吧 !

