

基于四点探针和扩展电阻模型的接触电阻率快速表征方法
描述
接触电阻率(ρc)是评估两种材料接触性能的关键参数。传统的传输长度法(TLM)等方法在提取金属电极与c-Si基底之间的ρc时需要较多的制造和测量步骤。而四探针法因其相对简单的操作流程而备受关注,但其广泛应用受限于所需的3D模拟数据拟合过程。本文通过引入结合Xfilm埃利四探针方阻仪与扩展电阻模型(SRM)的方法快速准确的提取ρc。
四点探针法基础
/Xfilm
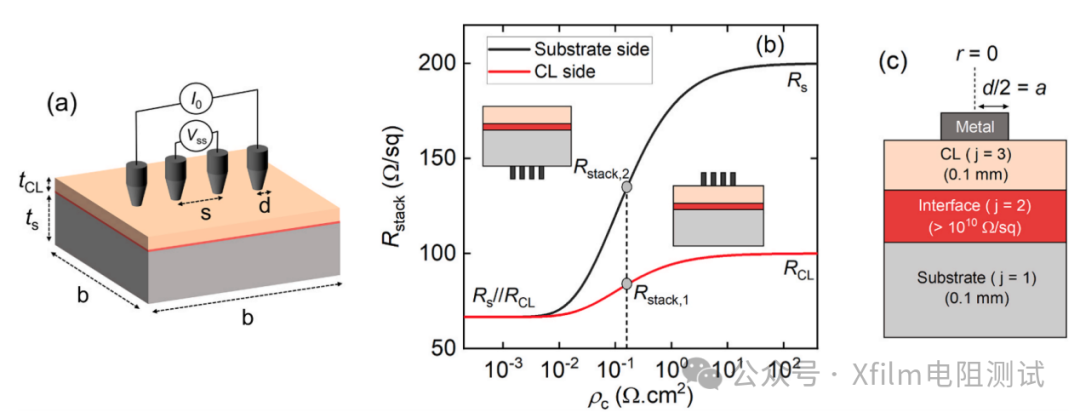
四点探针(4PP)多层结构测量示意图四点探针法通过测量表观电阻(Rapp)评估材料电学特性,其计算公式为: 其中,C 为几何修正因子,与探针间距(s)、样品尺寸(b)和接触直径(d)相关。
其中,C 为几何修正因子,与探针间距(s)、样品尺寸(b)和接触直径(d)相关。
- 单层材料,薄层电阻(Rsh)定义为电阻率(ρ)与厚度(t)的比值(Rsh = ρ/t);
- 多层结构(如接触层 - 基板堆叠,CL - 基板),堆叠电阻(Rstack)与接触电阻率(ρc)、接触层电阻(RCL)、基板电阻(Rs)及几何参数紧密耦合,需通过模型解耦各参数。

扩展电阻模型(SRM)
/Xfilm
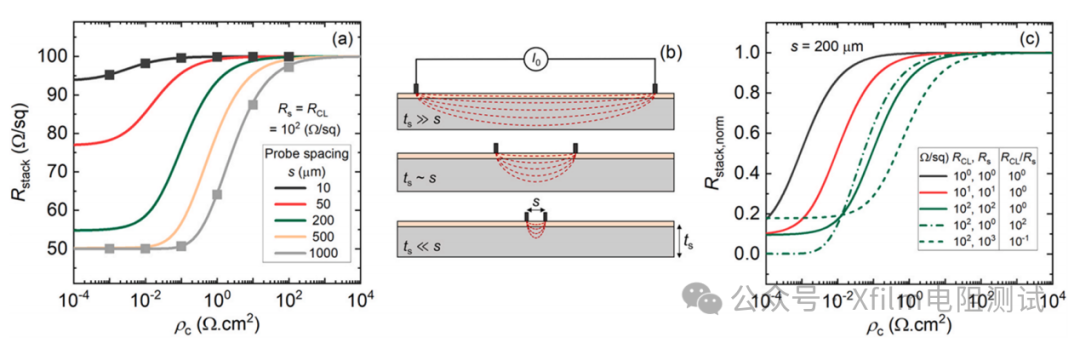 CL侧接触,Rstack随ρc变化;(b) 多层电流分布示意图;(c) 归一化Rstack随ρc变化扩展电阻模型(SRM)基于点电流源假设,通过贝塞尔函数积分和递归关系计算电势分布。其核心公式为:
CL侧接触,Rstack随ρc变化;(b) 多层电流分布示意图;(c) 归一化Rstack随ρc变化扩展电阻模型(SRM)基于点电流源假设,通过贝塞尔函数积分和递归关系计算电势分布。其核心公式为:

式中,FN 为多层结构的积分核函数,通过递归公式逐层计算各层电导率(σj)和厚度(tj)的影响。特别地,接触层(CL)与基板的界面通过等效薄层(厚度 10⁻⁵ nm)模拟接触电阻率(ρc),结合 MATLAB 数值求解,单次计算时间可控制在 0.2 秒以内,显著提升了求解效率。
扩展4PP方法(E4PP)
/Xfilm
E4PP方法仅需三个测量步骤:
- 基板电阻(Rs)测量:在未覆盖接触层(CL)的基板上进行四点探针测量,获取基板本身的薄层电阻。
- 正向堆叠电阻(Rstack1)测量:从接触层(CL)一侧对 CL - 基板堆叠结构进行测量,获取正向电流下的堆叠电阻。
- 反向堆叠电阻(Rstack2)测量:从基板一侧对同一堆叠结构进行反向测量,获取反向电流下的堆叠电阻。
通过非线性最小二乘求解方程组:

其中,RCL 为接触层电阻,tCL 和 ts 分别为接触层与基板的厚度。当 Rstack1 < Rstack2 时,方程组可唯一确定 RCL 和 ρc;若出现双解,需结合物理意义(如接触电阻率非负性)选择合理值。
模型验证与参数优化
/Xfilm
SRM与FEM模拟结果对比显示,对于10×10 cm²基板,相对误差δ < 0.1%;2×2 cm²基板误差δ < 1.9%,验证了SRM的准确性。SRM计算耗时仅0.2秒,较FEM(15–30分钟)显著提升。
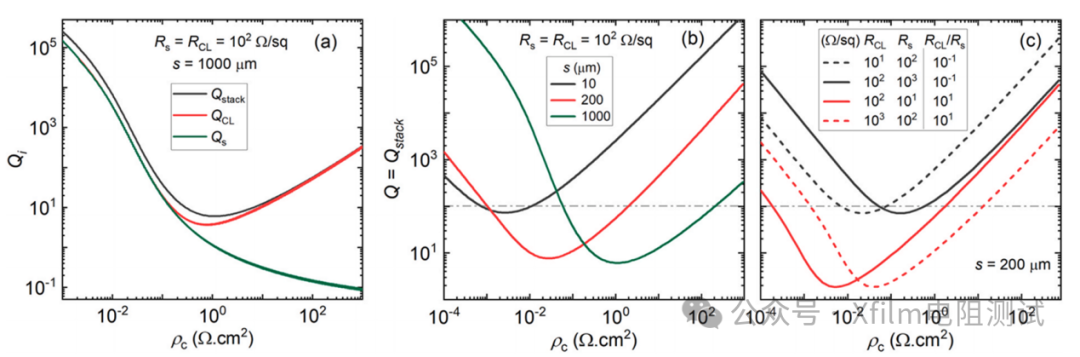
(a) Qi随ρc变化曲线;(b) Q=Qstack随 ρc变化曲线;(c) Q随ρc变化曲线
- 探针间距(s):减小s可提升低ρc(<10⁻² Ω·cm²)区间的灵敏度,但s需大于基板厚度(ts)以避免电流局域化。
- 薄层电阻比(RCL/Rs):高RCL/Rs比(>10)时,ρc的提取灵敏度显著提高,尤其在s ≈ ts时。
- 误差敏感性:定义灵敏度系数Q = (Ri/ρc)(∂ρc/∂Ri),Rstack的测量误差(Qstack)对ρc影响最大,需控制Q < 10²以确保误差<10%。

实验验证
/Xfilm
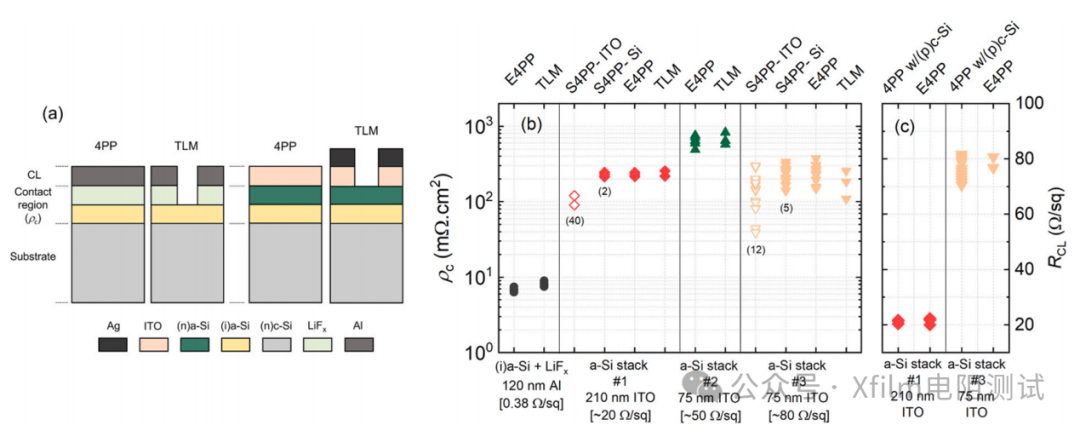 (a) 制备样品示意图;(b) 标准4PP、扩展4PP与TLM计算的ρc对比;(c) E4PP方法计算的 RCL与直接通过简单4PP测量提取的 RCL对比通过制备ITO/(n)c-Si和Al/(n)c-Si样品,对比S4PP、E4PP与TLM结果:
(a) 制备样品示意图;(b) 标准4PP、扩展4PP与TLM计算的ρc对比;(c) E4PP方法计算的 RCL与直接通过简单4PP测量提取的 RCL对比通过制备ITO/(n)c-Si和Al/(n)c-Si样品,对比S4PP、E4PP与TLM结果:
- S4PP在CL侧测量时,因RCL不确定性(±15%)导致ρc误差较大(Q ≈ 10²);
- E4PP通过单一样品测量,ρc与TLM结果高度一致(偏差<5%),且RCL估算准确。
- 实验覆盖ρc范围5×10⁻³–1×10⁶ Ω·cm²,验证了方法的普适性。
通过实验验证了扩展四点探针方法的有效性,结果显示扩展四点探针方法与传输长度法和标准四点探针方法的结果非常接近,适用于接触电阻率在5×10−3到1×100 Ω cm²范围内的测量。
Xfilm埃利四探针方阻仪
/Xfilm

Xfilm埃利四探针方阻仪用于测量薄层电阻(方阻)或电阻率,可以对最大230mm 样品进行快速、自动的扫描, 获得样品不同位置的方阻/电阻率分布信息。
- 超高测量范围,测量1mΩ~100MΩ
- 高精密测量,动态重复性可达0.2%
- 全自动多点扫描,多种预设方案亦可自定义调节
- 快速材料表征,可自动执行校正因子计算
本研究通过SRM与Xfilm埃利四探针方阻仪的结合,实现了接触电阻率的高效提取,未来工作可探索更复杂SRM、微区测量精度及多探针间距策略,进一步拓展方法的应用场景。
原文参考:《Spreading resistance modeling for rapid extraction of contact resistivity with a four-point probe 》
*特别声明:本公众号所发布的原创及转载文章,仅用于学术分享和传递行业相关信息。未经授权,不得抄袭、篡改、引用、转载等侵犯本公众号相关权益的行为。内容仅供参考,如涉及版权问题,敬请联系,我们将在第一时间核实并处理。
-
如何用四探针测量半导体电阻率2026-05-19 66
-
四探针 vs 双探针的电池极片电阻率测试方法对比2026-05-12 329
-
四探针法测量电阻率:原理与不确定度分析2026-03-17 780
-
源表应用拓展:四探针法测电阻率2026-03-16 476
-
四探针法在薄膜电阻率测量中的优势2025-12-18 699
-
基于传输线模型(TLM)的特定接触电阻率测量标准化2025-10-23 2525
-
判定高电阻率硅的导电类型:基于氢氟酸HF处理结合扩展电阻SRP分析的高效无损方法2025-09-29 1563
-
四探针法精准表征电阻率与接触电阻 | 实现Mo/NbN低温超导薄膜电阻器2025-07-22 859
-
使用两探针及四探针方法测得的电阻率差异2022-09-22 6636
-
半导体的电阻率该如何测量2022-05-27 7992
-
使用四探针电阻率测试仪有哪些注意事项?2021-05-08 2173
-
半导体电阻率测试方案解析2021-01-13 3222
-
吉时利四探针法测试系统实现材料电阻率的测量2020-10-19 5216
-
电阻率与霍尔电压的测量2011-07-05 3308
全部0条评论

快来发表一下你的评论吧 !

