

采用传输线法(TLM)探究有机薄膜晶体管的接触电阻可靠性及变异性
描述
有机薄膜晶体管(TFTs)的高频性能受限于接触电阻(RC),尤其是在短通道L < 10 μm 和高迁移率μ > 1 cm²(V・s)条件下。即使采用相同材料和工艺,接触电阻仍存在显著的批次间差异。这种变异性对器件性能的可靠性和规模化生产提出了挑战。本研究通过Xfilm埃利TLM接触电阻测试仪的高精度传输线法分析,结合通道形貌的纳米级表征,系统揭示了接触电阻的测量误差来源及其变异性机制,旨在为优化器件设计和工艺控制提供理论依据。
材料与器件制备
/Xfilm
 (a) 底栅-底接触(倒置共面)器件架构的有机TFT横截面示意图;(b)研究中使用的分子化学结构
(a) 底栅-底接触(倒置共面)器件架构的有机TFT横截面示意图;(b)研究中使用的分子化学结构
- 半导体材料:DPh-DNTT、DNTT、PhC₂ - BQQDI、DN4T等,真空沉积于硅基底。
- 器件结构:底栅-底接触(倒置共面)架构,金源漏电极通过模板光刻制备,表面功能化PFBT或MeSTP单层以调节功函数。
- 工艺参数:基底温度(p型90°C,n型140°C)、沉积速率(0.03–0.04 nm/s)、真空压力(10⁻⁷–10⁻⁵ mbar)。

接触电阻的显著变化性
/Xfilm
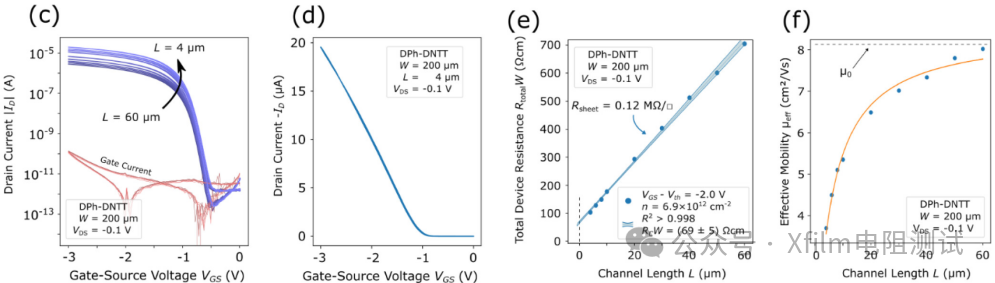 (c) DPh-DNTT TFT的典型转移特性曲线;(d) 通道长度4 μm的DPh-DNTT TFT转移特性曲线;(e) TLM分析:总器件电阻与通道长度的关系;(f) 有效载流子迁移率与通道长度的关系
(c) DPh-DNTT TFT的典型转移特性曲线;(d) 通道长度4 μm的DPh-DNTT TFT转移特性曲线;(e) TLM分析:总器件电阻与通道长度的关系;(f) 有效载流子迁移率与通道长度的关系

(a)模板光刻制备的金源漏电极TFT的SEM图像;(b)超过1100个TFT的实际通道长度(SEM测量)与标称通道长度的关系;(c) 使用实际通道长度与标称通道长度进行TLM分析提取的DPh-DNTT接触电阻对比;(d) 数据重绘以突出 (RCW)actual与 (RCW)nom 的相对偏差通过电学表征,研究团队发现:
- 当使用标称通道长度(Lnom)进行TLM分析时,接触电阻被系统性地高估。
- SEM图像显示,金源漏电极的实际通道长度 (Lactual = 2.53μm)比标称值(2μm)长0.53 μm。统计1100多个TFT的通道长度偏差,中位值(ΔL = +0.6μm),导致接触电阻被高估约10%。
这一结果表明,通道长度的工艺偏差是TLM分析中不可忽视的系统误差来源,尤其在短通道器件中影响更为显著。
TLM的可靠性剖析
/Xfilm
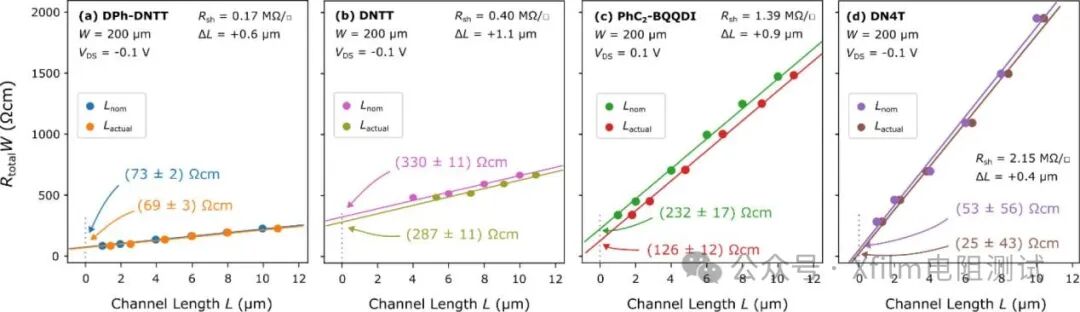
半导体薄层电阻对TLM提取接触电阻可靠性的影响半导体器件关键参数对比

TLM的核心是通过线性拟合RtotalW = RsheetL + RCW提取接触电阻。然而,其可靠性受以下因素制约:
- 半导体薄层电阻(Rsheet)的影响:当Rsheet较高时(如PhC₂− BQQDI的1.39 MΩ/),忽略ΔL会引入高达46%的系统误差。
- 统计误差与最小通道长度的选择:对于高Rsheet材料(如DN4T的2.15 MΩ/),其统计误差σ = 43Ωcm甚至超过接触电阻本身(25Ωcm)。此时需通过Λ = RCW / Rsheet确定最小通道长度(如DN4T需L < 0.12 μm),否则TLM结果不可靠。
TLM分析的优化需结合实际通道长度测量,并针对不同半导体材料调整通道长度范围。
接触电阻的变异性
/Xfilm
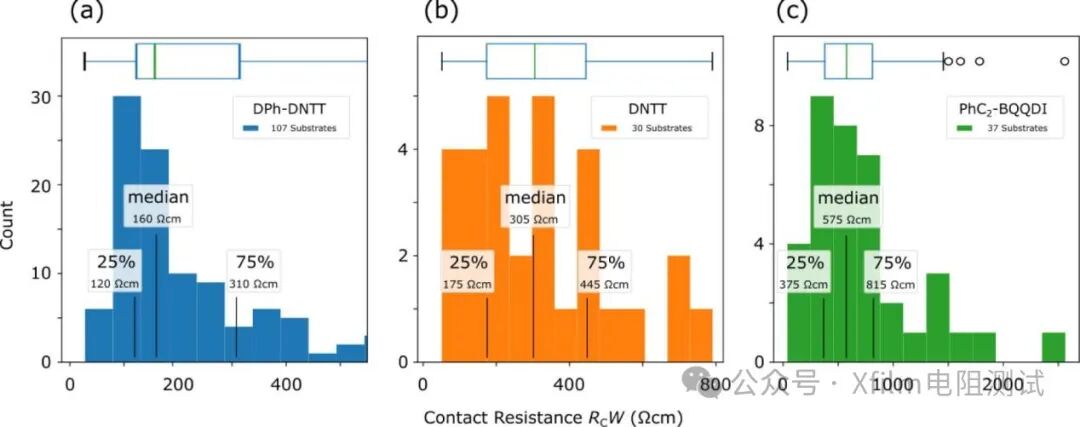 接触电阻分布直方图通过分析174个基底上的TFT数据,研究发现:
接触电阻分布直方图通过分析174个基底上的TFT数据,研究发现:
- 批次间差异显著:DPh-DNTT器件的接触电阻中位值为160 Ωcm,但跨度达28Ωcm至1 kΩcm;DNTT与PhC₂−BQQDI的变异性同样显著。
- 批次内一致性较高:同一批次基底的接触电阻变异仅为12%(DPh-DNTT)和16%(PhC₂− BQQDI),远低于批次间差异(>100%)。
这表明,接触电阻的变异性主要源于不可控的随机工艺波动,而非系统性参数偏差。
环境参数的相关性
/Xfilm
 DPh-DNTT TFT性能参数与环境条件的相关性DPh-DNTT TFT工艺参数与器件参数的相关系数矩阵
DPh-DNTT TFT性能参数与环境条件的相关性DPh-DNTT TFT工艺参数与器件参数的相关系数矩阵 为探究变异性来源,研究团队分析了实验室湿度(rH)、半导体沉积真空压力(pOSC)及电极沉积压力(pcontact)的影响:
为探究变异性来源,研究团队分析了实验室湿度(rH)、半导体沉积真空压力(pOSC)及电极沉积压力(pcontact)的影响:
- 弱相关性:所有环境参数与接触电阻的相关系数|c| < 0.25。仅观察到微弱趋势,如低pOSC(更高真空度)可能减少界面缺陷,略微降低RCW(c = -0.25)。
- 迁移率与阈值电压的独立性:本征迁移率μ0与阈值电压Vth同样未表现出强相关性,表明接触电阻的波动主要与接触-半导体界面特性相关。
环境参数对接触电阻的影响有限,变异性更可能源于微观界面形貌的随机差异(如分子排列、缺陷分布)。TLM优化方向:必须通过SEM精确测量实际通道长度,避免ΔL引入系统误差。针对高薄层电阻材料,需包含更短通道器件(L < Λ)以提高分析可靠性。接触电阻的随机性本质: 批次间差异主要由不可控的随机工艺波动主导,环境参数影响微弱。未来研究需聚焦界面形貌的微观表征(如AFM、XPS),以揭示分子级机制。
Xfilm埃利TLM电阻测试仪
/Xfilm
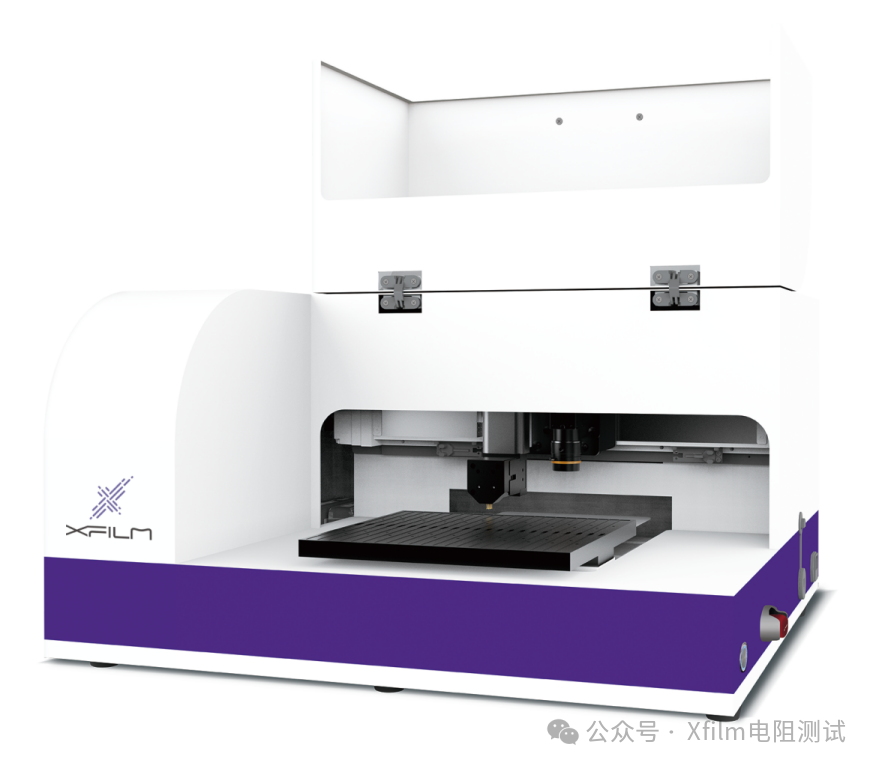
Xfilm埃利TLM接触电阻测试仪用于测量材料表面接触电阻或电阻率的专用设备,广泛应用于电子元器件、导电材料、半导体、金属镀层、光伏电池等领域。■ 静态测试重复性≤1%,动态测试重复性≤3%■ 线电阻测量精度可达5%或0.1Ω/cm■ 接触电阻率测试与线电阻测试随意切换■ 定制多种探测头进行测量和分析本研究通过Xfilm埃利TLM接触电阻测试仪的系统性数据采集与误差分析,明确了有机TFT接触电阻的核心挑战,为高频、高可靠性器件的开发提供了关键方法论支持。
原文出处:《Reliability of the Transmission Line Method and Reproducibility of the Measured Contact Resistance of Organic Thin-Film Transistors》
*特别声明:本公众号所发布的原创及转载文章,仅用于学术分享和传递行业相关信息。未经授权,不得抄袭、篡改、引用、转载等侵犯本公众号相关权益的行为。内容仅供参考,如涉及版权问题,敬请联系,我们将在第一时间核实并处理。
-
台阶仪在薄膜晶体管的应用 | 精准表征有源层厚度均匀性2026-04-03 198
-
精确表征有机异质界面:解析传输长度法TLM中的几何偏差与接触电阻物理关联2026-03-12 215
-
锂电池嵌入电极颗粒的传输线法TLM 模拟研究2025-11-13 502
-
基于传输线模型(TLM)的特定接触电阻率测量标准化2025-10-23 2530
-
基于传输线法(TLM)的多晶 In₂O₃薄膜晶体管电阻分析及本征迁移率精准测量2025-09-29 1585
-
液态金属接触电阻精确测量:传输线法(TLM)的新探索2025-07-22 1878
-
掺杂分布对太阳能电池薄膜方阻和接触电阻的影响2024-08-30 2053
-
光伏太阳能电池性能评估的利器:美能TLM接触电阻测试仪2024-05-22 4817
-
TFTLCD薄膜晶体管液晶显示器简介2022-03-02 6239
-
薄膜晶体管(TFT)阵列制造技术2021-04-15 1665
-
如何提高微波功率晶体管可靠性?2021-04-06 2510
-
薄膜晶体管液晶显示器技术2008-10-29 2775
全部0条评论

快来发表一下你的评论吧 !

