

高频混压板层压工艺
描述
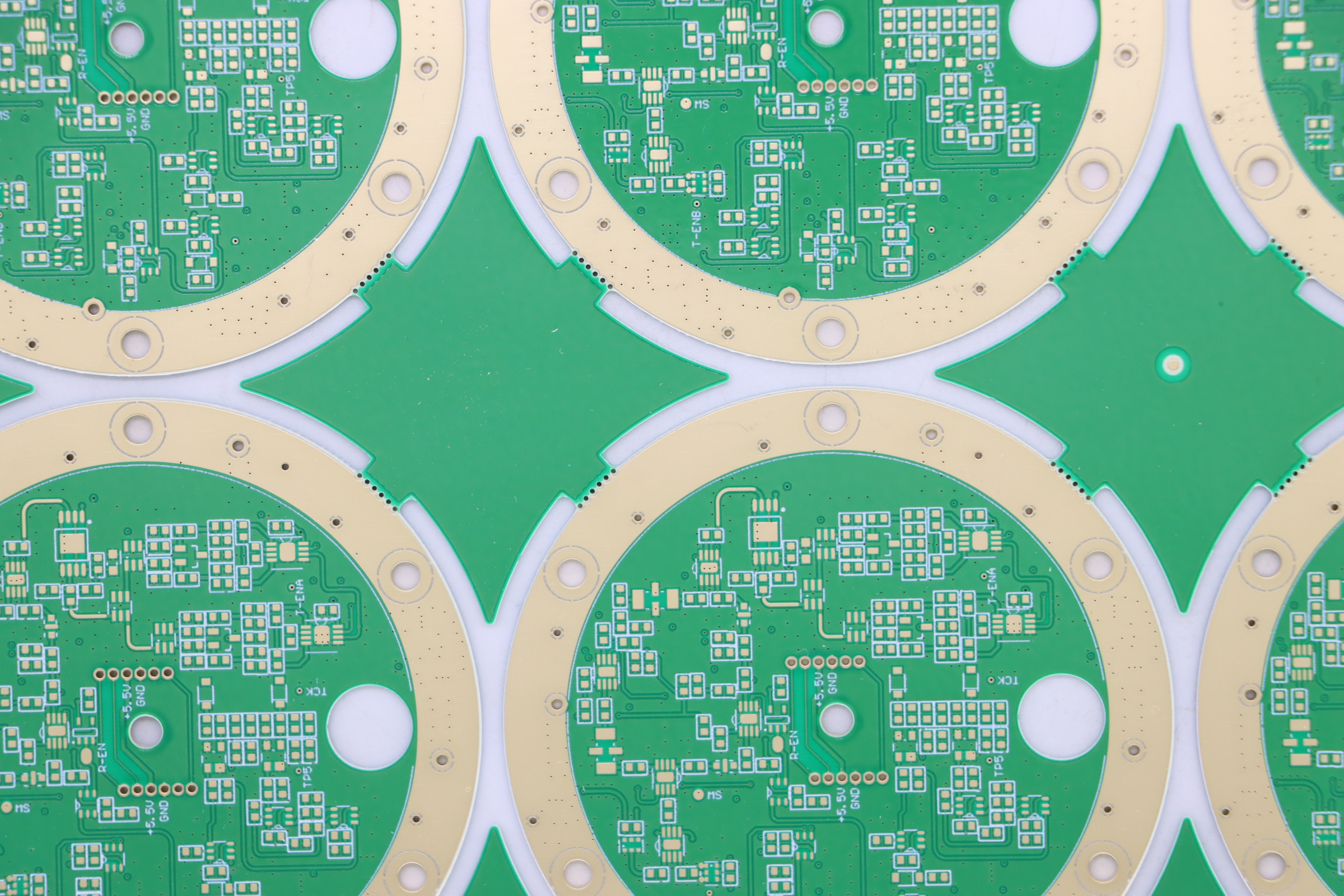
高频混压板的层压工艺是确保不同材质基材(如陶瓷、FR-4、PTFE等)在多层结构中稳定结合的关键技术,其核心在于解决热膨胀系数(CTE)差异、层间对准精度及材料兼容性等问题。以下是工艺要点:
一、工艺流程
基材预处理
陶瓷基板需经激光打孔、表面金属化(金/银/铜层)及活化处理,确保粘接强度;FR-4基板则通过棕化工艺形成微结构,增强树脂浸润性。
预压合阶段采用低温(80℃)和低压(0.5MPa)释放应力,放置24小时稳定伸缩量。
层压参数控制
采用阶梯式压合曲线:80–120℃树脂熔融(20分钟),150–180℃高压段(34.3MPa,70分钟),205℃峰值阶段降压至24.5MPa避免过度压缩。
真空层压(10⁻³ Torr)可减少气泡尺寸至<5μm,剥离强度提升57%。
层间对准技术
通过X射线+CCD视觉双重定位,植入0.1mm金属靶标校准,误差<5μm。
对称叠层设计(如“FR4-高频芯板-FR4”)可降低翘曲度至0.5%。
二、关键技术优化
CTE匹配:选用Z轴CTE相近材料(如Rogers RO4835的28ppm/℃与FR4的25ppm/℃),过渡层插入LCP(CTE=12ppm/℃)吸收80%热应力。
过孔设计:阶梯孔(PTFE层0.2mm→FR4层0.3mm)降低10GHz信号损耗至0.3dB。
表面处理:氧等离子处理使高频板表面能从38mN/m升至72mN/m,树脂附着力翻倍。
三、质量验证
层间剥离强度需达1.8N/mm以上,热循环测试后分层率<2%。
信号损耗控制在0.5dB以内,阻抗匹配精度±5%。
通过上述工艺,高频混压板可满足5G、毫米波雷达等场景对信号完整性和可靠性的严苛要求。
审核编辑 黄宇
- 相关推荐
- 热点推荐
- 高频
-
高频板ROGERS Ro4000系列层压板简介2023-04-03 914
-
DiClad® 870 和 880 层压板Rogers2023-03-16 1248
-
多层印制板层压工艺技术及品质控制(三).zip2022-12-30 484
-
提高多层板层压品质工艺技术总结,不看肯定后悔2021-04-25 1459
-
PCB制造中层压板的发展和重要性介绍2020-09-22 2572
-
PCB层压板的重要性2019-08-05 5438
-
什么是铜包覆层压板2019-08-03 4596
-
HDI PCB板层压板结构简介2019-08-01 10252
-
提高多层板层压品质工艺技术总结2018-11-22 1777
-
基材及层压板可产生的质量问题及解决办法2018-09-04 1580
-
多层板层压技术2013-08-26 2212
-
提高多层板层压品质工艺技术技巧2009-11-18 1342
全部0条评论

快来发表一下你的评论吧 !

