

基于传输线模型(TLM)的特定接触电阻率测量标准化
描述
金属-半导体欧姆接触的性能由特定接触电阻率(ρₑ)表征,其准确测量对器件性能评估至关重要。传输线模型(TLM)方法,广泛应用于从纳米级集成电路到毫米级光伏器件的特定接触电阻率测量,研究发现,不同尺寸的TLM结构测得值存在显著差异,表明测试结构的几何尺寸对提取结果有影响。
Xfilm 埃利的 TLM 接触电阻测试仪,凭借高精度与智能化特性,为特定接触电阻率(ρₑ)和薄层电阻(Rsh)的测量提供可靠支持。本文通过系统分析TLM宽度、焊盘长度及测试结构类型(线性与圆形)对提取参数的影响,提出标准化测量建议,以提高ρₑ的测量准确性。

TLM方法基础
/Xfilm
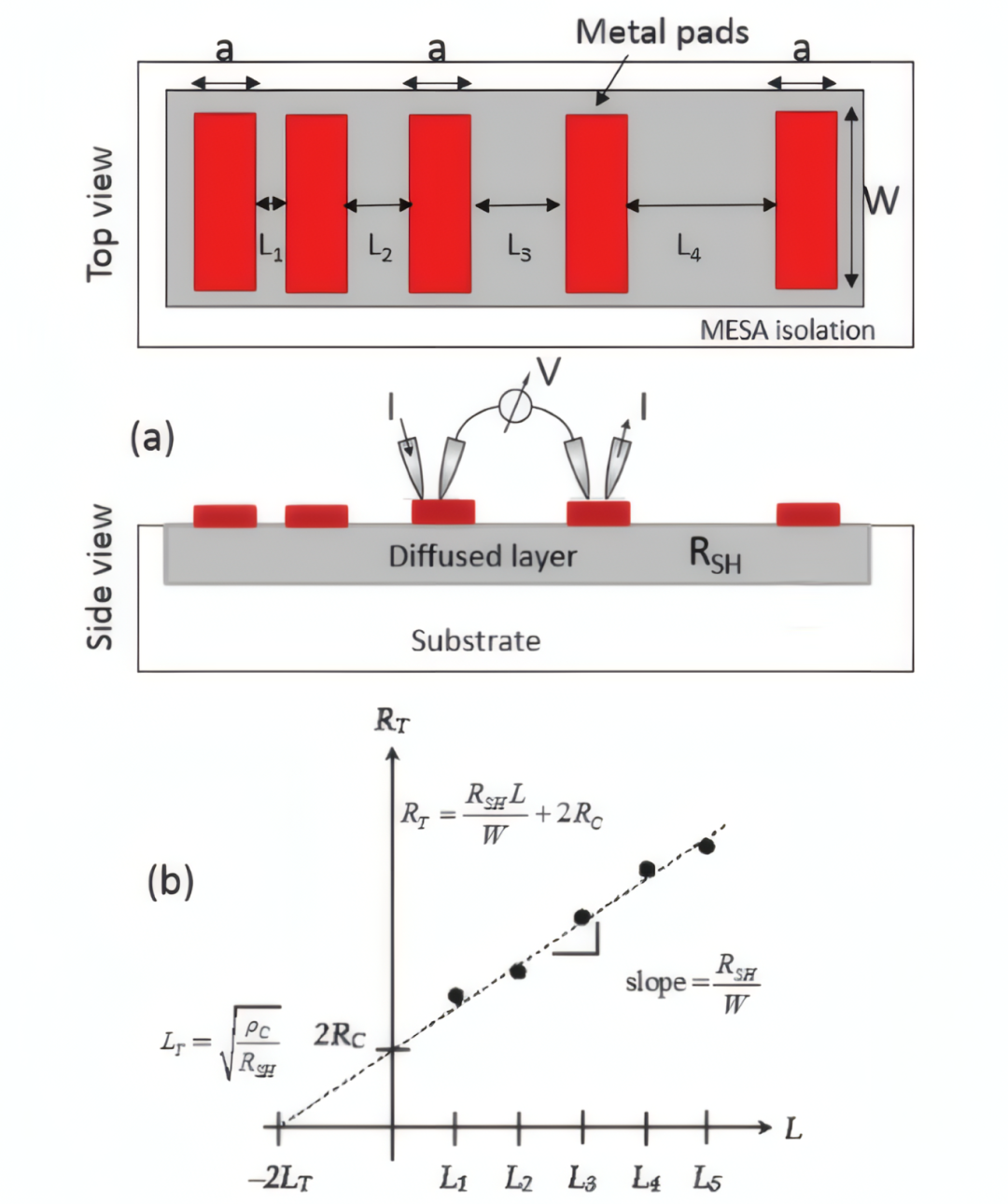
(a) 典型 TLM 结构的顶视图和横截面图;(b) 薄层电阻和传输长度的提取
传输线模型(TLM) 方法最初由Shockley提出,典型 TLM 结构中金属触点的宽度为“W”,长度为“a”,间距各不相同。对每个相邻触点进行IV 测量。接触垫两端的电压降是使用分布式电阻网络或集总模型得出的,该模型假设W 较大。将传输长度Lₜ定义为电压降至触点边缘值的1/e 的距离。

TLM测量中的误差分析
/Xfilm
系统误差在TLM测量中占主导地位。通过误差传播分析发现,最优接触宽度由下式决定:

该公式表明,最优宽度与特定接触电阻率ρₑ和薄层电阻(Rsh)的平方根成正比。实验系统研究了Al和NiSi/Al在不同掺杂浓度硅衬底上的传输长度随宽度变化规律。结果表明,传输长度Lₜ随宽度W增加而增大,在较低Rsh和较高ρₑ情况下更为显著。当W足够大时,Lₜ趋于饱和,此时电流流动近似层流,满足传统TLM模型的基本假设。

边缘场与焊盘长度的影响
/Xfilm
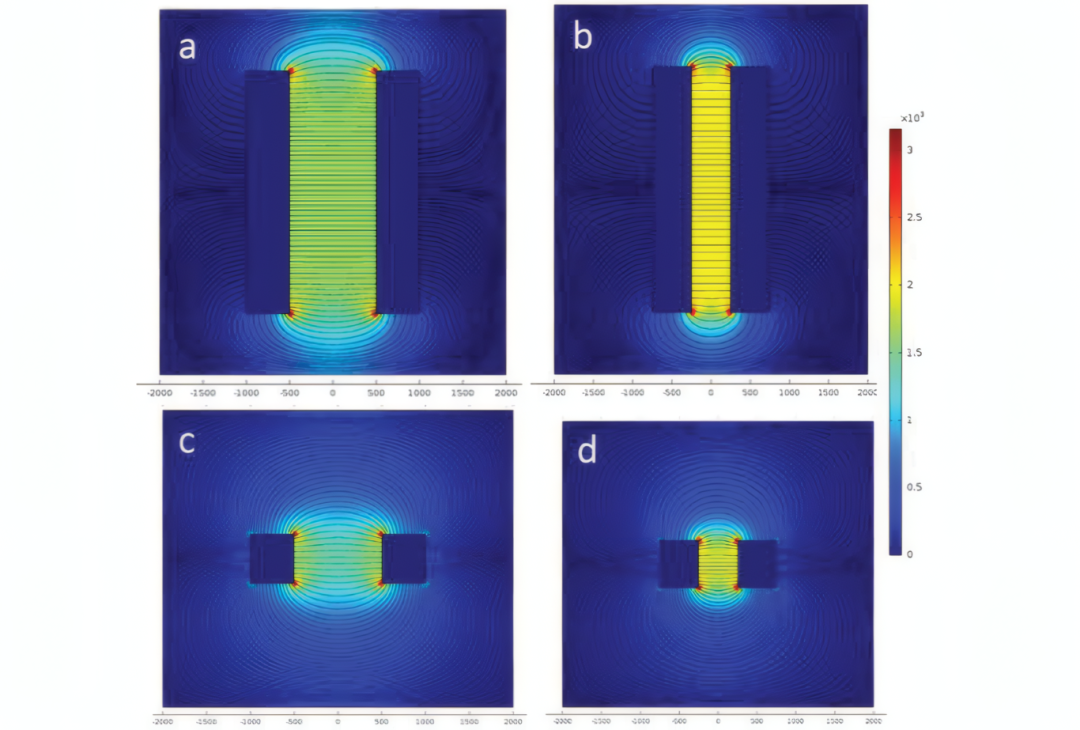
对于硅基上的铝接触点,在四种不同尺寸下的电场TLM模拟
当TLM宽度减小时,边缘场效应变得显著。通过COMSOL Multiphysics进行的二维电场模拟清晰显示,宽度为3000μm时电流呈均匀分布,而宽度为600μm时边缘场效应明显,传统一维模型不再适用。
此外,精确场解模型研究表明,焊盘长度a对传输长度Lₜ提取影响显著,当a从20μm增加到100μm时,提取的传输长度相应增加。模型比较表明,传统TLM方法仅在有限范围内(0.63h₂至0.63a)与精确场解结果一致。建议将a设计为:a>2.5×Lₜ

圆形TLM结构
/Xfilm
圆形传输线模型cTLM结构因无需mesa 隔离而适用于太阳能电池等器件。其电阻表达式基于贝塞尔函数,适用于径向电流分布。实验系统比较了圆形和线性的TLM结构的测量结果,结果表明:
圆形传输线模型cTLM与线性TLM提取的特定接触电阻率ρₑ值高度一致;
但圆形传输线模型cTLM提取的薄层电阻Rsh值与四探针法结果更为接近,且不受几何尺寸影响,可靠性更高。
综上,本实验通过设计不同尺寸的线性和圆形TLM结构,并对Al/NiSi-Si接触系统进行测试,发现:
线性与圆形TLM提取的特定接触电阻率ρₑ数值非常接近;
线性TLM提取的Rsh值受结构尺寸影响显著,而圆形cTLM测量结果稳定;
建议在报告ρₑ与Rsh时明确标注所用TLM结构的几何尺寸。

Xfilm埃利TLM电阻测试仪
/Xfilm
Xfilm埃利TLM接触电阻测试仪是可用于测量金属-半导体材料表面特定接触电阻率和薄层电阻的设备,广泛应用于电子元器件、导电材料、半导体、金属镀层、光伏电池等领域。

静态测试重复性≤1%,动态测试重复性≤3%
线电阻测量精度可达5%或0.1Ω/cm
接触电阻率测试与线电阻测试随意切换
定制多种探测头进行测量和分析
通过使用Xfilm埃利TLM接触电阻测试仪进行定量测量的实验手段,可精确表征和验证理论预测特定接触电阻率。
#传输线方法TLM #特定接触电阻率测量 #TLM接触电阻测试仪 #电阻测量
原文参考:《Standardization of Specific Contact Resistivity Measurements using Transmission Line Model (TLM)》
-
锂电池嵌入电极颗粒的传输线法TLM 模拟研究2025-11-13 494
-
基于传输线法(TLM)的多晶 In₂O₃薄膜晶体管电阻分析及本征迁移率精准测量2025-09-29 1568
-
液态金属接触电阻精确测量:传输线法(TLM)的新探索2025-07-22 1878
-
TOPCon电池铝触点工艺:接触电阻率优化实现23.7%效率2025-06-18 1828
-
光伏太阳能电池性能评估的利器:美能TLM接触电阻测试仪2024-05-22 4809
-
太阳能电池接触电阻测试中的影响因素2024-01-14 2358
-
美能TLM接触电阻测试仪,看它如何作用于电池生产!2023-11-18 2391
-
什么是接触电阻?2021-01-19 10022
-
电阻率、体积电阻率、表面电阻率的区别与测定方法2020-09-14 4816
全部0条评论

快来发表一下你的评论吧 !

