

真空共晶炉/真空焊接炉——堆叠封装
描述
大家好久不见!今天我们来聊聊堆叠封装。随着信息数据大爆发时代的来临,市场对于存储器的需求也水涨船高,同时对于使用多芯片的堆叠技术来实现同尺寸器件中的高存储密度的需求也日益增长。那么,什么是堆叠封装呢?在芯片成品制造的环节中,堆叠封装(Stacked Packaging)是一种将多个芯片垂直堆叠在一起,通过微型互连方式(如TSV硅通孔、RDL重布线层、微凸点等)实现高密度集成的封装技术。与传统的二维封装相比,堆叠封装具有更小的占板面积、更短的信号路径和更高的带宽密度,因此在高性能计算、移动设备、存储和AI领域越来越受到青睐。
 图1.半导体封装方法的分类
图1.半导体封装方法的分类接下来我简单介绍一下三种封装方法:
1.封装堆叠
封装堆叠通过将多个已完成单个封装的集成电路在垂直方向上堆叠来实现,经封装级互连形成电气连接后,成为一个功能完整、高密度的系统级模块。封装堆叠可以通过锡球栅阵列堆叠、引脚堆叠、硅中介层或硅桥堆叠等方式实现。
优势:封装堆叠有极高的空间利用率,通过在Z轴上充分利用空间,能显著减小主板占用的面积;其次还能将不同工艺、不同功能、不用供应商的专用组件集成在一起;每一个封装体在堆叠前都会进行全面的测试和老化筛选,确保只有合格的组件才能被堆叠,从而降低了复杂度和成本,提高了测试效率和良品率,如果某个封装体测试不合格,也能轻松地完成替换;因为减少了主板上的走线密度和层数,主板的设计也得以简化。
难点:堆叠结构在受到弯曲、冲击或温度循环时,应力会集中在焊接点,容易导致开裂失效。需要使用底部填充胶来增强机械强度;功耗集中在狭小的立体空间内,热量难以散发,底部的封装会被上方的封装遮挡,散热路径受阻,可能导致器件过热,需要精心的热设计或使用导热界面材料;对于有严格厚度和重量限制的设备,堆叠的层数和每个封装的厚度都需要精确控制;需要协同设计多个封装和主板,考虑信号完整性、电源完整性和热分布的相互影响。
2.芯片堆叠
不同于在封装外部堆叠成品组件的封装堆叠,芯片堆叠是在封装内部进行,堆叠的是裸晶圆,可以说芯片堆叠是更底层、更紧密、性能潜力更高的集成方式。通过在Z轴方向上将两个或以上的经过减薄的芯片进行对准、贴装、互连,极大地提升了在单位面积上的晶体管数量和功能多样性。芯片堆叠的实现方式主要取决于芯片如何放置及连接的,可分为面对面、背对背、面对面和背对背混合。
优势:更短的互连能大幅减少信号延迟和功耗,数千个I/O通道可以实现极高的宽带,带来性能的飞跃;外观尺寸极小化,满足可穿戴设备、移动设备对于紧凑的需求;在最小的体积内集成最多的功能,实现功能密度最大化。
难点:功率密度急剧上升,而散热路径受限,堆叠在顶部的芯片热量必须穿过下方的芯片才能散出,导致“热耦合”效应,设计不当会引发过热失效;设计时需要协同进行系统架构、芯片设计、封装设计、热设计和信号/电源完整性分析,是一个极其复杂的多物理场问题;工艺步骤繁多,每一步都可能引入缺陷,总体良率是各步骤良率的乘积,“一颗坏,全盘废”,成本风险高;堆叠后内部的芯片难以直接测试,因此必须依赖内建自测试和已知合格芯片策略,这增加了芯片设计和测试的成本;不同材料的热膨胀系数不匹配,在温度变化时会产生应力,可能导致芯片翘曲、开裂或互连失效。
3.硅通孔
硅通孔是一种通过在硅片上钻孔来容纳电极的芯片堆叠技术。相比采用传统引线方法实现芯片与芯片(Chip-to-Chip)互连或芯片与基板(Chip-to-Substrate)互连,硅通孔通过在芯片上钻孔并填充金属等导电材料来实现芯片垂直互连,让电信号可以垂直穿过硅芯片本身,而不是像传统那样只能通过芯片四周的引线来水平连接。尽管使用硅通孔进行堆叠时使用了芯片级工艺,但却采用晶圆级工艺在芯片正面和背面形成硅通孔和焊接凸点(Solder Bump)。由此,硅通孔被归类为晶圆级封装技术。
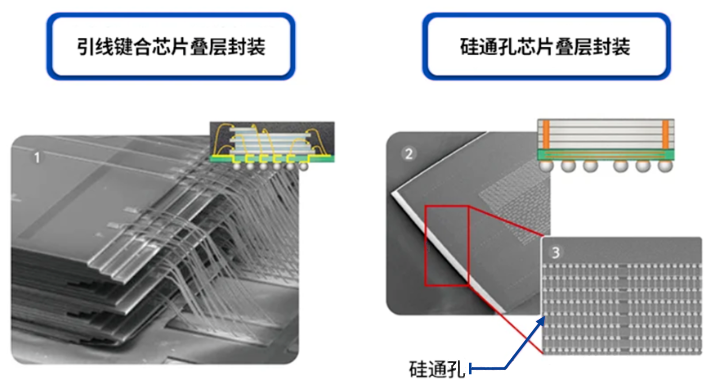 图2.硅通孔示意图
图2.硅通孔示意图硅通孔的简化制造工艺流程包括:深刻刻蚀——绝缘层沉积——阻挡层和种子层沉积——铜电镀填充——化学机械抛光——晶圆减薄——背面再布线层和凸点制作。
优势:缩短互联长度,降低延迟和功耗,提升带宽,带来性能的提升;实现真正的3D集成,大幅减小封装尺寸;使不同工艺、不同材料的芯片能够通过硅通孔和中介层实现高性能集成;更短的路径意味着更少的串扰和电感效应,改善信号完整性。
难点:工艺复杂,设备昂贵,是3D集成中成本最高的环节之一;深孔刻蚀、无空洞电镀、超薄晶圆处理等都极具挑战;铜和硅的热膨胀系数差异很大,在温度变化时会产生应力,可能导致硅片翘曲或晶体管性能漂移;电迁移、热机械疲劳等可靠性问题;对部分完成的硅通孔晶圆进行测试非常复杂。
关于堆叠封装的介绍就暂告一段落,本文只对堆叠封装进行了一点简单的介绍,如果大家感兴趣,后续我们还可以围绕这个话题深入讨论一些其他的内容,比如芯片堆叠实现方式的三种分类的优缺点、详细的硅通孔制造工艺流程、硅通孔的三种主要集成方案、堆叠封装的核心应用领域等。除此之外,我司的设备同样能满足堆叠焊接的工艺要求,配合我司持有的“正负压焊接工艺”,相信可以令您满意。如果您感兴趣,可以联系我们一同讨论。
 图3.我司设备示意图
图3.我司设备示意图
成都共益缘真空设备有限公司
-
深度解析:真空共晶焊炉在光电器件封装中的重要性2023-07-18 2970
-
加热板:真空共晶炉的热力中心与材料塑造者2023-05-23 2912
-
真空共晶炉焊接的新视野:探索控制焊接气氛的优势2023-06-09 4456
-
如何解决真空回流焊炉、氮气真空炉焊接过程中的锡珠问题2024-07-06 5865
-
真空焊接炉的焊料选择之铅锡共晶焊料2024-07-31 5333
-
真空焊接炉的焊料选择之铟银共晶焊料2024-08-30 6383
-
真空共晶焊炉升降温斜率:科技制造的新篇章2024-10-31 1689
-
还原性气氛助力真空共晶炉:打造高品质焊接的秘诀2024-11-11 3325
-
真空共晶炉怎么选?看这一篇就够了!2024-12-04 2268
-
真空回流焊炉/真空焊接炉——正压纯氢还原+燃烧装置2024-12-05 2382
-
选购真空共晶炉也有门道,快来get新技能!2025-01-09 1325
-
真空共晶炉加热板热膨胀系数探究2025-02-25 1409
-
真空共晶炉加热板怎么选?全面解析助您决策2025-03-06 1419
-
深度解读:真空共晶炉加热板的材质与性能关系2025-03-25 1689
-
真空共晶炉/真空焊接炉——镀层对共晶的影响2025-11-24 805
全部0条评论

快来发表一下你的评论吧 !

