

玻璃芯片基板成功实现激光植球技术新突破
描述
在5G通信、人工智能、自动驾驶等技术的推动下,半导体器件正朝着更高集成度、更小尺寸的方向发展。传统的有机基板和陶瓷基板逐渐面临物理极限,而玻璃基板凭借其优异的绝缘性、低热膨胀系数、高平整度及高频性能,成为下一代先进封装的核心材料。然而,玻璃基板的脆性特质和高精度封装需求,对焊接技术提出了全新挑战。在此背景下,自动激光植球技术凭借其非接触、高精度、低温可控等特性,成为玻璃基板封装的关键突破口。
玻璃基板的优势与挑战
为何选择玻璃基板?
高频性能卓越:玻璃的介电常数低,信号传输损耗小,适用于高频芯片封装。
热稳定性强:热膨胀系数与硅芯片接近,可减少热应力导致的失效风险。
工艺兼容性高:表面平整度优于有机基板,适合高密度布线及微型焊盘设计。
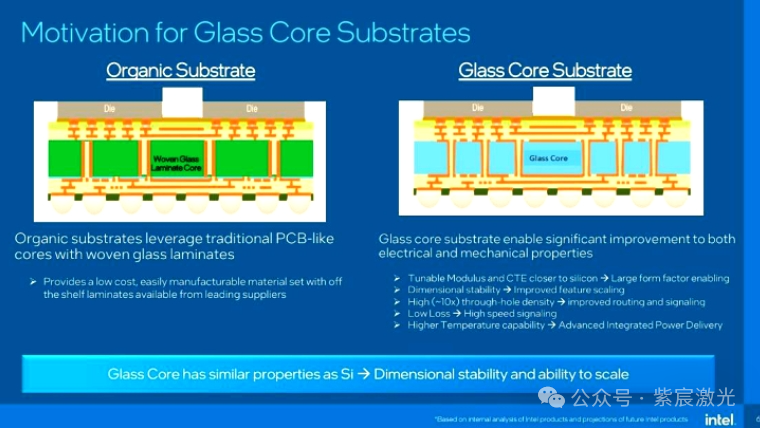
封装痛点
玻璃基板的脆性使其在传统焊接中易受机械应力损伤;同时,微型焊盘(如50μm以下)对焊球精度和热输入控制要求极高。传统的回流焊、热压焊等工艺易导致基板变形或焊球桥接,良率难以保障。
自动激光植球:技术原理与玻璃基板适配性
激光植球技术通过高能激光瞬间熔化锡球,并在氮气保护下将其精准喷射至焊盘,全程非接触、无机械应力。这一特性完美契合玻璃基板的封装需求:
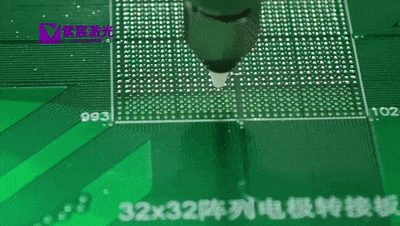
低温精准控温:激光能量可精确调节,避免玻璃因热冲击破裂。
微米级精度:支持60μm~2000μm锡球直径,配合CCD视觉定位,满足玻璃基板高密度焊盘需求。
无应力焊接:非接触式工艺避免机械压力,保护脆性基板结构完整性。
工艺突破:倒装芯片与2.5D/3D封装
在玻璃基板的倒装芯片(Flip Chip)封装中,激光植球可预先在芯片焊盘上植球,再通过精准对位实现芯片与基板的直接互连。此外,其支持非平面焊接的特性,为2.5D/3D堆叠封装提供了新可能,助力玻璃基板在HBM(高带宽内存)等领域的应用。
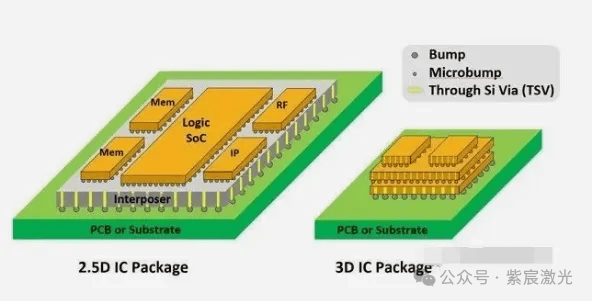
紫宸激光的解决方案:技术亮点与创新
作为激光焊接领域的领军企业,紫宸激光针对玻璃基板封装推出了一系列优化方案:
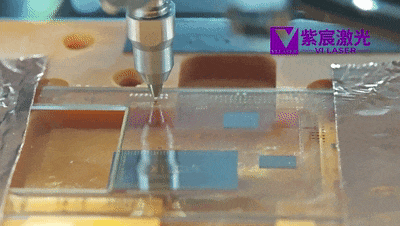
01
定制化激光参数:针对玻璃基板的热敏感特性,开发中低温焊接模式,控制热影响区(HAZ)在1mm以内。
02多材料兼容性:支持Au、Ag、Sn、Cu等多种焊盘镀层,适配玻璃基板常见的金属化工艺。03智能工艺系统:集成温度反馈与实时监测,确保焊点润湿性优良,X-Ray检测显示零空洞缺陷。04柔性生产设计:双工位交替作业、阵列上料等功能,提升生产效率至5球/秒,支持小批量多品种需求。
激光植球开启玻璃基板新时代
随着台积电、英特尔等巨头加速布局玻璃基板技术,未来3D IC、Chiplet等架构将更依赖高精度焊接工艺。激光植球技术凭借其工艺精简、成本可控、适应性强的优势,有望成为玻璃基板封装的核心标配。紫宸激光等企业通过持续迭代光学系统与智能化控制,将进一步推动半导体封装向“更小、更快、更可靠”的方向演进。
结语
Closing Remarks
在半导体行业“超越摩尔定律”的探索中,玻璃基板与激光植球技术的结合,不仅是材料与工艺的创新,更是整个产业链协同突破的缩影。未来,随着5G、AI、汽车电子等需求的爆发,这一技术组合或将成为中国半导体高端制造的重要竞争力。
-
紫宸激光植球技术:为BGA/LGA封装注入精“芯”动力2025-11-19 2316
-
解锁WiFi芯片植焊西安品茶技术工作室电路板传输新潜能2025-10-29 760
-
TGV产业发展:玻璃通孔技术如何突破力学瓶颈?2025-10-21 1484
-
震惊!半导体玻璃芯片基板实现自动激光植球突破2025-03-21 2008
-
AMD获得玻璃核心基板技术专利2024-12-06 1016
-
揭秘BGA芯片植球技巧,打造完美电子连接!2024-11-29 6687
-
AMD加入玻璃基板战局2024-11-28 1364
-
BGA倒装芯片焊接中的激光植锡球技术应用2024-08-14 2792
-
玻璃基板时代,TGV技术引领基板封装2024-05-30 6197
-
芯片植球的效果2023-11-04 3313
-
SMT之植球技术2011-07-05 5283
-
玻璃基板/Ambix,玻璃基板/Ambix是什么意思2010-03-27 2509
全部0条评论

快来发表一下你的评论吧 !

