

 半导体芯片制造核心材料“光刻胶(Photoresist)”的详解
半导体芯片制造核心材料“光刻胶(Photoresist)”的详解
描述
【博主简介】本人“爱在七夕时”,系一名半导体行业质量管理从业者,旨在业余时间不定期的分享半导体行业中的:产品质量、失效分析、可靠性分析和产品基础应用等相关知识。常言:真知不问出处,所分享的内容如有雷同或是不当之处,还请大家海涵。当前在各网络平台上均以此昵称为ID跟大家一起交流学习!

芯片是业内外认识避不开的话题。而光刻胶(PR)是芯片八大核心材料之一。据统计,光刻胶(PR)在半导体晶圆制造材料价值占比5%,光刻胶(PR)辅助材料占比7%,二者合计占比12%,光刻胶(PR)及辅助材料是继硅片、电子特气和光掩模之后的第四大半导体材料。
而严格来说,在芯片制造这场微观世界的雕刻盛宴中,光刻胶(PR)如同一位技艺精湛的工匠手中的隐形画笔,在硅片这片“晶圆画布”上勾勒出亿万个晶体管组成的复杂电路。然而,这支“画笔”却成了中国芯片产业最难突破的瓶颈之一:
全球高端光刻胶(PR)市场93%的份额被日本企业垄断,我国KrF、ArF、EUV等高端光刻胶(PR)自给率不足5%。更严峻的是,光刻胶(PR)保质期仅6-12个月,无法囤货,中芯国际、长江存储等头部晶圆厂随时面临断供停产风险。

一、光刻胶(PR)的起源
光刻开始于一种称作光刻胶(PR)的感光性液体的应用。图形能被映射到光刻胶(PR)上,然后用一个developer就能做出需要的模板图案。光刻胶(PR)溶液通常被旋转式滴入wafer。wafer被装到一个每分钟能转几千转的转盘上。几滴光刻胶(PR)溶液就被滴到旋转中的wafer的中心,离心力把溶液甩到表面的所有地方。光刻胶(PR)溶液黏着在wafer上形成一层均匀的薄膜。多余的溶液从旋转中的wafer上被甩掉。薄膜在几秒钟之内就缩到它最终的厚度,溶剂很快就蒸发掉了,wafer上就留下了一薄层光刻胶(PR)。最后通过烘焙去掉最后剩下的溶剂并使光刻胶(PR)变硬以更后续处理。镀过膜的wafer对特定波成的光线很敏感,特别是紫外(UV)线。相对来说他们仍旧对其他波长的,包括红,橙和黄光不太敏感。所以大多数光刻车间有特殊的黄光系统。

二、光刻胶(PR)的发展历史
1826年,法国人涅普斯(J. N. Niepce)最先发现了具有感光性的天然沥青,使用低黏度优质沥青涂覆玻璃板,预干后,置于相机暗盒内,开启曝光窗,经光学镜头长时间曝光后,沥青涂层感光逐渐交联固化,形成潜像,再经溶剂松节油清洗定影,获得最早的沥青成像图案。
1832年,德国人舒柯(G. Suckow)发现重铬酸盐在明胶等有机物中具有感光性。
1839年,英国人庞顿(S. M. Ponton)首先将重铬酸盐用于照相研究。
1850年,英国人塔尔博特(F. Talbot)将重铬酸盐与明胶混合后涂在钢板上制作照相凹版获得了成功。
19世纪中叶,德国人格里斯(J. P. Griess)合成出芳香族重氮化合物,并发现重氮化合物不但遇热不稳定,而且对光照也不稳定。
1884年,德国人韦斯特(West)首先利用重氮化合物的感光性显示出影像。
1890年。德国人格林(Green)和格罗斯(Gross)等人将重氮化的混合物制成感光材料。取得了第一个重氮感光材料的专利。不久,德国的卡勒(Kalle)公司推出了重氮印相纸,从而使重氮感光材料商品化,并逐渐代替了铁印相技术。
1921年,美国人毕勃(M. C. Beeb)等人将碘仿与芳香胺混合在一起,用紫外光照射得到染料像,称它为自由基成像体系。
1925年,美国柯达(Eastman-Kodak)公司发现了聚乙烯醇和肉桂酸酯在紫外光下有很强的交联反应并且感光度很高,随后用于光学玻璃的光栅蚀刻,成为光刻胶的先驱。
1942年,英国Eisler发明印刷电路板 [39],重铬酸盐感光材料作为光敏抗蚀剂用于制造印刷线路板。重铬酸在紫外光作用下还原成三价铬离子,三价铬离子可和水溶性聚合物中的羰基、胺基、羟基等作用形成不溶的配位络合物。
1943年,美国杜邦公司提交了世界第一份有关光引发剂的发明专利,尽管这种二硫代氨基甲酸酯化合物感光活性较低,后来也未能转化为实际应用,但确实开启了一种全新的聚合物材料加工技术。
1948年,美国专利中出现第一个光固化油墨配方和实施技术的专利。
1949年德国Kalle公司首先开发成功紫外正性光刻胶。
1954年,由柯达公司的明斯克(L. M. Minsk)等人研究成功的光敏剂增感的聚乙烯醇肉桂酸酯成为第一个光固化性能的光刻胶 [39],牌号KPR。先用于印刷工业,后用于电子工业。
1958年,柯达公司发展出了叠氮-橡胶系的负性光刻胶 ,牌号为KMER和KTFR。
1960年,出现邻重氮萘醌-酚醛树脂紫外正性光刻胶 。
1968年美国IBM公司的Haller等人发明聚甲基丙烯酸甲酯电子束光刻胶。
1973年由Bell实验室和Bowden发明聚烯砜类电子束光刻胶。
1976年,美国麻省理工学院的H. Smith提出X射线曝光技术。
1989年,日本科学家Kinoshita提出极紫外光刻技术(EUVL)。
1990年后,开始出现248 nm化学增幅型光刻胶。
1992年,IBM使用甲基丙烯酸异丁酯的聚合物作为化学增幅的193 nm光刻胶材料。同年Kaimoto等也发现了非芳香性的抗蚀刻剂,而且在193 nm有较好的透光性 。
20世纪90年代中期,美国明尼苏达大学纳米结构实验室提出了一种叫做“纳米压印成像”(nanoimprint lithography)的新技术。
1996年,欧洲主要成立了4个极紫外光刻相关研究项目,约110个研究单位参与,其中比较重要的项目为MEDEA和MORE MOORE。
1997年,Intel公司成立了包括AMD、Motorola、Micron、Infineon和IBM的EUV LLC,并与由LBNL、LLNL和SNL组成的国家技术实验室(VNL)签订了极紫外光刻联合研发协议(CRADA)。
1998年,日本开始极紫外光刻研究工作,并于2002年6月成立极紫外光刻系统研究协会(EUVA) 。
1962年,中国北京化工厂接受中国科学院半导体研究所的委托,着手研究光刻胶,以吡啶为原料,采用热法工艺,制成聚乙烯醇肉桂酸酯胶。
1967年,中国第一个KPR型负性光刻胶投产。
1970年,103B型、106型两种负胶投产,环化橡胶系负胶BN-302、BN-303也相继开发成功。
2018年5月24日,国家科技重大专项(02专项)极紫外光刻胶项目顺利通过国家验收。
2018年5月30日,国家科技重大专项“极大规模集成电路制造装备与成套工艺”专项(02专项)项目“极紫外光刻胶材料与实验室检测技术研究”,经过项目组全体成员的努力攻关,完成了EUV光刻胶关键材料的设计、制备和合成工艺研究、配方组成和光刻胶制备、实验室光刻胶性能的初步评价装备的研发,达到了任务书中规定的材料和装备的考核指标。
2019年11月25日,8种“光刻胶及其关键原材料和配套试剂”入选工信部《重点新材料首批次应用示范指导目录(2019年版)》 。

三、光刻胶(PR)的介绍
光刻胶,英文全称:Photoresist,简称:PR,也称为光致抗蚀剂。光刻胶(PR)是一种对光敏感的混合液体,是微电子技术中微细图形加工的关键材料。它由光引发剂(光增感剂、光致产酸剂)、光刻胶(PR)树脂、溶材料剂、单体(活性稀释剂)和其他助剂组成。

四、光刻胶(PR)的成分组成
光刻胶是一种对光敏感的混合液体,主要由以下部分组成:
1、基体材料
通常为树脂,一种惰性的聚合物,是用于粘合光刻胶中的不同成分,构成光刻胶(PR)的基本骨架,决定其机械性能和化学稳定性。提高光刻胶的化学抗腐蚀性能和胶膜厚度等基本性能。
2、感光化合物(PAC)
控制光刻胶在曝光前后的溶解性变化。
3、正性光刻胶
PAC在曝光前抑制溶解,曝光后促进溶解。
4、负性光刻胶
PAC在曝光后引发交联反应,使曝光区域不溶解。
5、溶剂
调节光刻胶的黏滞性,溶解光刻胶的各种组成成分,确保其在涂覆时保持液体状态,并均匀成膜,也是后续光刻化学反应的介质。

五、光刻胶(PR)基础知识分享
以下就是本章节要跟大家分享的:半导体芯片材料“光刻胶(Photoresist)”基础知识培训的内容,如有遗漏或是不足之处,希望大家见谅,分享内容如下:
















http://weixin.qq.com/r/QhAjO9TE64mUrZBY90VQ (二维码自动识别)
因为本PPT章节太多,剩下部分如有朋友有需要,可私信我邀请您加入我“知识星球”免费下载PDF版本。注意:此资料只可供自己学习,不可传阅,平台有下载记录,切记!欢迎加入后一起交流学习。

六、光刻胶(PR)的主要技术参数
1、分辨率(resolution)
区别硅片表面相邻图形特征的能力。一般用关键尺寸(CD,Criical Dimension)来衡量分辨率。形成的关键尺寸越小,光刻胶(PR)的分辨率越好。
2、对比度(Contrast)
指光刻胶(PR)从曝光区到非曝光区过渡的陡度。对比度越好,形成图形的侧壁越陡峭,分辨率越好。
3、敏感度(Sensitivity)
光刻胶(PR)上产生一个良好的图形所需一定波长光的最小能量值(或最小曝光量)。单位:毫焦/平方厘米或mJ/cm2。光刻胶(PR)的敏感性对于波长更短的深紫外光(DUV)、极深紫外光(EUV)等尤为重要。
4、粘滞性/黏度(Viscosiy)
衡量光刻胶(PR)流动特性的参数。粘滞性随着光刻胶(PR)中的溶剂的减少而增加;高的粘滞性会产生厚的光刻胶(PR);越小的粘滞性,就有越均匀的光刻胶(PR)厚度。光刻胶(PR)的比重(SG,Specifc Gravitvy)是衡量光刻胶(PR)的密度的指标。它与光刻胶(PR)中的固体含量有关。较大的比重意味着光刻胶(PR)中含有更多的固体,粘滞性更高、流动性更差。粘度的单 位:泊(poise),光刻胶(PR)一般用厘泊(cps,厘泊为1%泊)来度量。百分泊即厘泊为绝对粘滞率;运动粘滞率定义为:运动粘滞率=绝对粘滞率/比重。 单位:百分斯托克斯(cs)=cps/SG。
5、粘附性(Adherence)
表征光刻胶(PR)粘着于衬底的强度。光刻胶(PR)的粘附性不足会导致硅片表面的图形变形。光刻胶(PR)的粘附性必须经受住后续工艺(刻蚀、离子注入等)。
6、抗蚀性(Anti-etching)
光刻胶(PR)必须保持它的粘附性,在后续的刻蚀工序中保护衬底表面。耐热稳定性、抗刻蚀能力和抗离子轰击能力。
7、表面张力(Suface Tension)
液体中将表面分子拉向液体主体内的分子间吸引力。光刻胶(PR)应该具有比较小的表面张力,使光刻胶(PR)具有良好的流动性和覆盖。
8、存储和传送(Storage and Transmision)
能量(光和热)可以激活光刻胶(PR)。应该存储在密闭、低温、不透光的盒中。同时必须规定光刻胶(PR)的闲置期限和存贮温度环境。一旦超过存储时间或较高的温度范围,负胶会发生交联,正胶会发生感光延迟。

七、光刻胶(PR)的分类
光刻胶(PR)并非单一产品,而是一个庞大的家族。
1、根据光刻胶按照如何响应紫外光的特性可以分为两类:负性光刻胶和正性光刻胶。

a. 负性光刻胶(Negative Photo Resist)
最早使用,一直到20世纪70年代。曝光区域发生交联,难溶于显影液。
原理:曝光区域PAC引发交联反应,形成不溶性网状结构,未曝光部分溶解。
特性:良好的粘附能力、良好的阻挡作用、感光速度快;显影时发生变形和膨胀。所以只能用于2um的分辨率。
应用场景:厚膜光刻、特殊封装工艺。

b. 正性光刻胶(Positive Photo Resist)
20世纪70年代,有负性转用正性。正性光刻胶的曝光区域更加容易溶解于显影液。
原理:曝光区域PAC发生光化学反应,从抑制剂变为促进剂,使曝光部分溶于显影液
特性:分台阶覆盖好、对比度好;粘附性差、抗刻蚀能力差、高成本。辨率高。
主流应用:先进芯片制造(如逻辑电路、存储器)、微机电系统(MEMS)。

正胶与负胶优缺点的对比:

正胶与负胶的区别:
负胶是最早使用,一直到20世纪70年代。特性为,具有良好的粘附能力和阻挡作用、感光速度快;显影时发生变形和膨胀,所以只能用于2μm的分辨率。
负胶显影中保留部分的胶会吸收显影液,造成光刻胶的变相“膨胀”,从而使图形扭曲,一般分辨率只能达到光刻胶厚度的2-3倍;而正胶在显影过程中则不会吸收显影液,从而获得较高的分辨率!
20世纪70年代,有负性转用正性。正胶具有很好的对比度,所以生成的图形具有良好的分辨率,其他特性如,台阶覆盖好、对比度好;粘附性差、抗刻蚀能力差、高成本。
现在最小尺寸小于3um一般都会用正胶!
目前一般都是用正胶,对于线宽要求不高的时候或者一些特殊的用途(比如PSS等)可以选择负胶。

2、根据光刻胶能形成图形的最小光刻尺寸来分:传统光刻胶和化学放大光刻胶。
a. 传统光刻胶
适用于I线(365nm)、H线(405nm)和G线(436nm),关键尺寸在0.35um及其以上。
b. 化学放大光刻胶(CAR,ChemicalAmplifedResist)
适用于深紫外线(DUV)波长的光刻胶。KrF(248nm)和ArF(193nm)。
其实,关于光刻胶(PR)的分类,根据应用行业、显示效果、化学结构、曝光波长......等等,可分的类别太多太多了,这里我就不一一赘述了。

八、光刻胶(PR)的工作原理
光刻胶的基本原理是利用紫外线或电子束等高能辐射照射光刻胶,使其发生化学或物理变化,形成图案。具体来说,光刻胶通常由两层组成,即敏化剂层和树脂层。敏化剂层包含一些化学物质,可以吸收光线并将其转化为化学能,从而导致光刻胶的化学反应发生变化。而树脂层则是一种聚合物材料,其化学性质可以受到敏化剂层的影响,从而发生聚合或交联反应,形成所需的图案。
在光刻过程中,首先将光刻胶涂覆在衬底表面,并进行软烤处理,使光刻胶形成一定的膜厚和表面特性。然后,将光掩模置于光刻胶表面,利用紫外线或电子束等高能辐射照射光刻胶,使得光刻胶在照射区域发生化学或物理变化。经过显影处理后,未被照射的区域的光刻胶被去除,而被照射的区域的光刻胶则被保留在衬底表面上,形成所需的图案。
不同类型的光刻胶,其化学体系和工作机制也大相径庭。
g线和i线光刻胶均使用线性酚醛树脂作为树脂主体,重氮萘醌(DQN体系)作为感光剂。
曝光后,重氮萘醌基团转变为烯酮,与水接触时,进一步转变为茚羟酸,从而在曝光区被稀碱水显影时除去。
而KrF(248nm)和ArF(193nm)等深紫外光刻胶则采取了完全不同的技术体系——化学放大光阻体系(CAR,Chemically Amplified Resist)。
在CAR技术体系中,光刻胶中的光致酸剂(PAG,Photo Acid Generator)经过曝光后并不直接改变光刻胶在显影液中的溶解度,而是产生酸。
在后续的热烘焙流程(PEB,Post-Exposure Bake)的高温环境下,曝光产生的酸作为催化剂改变光刻胶在显影液中的溶解度。
CAR光刻胶的光敏感性很强,所需要从深紫外辐射中吸收的能量很少,大大提高了光刻的效率,其曝光速度是DQN光刻胶的10倍左右。

九、光刻胶(PR)的应用和未来发展方向
1、新型微电子器件的制造
光刻胶在微电子器件的制造中已经得到广泛应用。未来,随着微纳技术的不断发展和新型器件的出现,光刻胶的应用将更加多样化和精细化,如制造高速器件、量子器件等。
2、3D微纳加工技术的发展
随着3D打印技术的发展,3D微纳加工技术也逐渐成为一个新的研究热点。光刻胶在3D微纳加工中具有重要的应用前景,可以制造出更加复杂的三维微纳结构。
3、生物医学领域的应用
光刻胶在生物医学领域中的应用也有很大的潜力。未来,光刻胶可以用于制备更加复杂的生物芯片、微型医疗器械、组织工程等。
4、纳米光学器件的制备
光刻胶在纳米光学器件的制备中具有重要的应用前景,如制造表面等离子体共振传感器、纳米光学器件等。
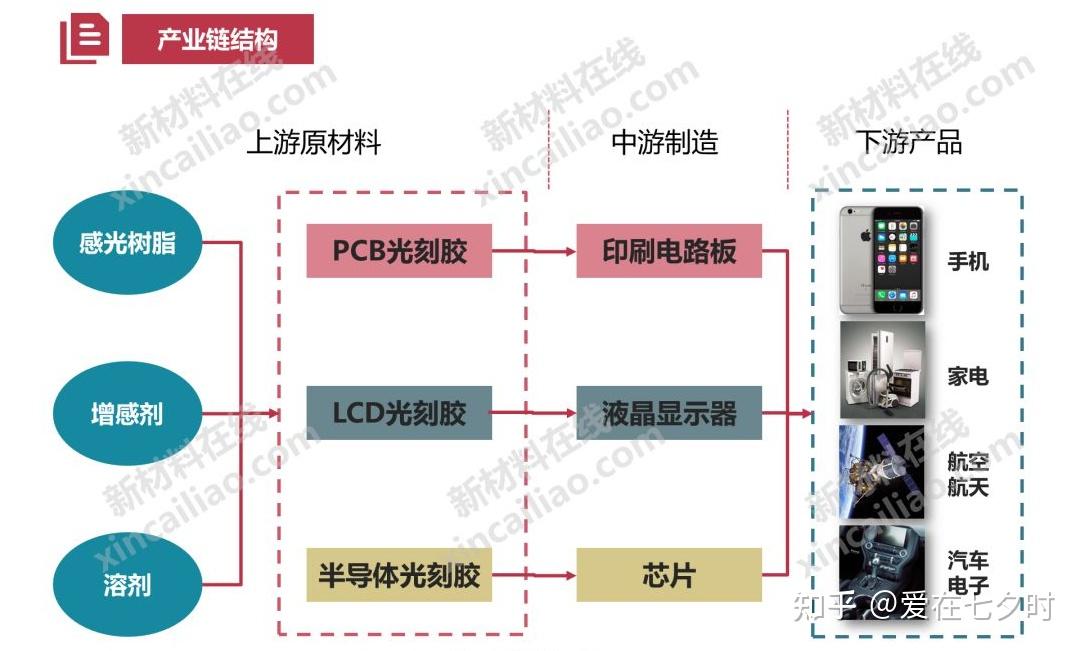
十、光刻胶(PR)的未来展望
中国光刻胶产业要实现真正的突破,必须从产业链、技术研发和产业生态三方面着手。
1、在产业链方面,必须实现全链条协同发展。
光刻胶的发展离不开光刻机的进步。目前,我国光刻机的国产化率不足3%,2023年进口光刻机数量高达225台,进口金额高达87.54亿美元。仅有上海微电子能制造90nm工艺节点DUV光刻机,与ASML差距极大。
2、在技术研发方面,需要持续加大投入,尤其是在新型光刻胶的研发上。
近期,清华大学与浙江大学的联合团队全球首次提出了“点击光刻”新方法,并成功开发出与之匹配的超高感光度光刻胶样品。这种新型的光刻胶材料,能在极低曝光剂量下实现高对比度成像,大大降低了光刻曝光剂量,提高光刻效率。
3、在产业生态方面,必须与下游企业深度合作,形成自己的产业生态体系。
就像日本光刻胶企业一样,与晶圆厂深度合作,嵌入其全产业生态中,构建起牢不可破的产业壁垒。随着芯片制程不断迈向7nm、5nm、3nm乃至更小线宽,光刻技术也在不断演进。在EUV光刻胶领域,中国虽然起步较晚,但通过产学研各界的共同努力,正逐步缩小与国际先进水平的差距,一步步点亮芯片制造的关键材料版图。

十一、写在最后面的话
回顾光刻胶的历史和发展,我们可以看到一个从简单到复杂,从微观到纳米的进化轨迹。这种材料不仅推动了电子产业的进步,还成为跨学科研究和应用的桥梁。面对未来,光刻胶将继续与时俱进,满足我们对更高技术标准的追求,同时为新的创新和发现奠定基础。
伴随全球半导体产业东移,加上我国持续增长的下游需求和政策支持力度。同时,国内晶圆厂进入投产高峰期,由于半导体光刻胶与下游晶圆厂具有伴生性特点,国内光刻胶厂商将直接受益于晶圆厂制造产能的大幅扩张。当前我国高端光刻胶与全球先进水平有近40年的差距,半导体国产化的大趋势下,国内企业有望逐步突破与国内集成电路制造工艺相匹配的光刻胶,所以我们必须要对光刻胶足够的重视,不断向日本和欧美等发达国家学习,努力开发出性能优异的国产光刻胶,使我国在未来的市场中占据一席之地。
参考资料
1. 证券时报网,《填补空白!EUV光刻胶标准立项,技术突破好消息不断(附股)》,2025年
2. 新材料在线,《光刻胶》
3. 中国科学院深圳先进技术研究院大型仪器共享平台,《光刻工艺简要流程介绍》,2025年
4. 中商情报网,《2025年中国光刻胶行业企业核心竞争力排名》,2025年
5. 36氪,《中国光刻胶,如何突围?》,2025年
6. 雪球,《2025当下,全球高端光刻胶市场被日本企业垄断93%份额》,2025年
7. 英语词典,《固体光刻胶》
8. OFweek光刻胶网,《一文看懂光刻胶技术发展史》,2021年
9. 应用化学,《g-线/i-线光刻胶研究进展》,2021年
10. 科普中国,《光刻》,2021年

免责声明
【我们尊重原创,也注重分享。文中的文字、图片版权归原作者所有,转载目的在于分享更多信息,不代表本号立场,如有侵犯您的权益请及时私信联系,我们将第一时间跟踪核实并作处理,谢谢!】
-
国产光刻胶开启“钳形攻势”2026-01-13 7185
-
Futurrex高端光刻胶2010-04-21 3997
-
光刻胶2018-07-12 3009
-
光刻胶在集成电路制造中的应用2018-08-23 7435
-
半导体材料市场构成分析2021-01-22 5580
-
日本已部分解除对韩国出口光刻胶的限制 日韩制裁争端或缓解2019-12-24 3749
-
半导体集成电路制造的核心材料:光刻胶2020-11-14 7709
-
一种半导体制造用光刻胶去除方法2022-04-13 1813
-
半导体制造领域光刻胶的作用和意义2023-10-26 1547
-
光刻胶分类与市场结构2024-01-03 3080
-
光刻胶成为半导体产业的关键材料2024-12-19 2818
-
半导体材料介绍 | 光刻胶及生产工艺重点企业2025-03-18 4858
-
光刻胶的类型及特性2025-04-29 10681
-
从光固化到半导体材料:久日新材的光刻胶国产替代之路2025-08-12 2694
-
光刻胶剥离工艺2025-09-17 2495
全部0条评论

快来发表一下你的评论吧 !

