

光学膜厚测量技术对比:光谱反射法vs椭偏法
描述
在现代高科技产业如半导体和新能源领域,厚度低于一微米的薄膜被广泛应用,其厚度精确测量是确保器件性能和质量控制的核心挑战。面对超薄、多层、高精度和非破坏性的测量需求,传统的接触式或破坏性方法已难以胜任。Flexfilm全光谱椭偏仪可以非接触对薄膜的厚度与折射率的高精度表征,广泛应用于薄膜材料、半导体和表面科学等领域。
为解决这一难题,以光谱反射法(SR)和光谱椭偏法(SE)为代表的非接触光学测量技术成为主流解决方案。光谱反射法通过分析薄膜反射的干涉光谱实现快速、大范围的厚度检测;光谱椭偏法进一步利用偏振态变化,不仅能测量极薄薄膜,还能同步获取材料的光学常数。本文将系统综述这两类技术的原理、发展和应用,并探讨其在未来精密制造领域向更高速度、更宽动态范围和更可靠测量演进的关键路径。
1
光谱反射法(SR)
flexfilm
光谱反射法通过将一束宽带光(如白光)照射到薄膜样品上,并收集其反射光谱来进行测量。光在薄膜的上下界面会发生多次反射和干涉,形成的干涉光谱中包含了薄膜厚度与光学常数的信息。
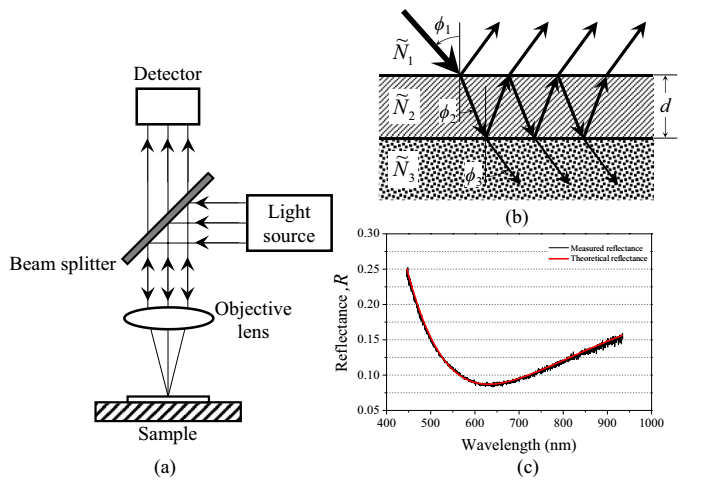
(a) 简易反射仪的光学结构示意图(b) 单层薄膜结构中两个界面的反射与透射光路示意图(c) 实测反射光谱与基于最小二乘法拟合的模型反射光谱对比图
基本模型与厚度提取:
对于最简单的单层膜结构(空气/薄膜/衬底),总反射率可通过菲涅尔公式和干涉项进行计算。

菲涅尔公式
测量时,已知(或预先标定)薄膜与衬底的光学常数(折射率、消光系数)及入射角,通过将实测反射光谱与不同厚度下的理论模型光谱进行匹配(通常采用最小二乘法),即可反演出最匹配的薄膜厚度。

高数值孔径物镜中入射角对理论反射光谱建模的影响示意图
技术演进与挑战:
模型精化: 早期模型常忽略材料的吸收。对于吸收不可忽略的材料,需采用复折射率来建立更精确的模型。此外,当使用高数值孔径物镜时,入射光包含一个角度范围,需引入“有效入射角”概念来修正模型。
分析效率: 传统的全光谱拟合计算量较大。为提高速度,研究提出了多种优化算法,例如利用反射光谱的极值位置或光谱相位信息来快速估算厚度初值,再进行精修。
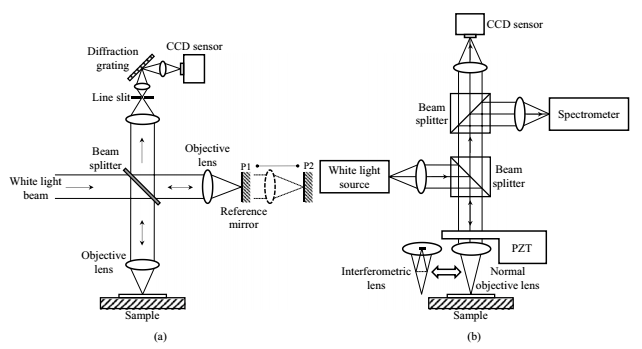
(a) 集反射法与干涉法两种测量模式于一体的光学结构示意图(b) 光谱分辨白光干涉测量法的光学结构示意图
集成测量: 将SR与干涉测量技术结合,可实现对薄膜厚度与表面三维形貌的同步测量。通过巧妙的信号分离技术(如频域分离),从同一组数据中提取出不同信息。

基于人工神经网络算法的薄膜厚度分析流程示意图(a) 训练阶段(b) 训练完成的网络预测阶段
人工智能的引入:
为应对复杂模型拟合耗时、对初始值敏感等问题,人工神经网络(ANN)等AI方法被应用于SR数据分析。通常使用大量基于理论模型生成的光谱-厚度数据对来训练神经网络。训练完成后,网络可直接、快速地从实测光谱预测出厚度。然而,AI模型的可靠性验证是关键,研究提出了利用有证标准物质来评估其在实际测量环境中性能的方法。
多层膜测量与可靠性:
测量多层薄膜结构中每一层的厚度更具挑战性。研究基于传输矩阵法建立多层膜反射模型,并结合优化算法进行反演。为确保测量结果的可靠性,韩国标准科学研究院的研究者提出了一种创新方法:在沉积多层膜的同时,制备一系列已知结构的辅助单层膜样品,用以交叉验证和评估整个测量系统的不确定度。
2
光谱椭偏法(SE)
flexfilm
椭偏法通过测量偏振光与样品相互作用后,其偏振态的改变来表征样品。它能同时测定薄膜的厚度和光学常数(复折射率 n 和 k),对超薄膜(可达亚纳米级)极为敏感。

椭偏仪的基本组成元件与光路布局示意图
系统构成与分类:
一台典型椭偏仪的核心组件包括:光源、偏振态发生器、样品台、偏振态分析器和探测器。根据这些组件中可动元件(如偏振片、补偿器)的类型和工作方式,椭偏仪主要分为五类:
单波长椭偏仪: 使用激光光源,结构简单。
光谱椭偏仪: 使用宽带光源和光谱仪,可获取随波长变化的光学信息,应用最广。
旋转元件椭偏仪: PSG或PSA中的元件(如偏振片)匀速旋转,通过分析探测器信号的谐波成分来提取数据。
零值椭偏仪: 通过调整偏振元件方位角使检测信号归零,常用于成像椭偏仪。
相位调制椭偏仪: 使用光弹性调制器等元件,测量速度极快。
其中,旋转元件光谱椭偏仪(RE-SE)因其良好的性能平衡,在工业在线检测和科研中应用最为广泛。
测量原理与数据分析:
椭偏测量的核心输出是椭偏传输量(ETQ),用于描述偏振态的变化。对于各向同性样品,最常用的ETQ是 Ψ 和 Δ 两个角度,它们与样品的光学参数和厚度通过复杂的物理模型相关联。

RE-SE记录随旋转元件角度变化的探测器信号

傅里叶分析提取谐波系数
测量时,RE-SE记录随旋转元件角度变化的探测器信号,通过傅里叶分析提取谐波系数,最终计算出ETQ。

ETQ
为了从测得的ETQ光谱(Ψ(λ), Δ(λ))反演出样品的厚度和光学常数,需要构建精确的光学分析模型,并采用非线性最小二乘法进行拟合,寻找使理论ETQ与实测ETQ差异最小的参数解。

非线性最小二乘法
不确定度评估:
椭偏测量的可靠性依赖于严格的不确定度评估。其不确定度主要来源于两部分:
ETQ测量值本身的不确定度(由仪器噪声、元件校准误差等引起)。
通过拟合分析得到样品参数(厚度、折射率)时,由拟合过程引入的不确定度。
传统方法在评估后者,尤其是针对复杂的光谱数据时存在局限。近期研究引入了基于隐函数定理的不确定度评估方法,能够更完备地考量所有潜在误差源的传播效应,从而更可靠地评估测量结果的置信区间。
3
技术对比与发展趋势
flexfilm
薄膜厚度测量是支撑现代精密制造的核心计量技术之一。本文详细综述了两种主流的光学非接触测量方法:光谱反射法和椭偏法。
光谱反射法原理直观,系统相对简单,通过与干涉等技术融合,功能不断拓展,AI的引入显著提升了其分析效率。
椭偏法信息量丰富,测量精度高,尤其擅长超薄膜与复杂光学常数的表征,其不确定度评估方法日趋完善。
两类技术各有侧重,并在不同应用场景下衍生出多种变体。
光谱反射法与光谱椭偏法是薄膜厚度光学测量的两大支柱。光谱反射法SR在工程应用和集成测量方面展现出灵活性,而光谱椭偏法SE在极限精度和材料表征深度上具有不可替代的优势。未来,随着器件尺寸不断缩小和新型材料涌现,对测量技术提出了“更快、更准、更广、更可靠”的终极要求。两大技术路径将在自身优化(如算法、校准)与相互融合(如椭偏成像、集成式多技术传感器)中持续演进,共同支撑前沿制造业的精密计量需求。
Flexfilm全光谱椭偏仪
flexfilm

全光谱椭偏仪拥有高灵敏度探测单元和光谱椭偏仪分析软件,专门用于测量和分析光伏领域中单层或多层纳米薄膜的层构参数(如厚度)和物理参数(如折射率n、消光系数k)
- 先进的旋转补偿器测量技术:无测量死角问题。
- 粗糙绒面纳米薄膜的高灵敏测量:先进的光能量增强技术,高信噪比的探测技术。
- 秒级的全光谱测量速度:全光谱测量典型5-10秒。
- 原子层量级的检测灵敏度:测量精度可达0.05nm。
Flexfilm全光谱椭偏仪能非破坏、非接触地原位精确测量超薄图案化薄膜的厚度、折射率,结合费曼仪器全流程薄膜测量技术,助力半导体薄膜材料领域的高质量发展。
#光谱椭偏法 #光谱反射法 #SE #SR
原文参考:《A Review ofThin‑flm Thickness Measurements using Optical Methods》
*特别声明:本公众号所发布的原创及转载文章,仅用于学术分享和传递行业相关信息。未经授权,不得抄袭、篡改、引用、转载等侵犯本公众号相关权益的行为。内容仅供参考,如涉及版权问题,敬请联系,我们将在第一时间核实并处理。
-
基于均匀样品的薄膜厚度测量:椭偏仪vs.反射仪2026-04-17 125
-
[VirtualLab] SiO2膜层的可变角椭圆偏振光谱(VASE)分析2026-04-09 92
-
椭偏仪常见技术问题解答(二)2025-10-10 722
-
椭偏仪选型指南 | 椭圆偏振法与反射法的优劣对比2025-09-15 1047
-
椭偏仪在半导体薄膜厚度测量中的应用:基于光谱干涉椭偏法研究2025-09-08 2371
-
薄膜测厚选台阶仪还是椭偏仪?针对不同厚度范围提供技术选型指南2025-08-29 2987
-
椭偏仪薄膜测量原理和方法:光学模型建立和仿真2025-08-15 4722
-
大面积薄膜光学映射与成像技术综述:全光谱椭偏技术2025-07-22 1686
-
芯片制造中的膜厚检测 | 多层膜厚及表面轮廓的高精度测量2025-07-21 1108
-
VirtualLab Fusion应用:氧化硅膜层的可变角椭圆偏振光谱(VASE)分析2025-02-05 516
全部0条评论

快来发表一下你的评论吧 !

