

晶圆多层膜的阶高标准:实现20–500nm无金属、亚纳米级台阶精度
描述
在集成电路检测中,高光学对比度的晶圆级阶高标准对提升自动图像识别的精度至关重要。传统基于单层Si-SiO₂薄膜的阶高标准在低台阶高度下对比度不足,通常需借助金属镀层增强信号,但这会引入污染风险。Flexfilm探针式台阶仪可以实现表面微观特征的精准表征与关键参数的定量测量,精确测定样品的表面台阶高度与膜厚,为材料质量把控和生产效率提升提供数据支撑。
本研究提出了一种基于绝缘体上硅(SOI)全介质多层膜(Si-SiO₂-Si)的新型阶高标准。该结构通过优化膜层设计,在不同台阶高度下均可实现高反射对比度。本文在8英寸晶圆上成功制备了20 nm、100 nm与500 nm三种规格的标准样品。测试表明,其光学对比度最高可达同类单层膜标准的百倍以上,同时台阶高度控制精准、表面粗糙度优异。该方案无需金属镀层,从根源上避免了污染,为半导体制造中的高精度光学检测提供了可靠解决方案。
1
阶高标准
flexfilm
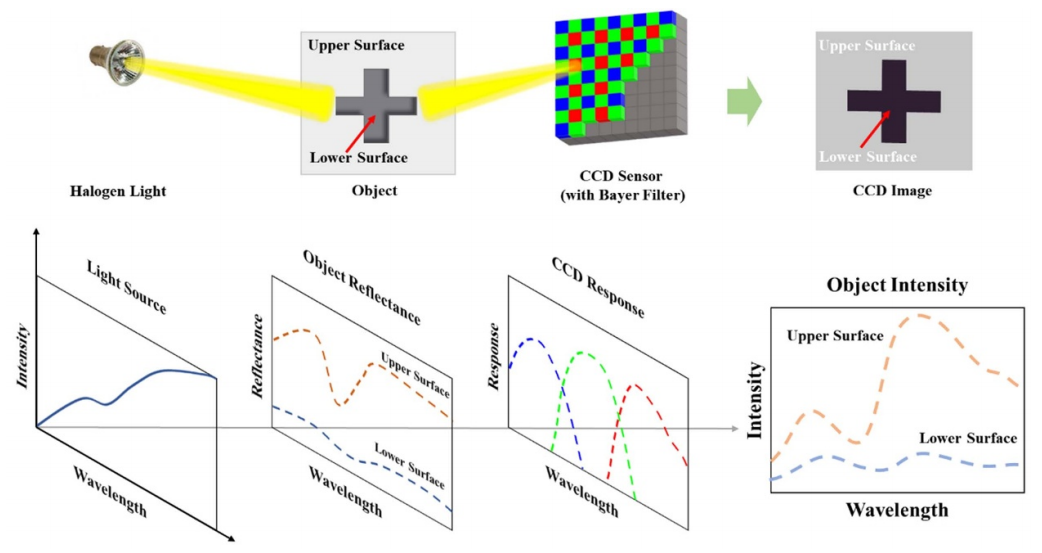
图像对比度的形成示意图

(a)可见光波段卤素光源的归一化光谱(b)可见光波段Basler彩色CCD的归一化光谱响应
阶高标准是校准纳米测量仪器(如台阶仪、原子力显微镜)的重要参照物,其性能直接影响半导体生产中的计量精度与良率控制。自动光学检测系统依赖图案的明暗对比进行识别与测量,因此阶高标准的对比度成为关键指标。
传统的单层SiO₂-on-Si阶高标准,其对比度受限于SiO₂厚度与台阶高度的耦合关系,在低台阶(如≤100 nm)时对比度显著下降。行业惯用的解决方案是沉积铬等金属层以增强光反射,但金属颗粒可能污染产线及器件。另一种改进思路是局部调整SiO₂厚度,但未能从根本上解决低阶高区域的对比度问题。
为此,本研究提出一种全介质多层膜设计方案,利用Si-SiO₂-Si结构,通过调控中间SiO₂层的厚度来实现宽范围、高对比度的光学响应,同时完全避免使用金属材料。
2
设计与仿真
flexfilm
阶高标准的光学对比度可用韦伯对比度定量描述,其大小主要取决于台阶表面与衬底区域在检测光谱范围内的反射率差异。在固定照明与探测条件下,提升对比度的核心在于最大化两区域的反射率比值。
单层膜结构中,衬底反射率固定,表面反射率由台阶高度(即SiO₂厚度)决定,设计自由度受限。而在本文提出的三层膜结构中,顶层Si的厚度决定台阶高度,中间SiO₂层的厚度则可独立优化,通过干涉效应抑制衬底区域的反射,从而大幅提升对比度。

(a)多层膜阶高标准的截面示意图(b)单层膜阶高标准的截面示意图;不同阶高的多层膜与单层膜阶高标准模拟光谱:(c)20 nm(d)100 nm(e)500 nm
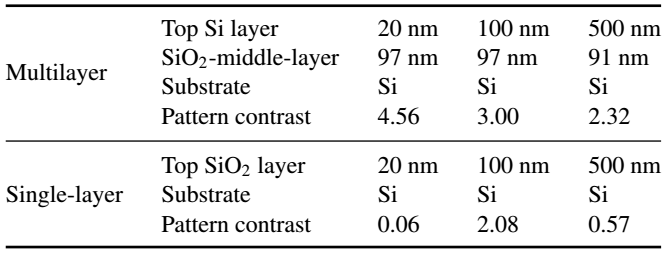
多层膜与单层膜阶高标准对比度模拟结果对比
本文采用传输矩阵法进行光学仿真,针对20 nm、100 nm和500 nm三种目标台阶高度,优化了中间SiO₂层的厚度。仿真结果表明,多层膜结构在所有高度下均展现出显著高于单层膜的对比度,尤其在20 nm时,对比度从单层膜的0.06提升至4.56,增幅超两个数量级。
3
制备与实验结果
flexfilm
制备工艺
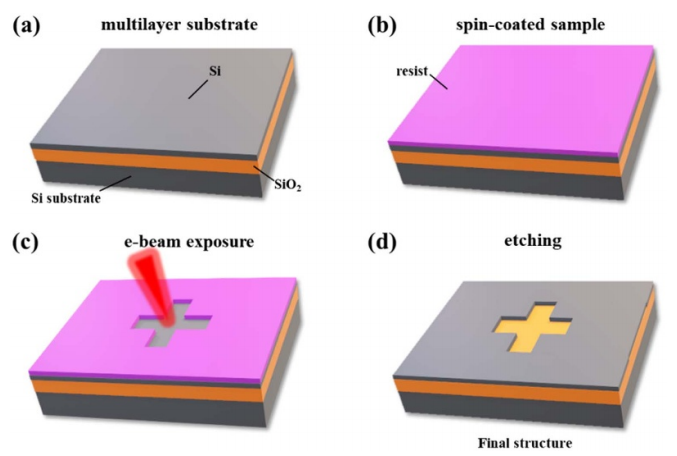
多层膜标准制备工艺流程示意图
在8英寸硅衬底上,通过离子束溅射依次沉积SiO₂与多晶硅薄膜。随后采用电子束光刻定义台阶图案,并利用感应耦合等离子体刻蚀进行图形转移。工艺中利用SiO₂相对于Si更低的刻蚀速率,将其作为刻蚀停止层,实现了对台阶高度的精确控制。
光学性能
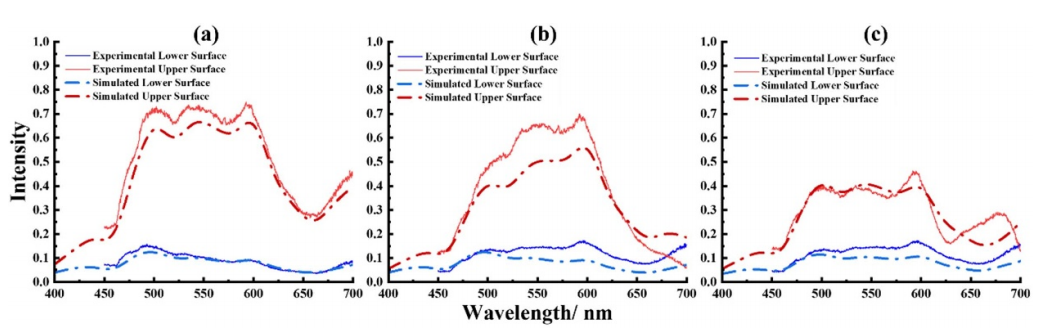
不同阶高多层膜阶高标准的光谱测量结果:(a)20 nm;(b)100 nm;(c)500 nm
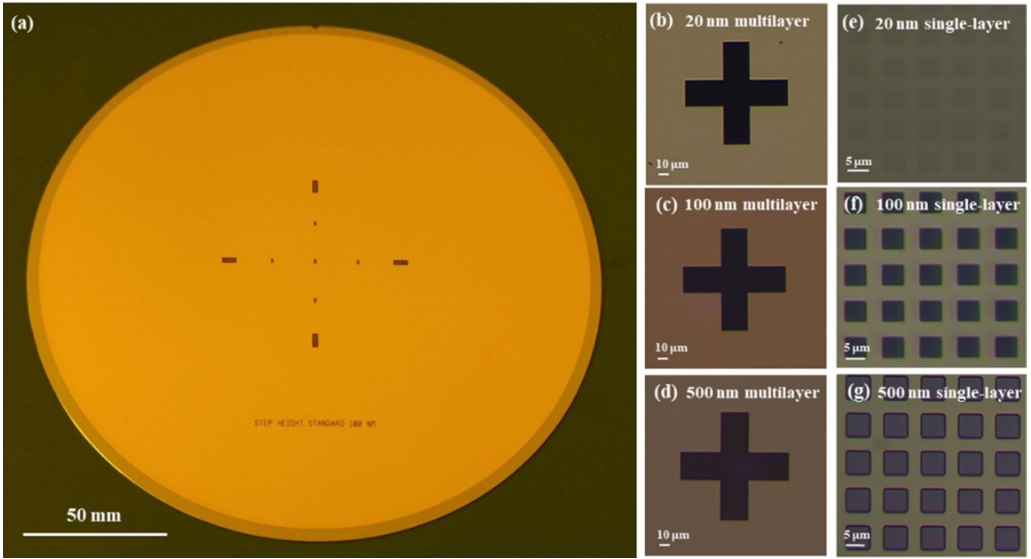
(a)8英寸晶圆上100 nm多层膜阶高标准示例照片;卤素光照明下不同阶高多层膜阶高标准的CCD图像:(b)20 nm(c)100 nmd)500 nm;卤素光照明下不同阶高单层膜阶高标准的CCD图像:(e)20 nm(f)100 nm(g)500 nm
光谱测量显示,制备的20 nm、100 nm和500 nm多层膜阶高标准对比度分别为4.87、2.37和1.57,与仿真趋势高度吻合。光学显微镜图像直观表明,多层膜样品在各阶高下均呈现清晰图案,而单层膜在20 nm时几乎不可辨,验证了多层膜方案在提升低阶高可视性方面的卓越效果。
台阶高度准确性与表面粗糙度

(a)阶高标准的AFM表面形貌图;阶高标准上下表面的AFM形貌图:(b)上表面;(c)下表面

标称20 nm、100 nm与500 nm阶高的实测结果
测量结果表明,所有台阶高度的均匀性优异(标准偏差<0.3 nm),实际高度与设计值偏差小。台阶上下表面的算术平均粗糙度Ra均低于0.15 nm,满足高精度计量对参考表面质量的要求。
本研究成功设计并制备了一种基于全介质多层膜的无金属、高对比度晶圆级阶高标准。该方案通过解耦台阶高度与光学对比度设计参数,实现了从亚50nm到数百纳米范围内的一致高对比度,且避免了金属污染风险。实验证实其同时具备优异的阶高控制精度与表面质量。这项工作不仅提供了一种更可靠的计量标准,也为将光学薄膜设计理念扩展至其他类型计量标准(如畸变靶、分辨率靶)提供了思路。
Flexfilm探针式台阶仪
flexfilm

在半导体、光伏、LED、MEMS器件、材料等领域,表面台阶高度、膜厚的准确测量具有十分重要的价值,尤其是台阶高度是一个重要的参数,对各种薄膜台阶参数的精确、快速测定和控制,是保证材料质量、提高生产效率的重要手段。
- 配备500W像素高分辨率彩色摄像机
- 亚埃级分辨率,台阶高度重复性1nm
- 360°旋转θ平台结合Z轴升降平台
- 超微力恒力传感器保证无接触损伤精准测量
费曼仪器作为国内领先的薄膜厚度测量技术解决方案提供商,Flexfilm探针式台阶仪可以对薄膜表面台阶高度、膜厚进行准确测量,保证材料质量、提高生产效率。
原文参考:《Metal-free high-contrast wafer-level step height standards with large height-range based on alldielectric multilayers》
*特别声明:本公众号所发布的原创及转载文章,仅用于学术分享和传递行业相关信息。未经授权,不得抄袭、篡改、引用、转载等侵犯本公众号相关权益的行为。内容仅供参考,如涉及版权问题,敬请联系,我们将在第一时间核实并处理。
-
晶圆表面的纳米级缺陷光学3D轮廓测量-3D白光干涉仪2026-02-11 330
-
触针式轮廓仪 | 台阶仪 | 纳米级多台阶高度的精准测量2025-07-22 994
-
高台阶基底晶圆贴蜡方法2024-12-18 406
-
如何借用物联网快速实现高标准农田信息化2024-06-24 1012
-
台阶仪膜厚测量:工业与科研中的纳米级精度检测2024-05-11 1484
-
台阶仪:亚埃级垂直分辨率,新材料纳米加工的测量利器!2024-02-20 747
-
台阶仪:亚埃级垂直分辨率,领跑新材料纳米加工的测量利器!2024-02-19 1515
-
纳米级测量仪器:窥探微观世界的利器2023-10-11 21116
-
AMEYA360分析蔡司用于亚10纳米级应用的离子束显微镜2023-07-19 1135
-
高性能20纳米级NAND闪存存储器2010-05-17 1510
全部0条评论

快来发表一下你的评论吧 !

