

基于四探针电阻测试的CuC 合金的导电性能研究
描述
在导电金属材料体系中,铜(Cu)以卓越导电性及远低于金、银的成本优势,成为电子浆料、催化等领域贵金属替代潜力材料。但纳米铜表面活性高,易氧化形成绝缘层,严重限制实际应用。因此,行业多通过合金化改性铜材料,利用组分协同效应赋予其优于单一金属的独特性能。本研究聚焦CuC合金,采用碳热还原法合成,借助Xfilm埃利的四探针技术系统测试导电性能,为开发高性能低成本铜基导电材料提供数据支撑。
本研究采用碳热还原法制备CuC合金。在惰性气氛保护下,将特定的铜源与碳源前驱体进行高温烧结还原,成功合成出目标材料。为准确评估其导电性能,并对比其与商用铜粉的差异,选用四探针电阻率测试法作为核心表征手段。
四探针电阻测试原理

Xfilm埃利四探针方阻仪
导电性能是评估导电浆料及薄膜的关键指标,本研究采用四探针电阻测试仪对烧结后的导电薄膜进行电阻率表征。该测试系统主要由计算机、测试台与四探针探头构成,具有测量速度快、范围广、精度高等优点。其基本原理是:将两个电流探针接触样品并输入恒定电流,同时在另外两个电压探针间检测产生的电压降,最终根据欧姆定律计算得到材料的电阻或电导率。
碳含量与材料结构对导电性的影响
/Xfilm
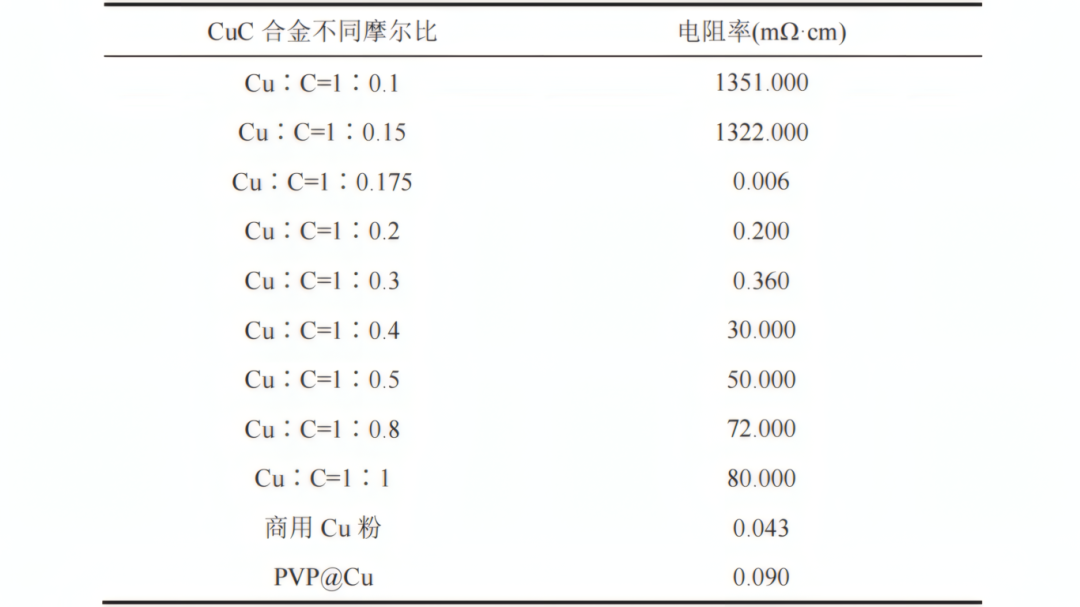
不同碳含量的CuC 合金与铜基材料的导电性
为探究碳含量及材料结构对导电性的影响,将不同配比合成的CuC合金粉体及对比样品通过压片法制成薄片,并使用四探针测试仪系统测量了其薄层电阻率。
1. 碳含量对CuC合金导电性能的影响
测试数据清晰表明,碳含量对CuC合金的导电性有决定性影响。随着碳源比例增加,薄层电阻呈现上升趋势。当碳源摩尔比超过0.3时,电阻急剧增大。这是因为过量的碳会沉积在铜颗粒表面,形成核壳结构,表面的碳层阻碍了电子传输,导致电阻升高。反之,当碳源摩尔比低于或等于0.15时,电阻也出现异常升高。这是由于还原剂不足,未能将铜前驱体完全还原,样品中残留了大量导电性差的氧化铜。因此,实验发现,当铜源与碳源的摩尔比控制在10.3之间时,CuC合金能获得最优异的导电性能。
2. 材料结构对导电性能的影响
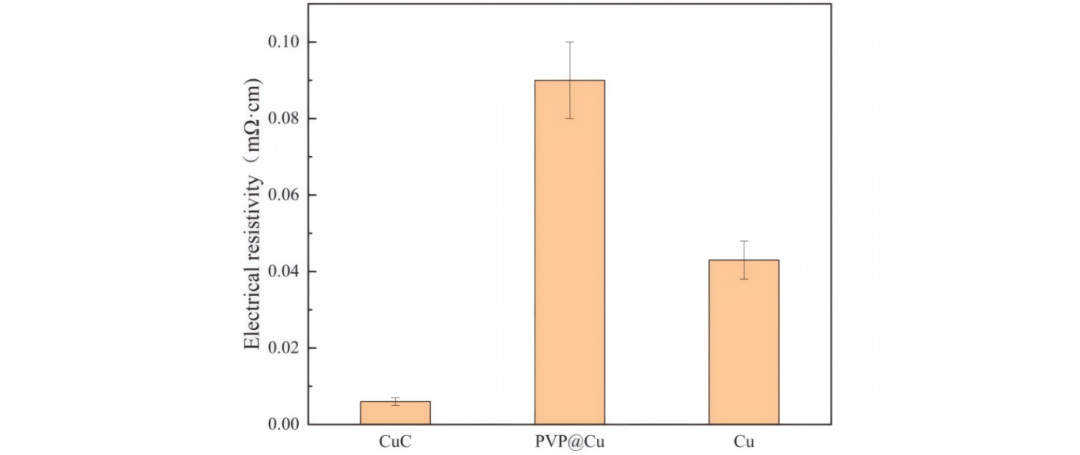 不同结构的铜粒子的导电性能,CuC 为合金结构,PVP@Cu 为核壳结构
不同结构的铜粒子的导电性能,CuC 为合金结构,PVP@Cu 为核壳结构
研究进一步对比不同结构材料的导电性,结果显示,具有合金结构的CuC薄片电阻率仅为商用铜粉薄片的约1/7,展现出显著的导电优势。而另一种核壳结构的PVP@Cu材料,其电阻率(0.09 mΩ·cm)则高于商用铜。
这种性能差异主要源于微观形貌:本研究合成的合金结构样品呈块状,颗粒间接触面积大,电子更易传输;而核壳结构多为球形,颗粒间为点接触,导电通道受限,导致电阻增高。这证明,通过合金化构建合适的微观结构,是大幅提升铜基材料导电性的有效途径。
本研究通过碳热还原法成功制备CuC合金,并利用四探针测试揭示了碳含量与材料结构对导电性的影响规律。实验表明,在铜碳摩尔比为1:0.175~0.3时,材料导电性最优;块状合金结构的CuC导电性能显著优于商用铜粉与核壳结构样品,得益于优化的成分有效抑制氧化,且块状形貌可构建更佳的导电通路。
Xfilm埃利四探针方阻仪
/Xfilm

Xfilm埃利四探针方阻仪用于测量薄层电阻(方阻)或电阻率,可以对最大230mm 样品进行快速、自动的扫描, 获得样品不同位置的方阻/电阻率分布信息。
- 超高测量范围,测量1mΩ~100MΩ
- 高精密测量,动态重复性可达0.2%
- 全自动多点扫描,多种预设方案亦可自定义调节
- 快速材料表征,可自动执行校正因子计算
基于四探针法的Xfilm埃利四探针方阻仪,凭借智能化与高精度的电阻测量优势,可助力评估电阻,推动多领域的材料检测技术升级。
-
如何区分万用表测电阻和四探针测电阻?2016-11-05 2939
-
使用两探针及四探针方法测得的电阻率差异2022-09-22 6647
-
测量薄层电阻的四探针法2023-08-24 3986
-
美能四探针电阻测试仪的智能操作软件2023-08-26 1379
-
电阻率越大导电性能越好还是越差2024-08-25 14892
-
标准电阻器的导电性能有要求吗2024-09-29 1157
-
如何提升漆包线的导电性能2024-12-09 2141
-
高温电阻测试仪的四探针法中,探针的间距对测量结果是否有影响2025-01-21 1650
-
四探针法丨导电薄膜薄层电阻的精确测量、性能验证与创新应用2025-07-22 1509
-
四探针电阻测试 | CuNiC 三元合金的导电性能研究2026-01-04 1278
-
基于四探针法的碳膜电阻率检测2026-01-22 388
-
四探针测试:铜浆料的配方和工艺对电阻率的影响2026-01-29 476
-
四探针测试在柔性OLED电极性能优化中的应用2026-02-05 366
-
从原理到应用:四探针测试仪选型指南2026-04-21 375
-
四探针 vs 双探针的电池极片电阻率测试方法对比2026-05-12 344
全部0条评论

快来发表一下你的评论吧 !

