

BGA封装技术与传统SMT/SMD的比较
描述
SMT(表面贴装技术)相对于传统的THT(通孔技术)而言。与THT组件相比,SMT组件可节省60%至70%的空间并减轻70%至80%的重量,因为它使电子元件直接焊接到PCB(印刷电路板)的两侧而无需钻孔。因此,SMT组件在加速电子产品的小型化,轻量化和薄型化方面起着重要作用,其特别是源自细间距SMT(间距小于0.65mm)。上述发展趋势可以通过手机,PC和摄像机清晰地捕捉到。 SMD(表面贴装器件)是一种没有引线或短引线的元件,如SOP(小外形封装),LCC(无引线芯片载体),PLCC(塑料无引线芯片载体),SOJ(小外形j-lead)封装,SOIC(小外形集成电路)和QFP(四方扁平封装),其中QFP占大多数应用。
随着IC(集成电路)的发展,它正在努力争取越来越多的功能和I/O引脚。此外,人们在小型化方面坚持越来越高的电子产品需求。因此,传统SMT封装技术的应用不再适用,例如使用QFP技术,改善I/O引脚和减小间距。 QFP的引线是线性分布的,并且引线间距减小已经接近极限。随着I/O引脚数量的不断增加,保持电子产品在功能上的改善和减小体积并使其在电子方面合理有效并不是一件容易的事。为了解决这个问题,另一种类型的封装,即BGA(球栅阵列)封装技术,能够成功解决问题,并在制造和应用方面取得突破。
BGA封装技术与传统SMT/SMD的比较
BGA封装技术与传统SMT/SMD之间的比较可以从以下几个方面实现。
•铅结构比较
BGA封装技术与传统SMT/SMD在引线结构方面的比较可以归纳到下表中。
| 项目 | 鸥翼 | J lead | 我领先 | BGA |
| 能够适应多线程包 | 好 | 普通 | 普通 | 优秀 |
| 包装厚度 | 好 | 普通 | 普通 | 优秀 |
| 引线刚性 | 普通 | 好 | 普通 | 优秀 |
| 适应多种焊接的能力 | 优秀 | 普通 | 普通 | 普通 |
| 回流焊接中的自对准功能 | 好 | 普通 | 普通 | 优秀 |
| 焊接后检查的能力 | 普通 | 好 | 普通 | 普通 |
| 清洁难度 | 普通 | 好 | 优秀 | 普通 |
| 有效区域利用率 | 普通 | 好 | 普通 | 优秀 |
•包装尺寸比较
三包的类型用作比较示例,其参数显示在下面的表2中。
| 包 | 潜在客户数 | 间距(mm) | 包装尺寸(mm) |
| BGA | 625 | 1.27 | 32 * 32 |
| TAB | 608 | 0.25 | 44 * 49 |
| PQFP | 304 | 0.5 | 46 * 46 |
根据上表所示的参数比较,很明显BGA功能最大数量的引线和最小的封装尺寸。
所有类型的封装结构之间的装配密度比较总结在下面的表3中
| 包 | 间距(mm) | 尺寸(mm) | I/O引脚数 |
| BGA | 1.27 | 32.5 * 32.5 | 625 |
| FPD | 0.50 | 32.5 * 32.5 | 240 |
| UFPD | 0.40 | 32.5 * 32.5 | 296 |
| UFPD | 0.30 | 32.5 * 32.5 | 408 |
| TCP | 0.25 | 32.5 * 32.5 | 480 |
| TCP | 0.20 | 32.5 * 32.5 | 600 |
•装配程序
BGA封装技术使传统的SMT封装扩展,增强了SMT的优势。就细间距元件或BGA封装元件而言,它们共享类似的装配程序,如下图所示。
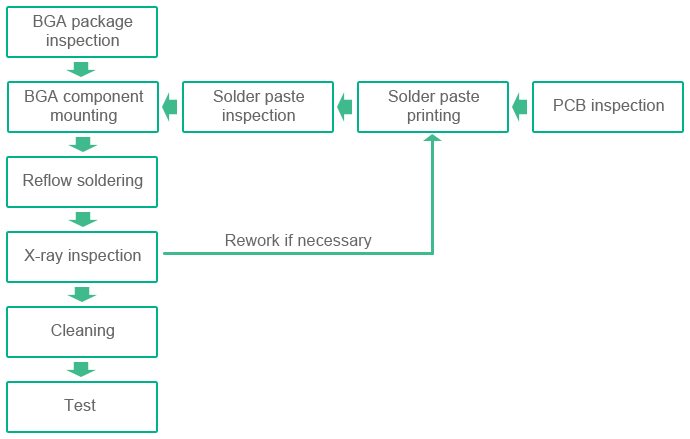
•装配缺陷率
装配缺陷率时BGA和QFP,在PCBCart生产线上积累了超过10年的装配经验,可以得出结论,BGA具有比QFP更低的缺陷率和更好的可制造性。
•最终检验
与BGA焊膏检测相比,细间距QFP由于其可靠性检查而带来了额外的成本。根据缺陷的特点,一般应采用检查短路或开路的自动系统,这增加了QFP的制造。由于BGA封装具有高制造效率和低缺陷率,因此它们的检查仅以对准和定位为中心。
•返工
由于以下原因,BGA封装的返工成本远高于QFP:
a。因为几乎不可能进行修改以击败单个短路或开路,所有组件关于BGA封装的缺陷消除必须依赖于返工。
b。 BGA封装返工比QFP更难,返工可能需要更多的设备和更高的成本增加。
c。返工后的BGA组件始终不起作用,只要经过仔细拆解,仍然可以应用一些QFP组件。
BGA与BGA之间的比较传统的SMT在返工技术方面,可以得出结论,BGA封装返工必须在完全预热的情况下完成。 BGA组件与其他类型的SMD具有相似的预热温度,但需要不同的预热升温速度。 BGA组件需要逐渐加热,并具有平滑的预热曲线。
此外,BGA封装下的所有焊球必须同时加热。必须严格应用BGA封装的焊膏,并且不允许对焊点进行修改。此外,BGA封装元件可以方便地应用,因为它们的间距很大。
•保留的焊接位置
领先的区别就保留焊接位置而言,BGA和QFP位于隐藏阵列和隐藏引线之间。在PCB设计能力提升方面,各种封装都有自己的优势,但最基本的问题在于跟踪密度,跟踪活动和综合性能。
因为BGA封装具有良好的散热性能即使PCB设计文件调节热元件之间的小间距,BGA封装也可以提供具有良好散热能力的操作环境。
•焊点可靠性
焊点可靠性和装配率受四个因素的影响:电路板可焊性,元件焊接性能,元件共面性和焊料粘贴量,所有这些都决定了最终产品的质量。
作为一种新的微电子封装技术,BGA肯定会取代QFP,以兼容多功能和高I/O的新要求引脚数。
-
BGA封装技术的发展 BGA封装的优势与应用2024-11-20 4853
-
SMT组装与传统焊接的比较2024-11-14 1886
-
SMT贴片中BGA封装的优缺点2024-04-07 2369
-
BGA封装是什么?BGA封装技术特点有哪些?2023-04-11 2013
-
【技术】BGA封装焊盘的走线设计2023-03-24 3681
-
讲解一下SMT贴片元器件中BGA封装的优缺点2023-02-14 4135
-
什么是SMT?使用表面贴装技术的典型PCB2020-11-21 7075
-
PCB制造:SMD与SMT组装2020-09-24 4329
-
SMT贴片加工的BGA有什么优缺点2020-05-13 4001
-
BGA元件SMT装配工艺要点简介2019-08-05 4888
-
SMT和SMD有什么区别呢?2019-03-07 3958
-
两种BGA封装的安装技术及评定2018-08-23 3179
-
BGA——一种封装技术2015-10-21 14459
全部0条评论

快来发表一下你的评论吧 !

