

BGA封装技术的焊接和检验方法
描述
随着电子技术的不断发展和进步,电子产品开始朝着轻量化,薄型化,小型化和先进功能的方向发展。经过几代升级,芯片封装技术使芯片面积与封装面积之比约为1,其中BGA(球栅阵列)已成为一种已进入实用阶段的高密度封装技术。如何保证BGA焊接质量的可靠性,如何检测BGA的质量以及如何对有缺陷的BGA进行返工对BGA SMT(表面贴装技术)组件至关重要,所有制造商必须完全了解其解决方案将在本文中讨论。
BGA封装技术
BGA封装在底部包含许多球形凸起管或在上表面。由于凸块,封装体和基座之间实现了互连。作为一种先进的封装技术,BGA具有较大的引线空间和较短的引线,通过分布I/O端,在封装体底部起到球或柱的作用。
基于不同的封装材料,BGA元件可分为PBGA(塑料BGA),CBGA(陶瓷BGA),CCBGA(陶瓷柱BGA),TBGA(带BGA)和CSP(芯片级封装)。
QFP(四方扁平封装)组件,BGA组件具有以下属性:
a。 I/O端间距很大,BGA可以保持更多的I/O端。
b。更高的封装可靠性,更低的焊接缺陷和更坚固的焊点。
c。 BGA芯片在焊点之间具有较大的间距,因此对准和焊接不会因对准放大系统而变得困难。 BGA焊接的共面性得到保证,因为焊料会在熔化后自动补偿芯片和PCB之间的平面误差。由于焊接点较小,自感和互感较低,因此具有优异的电气特性和频率特性。
f。能够实现自动自对准和焊接接头之间的张力,从而实现出色的自定心效果,从而实现高可靠性。它的主要缺点在于它们的检查和返工相对难以进行。
BGA装配
鱼骨图关于含有BGA组分的PCB板制造过程中元素的说明如下所示。
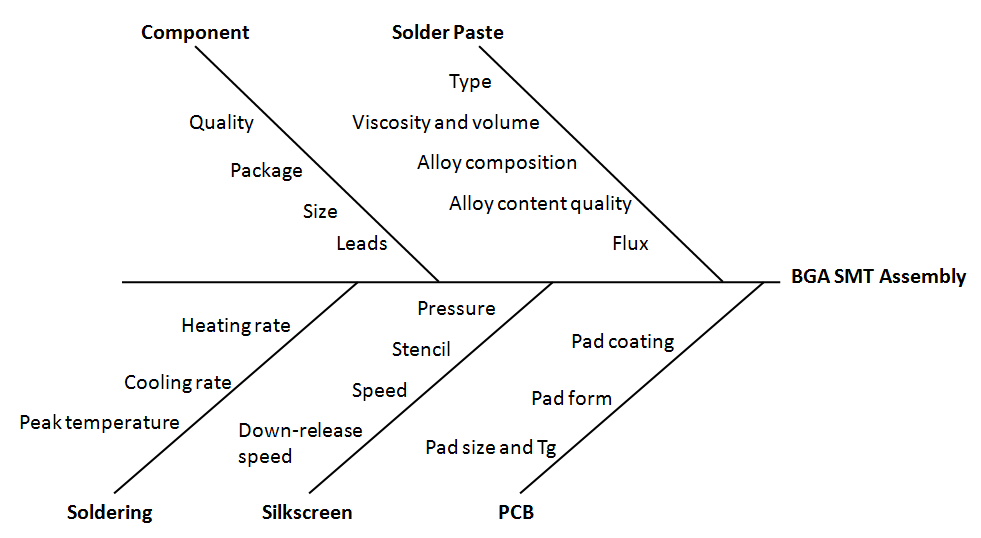
根据上述鱼骨,BGA SMT与焊膏,元件,PCB,丝网印刷和焊接紧密相关,其中焊接项目是回流焊接过程中最难处理的。
影响回流焊接的关键因素在于温度曲线设定。具体方法是在位于PCB背面的BGA中心的某个焊盘位置打开一个孔,然后将热电偶探针穿过PCB板底部的孔,并将其粘在焊盘的背面并固定用高温胶带。接下来,将参数设置良好的回流焊温度曲线测试仪与托盘和探头一起放入回流焊炉中。经过比较和分析,得到最佳温度曲线。
回流温度曲线由四个阶段组成:预热阶段,保温阶段,回流阶段和冷却阶段。加热过程和温度曲线应使封装达到回流温度,然后在焊球与焊盘产生的金属间化合物熔化后回落到焊盘的温度。加热不一致会导致封装不均匀地掉落或倾向于回流焊接的一侧或一角,导致非共面性和焊接不充分。
BGA方面也应强调以下两个方面。焊接:
a。预烘烤
塑料包装通常会吸收湿气。如果芯片在吸收空气中的湿气后立即被加热,则水分扩散将导致芯片内部的空腔。因此,塑料包装的一般烘烤条件在100°C下持续6到8小时。
b。氧化
在应用之前,应检查BGA组件以确保其引脚清洁并且不会发生氧化。
BGA检验方法
a。 BGA缺陷和检查方法
焊接后,BGA组件可能会因组件,组装设备,环境和焊接技术而出现不同的缺陷。领先的BGA缺陷包括未对准,松动焊接,开路,冷焊,桥接,短路和空腔。此外,BGA焊球可能还存在一些问题,例如缺失或掉落以及尺寸不均匀。对于BGA检测,由于焊球低于芯片,因此在焊接后很难判断焊接质量。传统的目视检查无法确定焊接接头内是否有缺陷或空洞。必须使用专业的检测设备来清楚地判断焊点的质量。
在SMT组装中利用BGA组件后,通常所依赖的检查方法包括电气测试,边界扫描和X射线检查。传统的电气测试能够扫描开路和短路缺陷。边界扫描技术取决于基于边界扫描设计的检查端口,可以访问边界连接器上的每个焊点,从而可以检查组件上的开路和短路。虽然边界扫描能够检查比电气测试更广泛的隐形焊点,但这两种方法仅测试电气性能而不会达到焊接质量检查。为了保证和提高制造工艺的质量,必须依靠其他方法进行焊接质量检查,尤其是那些看不见的焊点。 AXI(自动X射线检测)可以有效地解决问题,并且可以进行实时监控,以确保过程控制的质量和实时反馈。
湾最佳BGA焊点标准
最佳BGA焊点应光滑,边界清晰,无空隙,直径,体积,灰度和对比度应保持在所有焊点之间完全对齐,不产生焊球。与最佳BGA焊点的标准相比,合格的BGA焊点具有更低的要求。
•不对中。 X射线检查装置能够清楚地指示BGA焊球是否与PCB板上的焊盘位置精确兼容。可以允许小于25%的位移。
•松散的焊接接头。 BGA焊接不允许松动的焊接接头。
•开路和冷焊接接头。当焊料不与相应的焊盘接触或焊料不良流动时,可能会发生开路和冷焊接接头。 BGA焊接不允许开路和冷焊接接头。
•桥接和短路。当焊料过量或不适当地放置时,可能会发生桥接和短路。至于BGA焊点,不允许桥接和短路。
•腔。有关腔的问题有点复杂。 X射线检查装置能够在BGA部件组件上展示空腔。以下提示可作为判断标准:
1、产生空腔的原因
①在焊接BGA焊球之前可以使用空腔,这可能来自焊球制造或焊膏成分。
②如果通孔是设计为垫下,外部空气通过孔进入熔化焊球,冷却后形成空腔。
③焊盘表面有不良涂层或焊盘污染。
④回流焊温度曲线设置不合适。
2、空腔的最佳标准
空腔中的空气可能会产生收缩和膨胀的应力效应。空洞发生的地方将是应力集中,这可能是应力裂缝的根本原因。带有空腔的BGA焊接接头可能会导致技术问题,例如失效。根据IPC对BGA焊点规定的标准,焊盘上的空腔不应比焊球面积大10%,即空腔直径不应大于焊球直径的30%。
- 相关推荐
- 热点推荐
- BGA
- PCB打样
- 华强PCB
- 华强pcb线路板打样
-
请问含有BGA封装的板子怎么焊接?2024-05-08 631
-
请问PCB热设计的检验方法是什么?2021-04-21 1722
-
【技术】BGA封装焊盘的走线设计2023-03-24 3704
-
BGA封装是什么?BGA封装技术特点有哪些?2023-04-11 2041
-
电视节目带技术质量检验方法 GY T 120-19952008-11-22 887
-
BGA封装焊接技术2010-06-25 1141
-
集成电路(IC)封装的截面显微组织检验方法2010-04-25 1409
-
BGA焊接前的准备工作2015-11-17 817
-
smt贴片在加工前的检验方法都有哪些2020-06-16 2048
-
bga封装芯片的焊接2020-02-25 14346
-
目前BGA焊接失效检测的常用的方法是什么2020-07-24 2700
-
先进封装形式μBGA、CSP的回流焊接技术说明2022-05-06 1108
-
磁环的检验方法有哪些?要如何使用?2024-01-11 4824
-
常用的几种BGA焊点缺陷或故障检测方法2024-06-05 2994
-
如何进行BGA封装的焊接工艺2024-11-20 4603
全部0条评论

快来发表一下你的评论吧 !

