bga芯片pcb怎么画
更多
设计带有BGA(球栅阵列)芯片的PCB是一项需要精细规划和严格遵循规则的工作。以下是关键步骤和注意事项,请务必遵循:
一、 前期准备
- 获取完整准确的封装数据:
- 从芯片厂商获得官方推荐的PCB封装(通常包含在Datasheet或单独的封装文档中)。
- 关键参数:焊球直径、焊球间距、焊球阵列行列数、芯片本体尺寸/外形、基准标记位置、推荐焊盘尺寸、阻焊设计建议、丝印外框。
- 理解设计要求:
- 信号完整性: BGA常用于高速芯片(CPU, FPGA, DSP, DDR等),需考虑阻抗控制、串扰、时序。
- 电源完整性: 分析电源网络需求,规划层叠和电容放置。
- 热管理: 评估芯片功耗,规划散热通道(散热焊盘、过孔、散热器)。
- 层叠结构: 根据信号密度、速度和成本确定PCB层数(通常需要4层或更多)。规划好电源层、地层和信号层。
二、 PCB封装创建(关键!)
- 焊盘设计:
- 尺寸: 绝对不能直接用焊球直径做焊盘! 必须参考芯片厂商推荐的焊盘尺寸或IPC标准(如IPC-7351)。
- 通常比焊球直径小一些(如焊球0.4mm,焊盘0.25-0.35mm)。
- NSMD (Non-Solder Mask Defined): 最常用。铜焊盘尺寸小于阻焊开窗。焊点形状由熔融焊料在铜焊盘表面张力形成。优点: 焊点强度高,自对位性好。推荐!
- SMD (Solder Mask Defined): 阻焊开窗小于铜焊盘。焊点被限制在开窗区域内。较少用于BGA主体阵列,有时用于角落标识球或散热焊盘。
- 形状: 通常为圆形或椭圆形。椭圆形有时用于窄间距BGA以增加铜箔连接性。
- 阻焊开窗: 确保开窗尺寸略大于焊盘(通常单边大0.05-0.1mm),以保证焊盘完全暴露且不粘连。
- 尺寸: 绝对不能直接用焊球直径做焊盘! 必须参考芯片厂商推荐的焊盘尺寸或IPC标准(如IPC-7351)。
- 焊盘阵列:
- 严格按照BGA焊球排列的行列间距放置焊盘。
- 精确设置原点,通常为芯片几何中心或标记球的中心。
- 丝印层:
- 画出芯片本体外形框线(实线或点划线),明确芯片边界和方向。
- 标出第一脚位置(如圆点、斜角标记)和其它关键标记(如散热焊盘位置)。
- 装配层:
- 放置芯片本体外框(用于贴片机)。
- 基准标记:
- 在封装外添加局部基准点。通常至少放置3个(呈L形或对角),距离芯片边缘1-3mm。
- 基准点为实心铜圆盘(通常直径1.0mm),覆盖阻焊,周围有较大空白区(直径通常3mm)。
- 散热焊盘:
- 如果芯片中间有大的散热焊盘,创建对应的大型铜皮区域。
- 关键: 在散热焊盘上设计过孔阵列(通常称为热过孔或散热过孔)。过孔连接到内层地平面或多个平面层以散热。
- 过孔尺寸:常用0.2-0.3mm钻孔孔徑。
- 过孔排列:矩阵排列,间距0.5-1.0mm(或按厂商建议)。注意: 散热焊盘上的过孔通常需要塞孔和盖油(Via in Pad capped/plugged & plated over),以防止焊料流失导致虚焊。这会增加成本,但必要!
- 检查:
- 反复对照芯片规格书,确保所有尺寸、标记准确无误。
- 使用PCB软件的DRC检查封装内间距(焊盘间、焊盘到丝印)。
三、 PCB布局(Placement)
- 核心原则: 先BGA,后其他。 BGA的位置对整个布线、电源分配、信号质量影响最大。
- 放置BGA:
- 考虑连接器位置、散热路径、机械结构限制。
- 为后续布线留出足够的通道空间。
- 放置去耦电容:
- 就近原则! 将去耦电容(尤其小容值陶瓷电容)尽可能靠近BGA电源引脚放置。
- 优先放置在BGA芯片底部(Bottom Side Placement):利用芯片下方空间,效果最好。需考虑焊盘设计(通常使用小焊盘和细走线连接)。
- 其次放置在BGA周围(Top Side Placement):效果稍次,但更易加工。
- 电源引脚与电容焊盘间的回路电感要最小化(短线宽线,多个过孔并联)。
- 放置电源模块/转换器: 考虑电源电流路径,减少环路面积。
四、 PCB布线(Routing)与扇出(Fanout)
扇出是将BGA焊盘连接到PCB内层或外层走线的过程,是BGA布线最关键的步骤。
- 规划布线层和过孔:
- 确定哪几层用于信号,哪几层用于电源/地。
- 确定过孔类型:
- 通孔: 贯穿所有层。成本低,但占用所有层空间,影响布线密度。
- 盲孔: 从外层到内层(非贯穿)。
- 埋孔: 只在内层之间。盲埋孔可极大提高高密度BGA布通率,但显著增加PCB成本和加工难度。
- 对于引脚间距≤0.8mm的高密度BGA,几乎必须使用盲埋孔技术才能完成布线。0.8mm以上间距可尝试只用通孔。
- 扇出策略:
- “狗骨头”焊盘: 最常见。在BGA焊盘外侧(焊盘之间或外侧延伸区域)放置一个过孔。焊盘通过短走线(“脖子”)连接到过孔。
- 脖子宽度≤焊盘宽度。
- 过孔与焊盘边缘保持安全间距(通常≥0.15mm)。
- 盘中孔: 直接在焊盘上打孔(Via in Pad)。必须采用塞孔和电镀填平工艺(capped/plugged & plated over) ,否则焊料会流入孔内导致虚焊。成本高,但能节省空间,提高布线密度。常用于散热焊盘或极密间距BGA的信号扇出。
- 布线通道规划:
- 分析BGA阵列的空隙区域(如外围引脚间的通道、内部矩阵的空行/空列)。
- 设置布线网格和方向(垂直/水平交替层)。
- 估算每条通道能容纳的信号线数量(考虑线宽线距)。
- “狗骨头”焊盘: 最常见。在BGA焊盘外侧(焊盘之间或外侧延伸区域)放置一个过孔。焊盘通过短走线(“脖子”)连接到过孔。
- 常用扇出模式:
- 边缘扇出: 外围几圈引脚向外侧扇出到更宽的区域布线。适合引脚数较少的BGA。
- 区域扇出:
- 交错扇出: 首选! 将过孔错开排列在两排焊盘之间的通道中心线上,最大化利用通道空间。一行焊盘的过孔向左偏,相邻行焊盘的过孔向右偏。
- 直线扇出: 过孔直接打在焊盘正下方通道中心线上。布线通道利用率较低。
- 逃逸布线:
- 信号线从扇出过孔引出后,沿着同一层或通过少量换层,尽快将导线“逃逸”出BGA密集区域,进入更宽松的布线区域。
- 布线规则:
- 阻抗控制: 高速信号线需按计算确定线宽线距和介质厚度,参考平面必须完整。
- 线宽线距: 遵守PCB厂家的加工能力(最小线宽/线距)。
- 长度匹配: 差分对(USB, PCIe, DDR DQS/DQ等)需严格等长。总线(如DDR地址/控制)需满足时序要求的长度公差。
- 参考平面: 信号线下方(或上方)必须有完整的参考平面(GND或Power)。避免跨分割区(Split Plane)布线!电源平面分割处需加去耦电容“缝合”。
- 直角转弯: 严禁直角转弯! 使用45°角或圆弧转弯以减少反射和辐射。
- 过孔数量: 尽量减少换层次数(过孔会产生阻抗不连续和电感)。
- 电源/地布线:
- 使用大面积铺铜(Polygon Pour)连接电源网络和地网络。
- 电源引脚连接:使用尽量宽的走线,或通过多个过孔直接连接到内层电源平面。
- 地引脚连接:尽量通过短而粗的走线和多个过孔(Via Stitching)连接到完整的地平面。散热焊盘的过孔阵列也是重要的接地路径。
- 电源完整性: 确保电源网络阻抗足够低,满足芯片动态电流需求。合理分布去耦电容(不同容值组合,靠近芯片)。
五、 设计规则检查与生产考虑
- DRC检查:
- 运行PCB设计软件的Design Rule Check,确保所有线宽、线距、焊盘间距、过孔间距、丝印间距等符合设定的规则(这些规则必须兼容PCB厂家的工艺能力)。
- 重点检查BGA区域的最小间距。
- DFM (可制造性设计) 检查:
- 阻焊桥: 确认相邻焊盘间的阻焊是否能形成有效的隔离“桥”(防止焊接短路)。对于密间距BGA,这是关键点。
- 焊接可靠性: 确认焊盘设计、散热设计合理。
- 测试点: 考虑是否需要在关键网络(电源、地、复位、时钟、测试点)上添加测试点。
- 钢网设计:
- 钢网开孔尺寸和形状会影响焊膏量。
- 对于普通BGA焊点,钢网开孔通常比焊盘稍小(如焊盘0.3mm,开孔0.28mm)。
- 对于中间大散热焊盘,钢网开孔常设计成分割的网格状(如九宫格),而非一个大开窗,以防止焊膏过多造成芯片漂浮或焊接后应力大。
- Gerber文件生成:
- 生成符合厂家要求的Gerber文件(包含所有层:线路、阻焊、丝印、钻孔、外形等)和钻带文件(NC Drill)。
- 提供准确的设计说明,特别是关于过孔处理(如散热焊盘和盘中孔的塞孔盖油要求)、阻抗控制要求、层叠结构等信息。
- 与PCB厂家沟通:
- 务必在设计前期或提交生产前,将你的设计方案(尤其是BGA封装尺寸、间距、使用盲埋孔等关键信息)发给意向的PCB制造厂进行可行性确认!
- 确认他们的工艺能力(最小线宽/线距、最小钻孔孔径、最小焊盘/过孔环宽、盲埋孔能力、表面处理方式、塞孔工艺等)能满足你的设计。
- 获取他们对设计的反馈和建议。
核心总结与警告:
- 封装精准是基石: 错误的封装尺寸直接导致焊接失败。必须使用官方数据或精确计算。
- 扇出决定成败: 合理的扇出策略(特别是交错扇出)和布线通道规划是布通高密度BGA的关键。0.8mm以下间距强烈建议咨询专业SI/PI工程师或使用盲埋孔。
- 电源地是命脉: 低阻抗的电源分配网络和完整的地平面是芯片稳定工作的基础。去耦电容必须足够且靠近。
- 散热不可忽视: 散热焊盘及其过孔阵列的设计和制造工艺至关重要。盘中孔必须要求塞孔盖油!
- DFM必须考虑: 设计再好,工厂做不出来或良率低等于零。务必提前与PCB厂和SMT厂沟通确认!
- 高速设计需专业: 对于高速BGA芯片(DDR, FPGA等),信号完整性和电源完整性设计极其复杂,强烈建议进行仿真或寻求有经验工程师的帮助。
设计BGA PCB是一个系统工程,需要细心、耐心和对细节的极致追求。务必反复检查,并充分利用厂家资源和设计指南。
PCB设计关于BGA芯片布线的通用技巧
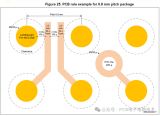
BGA封装具有最高的引脚密度,这意味着它们在PCB上占据最小的空间,这对于大多数现代高端电子产品(如智能手机)来说是必不可少的。然而,拥有如此高密度的封装意味着需要特殊技术将所有信号路由到
2024-03-08 11:13:29
怎么处理PCB上BGA芯片的零件走线

BGA 是 PCB 上常用的组件,通常 CPU、NORTH BRIDGE、SOUTH BRIDGE、AGP CHIP、CARD BUS CHIP…等,大多是以
2023-12-28 16:35:37
PCB设计关于BGA芯片布线通用技巧
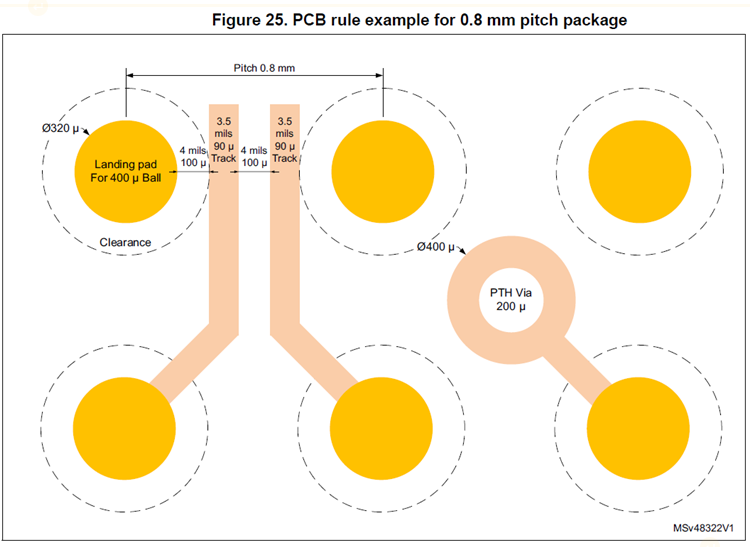
BGA芯片几乎总是需要去耦电容,可能还需要靠近芯片放置校准电阻(通常在其正下方),因此确定这些电容的封装尺寸也是一个重要步骤,应该提前完成。同样
2023-11-27 16:25:21
基于PCB板上BGA芯片的布局布线设计方法解析

BGA是PCB上常用的组件,通常CPU、NORTH BRIDGE、SOUTH BRIDGE、AGP CHIP、CARD BUS CHIP…等,大多是以 bga
2019-12-06 15:29:00
7天热门专题
 换一换
换一换
 换一换
换一换
- 如何分清usb-c和type-c的区别
- 中国芯片现状怎样?芯片发展分析
- vga接口接线图及vga接口定义
- 芯片的工作原理是什么?
- 华为harmonyos是什么意思,看懂鸿蒙OS系统!
- 什么是蓝牙?它的主要作用是什么?
- ssd是什么意思
- 汽车电子包含哪些领域?
- TWS蓝牙耳机是什么意思?你真的了解吗
- 什么是单片机?有什么用?
- 升压电路图汇总解析
- plc的工作原理是什么?
- 再次免费公开一肖一吗
- 充电桩一般是如何收费的?有哪些收费标准?
- ADC是什么?高精度ADC是什么意思?
- EDA是什么?有什么作用?
- dtmb信号覆盖城市查询
- 中科院研发成功2nm光刻机
- 苹果手机哪几个支持无线充电的?
- type-c四根线接法图解
- 华为芯片为什么受制于美国?
- 怎样挑选路由器?
- 元宇宙概念股龙头一览
- 锂电池和铅酸电池哪个好?
- 什么是场效应管?它的作用是什么?
- 如何进行编码器的正确接线?接线方法介绍
- 虚短与虚断的概念介绍及区别
- 晶振的作用是什么?
- 大疆无人机的价格贵吗?大约在什么价位?
- 苹果nfc功能怎么复制门禁卡
- 单片机和嵌入式的区别是什么
- amoled屏幕和oled区别
- 复位电路的原理及作用
- BLDC电机技术分析
- dsp是什么意思?有什么作用?
- 苹果无线充电器怎么使用?
- iphone13promax电池容量是多少毫安
- 芯片的组成材料有什么
- 特斯拉充电桩充电是如何收费的?收费标准是什么?
- 直流电机驱动电路及原理图
- 传感器常见类型有哪些?
- 自举电路图
- 通讯隔离作用
- 苹果笔记本macbookpro18款与19款区别
- 新斯的指纹芯片供哪些客户
- 伺服电机是如何进行工作的?它的原理是什么?
- 无人机价钱多少?为什么说无人机烧钱?
- 以太网VPN技术概述
- 手机nfc功能打开好还是关闭好
- 十大公认音质好的无线蓝牙耳机