FOWLP
三星开发新的芯片封装技术FOWLP-HPB,以防止AP过热
的顶部附加了一块散热块(HPB),这样的技术被称之为晶圆级扇出型 HPB 封装 (FOWLP-HPB) 技术,由三星晶片部门旗下的先进封装 (AVP) 业务部门开发,预计未来用于的 Exynos 系列手机处理器上,目标是在 2024 年第四季完成开发,并开始大量生产。 另外,该公司还正在
2024-07-05 18:22:55
三星FOWLP-HPB技术:革新芯片封装,解决AP过热难题
在智能手机性能日益强大的今天,应用处理器(AP)的散热问题成为了制约其性能释放的关键因素。为了应对这一挑战,三星电子正全力以赴,开发一项名为FOWLP-HPB的革新性芯片封装技术,旨在从根本上解决AP过热问题,为未来的Exynos芯片提供强有力的散热保障。
2024-07-05 11:10:38
谷歌Tensor G4芯片与三星Exynos 2400共用FOWLP工艺
IT之家了解到,借助FOWLP技术,有助于增强芯片组的I/O功能并加快电信号传输速度,同时提升其抗热性,使SoC能够维持更稳定高效的多核性能。据悉,三星在Exynos2400产品描述中指出,此技术能使多核性能提升约8%。
2024-03-06 16:05:17
三星Exynos 2400芯片采用FOWLP技术,提高性能与散热能力
据最新消息,三星的Exynos 2400芯片将采用扇出式晶圆级封装(FOWLP)技术。这种封装技术使得Exynos 2400在性能和散热能力方面有了显著提升。
2024-01-22 16:07:32
华海诚科:颗粒状环氧塑封料等自研产品可用于扇出型晶圆级封装
在扇出型晶圆级封装(fowlp) 华海诚科的FOWLP封装是21世纪前十年,他不对称的封装形式提出环氧塑封料的翘曲控制等的新要求环氧塑封料更加残酷的可靠性要求,经过审查后也吐不出星星,芯片电性能维持良好。
2023-09-13 11:49:37
扇出型晶圆级封装关键工艺和可靠性评价
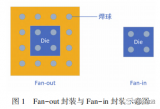
结合 FOWLP 近期技术发展和 应用的现状, 总结了发展趋势; 从 FOWLP 结构的工艺缺陷和失效模式出发, 阐述了 FOWLP 的工艺流程
2023-07-01 17:48:39
基于inFO的AiP天线的FOWLP技术分析
尽管目前AiP的实现工艺主要有LTCC(低温共烧结陶瓷)、HDI(高密度互联)及FOWLP(晶圆级扇出式封装)三种,但是我们认为,基于更高的集成度、更好的散热性、更低的传输损耗等优势,结合目前的产业化进度,FOWLP
2022-08-29 10:10:20
科普一下扇出型晶圆级封装(FOWLP)
近几年中,芯片特征尺寸已接近物理极限,而先进封装技术成为延续摩尔定律的重要途径。一系列新型封装技术出现在人们视野之中。而其中扇出型晶圆级封装(FOWLP)被寄予厚望,它将为下一代紧凑型、高性能的电子设备提供坚实而有力的支持。
2022-07-10 15:06:32
FOWLP技术如何使摩尔定律保持有效?
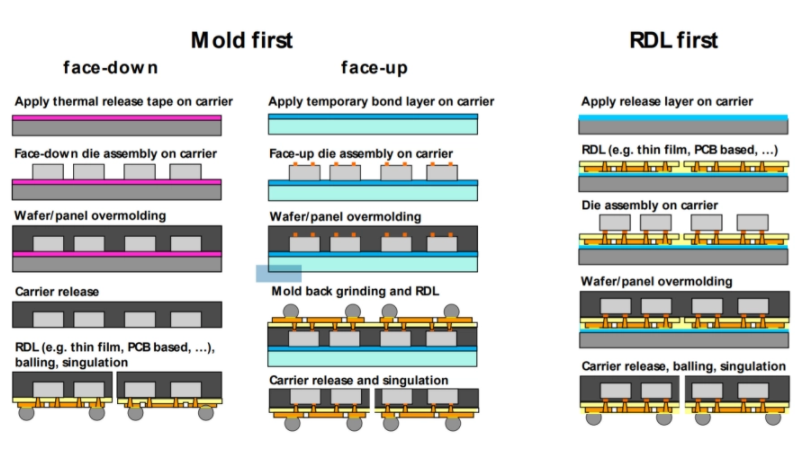
摩尔定律在制程技术中处于最后一刻,因此高级包装占据了接力棒。扇出晶圆级封装(FOWLP)等先进技术可提高组件密度并提高性能,并帮助解决芯片I / O限制。然而,成功使用这种技术的关键是从一开始就将
2021-04-01 16:44:35
 换一换
换一换
- 如何分清usb-c和type-c的区别
- 中国芯片现状怎样?芯片发展分析
- vga接口接线图及vga接口定义
- 芯片的工作原理是什么?
- 华为harmonyos是什么意思,看懂鸿蒙OS系统!
- 什么是蓝牙?它的主要作用是什么?
- ssd是什么意思
- 汽车电子包含哪些领域?
- TWS蓝牙耳机是什么意思?你真的了解吗
- 什么是单片机?有什么用?
- 升压电路图汇总解析
- plc的工作原理是什么?
- 再次免费公开一肖一吗
- 充电桩一般是如何收费的?有哪些收费标准?
- ADC是什么?高精度ADC是什么意思?
- EDA是什么?有什么作用?
- dtmb信号覆盖城市查询
- 苹果手机哪几个支持无线充电的?
- type-c四根线接法图解
- 华为芯片为什么受制于美国?
- 怎样挑选路由器?
- 元宇宙概念股龙头一览
- 锂电池和铅酸电池哪个好?
- 什么是场效应管?它的作用是什么?
- 如何进行编码器的正确接线?接线方法介绍
- 虚短与虚断的概念介绍及区别
- 晶振的作用是什么?
- 大疆无人机的价格贵吗?大约在什么价位?
- 苹果nfc功能怎么复制门禁卡
- amoled屏幕和oled区别
- 单片机和嵌入式的区别是什么
- 复位电路的原理及作用
- BLDC电机技术分析
- dsp是什么意思?有什么作用?
- 苹果无线充电器怎么使用?
- iphone13promax电池容量是多少毫安
- 芯片的组成材料有什么
- 特斯拉充电桩充电是如何收费的?收费标准是什么?
- 直流电机驱动电路及原理图
- 传感器常见类型有哪些?
- 自举电路图
- 通讯隔离作用
- 苹果笔记本macbookpro18款与19款区别
- 新斯的指纹芯片供哪些客户
- 伺服电机是如何进行工作的?它的原理是什么?
- 无人机价钱多少?为什么说无人机烧钱?
- 以太网VPN技术概述
- 手机nfc功能打开好还是关闭好
- 十大公认音质好的无线蓝牙耳机
- 元宇宙概念龙头股一览




