

不同 IGBT 架构的高效电机驱动应用
功率器件
描述
在选择 IGBT 时,设计人员面临许多架构选择,这些选择可能会偏向于一种形式的 IGBT,例如对称阻断与非对称阻断。本文将回顾不同 IGBT 架构提供的设计选项。
与具有类似额定电压的功率 MOSFET 相比,绝缘栅双极晶体管 (IGBT) 是电机驱动应用的常见选择,因为它具有高阻断电压和低成本。该技术允许设计变频驱动器,这被视为对节能系统有益。
IGBT 提供驱动重要逆变器级所需的开关能力。通常,使用 200-240 V AC电源供电的驱动器需要 600 V 的额定阻断电压,而 460 V AC应用则需要 1200 V。
IGBT 的结构从 1980 年代的功率 MOSFET 演变而来,以应对增加阻断电压的需要。这是通过在 MOSFET 架构的漏极上增加一个额外的 PN 结,创建双极晶体管结构和整体 NPNP 半导体来实现的。与当今制造的大多数功率晶体管一样,晶体管的结构是垂直的而不是水平的,PNP 双极晶体管的集电极位于管芯的背面。包含 N 掺杂阱的 AP 或 P+ tub 连接源极/发射极和栅极区域。电流流过这个槽,进入一个比较宽的 N 掺杂漂移区,进入集电极。但是,由于它具有 MOSFET 的绝缘栅极,因此该器件作为一个整体保持电压控制而不是电流控制。
虽然它通常提供比 MOSFET 更高的电压隔离,但 IGBT 的架构意味着它不能快速开关,这限制了逆变器中使用的开关频率,尽管器件结构的最新进展已将有效开关频率推向 100 kHz。IGBT 的效率通过比 MOSFET 更低的导通电压降来提高。此外,与同等 MOSET 相比,高电流密度允许使用更小的裸片达到更高的额定功率,从而提高成本效益。
早期的 IGBT 设计方法包括对称结构,也称为反向阻断架构。它们具有正向和反向阻断功能,适合交流应用,例如矩阵(AC-to-AC)转换器或三电平逆变器。非对称结构仅保持正向阻断能力,但往往比对称结构更广泛地使用,因为它们通常提供比对称 IGBT 更低的通态电压降。不对称结构适合直流应用,例如变速电机控制。然而,IGBT 电机控制应用往往涉及感性负载并且通常是硬开关,需要将 IGBT 与续流二极管并联使用,以允许反向电流在这些拓扑中流动。然而,
IGBT 的另一个区别在于穿通 (PT) 和非穿通 (NPT) 架构。PT 设计主要用于较低的隔离电压,并使用在 P+ 衬底和集电极区域上生长的 N+ 区域。当器件关闭时,N-漂移会完全耗尽载流子,这种效应会“穿透”到下面的 N+ 层,但不会完全穿过它进入集电极。结果是一个非常薄的 N 区域,可最大限度地降低开启电压。额外的 N+ 层还通过减少注入 P+ 衬底的多余空穴的数量来提高开关速度。当设备关闭时,这些载体会很快被移除。
不幸的是,高掺杂会引入大量少数载流子,需要在 IGBT 关断后去除这些载流子,这会增加开关时间,从而降低效率。这是与功率 MOSFET 相比开关频率较低的主要原因之一。PT IGBT 也可能遭受热失控。
NPT 的开发是为了避免 PT 架构的主要问题并去除 N+ 缓冲层。但是,它们经过精心设计,以避免让电场一直渗透到收集器。晶体管的制造方式通常与 PT 器件不同。与在 P 掺杂衬底顶部外延形成 N 区不同,NPT 晶体管通常使用 N 掺杂衬底制成,集电极区生长在背面。
通过将晶圆减薄至 100 µm 或更小,可以使用非常轻掺杂的集电极区,同时仍能实现低电阻和高性能。使用较轻的掺杂减少了器件在导电时可以存储在器件中的电荷量,这转化为更好的开关性能,因为在器件切换时需要杀死的载流子更少。
Fairchild Semiconductor的FGP10N60和FGP15N60使用NPT 技术支持一系列电机驱动应用。它们在 150°C 时提供高达 10 µs 的短路电阻,并表现出约 2 V 的饱和电压。为了支持高开关速度,晶体管的关断延迟时间刚刚超过 55 ns。
大约十年前,国际整流器等制造商转向了沟槽结构。沟槽架构不仅通过减小栅极和基极区域的有效直径来实现更高的沟道密度,它还增强了累积层电荷注入并减少了旧平面设计所遭受的寄生 JFET 的影响。对于给定的开关频率,与传统的 PT 和 NPT 结构相比,沟槽结构降低了传导损耗和开关损耗。沟槽 IGBT 现在可从许多供应商处获得广泛的额定值。IR 自己的范围涵盖了关键的600 V 和 1200 V阻断电压范围。
典型的器件IRGB4060是一个 1.55 V 晶体管,采用软恢复反向二极管封装,提供低至 95 ns 的关断延迟时间,以支持相对较高的开关频率。
向薄晶圆 NPT 器件添加场终止区可以进一步提高性能。有点类似于 PT 概念,该层阻止电场,允许使用更薄的晶片来获得相同的高击穿电压。通过控制场截止层和 p+ 集电极层的载流子浓度,可以提高背面结的发射极效率。因此,场停止提供了更快的开启低 V CE(sat)的设备,这可以通过更薄的晶圆实现。
场截止技术使得将许多电路中所需的续流二极管与 IGBT 本身集成起来变得更加容易。英飞凌科技的TrenchStop系列器件就是一个例子。该系列的许多成员将二极管作为核心 IGBT 元件的一部分,允许反向电流通过器件。其他公司通过将二极管集成在封装内来提供针对电机控制等应用优化的二极管技术,例如IKD06N60RF,它支持高达 30 kHz 的电机控制开关速度。

图 1:英飞凌 IGBT 向 TrenchStop 工艺的演变。
IXYS开发了多个系列的场停架构,最终形成了Gen3 和 Gen4 系列。Gen4 架构将沟槽拓扑与 Gen3 的“极光穿透”(XPT) 场截止设计相结合,支持低通态电压和快速关断的组合,从而最大限度地降低开关损耗。
这些器件具有方形反向偏置安全工作区 (RBSOA) 形状,击穿电压高达 650 V,高温下额定电流是标称电流的两倍,适合无缓冲器硬开关应用。这些器件可与反并联二极管共同封装,并具有在 150°C 下长达 10 µs 的高温短路耐用性。
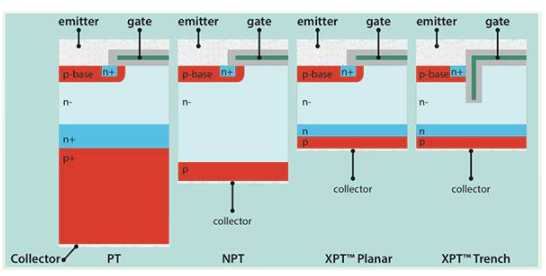
图 2:经典和 IXYS XPT 架构之间的差异。
器件结构的进一步进步(例如晶圆减薄和改进的掺杂控制和器件结构)可能会提高 IGBT 的性能,使功率 MOSFET 在高效电机驱动应用中具有激烈的竞争,尤其是在成本是关键考虑因素的情况下。
-
工业电机驱动中的IGBT过流和短路保护2018-07-30 0
-
工业电机驱动IGBT过流和短路保护2018-08-20 0
-
【案例分享】工业电机驱动中的IGBT过流和短路保护2019-07-24 0
-
全面解读工业电机驱动的IGBT2019-10-06 0
-
第7代IGBT电机驱动器的新基准资料说明2020-12-04 863
-
采用 IGBT 的电机驱动器中的噪声管理2022-11-15 205
-
什么是IGBT驱动?2023-02-07 926
-
变频器电机驱动使用什么IGBT?2023-02-19 884
-
IGBT驱动介绍2023-02-22 266
-
一文看懂IGBT驱动2023-02-23 239
-
工业电机驱动为什么需要IGBT2023-02-24 151
-
一文弄懂IGBT驱动2022-02-11 1525
-
IGBT在电机驱动中的主要作用2023-12-05 844
全部0条评论

快来发表一下你的评论吧 !

