

介绍离子注入在电容极板和湿法腐蚀自停止技术上的应用
描述
介绍了离子注入在电容极板、PN结、金属互连和湿法腐蚀自停止技术上的应用。
电容极板
在MEMS电容式压力传感器、平面硅电容器和RF MEMS开关中,离子注入均有应用。这三类电容式的器件,下极板可采用重掺注入硅衬底或重掺多晶硅,这样相较于金属作为下电极有更高的热预算。

图1 电容极板器件的示意图
PN结温度传感器
很多MEMS压力芯片上集成了温度传感器,PN结温度传感器是利用PN结在不同温度下的电学特性变化来反映温度变化。随着温度升高,PN结内部电场减弱,空间电荷区域扩散,导致逆向饱和电流增加,正向电阻下降,从而导通电流增大。一般PN结温度传感器的测试温度在-50~200°C。
在MEMS硅衬底上制造PN结温度传感器,首先在N型衬底上离子注入P型材料,并在P型区域上形成金属接触点。
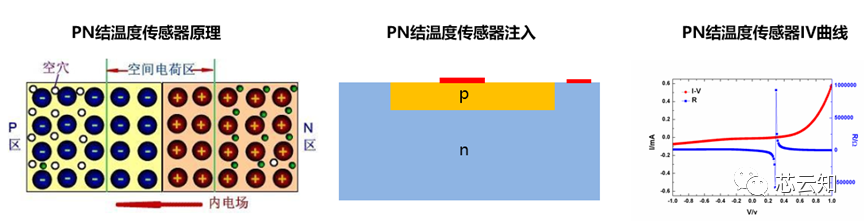
图2 PN结温度传感器示意图
金属互连
无论是电容极板还是PN结温度传感器,离子注入硅都需要将电信号引出来,这样就必须与金属形成互连,不可避免的出现金属和注入硅的接触问题。理想的欧姆接触是指,当金属与半导体通过一定条件接触在一起时,交界处没有势垒的存在,表现出低阻特性,类似纯电阻,伏安特性曲线呈线性。低浓度注入硅无法和金属形成良好的欧姆接触,对注入硅,注入浓度需要达到5E19cm-3以上。与注入硅容易形成良好欧姆接触的金属有Al,TiAl,TiPtAu,TiNiAu,TiNiVAu等,合金化温度通常在400~500°C之间。 
图3 欧姆接触前后的原理图
湿法腐蚀停止技术
离子注入常用于局部掺杂,高剂量的硼(>5E15cm-2)注入硅或多晶硅中并退火后可以形成合适的掺杂硅,这些掺杂的衬底可以作为某些各向同性和各向异性腐蚀剂的有效自停止层。重掺杂硅湿法腐蚀停止技术其原理是硅表面和腐蚀溶液之间的电子、空穴的输运能力不同,对重掺层,湿法腐蚀到该位置时,腐蚀速率减小约1到3个数量级,有利于很好地控制薄膜的厚度。
然而,实际应用过程中,重掺注入的结深有限,不可能任意控制自停止的厚度,其次重掺硅衬底在高温工艺下,重掺离子向其它位置扩散,导致电学性能受影响。因此,在实际的MEMS加工中,注入硅的自停止技术较少用到。
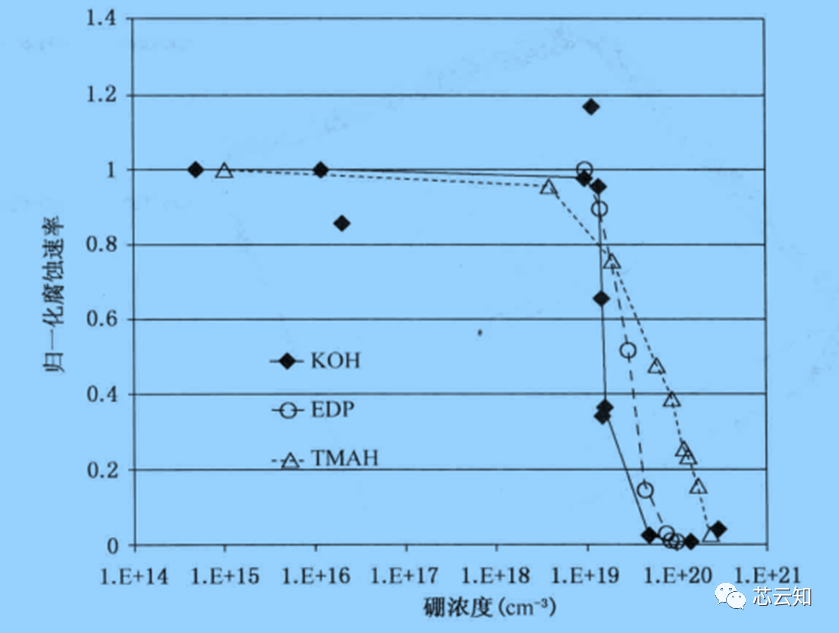
图4 硼掺杂浓度和腐蚀速率曲线

图5 硼掺杂浓度和对应腐蚀剂
审核编辑:刘清
-
铒离子注入碳化硅后的射程分布和射程离散2010-04-22 0
-
离子注入工艺资料~还不错哦~2012-08-01 0
-
离子注入技术有什么特点?2019-10-30 0
-
寻求一种Si衬底上氮离子注入的有效单项监控手段2021-04-01 0
-
离子注入技术介绍2011-05-22 4338
-
什么是离子注入技术2011-05-22 4945
-
离子注入技术原理2011-05-22 18867
-
离子注入的特点2011-05-22 4406
-
离子注入设备和方法2011-05-22 7419
-
离子注入技术2011-05-22 1569
-
离子注入高效SE电池2017-11-06 528
-
离子注入工艺的设计与计算简介2020-11-20 6592
-
什么是离子注入?离子注入相对于扩散的优点?2023-12-11 1223
-
离子注入仿真用什么模型2023-12-21 339
-
离子注入机的简易原理图2024-04-18 291
全部0条评论

快来发表一下你的评论吧 !

