

XeF2和SF6可以相互替换吗?XeF2和SF6对硅腐蚀的区别?
描述
我们知道含F的XeF2和SF6都被当做腐蚀硅的气体,XeF2常被作为各向同性腐蚀硅的气体,而SF6常和CF4搭配作为硅各向异性腐蚀的气体,那么XeF2和SF6可以相互替换吗?
XeF2和SF6能否相互替换?答案是否定的。
根本原因在于二者的反应机理不同。
XeF2是一种氟基化合物,在室温下能够自发地和硅发生化学反应,且反应速率很快。除了对各向同性腐蚀硅,还可以对Ge和SiGe进行干法腐蚀。化学反应方程式为:
2XeF2(g)+Si(s)→SiF4(g)+2Xe(g)
本反应不需要外界的能量来提高反应活化能,因此XeF2腐蚀硅具有低成本特性。同时,生产的副产物SiF4和Xe都是挥发性气体,易于排出。
SF6也是一种氟基化合物,但是在室温下几乎无法自发和硅发生化学反应,所以要借助外界的射频将SF6进行电离,得到F*游离基,4个F*游离基与Si原子结合形成挥发性的SiF4副产物离开衬底表面排出。
SF6与Si反应方程式为:
(1)SF→SFx++F*+F-+SF6*;
(2)F*+Si→SiF4↑
本反应需要射频参与,不是纯化学反应,为等离子体物理化学反应。
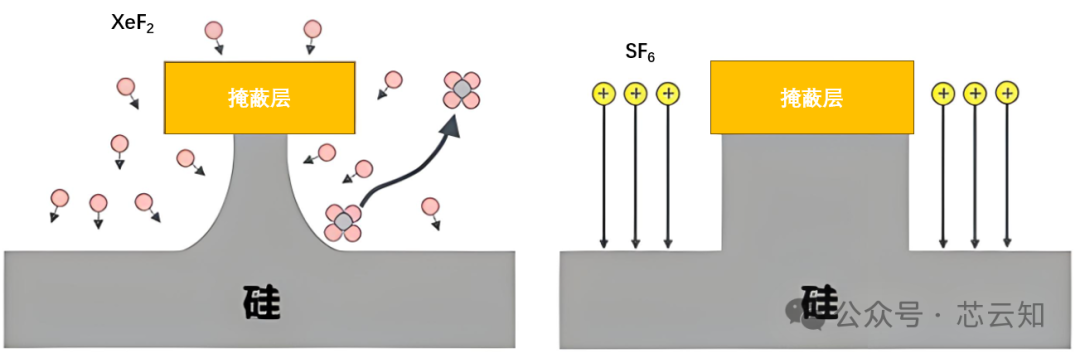
图 硅的各向同性腐蚀和各向异性腐蚀示意图
由于XeF2和SF6刻蚀硅不同的机理,因此在选择掩蔽层也有不同的方案。XeF2在与Si和SiO2纯化学反应的刻蚀选择比大于1000 : 1,而SF6在与Si和SiO2的RIE刻蚀选择一般小于100 : 1。
这就意味在深刻硅的工艺中, XeF2可以根据选择比选择合适厚度的SiO2的作为单一掩蔽层,而SF6一般不能作为DRIE的单一掩蔽层,需要与光刻胶形成复合掩蔽层。
XeF2刻蚀硅是纯化学反应,气体分子只能通过扩散和吸附在硅表面才能发生反应产生腐蚀,因此此反应具有较为明显的尺寸效应,即刻蚀尺寸越小,刻蚀速率越慢。
因此在设计芯片图形结构时,应注意不同区域的线宽和间距不相差过大。
同时XeF2刻蚀硅最优的方式是采用脉冲通气方式,对刻蚀腔室进行快速的充气和抽气,使气体分子具有更好的穿透力,能进入更小的刻蚀区域,另外快速的循环可以加速副产物的排出,从而抑制尺寸效应。
审核编辑:刘清
- 相关推荐
- 光刻胶
-
SF6气体回收充放装置产品介绍2018-05-03 0
-
导致SF6释放的危险情况2018-10-26 0
-
SF6气体管理:概述2019-02-13 0
-
SF6气体密度继电器现场检查相关问题2019-03-13 0
-
sf6综合测试仪厂家的优惠力度如何?2019-07-22 0
-
凉山州带sf6负荷开关电缆分支箱现货2019-11-12 0
-
SF6密度继电器校验仪的作用是什么?2020-10-23 0
-
SF6密度继电器校验仪介绍2020-12-10 0
-
SF6断路器实用技术2008-11-12 610
-
SF6高压电器设计2008-11-12 1127
-
高压SF6开关设备的设计与计算2008-11-12 827
-
SF6气体及SF6气体绝缘变电站的运行2008-11-15 846
-
SF6密度继电器校验仪2020-04-16 1099
-
SF6气体定性检漏仪有什么功能2021-03-10 2128
-
SF6 密度继电器氦质谱检漏法2023-12-08 218
全部0条评论

快来发表一下你的评论吧 !

