

东芝的创新型双面散热MOSFET封装DSOP Advance
描述
话说,人是铁饭是钢,一顿不吃饿得慌,食物就是人的能量来源,是生命中不可缺少的部分。对于电子产品来说,它不吃食物,吃的是电,也就是说它的能量来源是电源,电源系统是保证电子产品正常工作的源泉。随着电子产品的多样化需求和发展,不仅要求产品体积变小,而且也要它的功能要更加强大,特别是低功耗便携式产品。电源是系统中体积比较大的部件,显然,如果要将整个产品做小,留给电源的空间也不能太大,这就要求电源系统的功率密度要高,体积小,功率大。这样带来的问题是,空间变小了,热量散发不出去,很容易导致电源系统损坏。
问题出在哪儿了?
电源系统中的主开关器件是低电压功率MOSFET,这些系统需要的功率密度正在不断增加。为减小系统体积和功率损失,需要大力改进MOSFET的封装散热性。通过降低器件导通电阻和寄生电容,可降低功率损失。但是,MOSFET散热性能的改进因封装结构而有所限制。例如,传统的单面散热MOSFET通常安装有散热片,在这种情况下,器件与散热片之间的散热被封装表面的塑料模型所阻断。因此,需要较大的散热片进行有效散热。如图1所示:
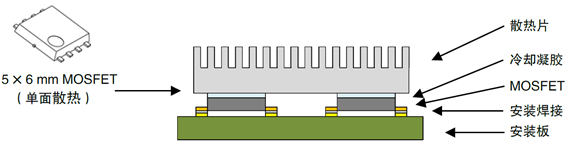
图1. 单面散热MOSFET的典型实现方案
如何解决散热问题?
为解决这一问题,东芝开发了名为“DSOP Advance”的高散热性MOSFET封装。该器件的特点是实现了双面散热的创新热传导,具体方法是在封装上下表面使用铜(Cu)板。与单面散热封装结构相比,热阻(Rth)可以降低26%,同时由于改进了热传导,雪崩能量也增加。另外,由于导通通道横截面积增加,封装电阻下降可达25%。如图2所示:
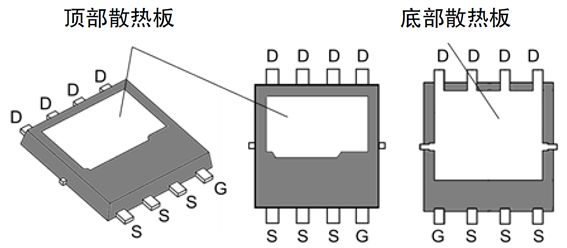
图2. 全新MOSFET封装“DSOP Advance”的结构
创新点在哪里?
竞争对手的双面散热封装在铜连接器顶部有一个独立的铜散热板,因此这种结构会在铜散热板和铜连接器之间产生界面热阻和电阻。相比之下,DSOP Advance封装只采用了一个集成连接器,所以不存在附加的界面热阻和电阻。而且由于减少了组件数,有望实现较低的制造成本。
由于在顶部增强了热传导性能,估测了DSOP Advance和带有散热器的传统单面散热结构的热阻,它比传统单面散热结构的热阻低26%。
同时,DSOP Advance和传统单面散热封装之间的雪崩能量比较,DSOP Advance的雪崩能量改进了13%。
得益于采用了最新一代的芯片(UMOSIX-H),结合DSOP Advance的厚铜连接器,对于封装电阻,传统单面散热封装、DSOP Advance和竞争对手比较,DSOP Advance的封装电阻下降25%。
本文介绍了东芝的创新型双面散热MOSFET封装DSOP Advance。使得MOSFET热阻降低高达26%,封装电阻降低25%,DSOP Advance的卓越热阻能够使外部散热片的尺寸降低。另外因结合使用UMOSⅨ-H和DSOP Advance也实现了最佳的全新功率MOSFET。此类器件有助于减小系统体积和增加系统功率密度。
-
导热双面贴在IC散热设计中的应用2013-11-09 0
-
创新型MOSFET封装:大大简化您电源的设计2013-12-23 0
-
IR新型DirectFET MOSFET2018-11-26 0
-
创新封装将功率MOSFET散热效率提升80%2010-03-01 839
-
东芝光耦 MOSFET Output2012-03-16 588
-
满足供电需求的新型封装技术和MOSFET2012-08-29 788
-
东芝推出了两款面向车载电气系统应用的新型MOSFET2019-12-26 3135
-
东芝新型高散热封装的车载40V N沟道功率MOSFET支持车载大电流设备2023-02-04 2713
-
东芝推出采用新型高散热封装的车载40V N沟道功率MOSFET,支持车载设备对更大电流的需求2023-02-06 1050
-
英飞凌推出PQFN封装、双面散热、25-150V OptiMOS™源极底置功率MOSFET2023-02-16 796
-
双面散热汽车IGBT器件热测试评估方式创新2023-03-02 3584
-
东芝推出采用新型封装的车载40V N沟道功率MOSFET,有助于汽车设备实现高散热和小型化2023-08-22 615
-
东芝推出采用新型封装的车载40V N沟道功率MOSFET2023-08-24 634
-
AOS推出创新型双面散热 DFN 5x6 封装2024-01-25 738
全部0条评论

快来发表一下你的评论吧 !

