

使用湿化学物质去除光刻胶和残留物
今日头条
1189人已加入
描述
摘要
在未来几代器件中,去除光刻胶和残留物变得非常关键。在前端线后离子注入(源极/漏极、扩展),使用PR来阻断部分电路导致PR基本上硬化并且难以去除。在后端线(BEOL)蚀刻中,除低k材料的情况下去除抗蚀剂和残留物的选择性非常具有挑战性。
介绍
光致抗蚀剂用于保护晶片的某些区域免受干蚀刻化学物质、离子注入等影响。工艺完成后,需要选择性去除光刻胶并清洁表面,确保表面无残留物和颗粒。使用湿化学物质,如热 SPM、有机溶剂或使用干等离子体“ 灰化”,原则上可以去除抗蚀剂。然而,抗蚀剂在干法蚀刻或注入处理期间被化学改性,并且适种改性可以显著降低剥离速率。
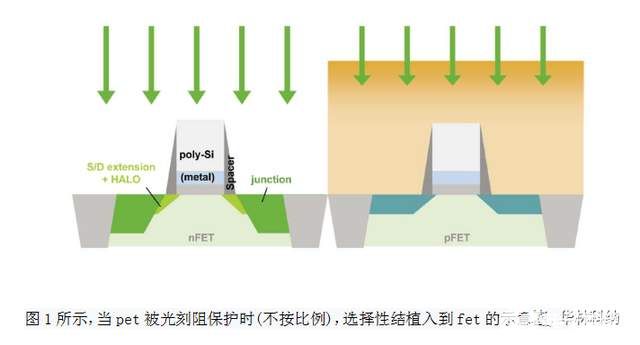
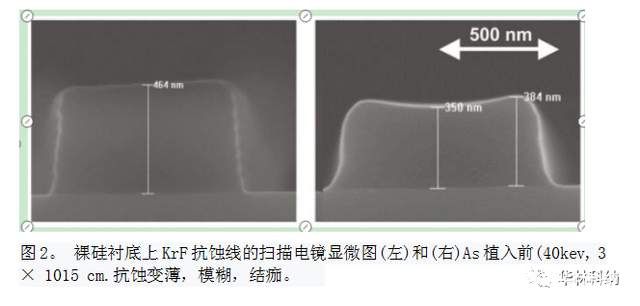
当前的方法
为了达到足够,从而达到可接受的低周期时间,以及良好的残留去除,腐蚀等离子体str ip化学与晶片加热结合使用。这些典型的inyolye等离子体是基于高度氧化的自由基。为了增强结壳带,在等离子体中加入含f的物质。然而,这些倾向于攻击暴露的氧化硅衬底。为了解决这个问题,通常采用两步工艺:含f的结壳带和无f的散装带 。

审核编辑:汤梓红
声明:本文内容及配图由入驻作者撰写或者入驻合作网站授权转载。文章观点仅代表作者本人,不代表电子发烧友网立场。文章及其配图仅供工程师学习之用,如有内容侵权或者其他违规问题,请联系本站处理。
举报投诉
-
芯片湿法刻蚀残留物去除方法2024-12-26 2476
-
光刻胶清洗去除方法2024-11-11 2929
-
负光刻胶显影残留原因2023-04-20 1668
-
干法刻蚀去除光刻胶的技术2022-07-21 8640
-
蚀刻后残留物和光刻胶的去除方法2022-07-04 11786
-
一种半导体制造用光刻胶去除方法2022-04-13 1817
-
微泡对臭氧水去除光刻胶的影响报告2022-02-11 1302
-
使用超临界二氧化碳剥离碳化光刻胶的实验2022-01-27 3362
-
《炬丰科技-半导体工艺》光刻前 GaAs 表面处理以改善湿化学蚀刻过程中的光刻胶附着力和改善湿蚀刻轮廓2021-07-06 2932
-
Mattson利用欧洲的IMEC为低k/铜工艺开发光刻胶去除技术2019-08-13 11635
-
光刻胶在集成电路制造中的应用2018-08-23 7438
-
光刻胶2018-07-12 3012
-
光刻胶残留要怎么解决?2016-11-29 31563
-
Futurrex高端光刻胶2010-04-21 4002
全部0条评论

快来发表一下你的评论吧 !

