

SOT-23封装的注意事项及PCB布局技巧
描述
传统的引线键合 SOT-23封装的功耗能力有限。由于内部结构不同,倒装芯片 (FCOL) SOT-23 封装具有更好的功耗能力。本应用笔记比较了两种封装技术,并提出了一些如何优化 PCB 布局以实现最佳热性能的实用指南。
一、简介
SOT-23 封装因其小尺寸和低成本而广受欢迎,而 6 引脚和 8 引脚版本仍然允许它们用于各种应用,例如 LDO 和开关稳压器。
SOT-23 封装的缺点之一是它们的功耗能力有限,因为这些封装没有散热垫。
JEDEC 热参考板中的标准引线键合 SOT-23-6 封装热阻显示 θ JA值(从结点到环境的热阻)约为 220 ~ 250 o C/W,这意味着在环境温度约为 55 ℃的应用中o C,0.3W 的 IC 耗散已经达到 125 o C的最大推荐结温。
在实际的 PCB 布局中,有一些方法可以增加功耗能力,通过增加连接到引脚的走线宽度,但这些措施的有效性很大程度上取决于 SOT-23 封装的内部结构。
与倒装芯片 (FCOL) 封装相比,传统的引线键合封装在热方面的表现截然不同。为了做出最佳的 PCB 布局,了解更多关于这两种封装类型的内部结构非常重要。
2.Wire-Bond SOT-23-6封装结构
下面的图 1 显示了引线键合 SOT-23-6 封装的基本结构。
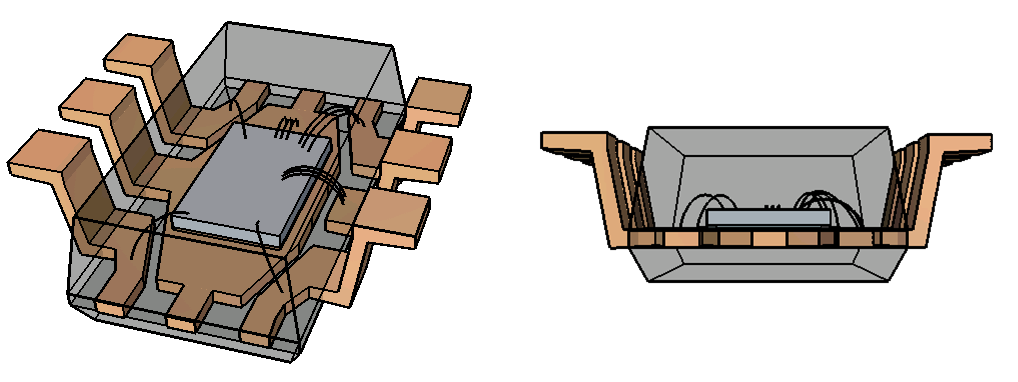
图1
硅管芯粘在中心接地引线上,管芯电气连接通过键合线连接到引线框架引脚,键合线通常是 25-38 微米的金线或铜线。
这些细线会增加关键电路节点的电阻、电感和杂散电容,从而降低高频开关转换器的性能。尤其是在更高电流的降压转换器中,键合线会在器件的总功率损耗中发挥重要作用。
细的键合线也是不良的热导体,因此引脚的大部分潜在热传递都会丢失。热传递主要是从芯片背面通过粘合剂传递到中心接地引脚,从而在中心引脚上产生热点。
图 2 显示了降压转换器应用中引线键合 SOT-23-6 封装的热图像仿真。
器件功耗设置为 0.5W。

图 2
可以清楚地看到,中心引脚的温度远高于相邻引脚。该单个引脚在将所有热量从管芯传导到 PCB 方面受到限制,并且在器件中心引脚周围形成热点。
3.FCOL SOT-23-6封装结构
下面的图 3 显示了 Flip-Chip-On-Lead SOT-23-6 封装的内部结构。
(为了清楚起见,模具是透明的)
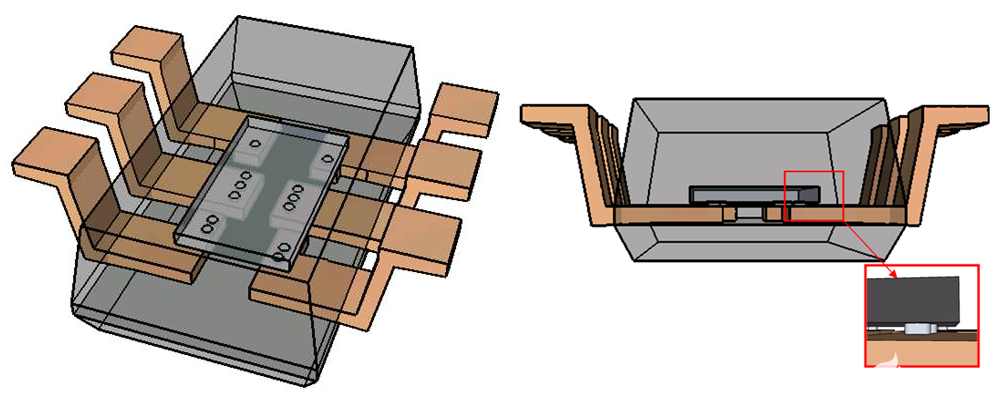
图 3
硅管芯的顶面通过柱接合安装到引线框架,提供从硅管芯到引线框架的直接热和电连接。
柱键合的短互连长度可显着降低电阻、电感和保持电容,从而最大限度地降低 I 2 R 和开关损耗,同时减少废热。
所有引脚现在都充当小型散热器,可用于高效冷却,因此从封装到 PCB 的热传递更多,从而降低芯片温度。图 4 显示了具有相同 0.5W 器件功耗的 FCOL 封装的热仿真。
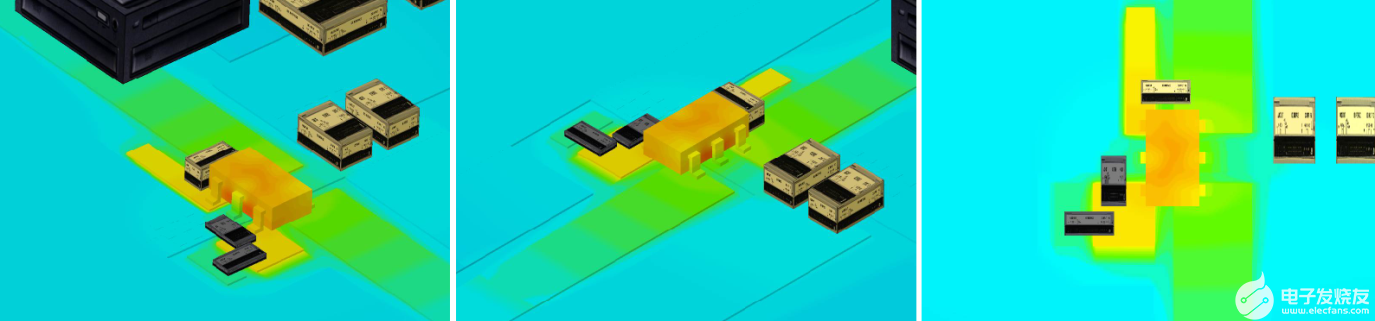
图 4
热仿真清楚地显示了 FCOL 封装对所有引脚的热传导更加均匀,并且中心引脚周围没有明显的热点。
4.SOT-23 PCB布局技巧
很明显,引线键合和 FCOL SOT-23 封装在其对器件引脚的热传导特性方面存在一些明显差异。PCB 设计人员可以利用这些知识来优化每个封装的 PCB 布局。
图 6 显示了使用RT7295C GJ6F的示例布局,它是基于立锜 ACOT® 拓扑的 FCOL SOT-23 中的 3.5A 降压转换器。(“F”后缀代表 FCOL)。简单示意图如图 5 所示。
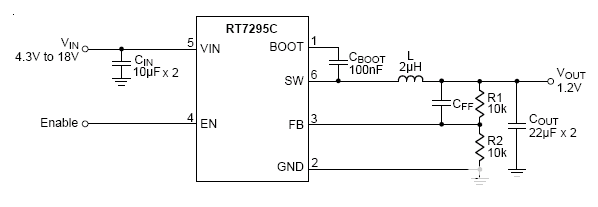
图 5
基本设置如下所示。它使用 4 层板。标准通孔用于连接内层和底层。

图 6
在图 6 的布局中,每个引脚都有额外的铜。对于 Boot 和 SW 引脚,较大的铜层可能会导致额外的辐射,因此必须做出妥协。FB 引脚对噪声拾取很敏感,因此也不能有大的覆铜面积。GND 和 VIN 引脚通过多个通孔连接到内层铜平面。使能引脚也可以有一些额外的铜并连接到底层。

图 7
PCB 横截面按比例显示过孔和内层。通孔在将热量从顶层传导到其他层方面非常有效。可以添加额外的过孔以获得更好的热传导。
下表显示了不同层的布局。

以上布局仅供参考。在某些 PCB 设计中,顶层和底层可能没有那么多空间。在这些情况下,IC 引脚可以通过通孔连接到内层的铜平面。重要的是要认识到,在 FCOL 封装中,所有 IC 引脚都是潜在的热导体,与 PCB 铜平面的良好热连接可以增强热冷却效果。
5.热测量
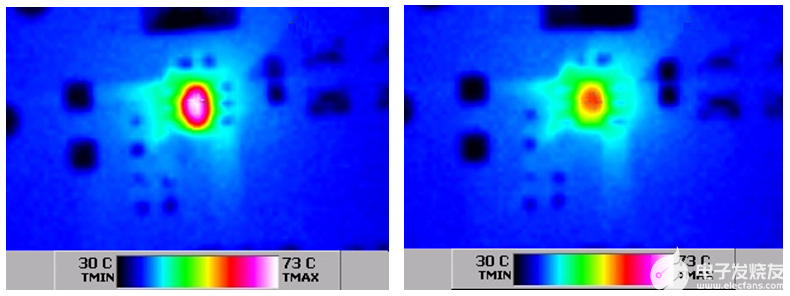
图 8
图 8 显示了两个热扫描图:左侧是标准引线键合 SOT-23-6 封装,而右侧扫描图显示的是 FCOL SOT-23-6。两款 IC 均安装在 Richtek 评估板上,器件功耗相同,约为 0.7W。根据第 4 章中提到的指南,对布局进行了优化,以获得良好的热性能。焊线 SOT-23-6 清楚地显示了一个大热点,并且扫描还显示封装左侧的引脚比引脚更热在右侧。这是因为 GND 引脚位于左侧。FCOL 封装热点比引线键合温度低 20 ~ 30 度左右,所有引脚的热传导均匀。
基于上述结果,在高度优化的布局中,FCOL SOT-23-6 封装从结到环境的热阻可以低至55 o C/W。在可用空间较小的布局中,冷却性能可能会稍差,但绝对可以实现 70~80 o C/W 的值。这使得在 60 o C 的环境条件下耗散大约 0.85W 成为可能。
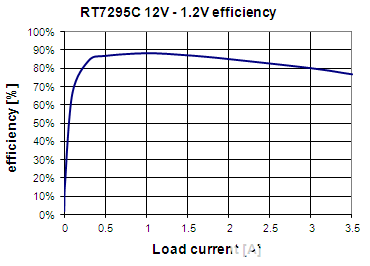
图 9
图 9 显示了RT7295C在 12V 至 1.2V 应用中的效率图。
3.1A 负载下的 IC 损耗约为 0.85W。
这意味着当RT7295C应用在热增强布局中时,该器件绝对可以提供 3A 负载电流而不会过热。
6.总结
FCOL 封装具有一些电气和热学优势。在 FCOL 封装中,每个引脚与硅芯片都有良好的热连接。可以优化 PCB 布局,让每个引脚将更多的热量从芯片传导到 PCB,从而降低从结到环境的整体热阻。与具有引线键合连接的相同封装相比,这允许在 FCOL 封装中消耗更多功率。
-
SOT-23封装20V N沟道MOSFET技术特性分析2026-05-08 81
-
电源PCB布局、布线、调试要点及注意事项2022-01-06 2558
-
UG-838:5引线SOT-23和6引线SOT-23封装的单高速运算放大器评估板2021-05-24 967
-
电路PCB布局注意事项2021-03-01 4251
-
采用SOT-23封装的SMBU风扇速度控制器2020-08-27 2353
-
关于SOT-23封装的TVS管怎么用2019-03-28 3603
-
SOT-23 FCOL封装的散热效能2018-05-23 5745
-
SOT-23封装,丝印为G2HGA,这是什么管子啊2018-01-02 4988
-
紧急求助SOT-23封装丝印1KPG3管子型号2015-06-30 2591
-
关于三极管SOT-23封装的问题2013-08-08 21753
-
pcb布局的注意事项2012-09-02 4565
-
封装SOT-23 贴片EA2 请问是什么元件2012-04-21 6918
-
SOT-23封装有哪些管2011-09-30 2194
-
sot-23封装尺寸/标准尺寸图2008-06-11 31757
全部0条评论

快来发表一下你的评论吧 !

