

 BGA焊接可靠性评价指引方案
BGA焊接可靠性评价指引方案
电子说
1.4w人已加入
描述
日常分析中,经常出现由于BGA焊接可靠性导致的工程、市场失效问题,或检出存在焊接可靠性风险的问题。鉴于BGA焊接的隐蔽性,造成失效对象品的风险较难预测,因此需要从源头便开始科学有效地评价,这也利于后续的回流工艺标准化管理,进一步为产品的质量保驾护航。基于此,新阳检测中心分享这篇技术文章,供各位讨论学习。
BGA焊接评价提案背景
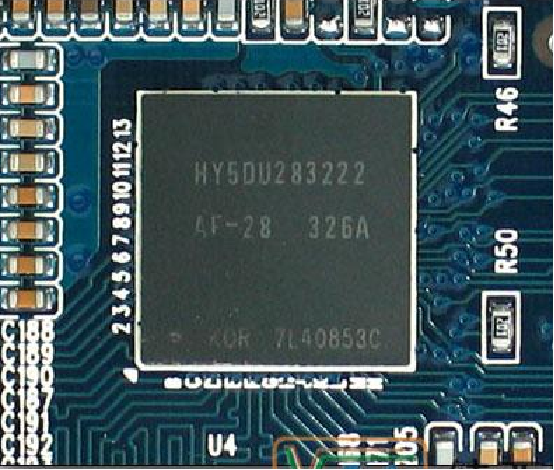
焊点成型、焊接面积、焊点开裂以及焊接强度方面存在的问题可能会带到批量阶段,对量产的品质稳定性造成影响。

从上表对常规BGA的评价方法的分析可见,BGA焊接的关键要素仅集中于枕焊分析,缺乏焊点的整体可靠性确认,特别是焊接IMC层的分析缺失,对现行回流工艺参数的评价并没有实际性的指导意义。
BGA工艺可靠性评价提案
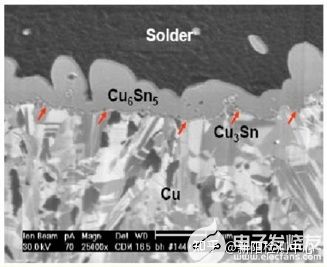
通过全面的分析,可以准确地判断是否有焊接质量隐患,现行回流工艺是否是最优状态。

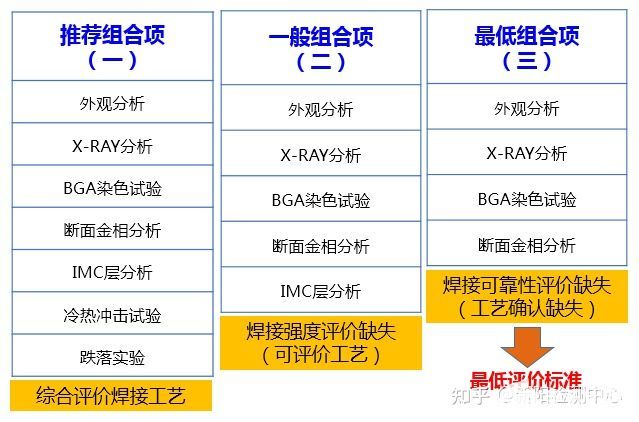

BGA评价方法说明
1.BGA染色试验

BGA染色试验:
- 可以直观的分析焊球剥离后,断面的状态;
- 缺陷清晰呈现,避免观察失误;
- 有效焊接面积可检测;
2.断面金相分析

切片断面分析:
- 可以直观的分析焊点的坍塌成型状态;
- 缺陷清晰呈现,并可做进一步的深入分析;
- 焊点微小开裂可有效检测;
3.IMC层分析(SEM)
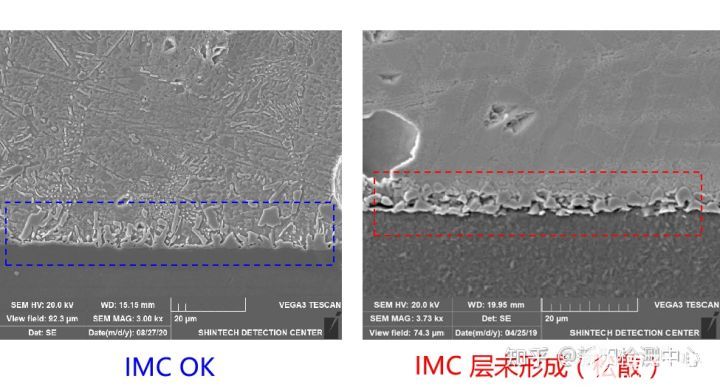
切片断面分析:
通过SEM分析,可以确认焊接IMC层形成的状态是否良好。由于IMC层的形成和回流温度、时间有直接的关系,可以通过IMC层的状态分析现行设定的回流温度是否合适。
焊接的实质是金属之间形成合金层,因此合金层的质量决定了焊点的质量。IMC层需满足的条件则有:①IMC层需连续、致密;②IMC层的厚度1.0μm-3.5μm。
4.IMC层分析(EDS)
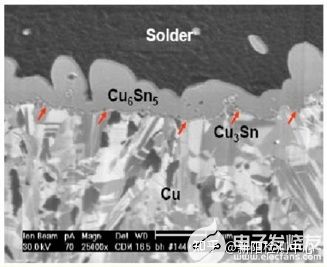



IMC层EDS分析:
通过合金层金属成分分析,可以判断合金金属元素构成比例,从而推算出合金结构,如上图(Cu6Sn5(良性IMC)、 Cu3Sn(恶性IMC) ),进而判断回流工艺的适合性。
总结
通过科学有效的分析,将BGA焊接存在的显性问题与隐性问题呈现出来,并为BGA提供可靠的焊接工艺,保障其稳定生产。
审核编辑:符乾江
声明:本文内容及配图由入驻作者撰写或者入驻合作网站授权转载。文章观点仅代表作者本人,不代表电子发烧友网立场。文章及其配图仅供工程师学习之用,如有内容侵权或者其他违规问题,请联系本站处理。
举报投诉
-
半导体集成电路的可靠性评价2025-03-04 2256
-
#硬声创作季 #可靠性 电子封装可靠性评价中的实验力学方法-1水管工 2022-09-29
-
102 改善BGA枕头效应,提高焊接可靠性车同轨,书同文,行同伦 2022-08-07
-
BGA封装的PCB布线可靠性2022-04-23 18235
-
BGA封装面临的主要技术瓶颈及可靠性2021-03-30 5482
-
BGA焊接工艺及可靠性分析2018-12-30 7105
-
输变电设施可靠性评价规程2008-09-12 778
全部0条评论

快来发表一下你的评论吧 !

