

评估1200V SiC MOSFET在短路条件下的稳健性
今日头条
描述
由于其极低的开关损耗,碳化硅 (SiC) MOSFET 为最大限度地提高功率转换器的效率提供了广阔的前景。然而,在确定这些设备是否是实际电源转换应用的实用解决方案时,它们的短路鲁棒性长期以来一直是讨论的话题。
由于相对较小的芯片尺寸,更高的短路电流密度和更小的热容意味着 SiC MOSFET 的短路耐受时间比类似额定值的硅 IGBT 短。幸运的是,最近对 1200 V、80 mΩ SiC MOSFET的一项研究表明,支持更快响应时间的正确栅极驱动设计可以保护 SiC MOSFET 免受短路损坏。本研究将讨论 1200 V、80 mΩ SiC MOSFET 的短路能力。展示和解释了在各种操作条件下执行的破坏性测试收集的结果,以及从应用和设备角度进行的设计权衡。此外,本研究的另一部分比较了各种具有去饱和保护功能的现成栅极驱动 IC 的性能。
SiC MOSFET 结构和短路能力
比较额定电流相似的 Si IGBT 和 SiC MOSFET 时,SiC MOSFET 在短路条件下的电流密度高 5-10 倍。更高的瞬时功率密度和更小的热容导致更快的温升和更低的短路耐受时间。MOSFET 饱和电流主要由沟道区的设计控制。虽然较短的沟道和较高的导通栅极电压对于降低导通电阻是可取的,但它们也会增加饱和电流并减少短路耐受时间。导通电阻和短路电流之间的这种权衡是 SiC MOSFET 设计中固有的,最好通过设计响应时间比传统 IGBT 栅极驱动更快的栅极驱动来解决。
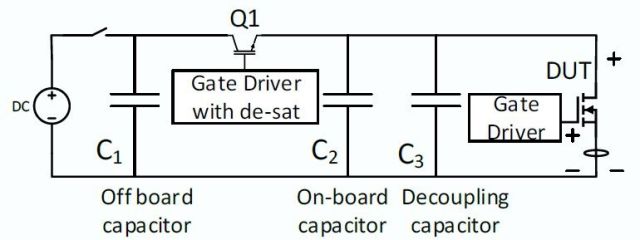 图 1a:短路测试电路原理图。
图 1a:短路测试电路原理图。
破坏性短路测试结果
测试电路(图 1a 和 1b)旨在评估 1200 V、80 mΩ SiC MOSFET(Littelfuse LSIC1MO120E0080)(图 2)在各种工作条件下的短路能力。高带宽、高电压无源探头用于测量漏源 (V DS ) 和栅源 (V GS ) 电压;Rogowski 线圈用于器件电流 (I DS ) 测量。
 图 1b:短路测试设置。一个丙烯酸外壳围绕着测试装置,以在发生灾难性的设备故障/爆炸时保护设备和实验者。
图 1b:短路测试设置。一个丙烯酸外壳围绕着测试装置,以在发生灾难性的设备故障/爆炸时保护设备和实验者。
 图 2:本次评估的被测器件是 Littelfuse LSIC1MO120E0080 系列增强型 1200 V、80 mOhm N 沟道 SiC MOSFET
图 2:本次评估的被测器件是 Littelfuse LSIC1MO120E0080 系列增强型 1200 V、80 mOhm N 沟道 SiC MOSFET
图 3 显示了 10 个样品在室温下 600 V 漏极电压和 20 V 栅极电压的短路测试结果。图 4 和图 5 显示了破坏性故障的短路耐受时间和临界能量结果。器件的结果分布紧密,短路电流约为 250 A,所有器件的短路耐受时间都大于 7 µs。
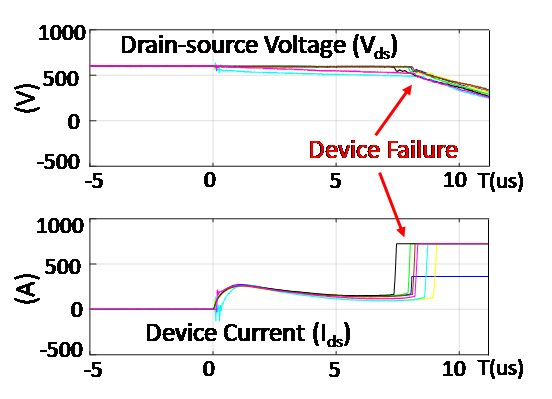 图 3:不同设备的短路测试结果
图 3:不同设备的短路测试结果
 图 4:600 V DC 漏极电压下的耐受时间
图 4:600 V DC 漏极电压下的耐受时间  图 5:600 V DC 漏极电压下的临界能量
图 5:600 V DC 漏极电压下的临界能量
图6所示为20V栅极电压下200V~800V各种漏极电压下的短路测试结果。虽然峰值电流相似,但在所有条件下250A左右,短路耐受时间从20多200 V 漏极电压为 µs,800 V 为 3.6 µs。随着直流总线电压的增加,瞬时功耗也显着增加。因此,温升更快,导致短路耐受时间更低。
图 7 显示了栅极电压为 15 V 和 20 V 且漏极电压为 600 V 的测试结果。这些结果表明峰值电流强烈依赖于栅极电压,从 20 V 栅极电压下的 250 A 降低到 100 A 15 V 栅极电压,支持设计权衡理论,关于驱动电压/导通电阻/短路峰值电流和耐受时间关系,本文前面已讨论过。已研究但证明对器件的短路耐受时间没有明显影响的其他因素是器件的外栅极电阻和环境温度。
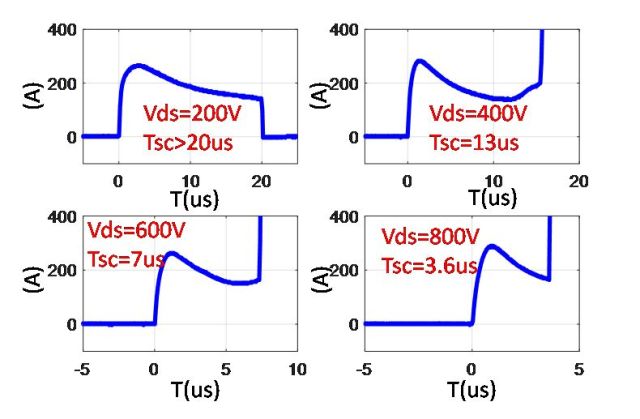 图 6:不同直流漏极电压下的短路
图 6:不同直流漏极电压下的短路
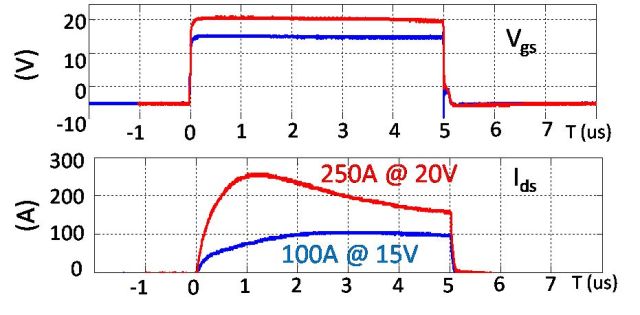 图 7:不同栅极驱动电压下的短路
图 7:不同栅极驱动电压下的短路
通过栅极驱动器 IC 去饱和保护进行短路保护
保护 SiC MOSFET 免于短路故障需要栅极驱动器检测过流情况并在其耐受时间内关闭 MOSFET。为 Si IGBT 器件开发的几种现成驱动器 IC 提供集成的去饱和 (de-sat) 保护功能,可在导通状态期间监控 V DS并在发生过流事件时关闭器件。如果驱动器 IC 响应速度足够快,则相同的驱动器 IC 可用于 SiC MOSFET 的短路保护。
图 8 显示了用于通过各种驱动器 IC 实现去饱和功能的电路。快速动作 Si 二极管 (D D )在关断状态下阻止 V DS,齐纳二极管 (D C ) 在开关转换期间保护 de-sat 引脚,电容器 (C B) 控制消隐时间以避免在开关瞬态期间误触发。图 9 显示了具有去饱和保护使能 IC 的短路事件波形。由于 SiC MOSFET 的快速开关速度和所需的优化功率回路布局,器件电压和电流在瞬态事件后达到稳态所需的时间比 IGBT 短得多。因此,基于 SiC 的设计中使用的驱动器 IC 的去饱和功能所需的消隐时间也应该更短。为了保护 SiC MOSFET,通常选择小于 100 pF的 C B并且消隐时间可以短至 200 ns,以减少驱动器 IC 的总响应时间。
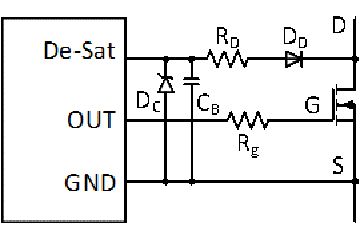 图 8:去饱和实施
图 8:去饱和实施
 图 9:去饱和保护瞬态
图 9:去饱和保护瞬态
表 1 比较了具有 33 pF 消隐电容器的不同驱动器 IC 的性能。结果表明,每个 IC 都可以在 1–4 µs 内在击穿期间保护 SiC MOSFET。它们中的每一个还具有“软关断”功能,可在短路条件下缓慢关断器件,以保护 MOSFET 和驱动 IC。
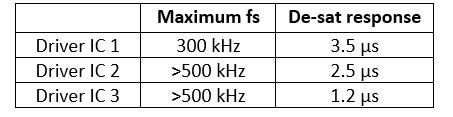 表 1:商用驱动器 IC 评估
表 1:商用驱动器 IC 评估
半桥配置中的短路保护
最后,具有最长响应时间的 SiC MOSFET 和栅极驱动器 IC 在短路条件下在单器件和半桥配置中一起进行了测试。图 9a 和 9b 显示了具有 800 V DC 总线电压的击穿瞬变期间的测试波形。在半桥配置中,顶部器件在整个瞬态期间保持开启,底部器件由具有去饱和功能的栅极驱动器驱动。
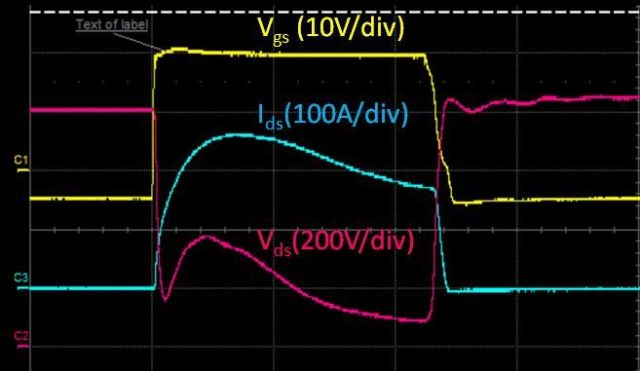 图 10a:单个设备的击穿保护
图 10a:单个设备的击穿保护
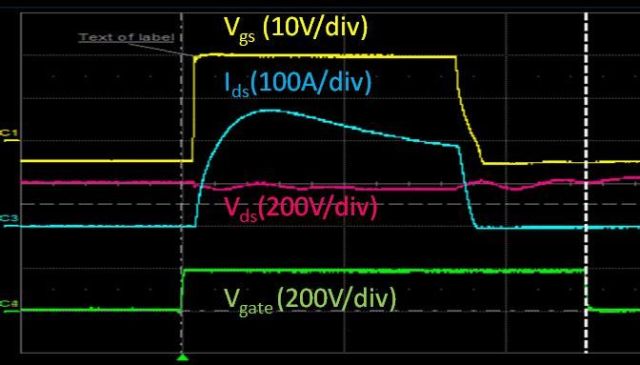 图 10b:半桥配置中的击穿保护
图 10b:半桥配置中的击穿保护
图 10 中的结果表明,在两种情况下都可以安全关闭 SiC MOSFET。结果还表明,在半桥配置中,直流母线电压由两个设备共享,每个设备的实际电压远低于直流母线电压,这为保护电路的反应时间提供了更多的裕度。如果底部和顶部器件都具有击穿保护功能,则任一器件都可以保护整个电路。
概括
本文介绍了 1200 V SiC MOSFET 的短路能力和使用现成驱动器 IC 的过流保护解决方案。讨论了几个设计注意事项,以确保准确的测量。测试结果表明,SiC MOSFET 的短路能力与漏极电压和栅极电压高度相关,但对外壳温度和开关速度不敏感。通过降低栅极驱动电压或降低总线电压可以实现更长的耐受时间,但这些解决方案会降低 SiC MOSFET 的性能。
更好的解决方案是实施过流保护以检测设备过流并安全关闭设备。具有去饱和保护的商用IGBT驱动器可以有效保护SiC MOSFET,但需要优化电路以确保去饱和保护的总响应时间足够短以保护SiC MOSFET。比较了各种具有去饱和保护功能的现成栅极驱动 IC 的性能,并展示了可以在真实短路条件下保护 1200V SiC MOSFET 的栅极驱动设计。
审核编辑:汤梓红
-
三菱电机1200V级SiC MOSFET技术解析2024-12-04 3141
-
基本半导体发布高可靠性1200V碳化硅MOSFET2019-01-17 11073
-
SiC-MOSFET的可靠性2018-11-30 4880
-
SiC MOSFET:经济高效且可靠的高功率解决方案2019-07-30 4306
-
1200V碳化硅MOSFET系列选型2020-09-24 2011
-
英飞凌推出1200V SiC MOSFET 将提高可靠性和降低系统成本2018-04-23 4478
-
雪崩下SiC MOSFET应用技术的鲁棒性评估2020-08-09 2660
-
SiC MOSFET在实际应用栅极开关运行条件下的参数变化2021-02-12 4275
-
SiC MOSFET单管在并联条件下的均流特性分析2021-03-11 4915
-
重复 UIS/短路条件下的 MOSFET 瞬态结温2022-11-14 729
-
Nexperia发布新款1200V碳化硅MOSFET2024-05-23 2083
-
瞻芯电子第三代1200V 13.5mΩ SiC MOSFET通过车规级可靠性测试认证2024-06-24 2316
-
闻泰科技推出车规级1200V SiC MOSFET2025-05-14 1537
-
1200V CoolSiC™ MOSFET评估平台:设计与应用全解析2025-12-21 803
-
1200V CoolSiC™ MOSFET评估平台深度解析2026-05-18 120
全部0条评论

快来发表一下你的评论吧 !

