

沟道工艺(Channel Process)
描述
调节 MOSFET 阈值电压的最直接的工艺方法就是对 n-MOSFET 和 p-MOSFET的沟道区分别进行离子注入,从而使其阈值电压达到预期值。另外,在沟道区为防止源漏穿通而引入的高能量离子注入,以及在栅电极形成后为减少短沟道效应而从源漏端大角度地侧面离子注入,也会对 MOSFET 的阈值电压有直接影响。沟道工艺在一定程度上还与双阱工艺相关。
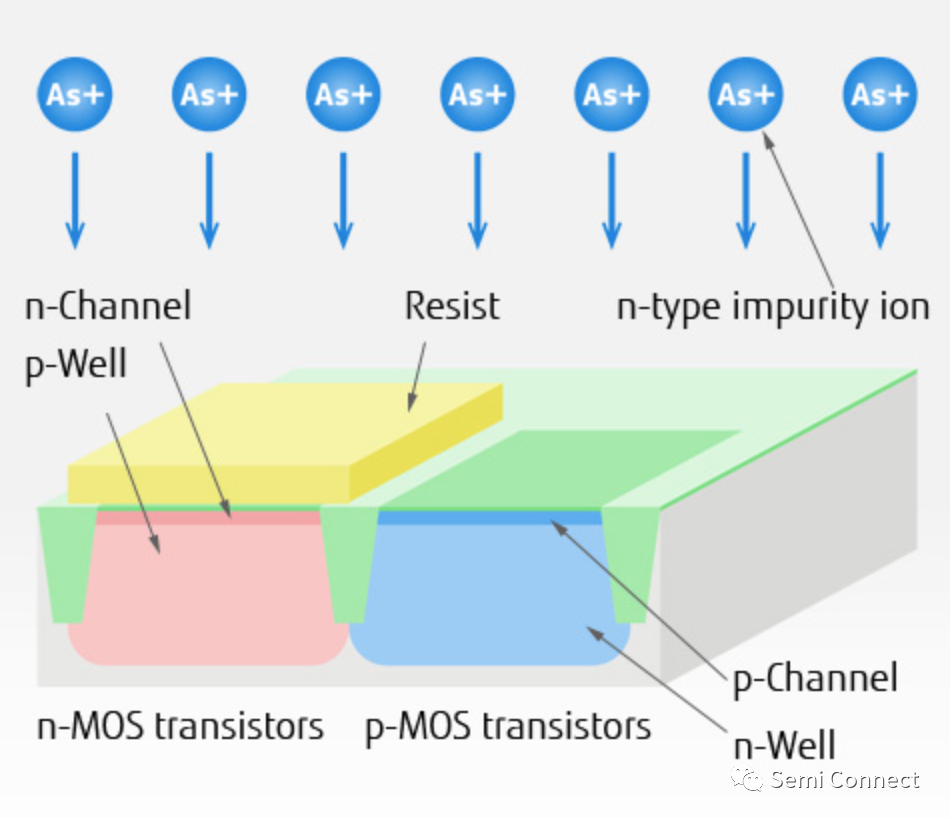
沟道工艺是集成电路的核心工艺之一,它确定了场效应晶体管的基本特性,如阈值电压、短沟道特性、噪声特性、穿通(Punch-througb)特性等,其目的是使场效应晶体管具有稳定的符合要求的电学参数,如阈值电压等。随着器件尺寸的不断缩小,出现了很多会影响阈值电压的因素,如栅氧厚度的波动,多晶硅栅长和宽度的变化,多晶硅栅的耗尽效应和掺杂的波动,侧墙的宽度,以及源漏注入 LDD 等。例如,为了改善短沟道效应,侧墙和轻掺杂漏工艺在20 世纪80 年代被引入。为了控制器件的穿通,在沟道区之间注入的基础上,也使用了大角度回转的从栅的侧面注入。接下来先后引入了氮氧化硅栅介质和高K栅介质层,以解决栅氧化层变薄引起的器件特性恶化问题。所以在一定程度上说,沟道工艺己经不再局限于沟道区的离子注入。例如,对于 40nm 以下的工艺,通过源漏锗硅(SiGe)外延对沟道区施加应力,可以提高 MOSFET 的开关速度。

由于 SoC 的应用越来越广泛,在一个集成电路中会有多种特性的场效应晶体管存在,它们工作在不同的电源电压和阈值电压条件下,同时器件尺寸(长宽)持续缩小,电源电压持续下降也导致阈值电压随之下降,这就使得器件的漏电和噪声问题变得越来越难以解决,随机因素显著增加,因此给沟道工艺带来了严峻的挑战。
审核编辑 :李倩
-
3D NAND中的Channel Hole工艺介绍2026-04-14 548
-
芯片制造中的浅沟道隔离工艺技术2025-03-03 4696
-
N沟道场效应管和P沟道场效应管有什么区别2024-09-23 8322
-
3D NAND的沟道通孔刻蚀工艺步骤2024-03-20 2919
-
场效应管怎么区分n沟道p沟道2023-09-02 15664
-
接触孔工艺(Contact Process)2022-11-22 11731
-
Fundamentals of Semiconductor Manufacturing And Process Control2021-07-26 1297
-
BRD4N60(CS4N60D)_N-CHANNEL_MOSFET_N沟道MOS晶体管2012-08-20 2207
-
MAX14850,Six-Channel Digital Isolator2012-03-28 1572
-
THS7318,pdf(3-Channel Low-Powe2010-09-27 563
-
TAS5028A,pdf(8 Channel Digital2010-09-10 706
-
NDS9410A,pdf(Single N-Channel2010-06-30 804
-
Low-Cost Single Channel AE Sys2010-03-30 1048
-
半导体工艺讲座2009-11-18 98251
全部0条评论

快来发表一下你的评论吧 !

