

PCB和QFN芯片建模过程
描述
随着电子产品的集成度越来越高,PCB板的尺寸越来越小,板级芯片散热的问题越来越成为电子工程师的一个重要挑战。 对于板级芯片散热,主要依靠工程师对 PCB自身的设计进行优化 ,同时要兼顾系统的尺寸和成本。 本文分别从芯片角度和PCB角度进行建模,芯片模型选用QFN封装,PCB模型采用走线导入模型,探讨了芯片结构,PCB铜厚,PCB叠层厚度对芯片散热的影响。
2、建模过程
为了最大程度的还原仿真对象,PCB模型采用Icepak自带PCB模型,通过导入真实的走线Trace真实模拟PCB的散热能力。 芯片也是采用Icepak自带的Package模型 对QFN封装进行详细建模。
2.1 PCB 板建模
通过ODB模型导入PCB 走线信息,并编辑PCB的叠层及铜厚:
设置板子尺寸为23X40mm
PCB铜厚为1oz(0.035mm)
PCB总叠层厚度为1.64mm
不考虑走线电流发热影响( 可通过SIwave导入,关注我后续带你分析! )
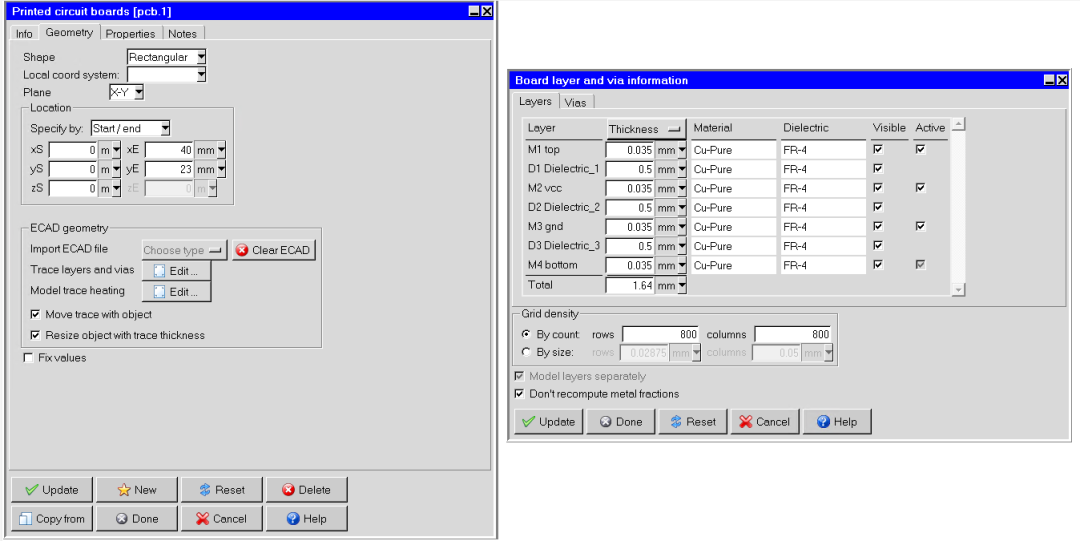
图2.1 PCB 参数和走线导入设置
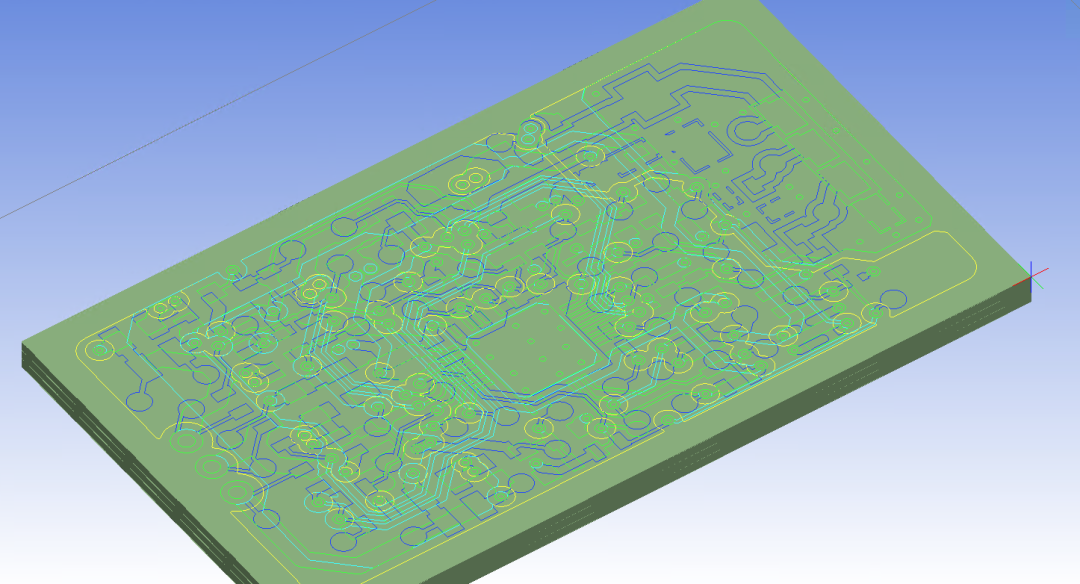
图2.2 PCB 导入走线后视图
2.2 QFN 芯片封装建模
根据数据手册尺寸设置QFN 芯片尺寸:
芯片外尺寸6x6x0.75mm
芯片Die尺寸3x3mm
散热盘尺寸5.4x5.4mm
芯片损耗为0.165w
其他按照规格书设置
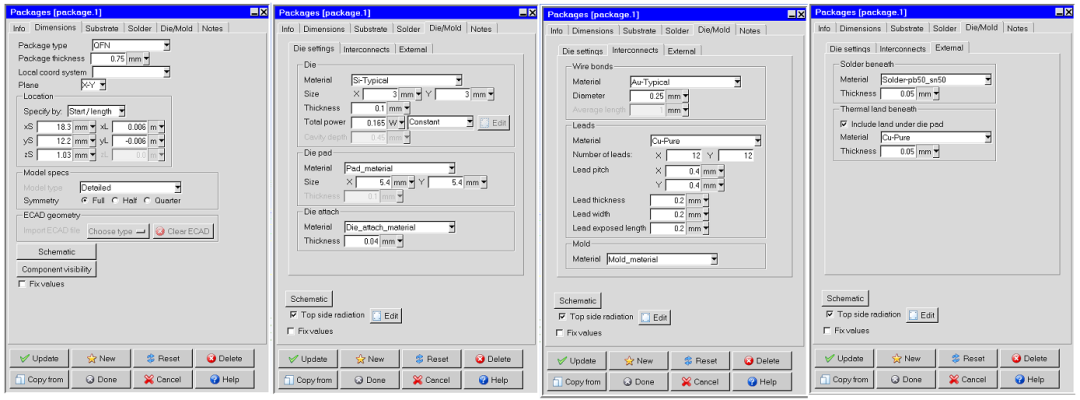
图2.3 QFN 芯片封装设置
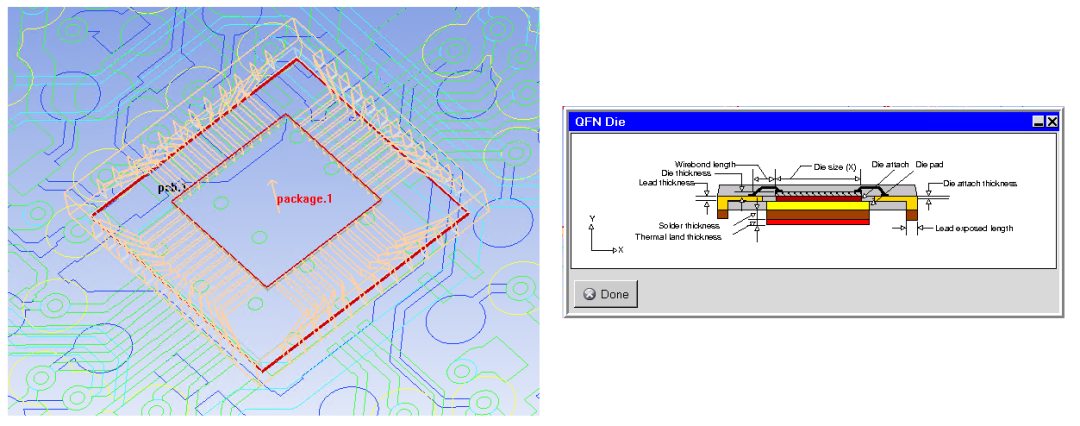
图2.4 QFN 芯片参数说明
2.3 基于热阻模型的芯片建模
使用QFN的热阻参数,建立二维热阻模型:
MinZ 为紧贴PCB的面(Bottom)
Rjc为 Junction-Case 热阻
Rjb为 Junction-Bottom 热阻,为主要传热路径
芯片损耗为0.165w
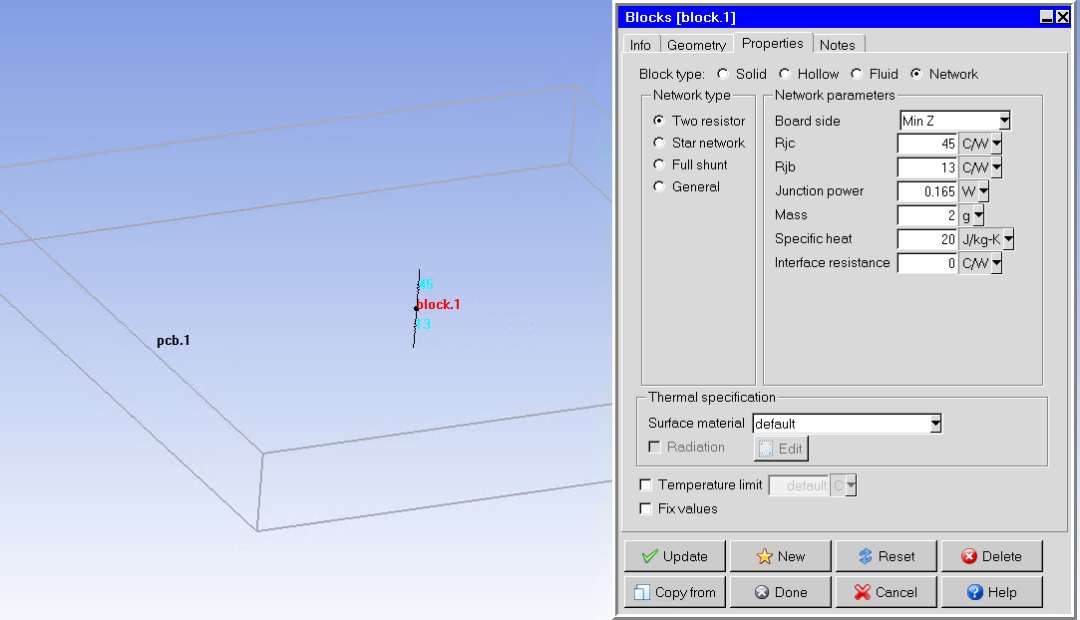
图2.5 QFN的二维热阻模型
3、仿真结果
静态PCB散热主要形式为 自然对流和辐射散热 ,通过重力模拟,和DO辐射模型对PCB进行仿真,参数设置如下:

图3.1 仿真参数设置
通过芯片和PCB的详细建模,可以获得散热模型的各种散热细节的仿真结果:

图3.2 PCB 表面散热云图

图3.3 PCB 内层散热云图

图3.4 PCB 周边自然对流情况
对仿真结果进行处理和分析:
| 仿真序号 | 仿真条件 | 仿真温度 | 温升 |
|---|---|---|---|
| --------------------------------------------------------------------------------- | |||
| 1,102 | 20C,Pdis=0.165W,真实QFN模型; 铜厚1oz,叠层绝缘层0.5mm | 56.8摄氏度 | 36.8摄氏度 |
| - | - | - | - |
| 2,104 | 20C,Pdis=0.165W, 热阻QFN模型 ; 铜厚1oz,叠层绝缘层0.5mm | 59.3摄氏度 | 39.3摄氏度 |
| 3,105 | 20C,Pdis=0.165W,真实QFN模型; 铜厚2oz ,叠层绝缘层0.5mm | 43.9摄氏度 | 23.9摄氏度 |
| 4,106 | 20C,Pdis=0.165W,真实QFN模型; 铜厚2oz ,叠层绝缘层0.25mm | 36.2摄氏度 | 16.2摄氏度 |
| 5,107 | 20C,Pdis=0.165W,真实QFN模型; 铜厚1oz,叠层绝缘层0.5mm,PCB倒立放置 | 57.0摄氏度 | 37.0摄氏度 |
| 6,108 | 20C,Pdis=0.165W,真实QFN模型; 铜厚1oz,叠层绝缘层0.5mm,侧面0.1m/s风冷 | 54.7摄氏度 | 34.7摄氏度 |
由上述仿真结果看出:
真实的QFN模型和热阻模型温度偏差不大,通过使用热阻模型可以简化建模过程
增加PCB 铜厚可以大幅度降低芯片温度,但是成本增加
减少PCB 叠层厚度能够降低芯片温度,成本几乎不变
PCB的摆放角度对芯片温度有一定影响,但是影响有限
微弱的空气对流,对芯片温度影响不大
小结
本文通过对PCB和QFN芯片建模,模拟的多种工况条件下的芯片散热,其中影响PCB散热最直接的因素为 PCB叠层厚度和走线铜厚 !
-
QFN封装的组装和PCB布局指南2010-07-20 7100
-
求各位高手相助 关于PCB设计中QFN封装芯片的问题2012-10-11 16157
-
什么是小间距QFN封装PCB设计串扰抑制?2019-07-30 2507
-
大家焊接QFN芯片有什么妙招吗?2020-10-11 3893
-
基于PSO和SVM的发酵过程建模与优化控制2009-08-31 706
-
软件过程建模方法研究2009-10-31 883
-
如何在 QFN 封装芯片的 PCB 设计上得到尽可能好的串扰性能(中文讲解视频 + PPT下载)2017-04-18 606
-
过程系统建模与仿真.pdf2018-05-19 2234
-
适用于DA4580蓝牙芯片的QFN40芯片尺寸及推荐PCB封装资料免费下载2021-02-02 3189
-
小间距QFN封装PCB设计串扰抑制的分析2021-11-10 3602
-
小间距QFN封装PCB设计串扰抑制分析2022-11-04 821
-
技术资讯 | 通过倒装芯片 QFN 封装改善散热2023-03-31 3856
-
UC3825A芯片建模过程2023-07-13 3908
-
sMT贴片加工过程中,QFN,QFP芯片短路原因分析2024-02-04 4530
-
HotRod™ QFN封装PCB附件2024-08-26 445
全部0条评论

快来发表一下你的评论吧 !

