

集成电路封装的分类与演进
描述
来源:
集成电路封测是集成电路产品制造的后道工序,包含封装与测试两个主要环节。集成电路封装是指将集成电路与引脚相连接以达到连接电信号的目的,并使用塑料、金属、陶瓷、玻璃等材料制作外壳保护集成电路免受外部环境的损伤。集成电路封装不仅起到集成电路芯片内键合点与外部进行电气连接的作用,也为集成电路提供了一个稳定可靠的工作环境,使集成电路能够发挥正常的功能,并保证其具有高稳定性和可靠性。集成电路封装质量的好坏,对集成电路总体性能影响较大。 一、集成电路封装的分类 由于不同集成电路产品电性能、尺寸、应用场景等因素各不相同,因此造成封装形式多样复杂。根据是否具有封装基板以及封装基板的材质,集成电路封装产品可以分为四大类,即陶瓷基板产品、引线框架基板产品、有机基板产品和无基板产品。其中陶瓷基板产品、引线框架基板产品和有机基板产品都可以分为倒装封装和引线键合封装两种方式,而无基板产品又可具体分为扇出型封装(Fan-out)和扇入型晶圆级芯片尺寸封装(Fan-inWLCSP)两类。
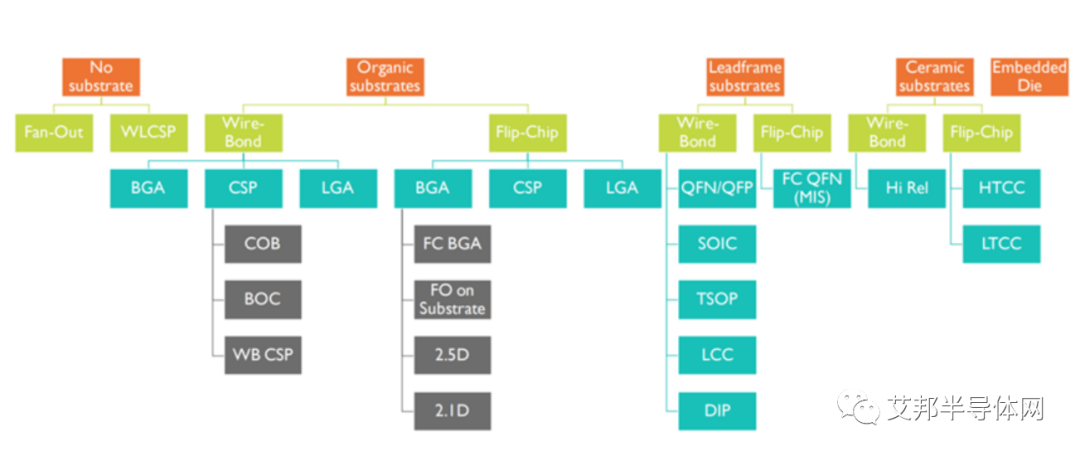
△集成电路封装形式的分类,来源:Yole 在业内,先进封装技术与传统封装技术主要以是否采用焊线(即引线焊接)来区分,传统封装一般利用引线框架作为载体,采用引线键合互连的形式进行封装,即通过引出金属线实现芯片与外部电子元器件的电气连接;而先进封装主要是采用倒装等键合互连的方式来实现电气连接。先进封装利用先进的设计思路和先进的集成工艺,对芯片进行封装级重构,并且能有效提升系统的功能密度。相较于传统封装形式,先进封装的主要优点有封装集成度高、封装体积小、内部连接短,且系统性强、功率密度高等,迎合了集成电路微小化、复杂化、集成化的发展趋势。
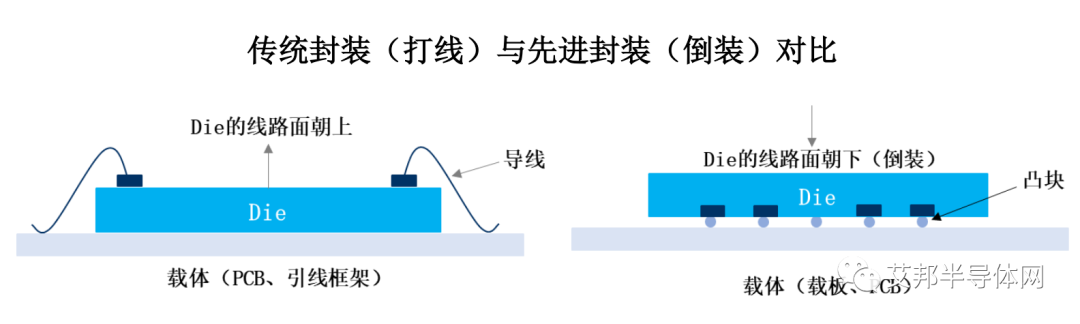
二、集成电路封装技术的演变 集成电路封装技术经过数十年来的发展和演变,总体可归纳为从有线连接到无线连接、从芯片级封装到晶圆级封装、从二维封装到三维封装,具体的技术演变可大致分为以下五个阶段:
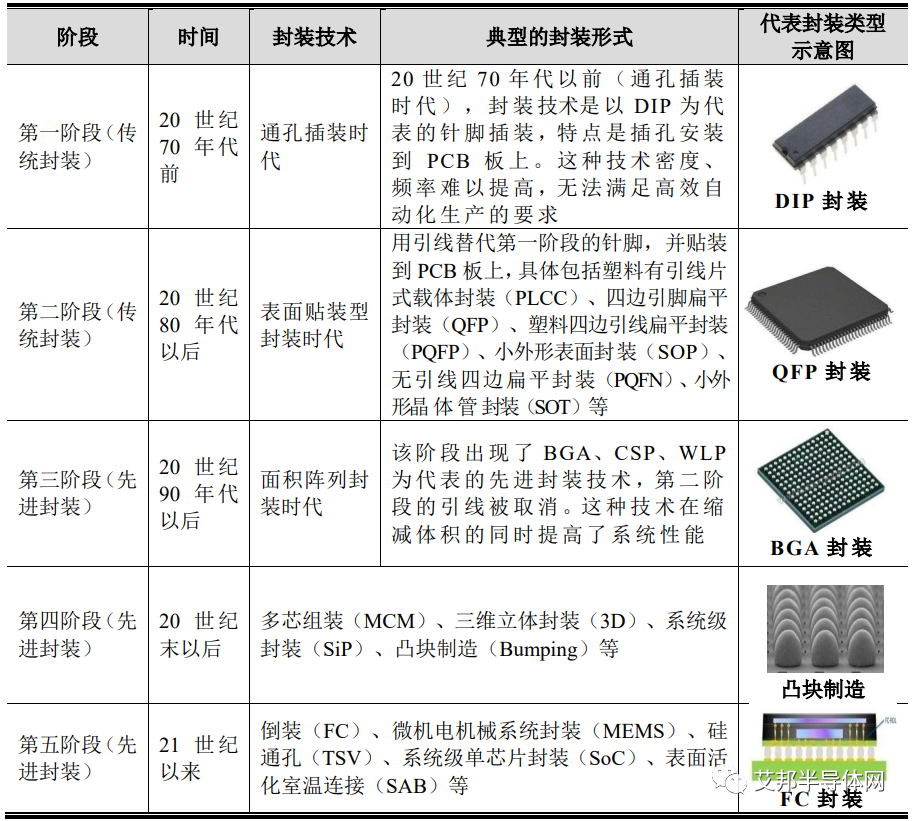
从第三阶段起的封装技术可统称为先进封装技术。目前全球半导体封装的主流仍处在第三阶段的成熟期和快速发展期,CSP、BGA、WLP等主要先进封装技术进入大规模生产阶段,同时向以系统级封装(SiP)、倒装(FC)、凸块制造(Bumping)、硅通孔(TSV)为代表的第四、第五阶段发展。而中国大陆封装企业目前大多数以第一、第二阶段的传统封装技术为主,例如DiP、SOP等,产品定位中低端,技术水平较国外领先企业具有一定差距。
-
不同维度下半导体集成电路的分类体系2025-12-26 1293
-
集成电路按照实现工艺分类可以分为哪些?2023-08-29 4467
-
半导体集成电路封装的技术层次和分类详细介绍!2022-12-16 5508
-
集成电路分类有哪些2022-02-01 9345
-
集成电路的封装形式有哪几种?2021-11-02 4205
-
什么是集成电路?集成电路的分类2021-07-29 3825
-
集成电路的分类2019-10-12 10587
-
集成电路电源芯片的分类及发展2018-10-18 4808
-
集成电路的分类有几种2018-08-28 51083
-
一文解读集成电路的工作原理(集成电路的组成及封装形式)2018-03-04 51895
-
集成电路是什么_集成电路封装_集成电路的主要原材料2018-01-24 31100
-
集成电路封装技术专题 通知2016-03-21 4004
-
TTL集成电路分类和性能参数简介2010-03-08 4488
-
集成电路的分类2009-03-09 7306
全部0条评论

快来发表一下你的评论吧 !

