

一文详解封装互连技术
描述
封装互连是指将芯片I/0端口通过金属引线,金属凸点等与封装载体相互连接,实现芯片的功能引出。封裝互连主要包括引线键合( Wire Bonding, WB)载带自动键合(Tape Automated Bonding,TAB)和倒裝焊 (Flip Chip Bonding)。
1.引线键合 ( WB)引线键合技术包括超声热压球焊技术和超声楔北焊接找术两种。超产热压球焊技术是指使用金属焊线,在外壳、基板或引线框架端加热的东件下,通过设备牌头施加的压力及超声波,利用陶监骘刀使金屬焊线与志片电板、金属焊线与外壳、基板或引线框架端子连接,以达到功能的输人与输出的一种封装技术。
超声楔形焊接技术是指使用金属焊线(通常是铝线或铝带等),通过设备惧头施加的压力及超声波,利用金属楔形劈刀使金属焊线与芯片电极、金属焊线与外壳、基板或引线框梁端子连接,以达到功能的输人与输出的一种封裝技术。
金属焊线包括纯金线、镀钯铜线、银合金线、纯铜线、铝线、铝带等。
金属焊线的选择取决于产品需要焊线承载的电流大小、成本的高低,以及芯片电极区铝层的厚度、耐蚀性等因素
下图所示为超声热压球焊引线键合产品局部图。

2. 载带自动键合 (TAB)
载带自动键合技术是指利用超声热压焊接机,将芯片上的凸点与载带上的焊点焊接在一起,再对焊接后的芯片进行密封保护的一种封装技术,如下图所示。
TAB 的关键工艺包括芯片凸点制作、载带制作,以及内引线、外引线的悍接和包封。
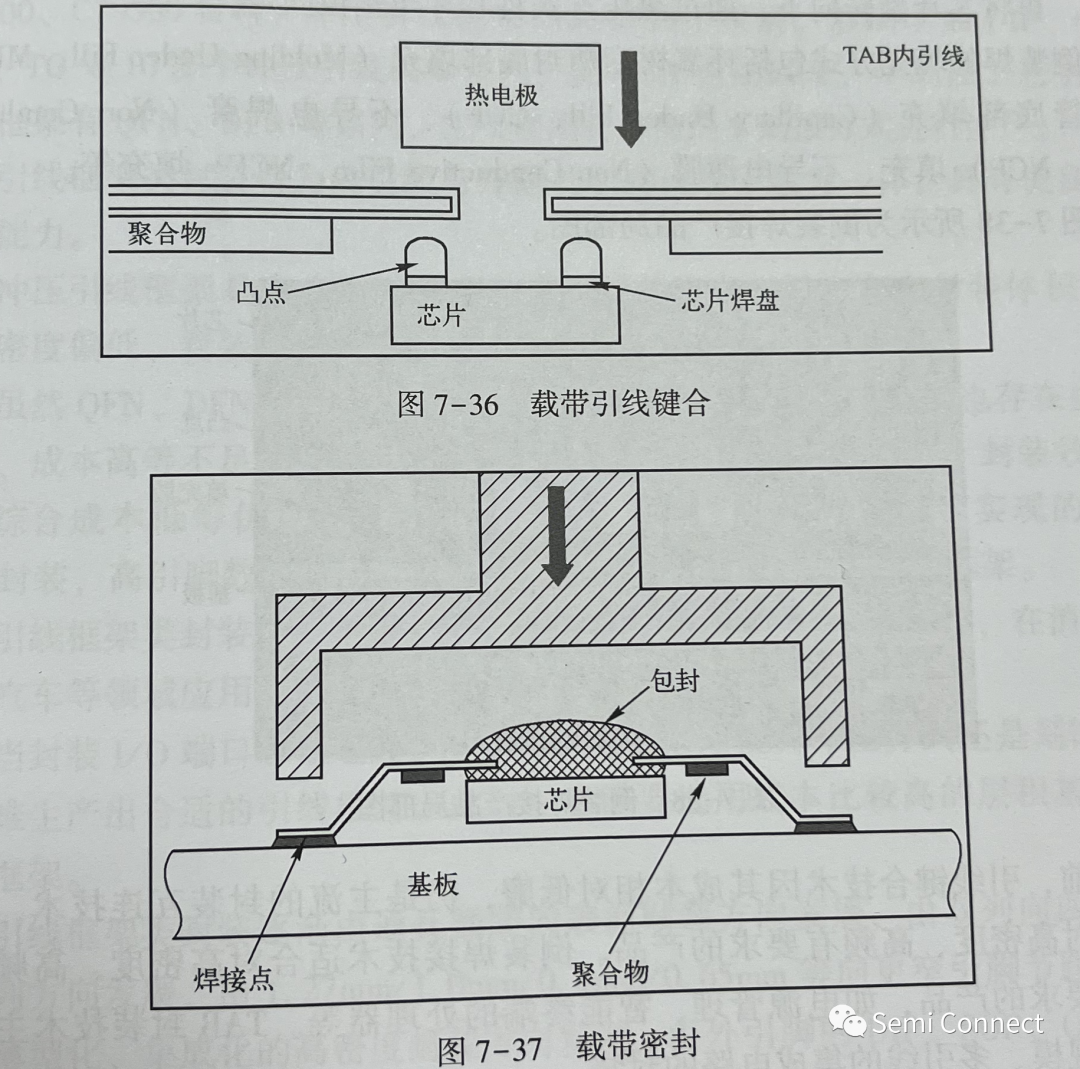
对载带材料的要求 是高温性能好、热匹配性好、收缩率小、机械强度高;典型的芯片表面凸点材料为金或金合金。
载带自动键合的优点是,结构轻、薄、短、小;密度高;具有更好的电性能;键合点抗键合拉力比引线键合的高。
3.倒装焊
倒装焊按技术是指在芯片的电极上预制凸点(Bump),再将凸点与基板或引线框架对应的电极区相连,以达到功能的输人与输出的一种封装技术。
芯片表面凸点种类包括铜柱 (Cu Prillar)、焊锡球(solder Ball)、金凸点(Au Bump) 等。焊接方式包括回流焊接和热压焊接 (Thermal Compression Bond,TCB)两种方式。
铜柱和焊锡球的焊接方法是,将芯片翻转向下,在铜柱、焊锡球表面蘸取水洗型或免洗型助焊剂,通过回流焊接方式将芯片与基板或引线框架固定;金凸点的焊接方法是,在基板上涂覆 NCP 材料,或者将 NCF材料涂敷在凸点圆片表面,再将芯片翻转向下,通过热压方式将芯片 与基板固定。
倒装焊的填充方式包括环氧树脂塑封底部填充 ( Molding Under Fill, MUF)、毛细管底部填充(Capillary Under Fill, CUF)、不导电焊膏 (Non ConductivePaste, NCP)填充、不导电薄膜 (Non Conductive Film, NCF)填充等。
下图所示为倒装焊接产品局部图。
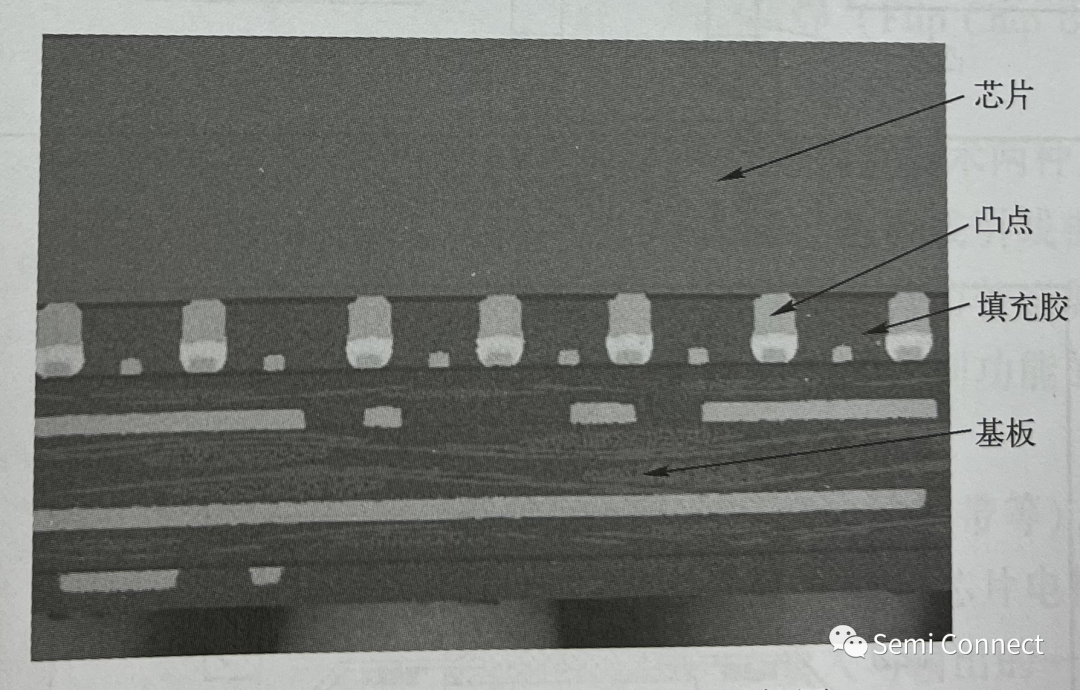
目前,引线键合技术因其成本相对低廉,仍是主流的封装互连技术,但它不适合对高密度、高频有要求的产品。倒装焊接技术适合对高密度、高频及大电流有要求的产品,如电源管理、智能终端的处理器等。TAB 封装技术主要应用于大规模、多引线的集成电路的封装。
审核编辑:汤梓红
-
一文详解铜互连工艺2025-06-16 4998
-
一文详解封装制程工艺2023-02-06 7614
-
一文详解半导体封装的封装互连技术2023-02-20 2713
-
一文详解硅通孔技术(TSV)2024-01-09 24083
-
一文详解封装缺陷分类2025-07-16 2884
-
芯片封装键合技术各种微互连方式简介教程2012-01-13 39550
-
请问Ultrascale FPGA中单片和下一代堆叠硅互连技术是什么意思?2020-04-27 2417
-
IGBT功率模块封装中先进互连技术研究进展2022-05-06 1058
-
一文详解精密封装技术2022-12-30 2701
-
一文详解封装互连技术2023-02-23 2688
-
一文详解分立元件门电路2023-03-27 5097
-
一文详解pcb和smt的区别2023-10-08 6010
-
一文详解pcb的msl等级2023-12-13 17015
-
基于FFmpeg解封装WMV和M4V格式2026-01-21 820
-
一文详解封装基板的制备工艺2026-01-27 1057
全部0条评论

快来发表一下你的评论吧 !

