

倒装芯片球栅阵列工艺流程与技术
描述
目前,FC-BGA 都是在C4 的设计基础上,再进行封装与工艺技术的设计与研发的。
FC-BGA 的结构与外形如图所示
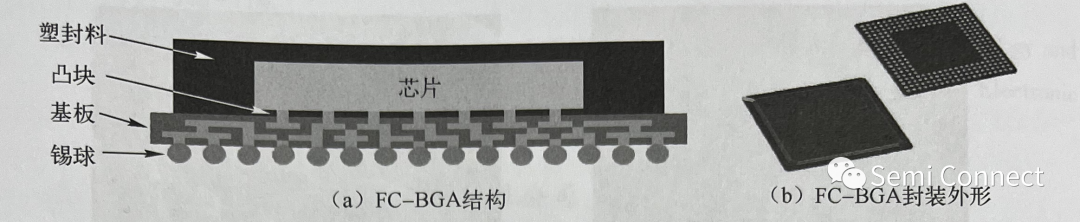
FC-BGA 是将芯片倒装在有机基板 上,在芯片输出端的电极上制作金属凸块,再将金属凸块焊接在有机基板上的。 依据产品应用的不同,目前金属凸块分别有金属钉头、金凸块、锡凸块及铜桂凸块等。 依据不同凸块的种类与应用:芯片输出端的凸块间距也会有所不同。
倒装(FC)工艺所需的金属凸块有很多种。 目前比较流行的锡凸块 FC-BGA 封装关键工艺流程如图所示。
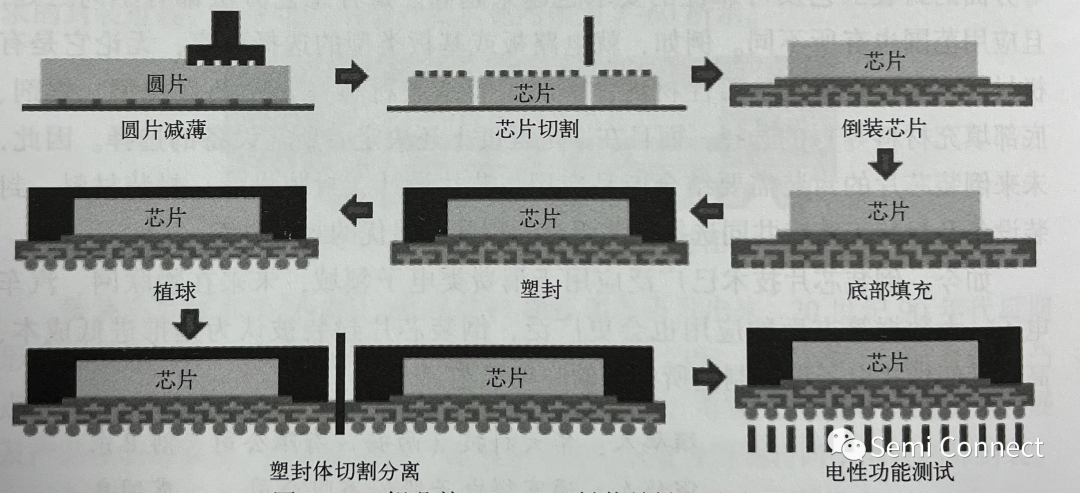
在FC-BGA 封装关键工艺流程中,圆片减薄、倒装芯片和底部填充是3个关键工序。
1.圆片减薄
凸块圆片减薄 ( Wafer Grinding with Bump) 就是根据产品应用及封装结构的要求,将圆片的厚度研磨到需要的厚度,如图所示。 在倒装芯片的工艺中,圆片来料上已经完成了凸块的制作,因此圆片正面并不平整。 由于圆片设有凸块的区域是空心结构,所以在研磨过程中,圆片会产生振动,容易造成圆片龟裂甚至破片,尤其是超薄园片的研磨更有风险。 为了解决有凸块不平整的研磨问题,大部分的研磨会采用底部填充工艺技术,使圆片正面能够保持平整,从而保证研磨过程的稳定。 目 前采用这种填充技术可将圆片厚度研磨至小于 200 μm。

倒装芯片 ( Flip Chip)
这是一种高精度的表面贴装技术(SMT),是将芯片翻转 180°形成芯片与锡凸块面朝下,并采用高精度坐标对准技术,将芯片锡凸块焊接在高密度线路基板上,如图所示。
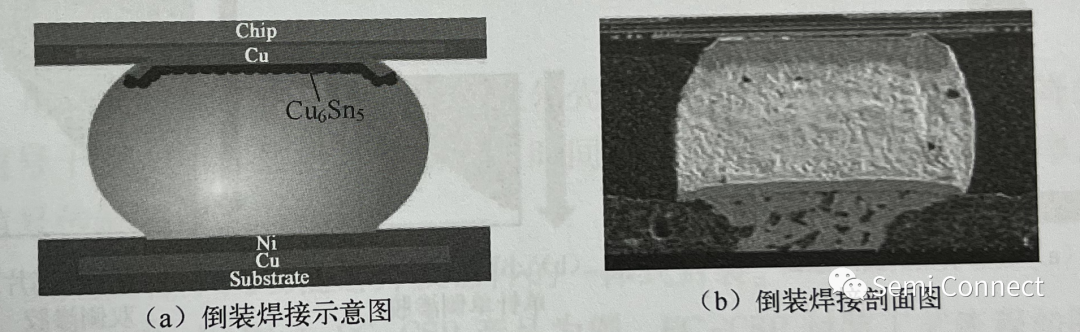
在芯片倒装工艺中,比较常用的焊接方法是高温熱压板焊接法与高温回流焊接法。
高温热压板焊接法就是在芯片上方采用热板直接传导热量到锡球,使锡球与锡膏软化,再与基板进行焊接,待冷却后形成年固的倒装焊接,如图所示。
高温回流焊接法是将芯片放置在基板上,再将基板放置于高温回流炉中,利用封闭式高温回流炉进行问接加热,将热量传导到锡球上,使锡球与锡齊同时软化,待冷却后形成牢固的倒装焊接,如图所示。
在倒装芯片作业过程中,在各方应力相互拉扯下,基板很容易产生翘曲现象,这会造成焊接出; 现偏移、冷焊、桥接短路等质量问题。
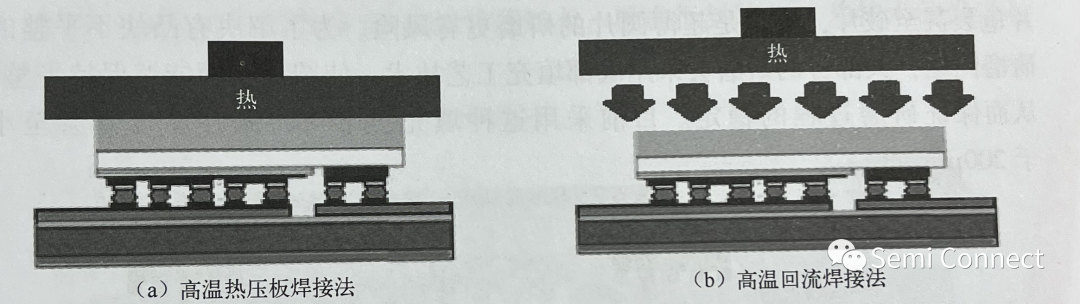
3.底部填充 ( Under Fill )
底部填充就是在芯片、锡凸块及基板了种材料之间填充底部填充料,以避免3种材料因膨账系数(CTE)不同而产生剪应力破坏。 底部填充涉及流体力学、化学、热力学及应力学等知识,其关键因素是黏度、温度、流动长度与时间。 常见的底部填充方法有毛细渗胶法 与异方性焊按法。 目前比较常用的是毛细滲胶法,如图所示。 依据芯片面积与填充空间的不同,毛细渗胶法又分为单针单侧滲胶法与双针双侧渗胶法。
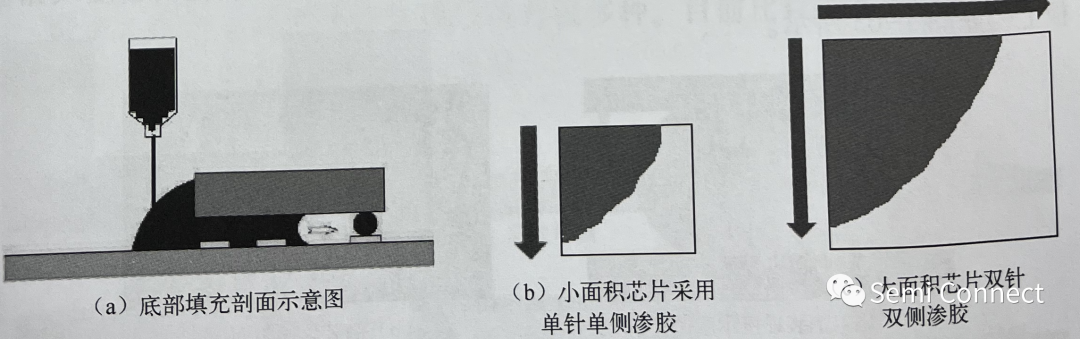
审核编辑:汤梓红
-
什么是倒装芯片 倒装芯片技术的优点 倒装芯片封装工艺流程2023-07-21 8611
-
芯片底部填充工艺流程有哪些?2024-08-09 3084
-
INTEL芯片制作工艺流程2009-09-21 90042
-
倒装晶片的组装工艺流程2018-11-23 4930
-
倒装芯片应用的设计规则2019-05-28 3157
-
倒装芯片的特点和工艺流程2020-07-06 14382
-
芯片制造全工艺流程解析2020-12-28 19165
-
芯片生产工艺流程是怎样的?2021-06-08 11903
-
芯片封装工艺流程-芯片封装工艺流程图2008-05-26 8640
-
芯片制造工艺流程步骤2021-12-15 46672
-
封装工艺流程--芯片互连技术2022-12-05 2489
-
倒装芯片球栅阵列工艺流程与技术2023-04-28 11522
-
倒装焊与球栅阵列封装:电子行业的关键技术2023-05-18 4064
-
芯片印刷工艺流程.zip2022-12-30 826
-
FCCSP与FCBGA都是倒装有什么区别2024-11-16 6987
全部0条评论

快来发表一下你的评论吧 !

