

扇出型圆片级封装工艺流程与技术
制造/封装
描述
扇出型圆片级封装(FoWLP)是圆园片级封装中的一种。相对于传统封装圆片级封装具有不需要引线框、基板等介质的特点,因此可以实现更轻、薄短、小的封装。扇出型圆片级封装也可以支持多芯片、2.5D/3D 和系统级封装(SP)。扇出型圆片级封装可以彻底去除芯片和封装的连接环节(既不需要打线,也不需要凸块),因此不仅可以实现最薄的封装,还因减少了一个可能的失效点而提高了封装的可 靠性。同时,由于信号进人芯片的线路更短,也具有更好的电性能。圆片级封装可以通过采用比传统封装更细的线路实现高密度的封装再布线,因此能够在实现封装小型化的同时,提供更高的带宽,从而更加适应先进技术节点芯片的封装。
eWLB (Embedded Wafer Level Ball Grid Arrar)是目前量产规模最大的扇出型圆片级封装,其生产工艺流程如图所示(图中有黑色框的工序为关键工序)。
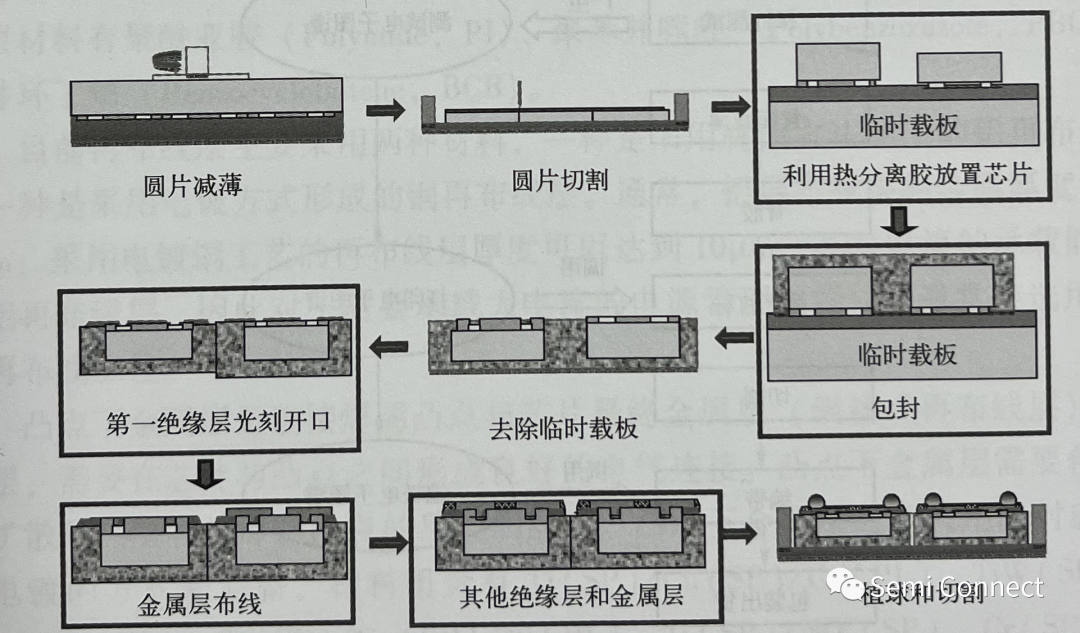
与eWLB 不同的另一种扇出型圆片级封装技术为 InFo。InFO 与eWLB 的主要区别是,在往临时载板上放置芯片时,IFO 将芯片焊盘面朝上放置,在焊盘上镀铜,钝化绝缘后再次研磨減薄,以漏出焊盘上电镀出来的连接点,这样增加了布线前的共面性,从而提高了布线的成功率。InFO 生产工艺流程如图所示(图中有黑色框的工序为关键工序)。
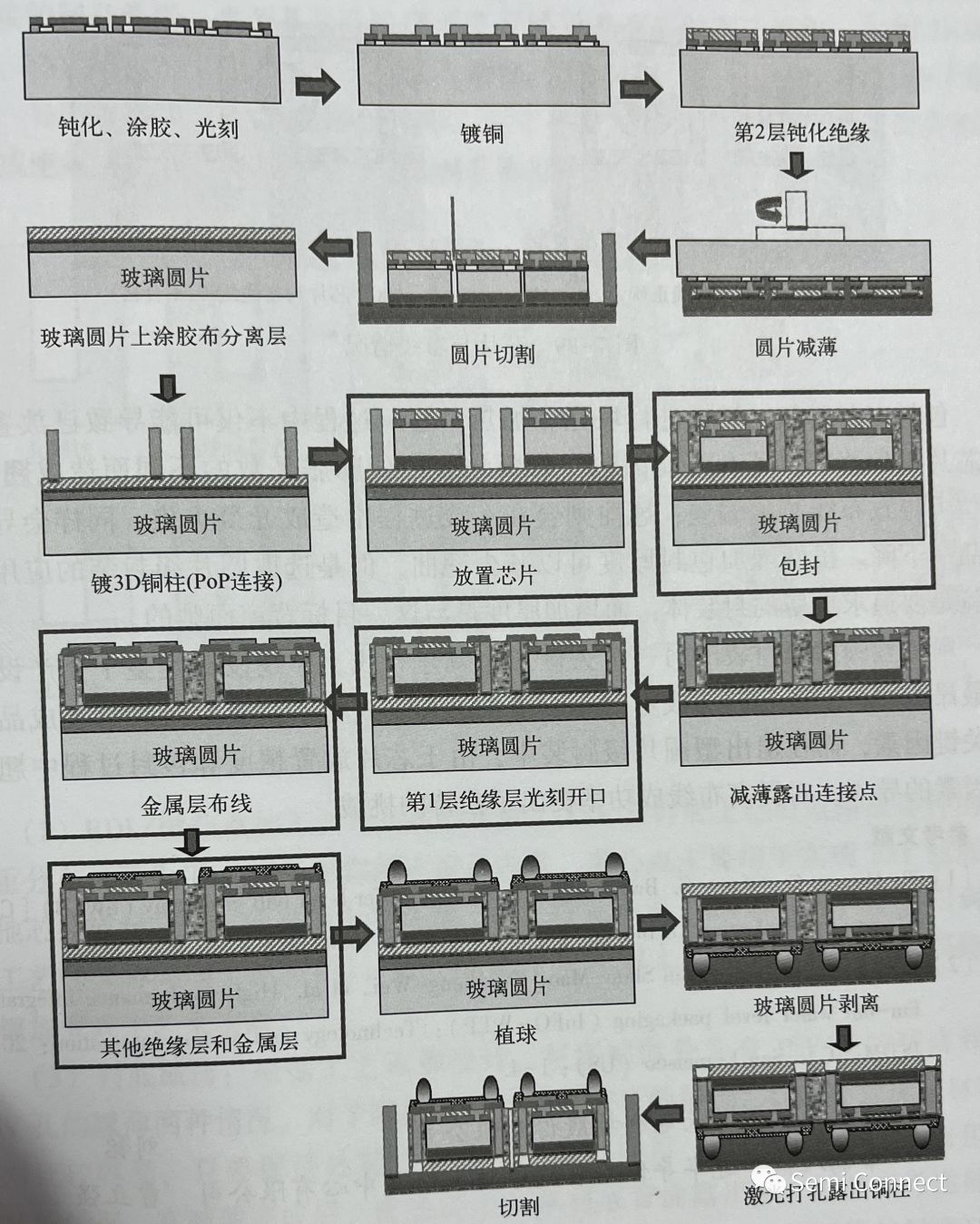
扇出型圆片级封装生产工艺的关键步骤包括芯片放置、包封和布线。芯片放置对速度和精度的要求都很高。放置速度直接决定了生产效率,从而影响制造成本;而放置精度也是決定布线精度的关键性因素,如图7-89 所示。特别是为了进一步增加生产效率,降低成本,增加临时载板或玻璃圆片的面积(甚至达到板级水平)是目前的主要发展方向。而随着载板面积的增大,从中心到边缘均保特稳定的放置精度,更是对芯片放置设备提出了前所末有的精度要求。
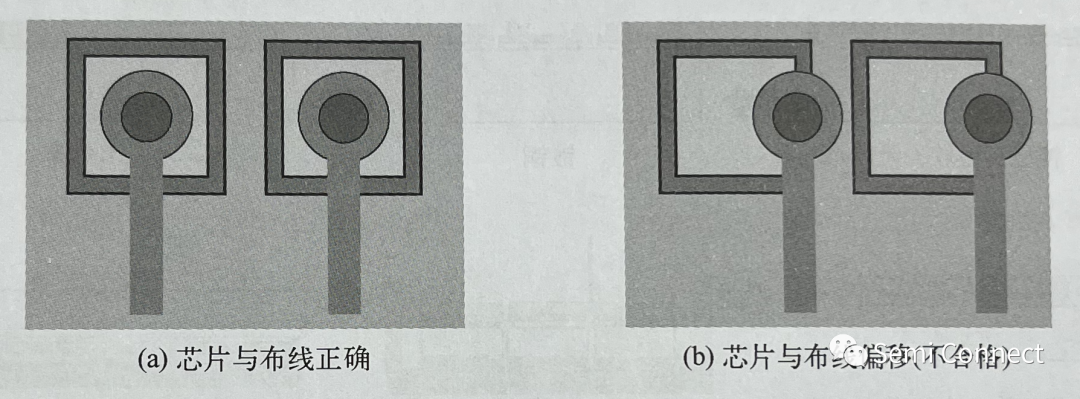
包封需要对包封材料进行填充和加热。这一过程中不仅可能导致已放置好的芯片发生移位,还有可能因包封材料与芯片的膨账系数的不同而造成翘曲。移位可导致布线产生偏差;超曲则会在布线过程中造成光刻失焦,同样会导致成品率下降。虽然增加包封厚度可以减少翘曲,但是选取圆片级封装的应用往往就是要追求更薄的封装体,而增加厚度是与这一日标背道而驰的。
扇出型圆片级封装的另一个关键工艺就是布线。布线设备是整个生产设备中最昂贵的,因此对制造成本的影响很大。布线成功率是快定最终封装成品率的关键因素,而在扇出型圆片级封装中,由于芯片放置精度和包封过程中翘曲等因素的导人,对提高布线成功率提出了独特的挑战。
-
ic封装工艺流程2010-07-18 3690
-
晶圆级封装的基本流程2023-11-08 12173
-
用于扇出型晶圆级封装的铜电沉积2020-07-07 2906
-
芯片封装工艺流程-芯片封装工艺流程图2008-05-26 8675
-
LAMP-LED封装工艺流程图2010-03-29 3844
-
新型封装工艺介绍2011-12-29 1375
-
扇出型晶圆级封装工艺流程2018-05-11 54372
-
集成电路芯片封装工艺流程2021-07-28 14272
-
芯片封装工艺流程是什么2021-08-09 73502
-
扇出式封装的工艺流程2021-10-12 13608
-
封装工艺流程--芯片互连技术2022-12-05 2499
-
圆片级芯片尺寸封装工艺流程与技术2023-05-06 4671
-
扇出型晶圆级封装技术的优势分析2023-10-25 2242
-
详解不同晶圆级封装的工艺流程2024-08-21 5017
-
晶圆级扇出型封装的三大核心工艺流程2026-02-03 1513
全部0条评论

快来发表一下你的评论吧 !

