

封装工艺流程介绍
电子说
描述
电子封装技术是系统封装技术的重要内容,是系统封装技术的重要技术基础。它要求在最小影响电子芯片电气性能的同时对这些芯片提供保护、供电、冷却、并提供外部世界的电气与机械联系等。本文将从发展现状和未来发展趋势两个方面对当前电子封装技术加以阐述,使大家对封装技术的重要性及其意义有大致的了解。
集成电路芯片一旦设计出来就包含了设计者所设计的一切功能,而不合适的封装会使其性能下降,除此之外,经过良好封装的集成电路芯片有许多好处,比如可对集成电路芯片加以保护、容易进行性能测试、容易传输、容易检修等。
因此对各类集成电路芯片来说封装是必不可少的。现今集成电路晶圆的特征线宽进入微纳电子时代,芯片特征尺寸不断缩小,必然会促使集成电路的功能向着更高更强的方向发展,这就使得电子封装的设计和制造技术不断向前发展。近年来,封装技术已成为半导体行业关注的焦点之一,各种封装方法层出不穷,实现了更高层次的封装集成。本文正是要从封装角度来介绍当前电子技术发展现状及趋势。
近年来,我国的封装产业在不断地发展。一方面,境外半导体制造商以及封装代工业纷纷将其封装产能转移至中国,拉动了封装产业规模的迅速扩大;另一方面,国内芯片制造规模的不断扩大,也极大地推动封装产业的高速成长。但虽然如此,IC的产业规模与市场规模之比始终未超过20%,依旧是主要依靠进口来满足国内需求。因此,只有掌握先进的技术,不断扩大产业规模,将国内IC产业国际化、品牌化,才能使我国的IC产业逐渐走到世界前列。
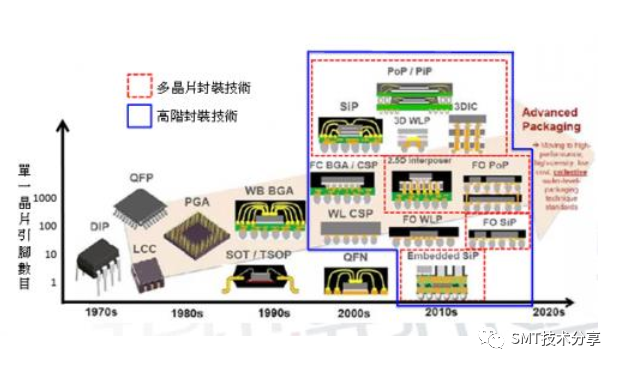
新型封装材料与技术推动封装发展,其重点直接放在削减生产供应链的成本方面,创新性封装设计和制作技术的研发倍受关注,WLP设计与TSV技术以及多芯片和芯片堆叠领域的新技术、关键技术产业化开发呈井喷式增长态势,推动高密度封测产业以前所未有的速度向着更长远的目标发展。
大体上说,电子封装表现出以下几种发展趋势:
(1)电子封装将由有封装向少封装和无封装方向发展;
(2)芯片直接贴装(DAC)技术,特别是其中的倒装焊(FCB)技术将成为电子封装的主流形式;
(3)三维(3D)封装技术将成为实现电子整机系统功能的有效途径;
(4)无源元件将逐步走向集成化;
(5)系统级封装(SOP或SIP)将成为新世纪重点发展的微电子封装技术。一种典型的SOP——单级集成模块(SLIM)正被大力研发;
(6)圆片级封装(WLP)技术将高速发展;
(7)微电子机械系统(MEMS)和微光机电系统(MOEMS)正方兴未艾,它们都是微电子技术的拓展与延伸,是集成电子技术与精密机械力加工技术、光学元器件技术为一体的新兴技术,真正达到了机、电、光的一体化。
从半导体技术的发展趋势来看,高密度薄型化系统集成的(芯片叠层封装)POP、(系统级封装)SIP、(晶圆级封装)WLP、(硅通孔)TSV、3D封装等代表着IC封测技术发展的主流方向,先进封装技术与SIP是产业发展热门话题,其封装基板向更小尺寸发展,引脚数量进一步增多,引脚线宽/引脚间距更微细化,布线密度增大,芯片堆叠层数增加,原材料、设备、工艺技术难度更高都是其发展趋势。
半导体技术路线图不断从质量、成本和小型化等方面对产品制定新的更高的要求,后摩尔定律的内涵是以“功能翻番”作为新的利润增长点,追求异构器件/模块集成、3D集成将成为主流,努力实现“功能翻番”和“尺寸缩小”以及“微结构”的复合发展,SIP是“后摩尔时代”的发展方向之一,开发集成微系统技术涉及微电子、光电子、MEMS、架形、极小的热效应区、很高的芯片强度值,同时还能保证很高的生产效率,将使其在划片工艺中得到广泛应用。
为了在封装内集成更多的功能,许多公司都在寻求密度更高的3D芯片封装,3D互连打破了当前芯片封装主要在x和y方向的格局,增加了z方向封装,该结构使用更短的信号通路,由于信号损耗降低,对传输功率的要求变得更低,性能也就有了很大的提高。因此3D互联技术成为未来封装技术发展的主要趋势,然而如何开发3D封装技术,还需要一步一步创新研发,未来的设备将集成程度将更高,而且功能也会愈来愈多。
3D集成被认为是下一代的封装方案,现已提出多种方法,关注规模生产中的生产率和成本,无凸点WOW(晶圆堆叠晶圆)是继芯片——芯片、芯片——晶圆技术后的第三代技术,在背面-正面堆叠任何数量的减薄300mm晶圆,自对准多TSV互连而不用凸点,能实现芯片对芯片的独立连接,提高了晶圆级堆叠的总良率,可制定通向以生产成本支撑的高密度集成路线图,其产出是以往的100倍。下一代3D制造中规模生产将采用芯片——晶圆技术,然后是WOW。
3D DRAM(动态随机存取存储器)封装采用TSV/DRAM阵列堆叠技术,将4片或更多的DRAM核心芯片通过TVS堆叠,并与另外的外围电路接口芯片一起键合到衬底上,从概念转为生产,有望带来优异的功率性能,封装更小,并支持更高数据速率,成为未来工艺发展的趋势。
CPU与存储器的3D封装是后摩尔时代的发展方向之一,3D封装技术在解决MEMS(微机电)传感器芯片的应用方面也扮演了关键性角色,在异质整合特性中,也可进一步整合模拟射频、数字逻辑、存储器、传感器、混合信号、MEMS等各种组件,具备低成本、小尺寸、多功能、微功耗等多重优势, MEMS的3D封装发展备受关注,逐步走向商品化。
TSV发展迅速,被许多半导体厂商和研究机构认为是最有前途的封装方法,国际上超过50%的厂商均参与3D TSV互连方面的研究,用于增加封装密度,以TSV为主要互连方式的3D封装结构,将在消费类电子、通信、网络设备、机器人、生物医学领域发挥重要作用。
先进封装技术在推动更高性能、更低功耗、更低成本和更小形状因子的产品上发挥着至关重要的作用。晶圆级芯片尺寸封装(WCSP)应用范围在不断扩展,无源器件、分立器件、RF和存储器的比例不断提高。随着芯片尺寸和引脚数目的增加,板级可靠性成为一大挑战。系统封装(SIP)已经开始集成MEMS器件、逻辑电路和特定应用电路。
MEMS应用覆盖了惯性、物理、RF、光学和生物医学等领域,这些应用要求使用不同种类的封装,比如开腔封装、过模封装、晶圆级封装和一些特殊类型的密封封装。使用TSV的三维封装技术可以为MEMS器件与其他芯片的叠层提供解决方案。TSV与晶圆级封装的结合可以获得更小的填充因子,潜在领域包括光学、微流体和电学开关器件等。
围绕3D封装、绿色封装、封装可靠性与测试、表面组装与高密度互连、封装基板制造、先进封装设备、封装材料、LED(发光二极管)封装、新兴封装(MEMS/MOEMS)等技术是多个产业界和学术界关注的专题,尤其对MEMS封装技术的研发持续高涨。
电子封装技术已涉及到各类材料、电子、热学、力学、化学、可靠性等多种学科,是越来越受到重视、并与集成电路芯片同步发展的高新技术产业。设计、芯片制造和封装测试三业并举,封装在整个IC产业链中的重要性是毋庸置疑的,其比例逐步趋向合理协调发展,其重要性有增无减。
目前电子封装正进入从平面封装到三维封装的发展阶段,在芯片——封装协同设计以及为满足各种可靠性要求而使用具成本效益的材料和工艺方面,还存在很多挑战。为满足当前需求并使设备具有高产量大产能的能力,业界还需要在技术和制造方面进行众多的创新研究。
当然,挑战与机遇并存,先进封装产品的市场需求呈现强劲增长,重大专项给力引领,产业环境日臻完善,自主知识产权成为封测产业发展的主旋律,因此电子封装技术研发任重而道远。
-
芯片封装工艺流程是什么2021-08-09 69848
-
IC芯片的封装工艺流程2008-05-26 0
-
倒装晶片的组装工艺流程2018-11-23 0
-
SMT组装工艺流程的应用场景(多图)2023-10-17 0
-
SMT组装工艺流程的应用场景2023-10-20 0
-
【华秋干货铺】SMT组装工艺流程的应用场景2023-10-20 0
-
芯片封装工艺流程-芯片封装工艺流程图2008-05-26 7911
-
ic封装工艺流程2010-07-18 3125
-
BGA的封装工艺流程基本知识简介2010-03-04 6764
-
LAMP-LED封装工艺流程图2010-03-29 3627
-
集成电路芯片封装工艺流程2021-07-28 12900
-
芯片封装工艺流程讲解2022-10-31 11515
-
封装工艺流程--芯片互连技术2022-12-05 2055
-
芯片封装工艺流程介绍2023-10-27 4294
-
传统封装工艺流程简介2024-01-05 1817
全部0条评论

快来发表一下你的评论吧 !

