

倒装芯片封装技术起源于哪里 倒装芯片封装技术的优缺点有哪些
制造/封装
468人已加入
描述
高密度电子封装正朝着小型化、高 I/O 密度、更好的散热性和高的可靠性方向发展,传统引线键合技术已经无法满足要求。先进的倒装芯片封装技术由于具有较高的单位面积内 I/O 数量、短的信号路径、高的散热性、良好的电学和热力学性能,在电子封装中被广泛关注。底部填充胶被填充在芯片与基板之间的间隙,来降低芯片与基板热膨胀系数不匹配产生的应力,提高封装的稳定性。然而,流动底部填充胶依赖于胶的毛细作用进行填充,存在很多缺点。为了克服这些缺点,出现了非流动底部填充胶,以改善倒装芯片底部填充工艺。文章回顾了倒装芯片封装技术的发展,阐述了流动和非流动底部填充胶的施胶方式和性质。









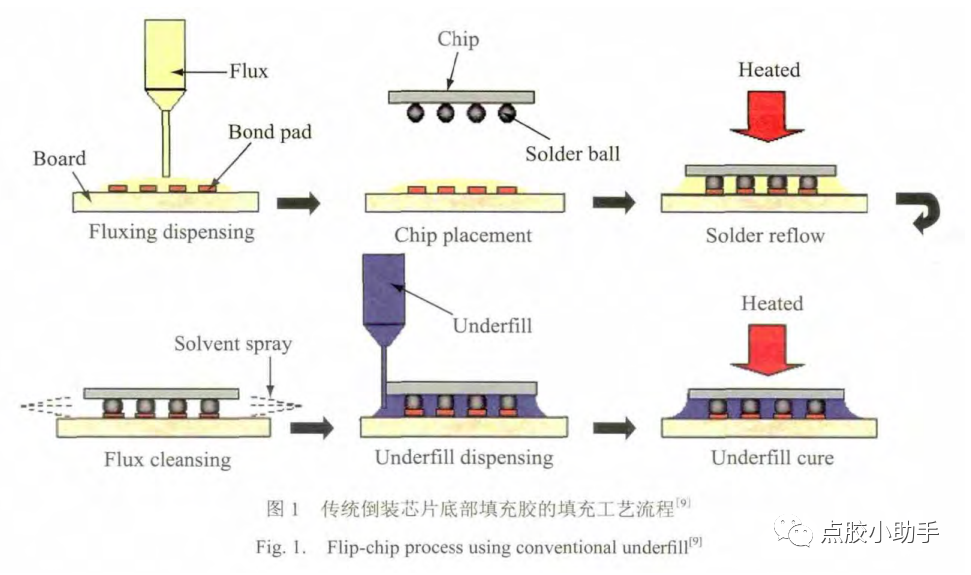





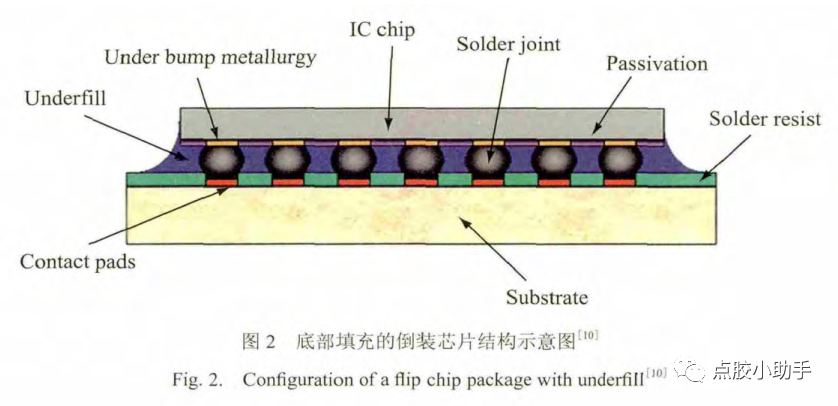



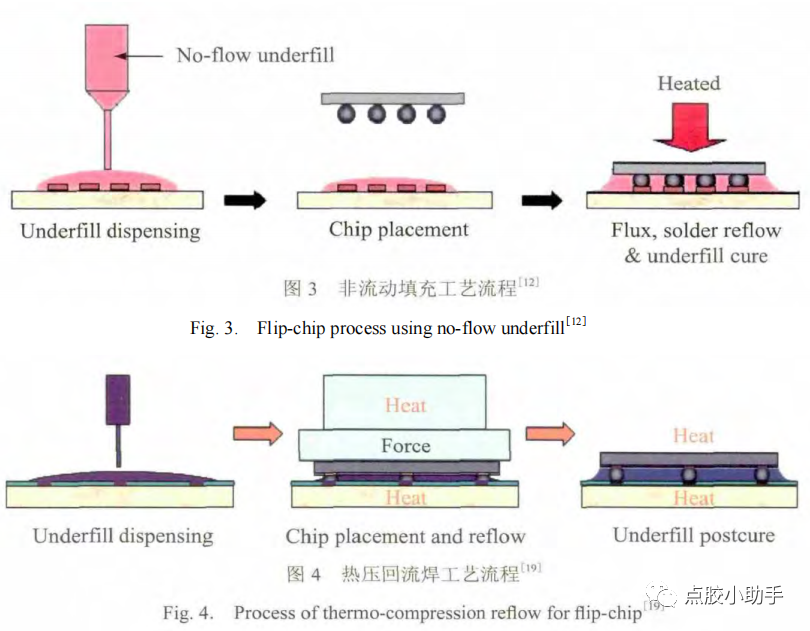



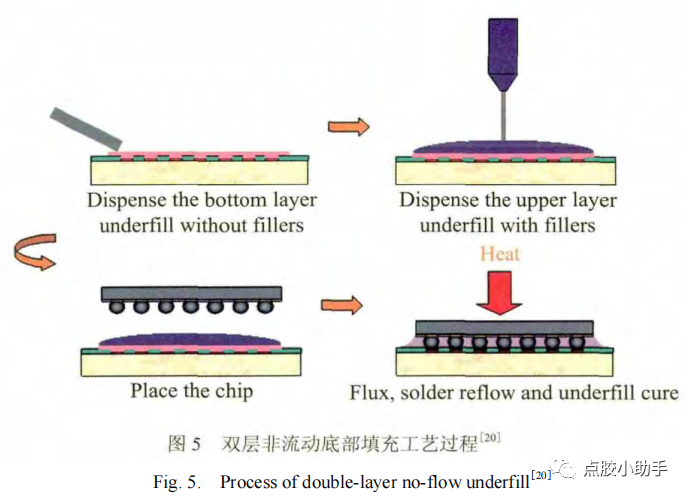
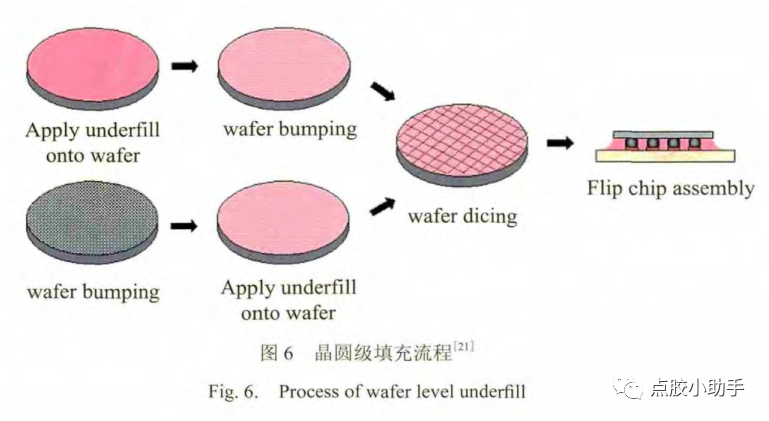




编辑:黄飞
声明:本文内容及配图由入驻作者撰写或者入驻合作网站授权转载。文章观点仅代表作者本人,不代表电子发烧友网立场。文章及其配图仅供工程师学习之用,如有内容侵权或者其他违规问题,请联系本站处理。
举报投诉
-
倒装芯片和晶片级封装技术及其应用2018-08-27 0
-
柔性电路板倒装芯片封装2018-09-11 0
-
倒装芯片的特点和工艺流程2020-07-06 0
-
倒装芯片封装的发展2011-10-19 4940
-
倒装芯片 CSP 封装2022-11-14 519
-
倒装芯片封装的挑战2023-05-22 651
-
技术资讯 | 通过倒装芯片 QFN 封装改善散热2023-03-31 1485
-
什么是倒装芯片 倒装芯片技术的优点 倒装芯片封装工艺流程2023-07-21 4306
-
一文了解倒装芯片技术 半导体封装技术简介2023-08-01 1389
-
什么是倒装芯片技术?倒装芯片的技术细节有哪些呢?2023-08-18 1798
-
倒装芯片和芯片级封装的由来2023-10-16 498
-
倒装芯片封装选择什么样的锡膏?2023-10-31 409
-
先进倒装芯片封装2023-11-01 167
-
芯片倒装Flip Chip封装工艺简介2024-02-19 1427
全部0条评论

快来发表一下你的评论吧 !

