

SiC外延片测试需要哪些分析
测量仪表
描述
SiC由于其禁带宽度大、热导率高、电子的饱和漂移速度大、临界击穿电压高和介电常数低等特点,在高频、高功率、耐高温的半导体功率器件和紫外探测器等领域有着广泛的应用前景,特别是在电动汽车、电源、军工、航天等领域备受欢迎。 外延材料是实现器件制造的关键,主要技术指标有外延层厚度、晶格布局,材料结构,形貌以及物理性质,表面粗糙度和掺杂浓度等。下面阐述SiC外延表面常见的测试手段:
1. 外延层厚度(傅里叶变换红外FT-IR)
原理:对于掺杂的SiC外延片,红外光谱测量膜厚为通用的行业标准。碳化硅衬底与外延层因掺杂浓度的不同导致两者具有不同的折射率,因此试样的反射光谱会出现反映外延层厚度信息的连续干涉条纹。当外延层表面反射的光束和衬底界面反射的光束的光程差是半波长的整数倍时,反射光谱中可以观察到极大极小值。根据反射谱中干涉条纹的极值峰位,试样的光学常数以及入射角可以计算出相应的外延层厚度。 应用:测定SiC外延层膜厚
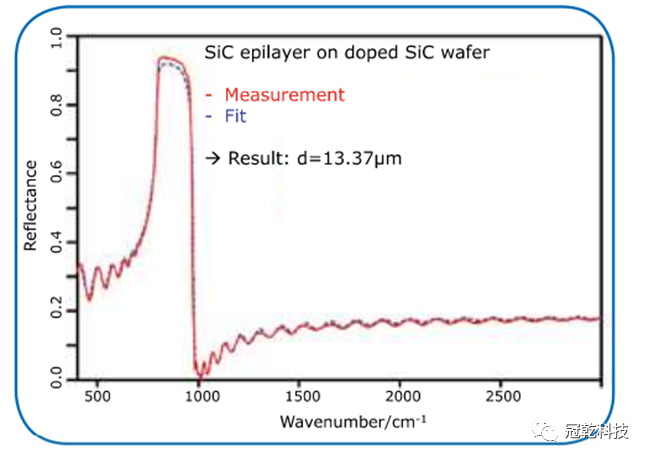
参数:测量直径至12”的硅晶片
2.掺杂浓度(汞探针CV测试仪)
原理:汞探针CV测试仪是利用肖特基势垒电容C-V特性来测试掺杂浓度的测试方法。汞探针和N型碳化硅外延层接触时,在N型碳化硅外延层一侧形成势垒。在汞金属和碳化硅外延层之间加一直流反向偏压时,肖特基势垒宽度向外延层中扩展。如果在直流偏压上叠加一个高频小信号电压,其势垒电容随外加电压的变化而变化可起到电容的作用。通过电容-电压变化关系,即可找到金属-半导体肖特基势垒在外延层一侧的掺杂浓度分布。
应用:外延掺杂浓度,电阻率等。
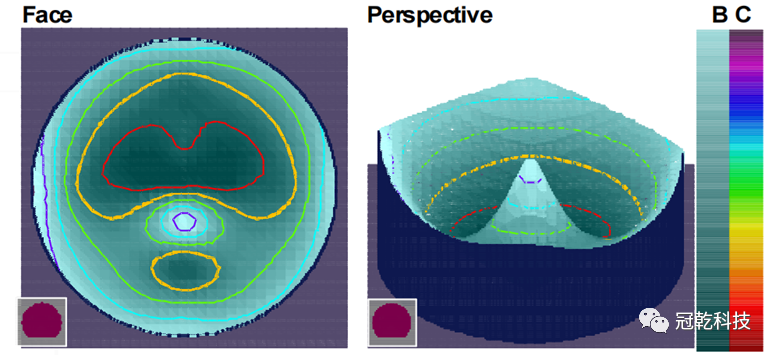
参数:测量范围 1E14 – 1E19/cm3。
3. SiC晶格布局,材料结构,形貌以及物理性质(X射线衍射仪XRD)
原理:XRD原理X 射线的波长较短与晶体结构在同一个数量级上。X射线分析仪器使用X射线源是X 射线管在管子两极间加上高电压,阴极就会发射出高速电子流撞击金属阳极靶从而产生X射线。当X 射线照射到晶体物质上,由于晶体是由原子规则排列成的晶胞组成,每种结晶物质都有其特定的结构参数(包括晶体结构类型晶胞大小,晶胞中原子、离子或分子的位置和数目等)。不同原子散射的 X射线相互干涉在某些特殊方向上产生强X 射线衍射,衍射线在空间分布的方位和强度与晶体结构密切相不同的晶体物质具有自己独特的衍射花样。高分辨衍射分析单晶外延膜的结构特征,用Bond法超精度地测点阵参数、点阵错配、化学组份,用Rocking曲线测定测算嵌镶结构、取向,作倒易空间测绘; 用于分析薄膜的厚度、密度、表面与界面粗糙度等。
应用:测SiC晶格布局,材料结构,形貌以及物理性质
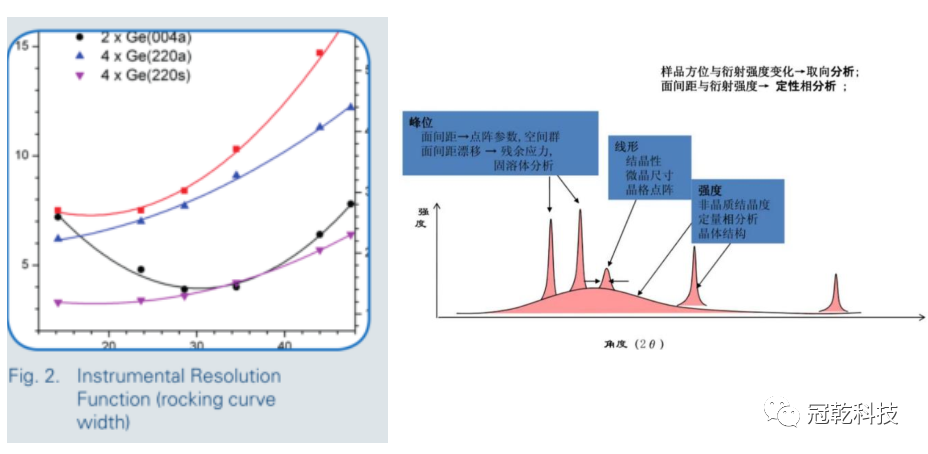
参数:最大可用角度范围-110°< 2Theta < 168°,最小步长0.0001°。
4. 表面形貌分析(扫描电镜)
原理:利用聚焦的很窄的高能电子束来扫描样品,通过光束与物质间的相互作用,来激发各种物理信息,对这些信息收集、放大、再成像以达到对物质微观形貌表征的目的。扫描电子显微镜的分辨率可以达到1nm;放大倍数可以达到100万倍连续可调;并且景深大,视野大,成像立体效果好。此外,扫描电子显微镜和其他分析仪器相结合,可以做到观察微观形貌的同时进行物质微区成分分析。
应用:表面形貌分析
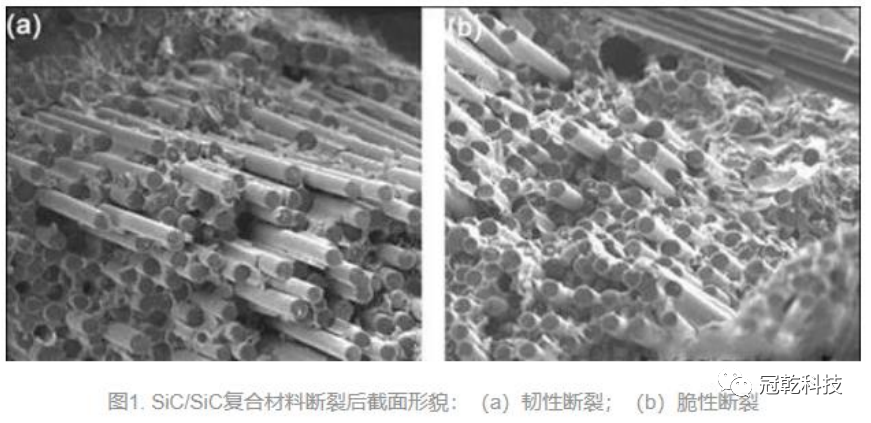
参数:放大倍率2~1000000倍
5. 表面粗糙度(原子力显微镜AFM)
原理:将一个对微弱力极敏感的微悬臂一端固定,另一端有一微小的针尖,针尖与样品表面轻轻接触,由于针尖尖端原子与样品表面原子间存在极微弱的排斥力,通过在扫描时控制这种力的恒定,带有针尖的微悬臂将对应于针尖与样品表面原子间作用力的等位面而在垂直于样品的表面方向起伏运动。利用光学检测法或隧道电流检测法,可测得微悬臂对应于扫描各点的位置变化,从而可以获得样品表面形貌的信息。
应用:样品表面形貌、表面粗糙度、力学、电学等性能测量。
参数:XY方向扫描范围90umx 90um,Z方向扫描范围10um,纵向噪音水平<30pm RMS值。
编辑:黄飞
-
关于LED外延片生长2013-12-11 5595
-
扩展电阻测试外延片厚度2018-11-20 4323
-
LED外延片代工厂走势分析2009-11-27 958
-
LED外延片及其质量辨别2011-09-22 1687
-
LED外延片基础知识2012-01-06 3618
-
基于简单的支架多片4H-SiC化学气相沉积同质外延生长2020-12-26 1386
-
希科半导体引领SiC外延片量产新时代2022-11-29 4047
-
氮化镓外延片工艺介绍 氮化镓外延片的应用2023-02-05 8169
-
SiC外延工艺基本介绍2023-05-31 8869
-
外延片和扩散片的区别是什么2024-07-12 2992
-
SiC外延生长技术的生产过程及注意事项2024-11-14 2887
-
钟罩式热壁碳化硅高温外延片生长装置2025-01-07 423
-
提高SiC外延生长速率和品质的方法2025-02-06 1979
-
有效抑制SiC外延片掉落物缺陷生成的方法2025-02-10 401
-
SiC外延片的化学机械清洗方法2025-02-11 414
全部0条评论

快来发表一下你的评论吧 !

