

平面全属化封装技术
PCB设计
2585人已加入
描述
由于引线互连带来的种种问题,人们开始研究如何改进互连技术,以避免采用引线。1995年以后,陆续开发出了一些无引线的集成功率模块,其特点是:互连结构的电感小、散热好、封装牢固等。图1(a)、图1(b)、图1(c)分别给出了三种不同引线键合(Non-Wire Bond)的集成功率模块技术:(a)嵌人功率器件(CPES,1999),(b)层叠式器件PowerOverlay,(c)倒装芯片法(参考APEC⒛00)。嵌入功率器件的平面金属化封装技术是其中较好的一种。
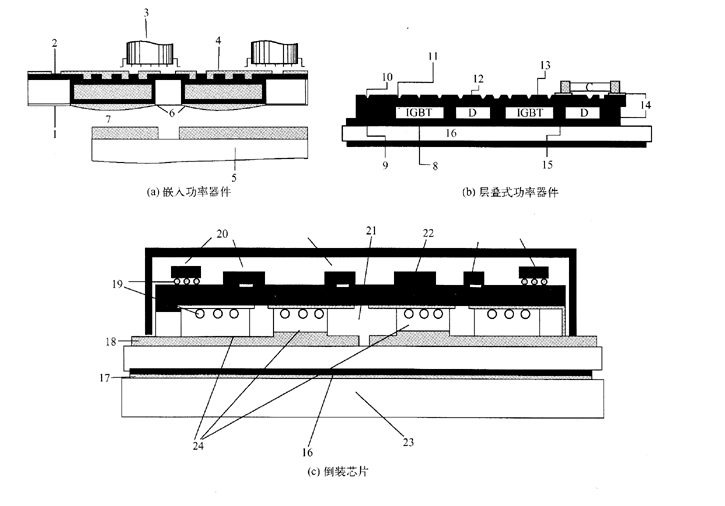
图1 不用引线键合的集成功率模块
图2给出了一个集成模块的剖面图,应用了嵌入功率器件的多层集成封装技术。包括:散热板、基板、绝缘传热材料、功率母线、功率器件、铜层、陶瓷、集成无源模块、金属层、表面贴装芯片(驱动、检测及保护元件)等。这种三维多层集成封装技术,将功率模块、集成电路等做成三明治(Sandwich)结构形式。
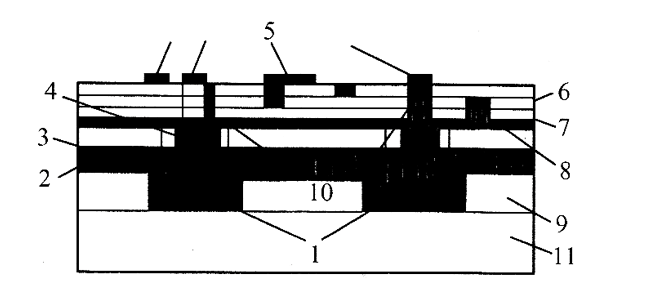
图2 嵌入功率器件的多层集成封装的剖面图
声明:本文内容及配图由入驻作者撰写或者入驻合作网站授权转载。文章观点仅代表作者本人,不代表电子发烧友网立场。文章及其配图仅供工程师学习之用,如有内容侵权或者其他违规问题,请联系本站处理。
举报投诉
-
什么是瞬态平面热源法?瞬态平面热源法导热仪有哪些优势2022-11-07 1567
-
全平面贴合技术是什么,全贴合的优点解析2020-05-04 6874
-
毫米波的PCB平面传输线技术2019-06-24 4273
-
平面光波导PLC分路器封装技术2018-11-27 2293
-
平面全属化封装技术2018-11-23 4278
-
全印制电子技术在pcb中的应用2018-08-30 1192
-
用于高速光电组件的光焊球阵列封装技术2018-08-23 2080
-
平面光波导技术及其器件发展趋势分析2018-02-22 8771
-
AltiumDesignerPCB封装库【很全】2014-10-29 7033
-
招聘封装技术工程师2014-08-01 2203
-
微电子封装技术2013-12-24 6487
-
基于ActiveX自动化技术实现路线平面图的自动生成2010-04-29 1225
-
平面光波导(PLC)分路器封装技术2009-11-18 2474
-
等离子平面屏幕(PDP)技术详解2008-10-19 2208
全部0条评论

快来发表一下你的评论吧 !

