

2.5D封装应力翘曲设计过程
制造/封装
描述
主要内容:
本文通过测试、仿真分析了影响2.5D CoWoS翘曲、应力、可靠性的因素:real/dummyHBM、interposer 厚度、C4 bump高度。对2.5D package的设计非常有指导意义。
2.5D CoWoS封装结构示意图:
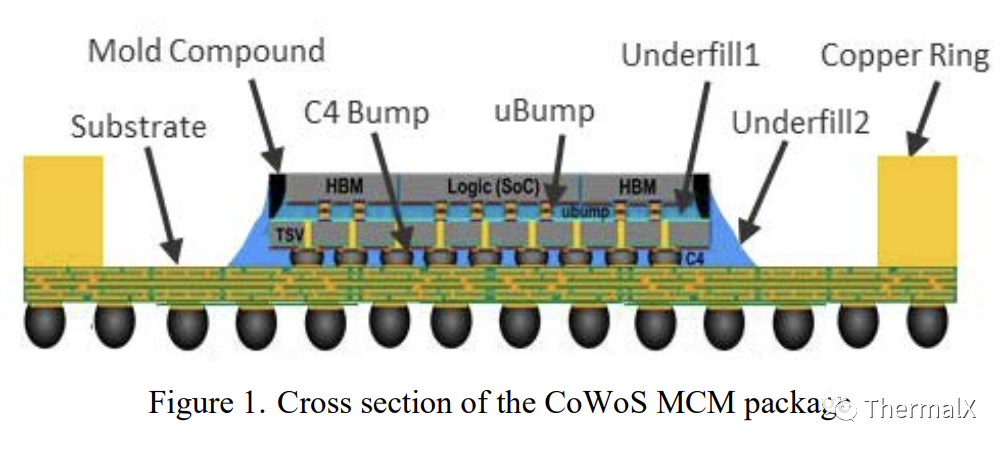
实物图:

关键参数:

两种配置:
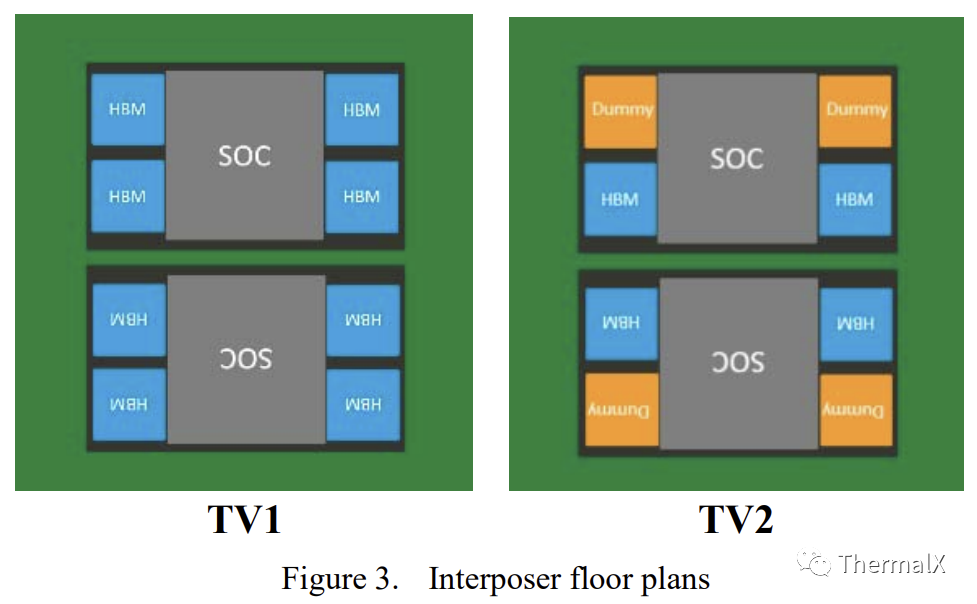
两种配置下reflow的翘曲测试结果:
由于结构的不对称,Dummy的要worse。不过按照JEDEC翘曲标准(140um、230um),貌似都fail了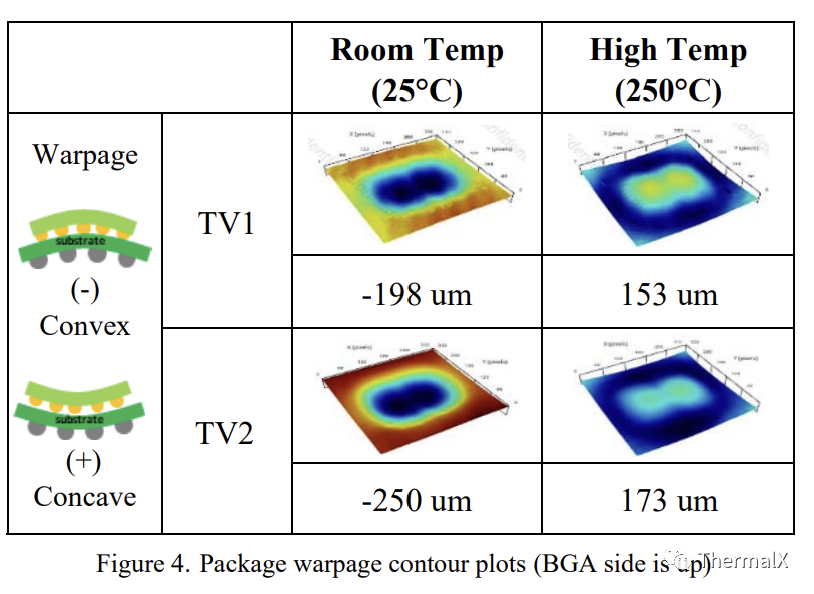
interposer边缘处是应力集中区域:

TCG(TC G类应力)200次测试后,TV1 OK,TV2 fail:

不同C4高度的影响:
65um C4 底填出现裂纹fail,85um C4 pass。
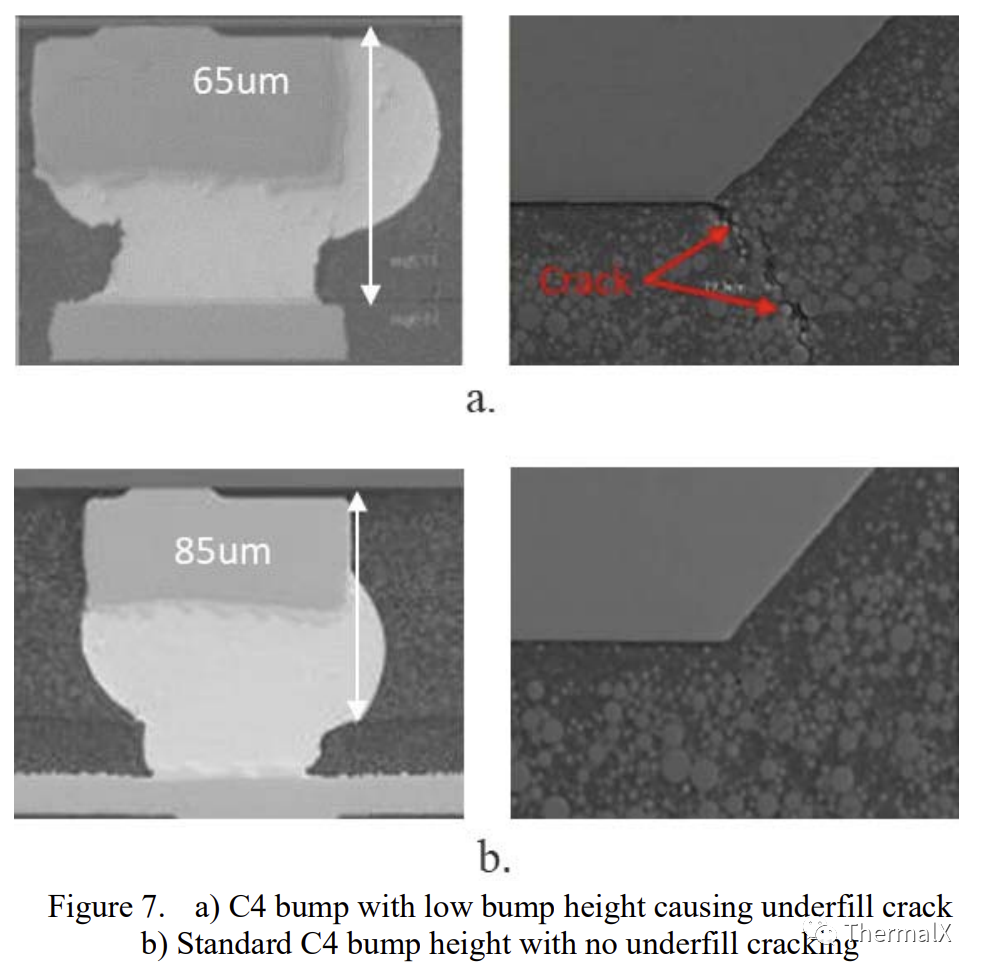
通过FEA进行分析TV1和TV2的interposer corner应力:
TV2比TV1高4%,因为HBM边缘处是Mold,与外面Mold的CTE mismatch没那么高。

Interposer 50um厚会比100um的corner stress低:
因为interposer的CTE约4ppm/K,underfill的约为20ppm/K,基板的约为14ppm/K,interposer越薄,变形越小,TC循环时产生的应力也相对小。

C4 越矮,interposer corner stress越大,因为C4越矮,边缘溢出的underfill2越多,应力越大。

可靠性测试表明:
100um interposer的TV1和50um interposer的TV2均可pass。100um interposer的TV2则fail在了TCG测试,因为interposer corner应力集中产生了边缘区域的crack。
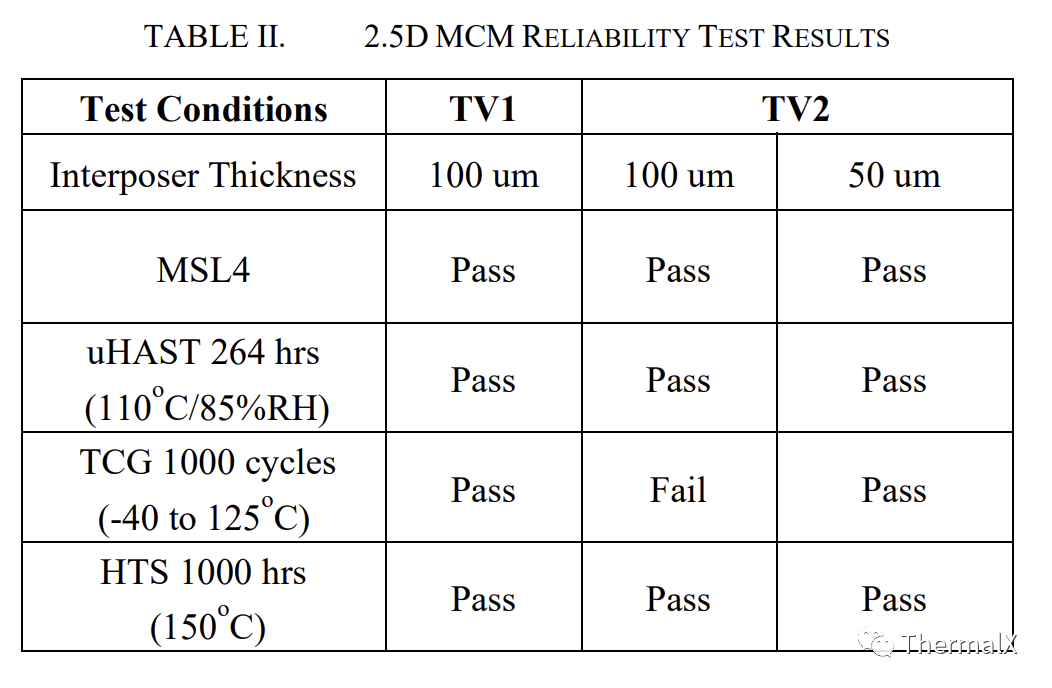
100um interposer TV1、50um interposer TV2局部图,都是OK的。
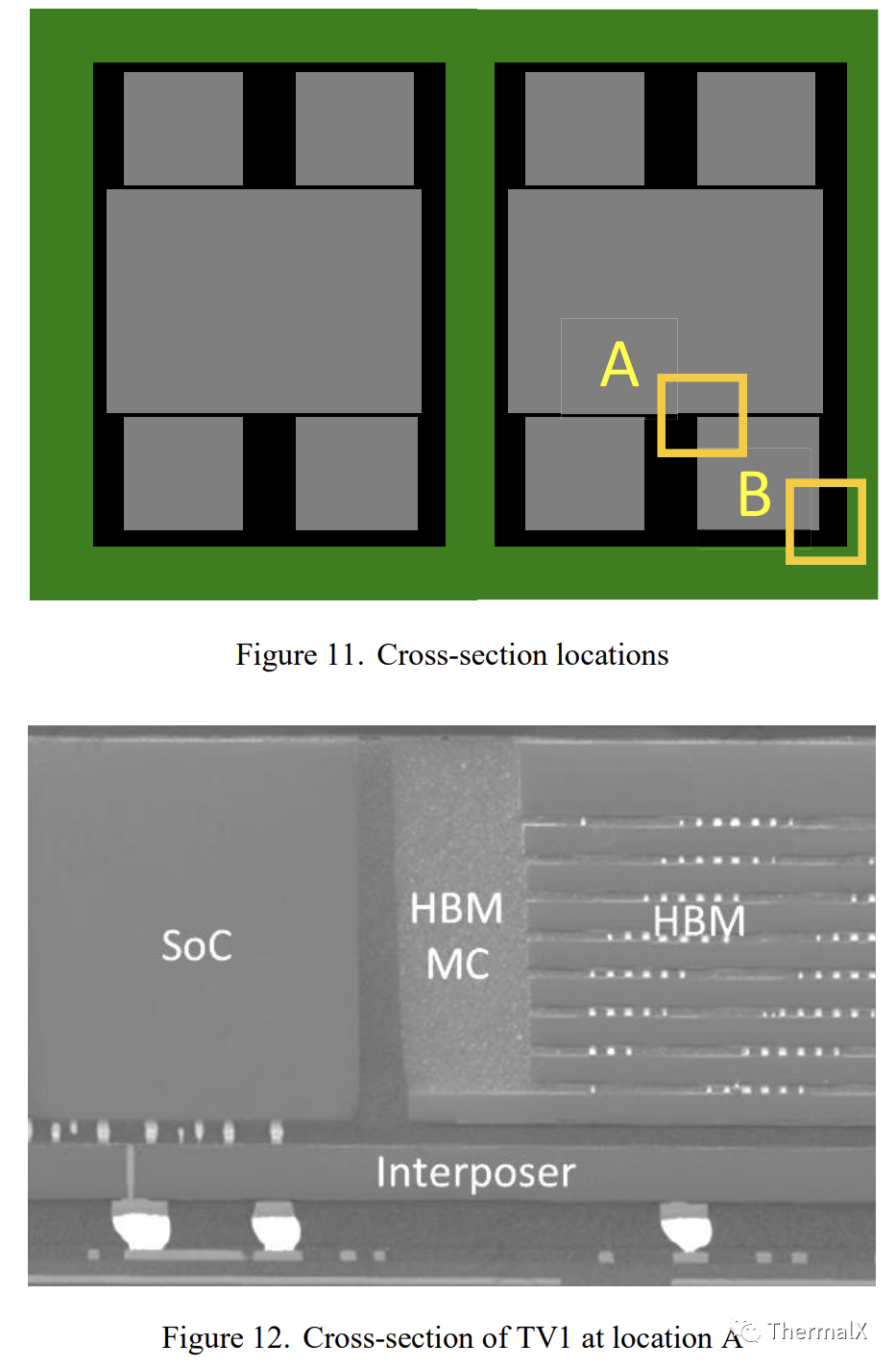
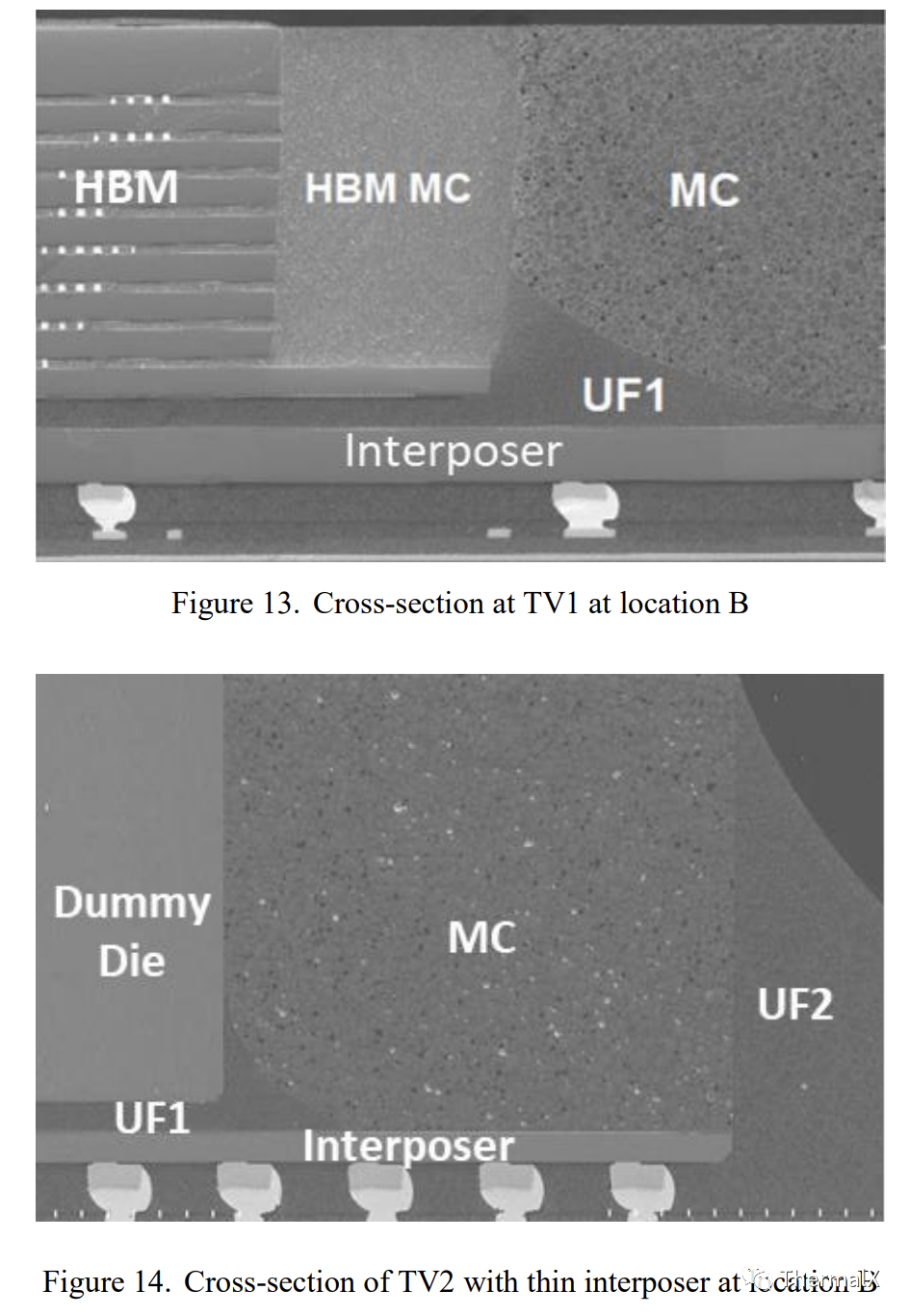
审核编辑:刘清
-
 SHDJHE
2024-02-20
0 回复 举报您好,想问下能看到最大翘曲值的JEDEC标准是哪个呢 收起回复
SHDJHE
2024-02-20
0 回复 举报您好,想问下能看到最大翘曲值的JEDEC标准是哪个呢 收起回复
-
预防印制电路板在加工过程中产生翘曲的方法2013-03-11 2391
-
PCB和元器件焊接过程中的翘曲研究2012-02-02 2800
-
如何解决印制电路板在加工过程中产生翘曲的问题2020-03-11 2245
-
新型2.5D和3D封装技术的挑战2020-06-16 8836
-
SiP 封装的焊点形态对残余应力与翘曲的影响2024-03-14 2351
-
2.5D封装的热力挑战2024-11-24 3882
-
深入剖析:封装工艺对硅片翘曲的复杂影响2024-11-26 3220
-
2.5D和3D封装技术介绍2025-01-14 3788
-
制程残余应力致CMOS芯片翘曲,白光干涉精准测量方案2026-05-11 129
全部0条评论

快来发表一下你的评论吧 !

