

AEC-Q101功率循环测试 简介
描述
功率循环测试-简介
功率循环测试是一种功率半导体器件的可靠性测试方法,被列为AEC-Q101与AQG-324等车规级测试标准内的必测项目。相对于温度循环测试,功率循环通过在器件内运行的芯片发热使器件到达设定温度;以及温度循环,通过外部环境迫使被测器件到达测试温度。
简而言之,一个是运动发热,一个是高温中暑。
由于功率循环测试时被测器件发热部分主要分布于器件工作区域内,因此它具有相似于正常运行时器件封装老化(aging)规律,故功率循环测试被认可为最接近于实际应用的功率器件可靠性测试而受到广泛的关注。

功率循环测试过程中,器件内部温度分布以及应力变化
功率循环测试台是应用于功率器件功率循环测试装置的设计原理不是很繁杂。试验台内由电流源向被测器件提供负载电流,电流/电压探头对被测器件电流/电压进行实时监测,控制器操纵电流源使负载电流按照设定的时间断流。设备整体的主要成本在电流源与控制器,设备的设计难度在于程序控制以及数据采集硬件。
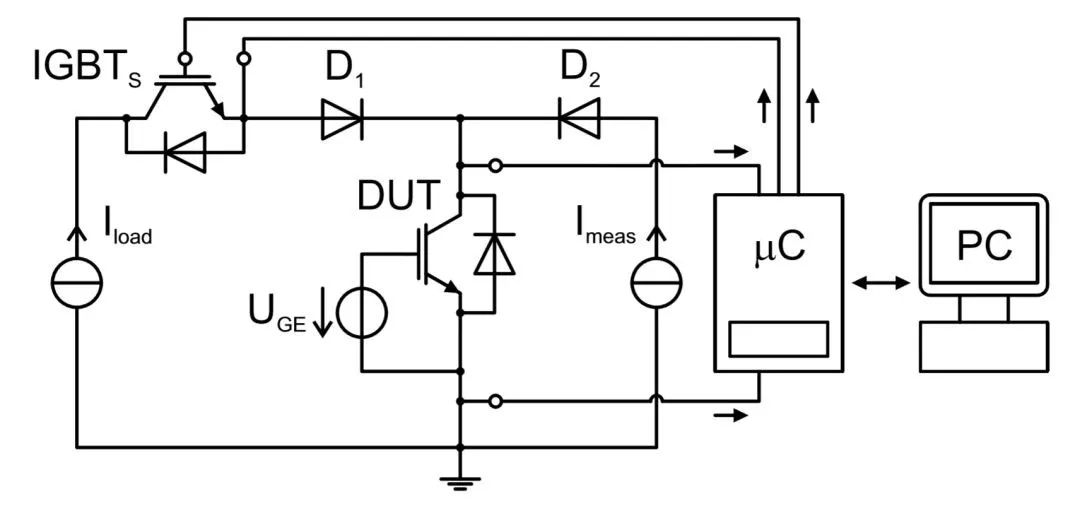
功率循环测试设备简图
功率循环测试时直接测试数据为器件电压降、负载电流和器件底部温度等。通过选择数据采样时间点采集最高温和最低温下被测器件电压和器件底部温度的变化情况,再经过计算获得器件芯片的温度变化情况和器件内热阻的变化情况。
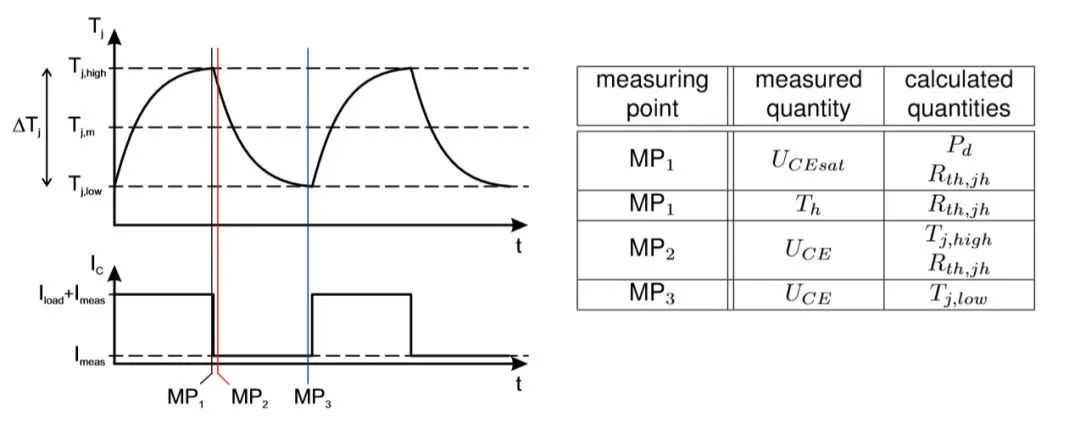
功率循环测试中,检测时间点以及被测试参数
由于大多数器件在测试中是处于被封装状态,其内部温度不可通过直接手段进行检测,故在功率循环测试中,器件内部芯片的温度是采用K系数的方式进行间接计算而获得的。功率循环测试时直接测试数据为器件电压降、负载电流和器件底部温度等。硅基IGBT芯片温度通常由Vce(集电极-发射极电压)来计算。同时Vce还可以反映IGBT器件内部电流路径老化程度,将Vce升高作为器件损坏判据。
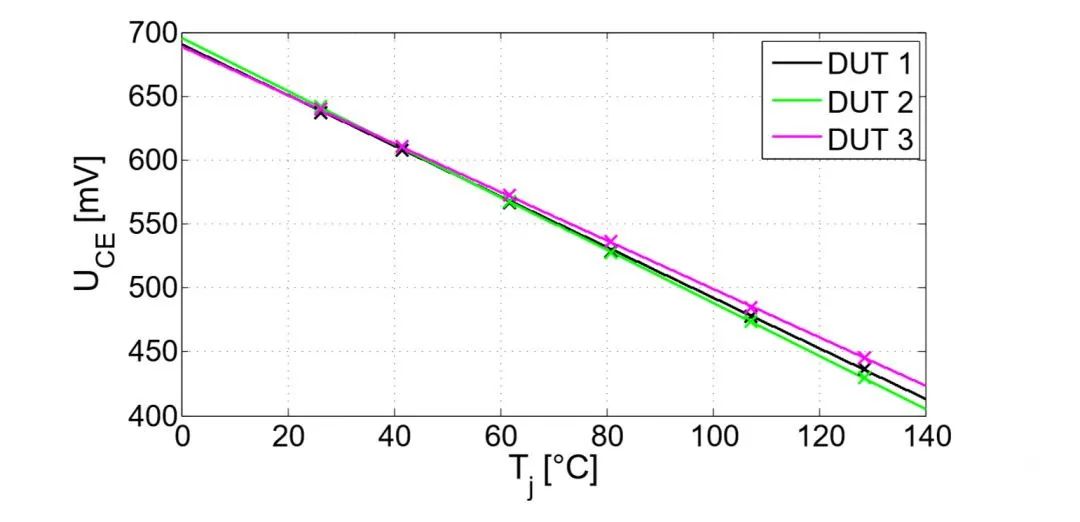
IGBT器件的K系数(Vce-Tj 拟合线)
被测试器件的热阻在功率循环测试中应当被实时监控,因为其反映了器件散热能力的变化。热阻通过下列方程简单计算得出,20%的Rth增长被认定为器件失效的标准。

以下列功率循环测试中收集的数据为例,Vce在427.4k循环数左右发生阶段跳跃,同时器件芯片的最高温度(Tj,high)上升明显。这表明器件芯片表面的键合线出现断裂或脱落。而Rth无明显变化,表明器件内部散热层老化情况不明显。

功率循环测试中的数据
上图功率循环试验数据存在明显不足,就是试验数据噪声大,不能正确反映器件内部真实状态。造成这一不足的主要原因是被测器件电学连接不够标准、功率循环测试设备精度受限、测试数据监测时间点选择错误等。
-
AEC-Q101汽车电子基于离散半导体元件应力测试认证的失效机理中文标准2018-10-25 2373
-
浅谈AEC-Q101认证标准2021-05-20 7168
-
白皮书:GaN FET 技术和 AEC-Q101 认证所需的稳健性 – 中文(650 V GaN FET 技术可提供出色效率,以及 AEC-Q101 认证所需的耐久性)-nexperia_whitepaper_...2023-02-17 613
-
什么是AEC-Q101认证?——华碧实验室2023-05-16 2613
-
功率器件AEC-Q101如何选择测试项目?认证准备及流程有哪些?2023-05-31 6841
-
功率半导体器件(IGBT、MOSFET和SiC)设计企业:上海陆芯获得第三代IGBT车规级AEC-Q101认证2022-06-21 2580
-
AEC-Q101的认证对象和测试项目2023-01-13 2474
-
AEC-Q101 标准之TC解读2023-08-30 4716
-
安建半导体40V SGT MOSFET产品已经通过AEC-Q101车规全部测试2023-09-06 1541
-
MOSFET符合AEC-Q101标准 采用小型有引脚和无引脚DFN的SMD封装2023-09-26 617
-
国星光电SiC-MOSFET器件获得AEC-Q101车规级认证2023-10-24 2252
-
SGS为华微电子颁发AEC-Q101认证证书2024-03-22 2097
-
雷卯解析AEC-Q101与AEC-Q2002024-06-12 2878
-
功率半导体器件功率循环测试与控制策略2024-10-09 2238
-
AEC-Q101——HAST试验介绍2025-01-09 1954
全部0条评论

快来发表一下你的评论吧 !

