

从SiP到Si³P未来发展研究
描述
市场分析
随着现代电子技术和系统复杂度的不断提高,电子装备越来越小型化和高集成化,而半导体特征尺寸逐渐逼近物理极限,芯片的设计难度和制造成本明显提升,传统封装技术已不能满足多芯片、多器件的高性能互联,这对封装技术提出了越来越高的要求。通过微缩特征尺寸以实现芯片性能翻倍难以继续,但系统对性能提升的要求没有降低,系统复杂度仍在持续增长。
为了满足需求,研究人员从封装层面上构建系统级封装(System in package, SiP)。与传统封装技术相比,SiP更能满足集成电路向更高集成度、更高性能、更高工作频率发展的要求,其中三维系统级封装(3D-system in package, 3D-SiP)通过多层堆叠和立体互联实现了芯片和器件的高性能集成。
而长运通也致力于由SiP向Si³P(SiiiP:integration-集成、 interconnection-互联、 intelligence-智能)方向研究,其产品为我们身处的模拟世界与数字化电子建立起到了不可或缺的桥梁。
今天这篇文章,长运通就要和大家讲讲长运通致力于研究的方向——Si³P。
从SiP到Si³P
首先说说SiP,
SiP是先进封装技术里的一种,可以在小体积内集成复杂的电子系统或子系统,在外形、性能和成本上都很有优势,可以给终端产品带来独特的价值。
SiP包含实现特定功能的所有器件,不受晶圆工艺的限制,可以根据功能需要进行自由组合。
智能手机中的基带、射频、Wi-Fi、蓝牙、电源管理、人工智能等芯片均可采用SiP技术。
示意图:
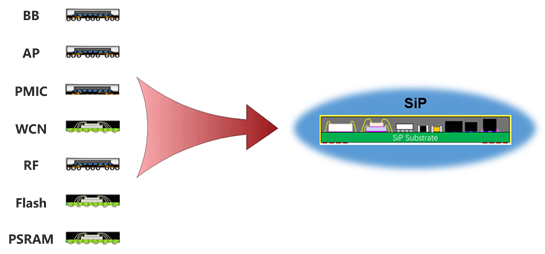
得益于SiP市场在快速增长,预计到2025年SiP封装产值将达到188亿美元,其中移动和消费电子达到157亿美元,占比为84%。在手机和可穿戴市场,SiP已经获得巨大成功,并开始在工业、医疗、汽车、电视、电脑、HPC、航空航天等各领域全面渗透。
而SiP系统级封装(System in Package),其中的两个关键词是系统(System)和封装(Package),其中的in看似无关紧要,其实却也起到重要的作用,表明整个系统是在一个封装内的。
通过以下六张图,我们就能清楚地理解Si³P代表的意义。
首先,第一张图,通过将一个i扩展为3个iii,
分别是integration,interconnection,intelligence。

第二张图,in,代表系统是包含在封装内部,或者说在封装内包含一个系统,其中系统是主体(body),封装是载体(Carrier)。

第三张图,integration,代表【集成,整合】的含义,是SiP理解的第一层次含义,
主要关注点为:
1.SiP中包含的模块或芯片;
2.SiP采用的封装结构;
3.SiP采用的工艺和材料;
4.SiP结构强度分析和热分析。

这更多从“物理结构”的角度去理解,它就像建造房屋,需要对结构,材料和工艺进行详细的规划,可以说,集成是SiP实现的基础。
第四张图,interconnection,代表【互联】的含义,是SiP理解的第二层次含义,
主要关注点为:
1.SiP中网络的连接的方法;
2.阻抗匹配(单端,差分);
3.高速的规则,等长约束;
4.电学设计,电学仿真,EDA工具。

这更多从“电气信号”的角度去理解,是SiP功能实现和性能提升的关键,现在也越来越受到人们的重视。
第五张图,intelligence,代表【智能,智力】的含义,这个"i"就是当前最火的"AI"中的i,是SiP理解的第三层次含义,
主要关注点为:
1.SiP系统功能的定义;
2.SiP产品应用的场景;
3.SiP系统调试(内部调试,外部联调);
4.SiP软件配置,算法应用等。

这更多从“产品应用”的角度去理解,是SiP真正发挥作用,实现功能的核心,其中重要的一点就是要将软件考虑到整个SiP系统中,和整个SiP系统一起进行优化。
这就好比一个城市有房屋,有交通,但这些还不够,只有生活在城市里的人,人如何去使用这些设施,实现某个功能,城市才有意义。
第六张图,做个总结,在设计一款SiP时,不仅仅要从“物理结构”方面考虑,还要重点考虑“电气信号”和“产品应用”。即要考虑三个i。

其次我们再来谈谈SiP的三类集成:
先来看第一类集成,Intergration on Chip,也就是IC层面的集成。目前IC晶体管微观尺寸已经接近极限;而如果把IC的面积做大,则会带来工艺难度和成本的提高;现在已知的3D集成的确是一种解决方案,不过目前也仅限于3D NAND Flash技术,相对其他期间还在探索中。
第二类集成,Intergration on PCB,也就是PCB的集成。从历史来看,PCB基板多年以来发展缓慢,要么继续缩小线宽、线间距;要么提高布线层数,但目前也都没有太大的余地。而且,PCB组装密度提高依赖于封装尺寸缩小,器件引脚密度增大;PCB的3D集成也要借助结构件才行。这些都是目前PCB集成遇到的卡点。
第三类集成,Intergration on Package,也就是封装的集成。封装的集成在3D集成的部分具备天然优势,因为芯片向上引出点通过键合线连接到基板便于堆叠安装,倒装焊芯片与键合线也能堆叠在一起。
发展现状
在进入21世纪,特别是近10年来,各种基于微组装技术的平面结构微系统和基于TSV、RDL等技术的2.5D微系统得以快速发展。
近年来,微系统三维集成技术已形成SiP 3D集成等发展路径,并在成像传感、光集成微系统、惯性传感微系统、射频微系统、生物微系统和逻辑微系统等方面开始应用创新。
工艺尺寸的缩减直接带来集成度的提升,封装形式也在不断地更新迭代,从1947年的TO型封装,进展到20世纪80年代后期的MCM封装,再到2009年前后,系统级集成在中国开始广泛地应用,国内目前主要开展的是微组装封装, SiP、 SoP、 2.5D和3D叠层集成技术研究,并且取得了较大的进展。
我国正从政策和各方条件保障逐步地加大对微系统技术的扶持力度,意在超越摩尔时代使我国集成电路产业走出“低端模仿”,走向以技术创新为主的“高端替代”。
未来发展
未来,在微系统集成方面,将在当前同质2.5D集成的基础上,快速往3D异质集成(即在同一衬底上实现不同材料、不同工艺的微纳器件集成)和3D异构集成(COWOS、Info和Chiplet等)甚至是4D方向发展。为适应电子产品发展趋势,未来3D SIP应用规模将快速扩大,3D SIP将逐步替代SIP。我国是全球最大的电子产品生产国,芯片制造能力逐步提升,封装实力不断增强,未来3D SIP市场空间广阔。
时至今日,国家也非常注重此方面的发展,国家科技部先后组织了“攀登计划”“微电子机械系统”、国家重点基础研究发展规划“集成微光机电系统研究”和“863”重大专项等。
长运通相信
随着先进封装技术的不断发展
集成电路芯片与集成电路封装之间的界限
会日渐模糊
形成共融发展的新态势
微系统集成技术的发展也会为电子产品的性能
带来许多颠覆性的进步
未来长运通也将实现Si³P智能微集成包括电源+(电机驱动、数字隔离器等多功能微集成)等等更高集成,将实现提频、高效、可智能、可通讯、可编程、可控制等等。把握后摩尔时代战略机遇,推动其在高端装备、汽车电子和健康医疗等领域的应用和全产业链发展,在Si³P微系统集成细分领域,努力实现从“并跑”到“领跑”的跨越。
审核编辑:汤梓红
-
系统级封装(SiP)技术介绍2024-11-26 3556
-
最新的系统级封装SiP发展趋势2022-11-24 3055
-
CAT-SI261-P729A CAT-SI261-P729A 矩形连接器壳体2021-08-04 164
-
CAT-SI261-P729 CAT-SI261-P729 线到板连接器组件和护套2021-07-31 169
-
SIP中陶瓷基板材料的未来发展趋势2020-05-21 2028
-
频谱感知技术研究发展到了哪一步?未来的发展方向是什么?2019-08-02 4078
-
Cadence SiP怎么集成到ADS中2019-04-25 3633
-
系统级封装(SiP)的发展前景(上)2018-08-23 4419
-
一文看懂SiP封装技术2017-09-18 4902
-
SiP封装需求持续增加威胁Fan-In封装未来发展2016-11-28 1840
-
德国启动“CoSiP” 研究项目专门针对端到端SiP设计环境2009-12-31 751
-
基于P2P-DHT节点搜索的SIP网络电话设计2009-04-13 1236
-
基于S/MIME的SIP安全性方案2009-03-20 513
-
CADENCE SIP DIGITAL SI2008-10-16 2063
全部0条评论

快来发表一下你的评论吧 !

