

功率MOSFET结构和参数解读
模拟技术
描述
众所周知,由于采用了绝缘栅,功率MOSFET器件只需很小的驱动功率,且开关速度优异。可以说具有“理想开关”的特性。其主要缺点是开态电阻(RDS(on))和正温度系数较高。本教程阐述了高压N型沟道功率MOSFET的特性,并为器件选择提供指导。最后,解释了Microsemi公司Advanced Power Technology (ATP) MOSFET的数据表。
功率MOSFET结构
图1为APT N型沟道功率MOSFET剖面图(本文只讨论N型沟道MOSFET)。在栅极和源极间加正压,将从衬底抽取电子到栅极。如果栅源电压等于或者高于阈值电压,栅极下沟道区域将积累足够多的电子从而产生N型反型层;在衬底形成导电沟道(MOSFET被增强)。电子在沟道内沿任意方向流动。电子从源极流向漏极时,产生正向漏极电流。沟道关断时,正向漏极电流被阻断,衬底与漏极之间的反偏PN结维持漏源之间的电势差。对于N型MOSFET,正向导通时,只有电子流,没有少子。开关速度仅受限于MOSFET内寄生电容的充电和放电速率。因此,开关速率可以很快,开关损耗很低。开关频率很高时,这让功率MOSFET具有很高的效率。
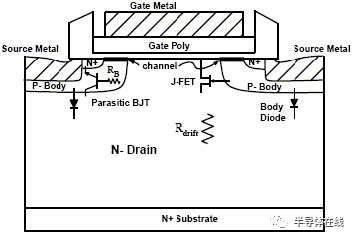
图1:N型沟道MOSFET剖面图。
开态电阻
开态电阻RDS(on)主要受沟道、JFET(积累层)、漂移区和寄生效应(多层金属,键和线和封装)等因素的影响电压超过150V时,RDS(on)主要取决于漂移区电阻。
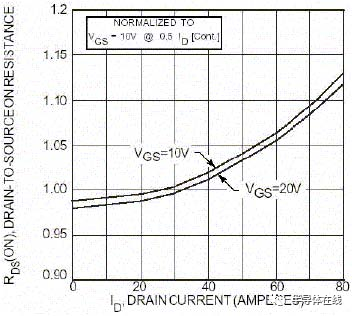
图2:RDS(on)与电流的关系。
高压MOSFET中RDS(on) 与电流的相关较弱。电流增大一倍RDS(on)仅提高了6%,见图2。

图3:RDS(on)与温度的关系。
相反,温度对RDS(on)的影响很大。如图3,温度从25℃升高到125℃,开态电阻提高近一倍。图3中曲线的斜率反映了RDS(on)的温度系数,由于载流子仅为多子,该温度系数永远为正。随着温度的升高,正温度系数将使导通损耗按照I2R增大。
功率MOSFET并联时,正的RDS(on)温度系数可以保证热稳定性,这是其很好的特性。然而,不能保证各分路的电流均匀。这一点容易被误解。MOSFET易于并联正是因为其参数的分布狭窄,特别是RDS(on)。并且与正温度系数相结合,可避免电流独占。
如图4,对于任何给定的芯片尺寸,随着额定电压的增大,RDS(on)也会随之增大。

图4:归一化后的RDS(on)与V(BR)DSS的关系。
对于功率MOS V型和功率MOS 7型MOSFET器件,通过对额定RDS(on)与V(BR)DSS的关系曲线进行拟和,可发现RDS(on)增量与V(BR)DSS的平方成正比。这种非线性关系显示了降低晶体管导通损耗的可能[2]。
本征和寄生参数
JFET寄生于MOSFET结构中,见图1。这对RDS(on)影响很大,并且是MOSFET正常操作的一部分。
本征衬底二极管
衬底和漏之间的PN结所形成的本征二极管称为体二极管(见图1)。由于衬底与源极短接,无法将反向漏极电流关断,这样体二极管构成了很大的电流通路。当反向漏极电流流过时,器件导通损耗降低,这是由于电子流过沟道,并且电子和少数载流子流过体二极管。
本征衬底二极管对于需要反向漏极电流(通常称为自振荡电流)通路的电路十分方便,例如:电桥电路。
对于这样的电路,FREDFET的反向恢复特性通常都得到了改善。FREDFET是Advanced Power Technology所使用的商标,用来区分那些采用了额外工艺步骤加快本征衬底二极管反向恢复特性的MOSFET。FREDFET中没有使用分离的二极管;仅仅是MOSFET的本征衬底二极管。通过电子辐射(经常使用的方法)或者掺杂铂来控制衬底二极管中少数载流子的寿命,极大地降低了反向恢复充电和时间。
FREDFET中额外工艺带来的负面影响是漏电流的增大,特别是高温时。然而,考虑到MOSFET开始工作时漏电流比较低,FREDFET带来的漏电流在PN结温度低于150℃时并不显著。根据电子辐射剂量的不同,FREDFET的额定RDS(on)可能比所对应的MOSFET还要高。FREDFET的衬底二极管正向压降也会稍微高于所对应的MOSFET。对于栅极充电和开关速度,两种器件性能相同。下文中,如无特别说明,MOSFET这个词既可以代表MOSFET,也可以代表FREDFET。
与分立的快恢复二极管相比,无论是MOSFET还是FREDFET,其反向恢复性能都显得很“笨重”。对在125℃工作的硬开关而言,由于衬底二极管反向恢复电流造成的开关损耗比分立快恢复二极管要高出5倍。造成这种状况的原因有两点:
1.对于MOSFET或FREDFET,体二极管的面积相同,但同样功能的分立二极管面积小很多,这样反向恢复充电效应减小了很多。
2.对于MOSFET或FREDFET,体二极管并没有像分立二极管那样对反向恢复性能进行优化。与常规硅二极管相似,体二极管反向恢复充电效应以及时间是温度,电流随时间的变化率(di/dt)和电流的函数。体二极管正向压降,VSD,随温度的变化率为2.5 mV/℃。
寄生双极晶体管
MOSFET结构中还寄生有NPN型双极晶体管(BJT),正常工作时并不会开启。但如果BJT开启并进入饱和区,将产生闩锁效应,这时只有从外部关断漏极电流才能关断MOSFET。闩锁效应产生大量的热会烧毁器件。
寄生BJT的基极与MOSFET源极短接用来防止闩锁效应,并且如果基极悬空,会极大的降低击穿电压(对同样的RDS(on) 来说)。理论上讲,关断时会产生极高的电压变化率(dv/dt),这是造成闩锁效应的主要原因。然而,对于现代常规功率MOSFET,电路很难产生如此之高的dv/dt。
如果体二极管导通后反向关断,将产生极高的电压变化率(dv/dt),这可能会造成寄生BJT开启。高dv/dt会在器件体区产生高的少数载流子(正载流子或者空穴)电流密度,体电阻上所积累的电压足以开启寄生BJT。这也是为什么器件会对整流(体二极管反向恢复)dv/dt峰值作限制的原因。由于降低了少数载流子寿命,FREDFET器件整流dv/dt峰值要高于MOSFET器件。
开关速度
由于电容不受温度的影响,因此开关速度和开关损耗也同样不受温度影响。然而,二极管反向恢复电流却随着温度提高而增大,因此,温度效应会对大功率电路中的外部二极管(可以是分立二极管和MOSFET或者FREDFET体二极管)造成影响,从而影响开关损耗。
阈值电压
阈值电压,即VGS(th),表示晶体管关断时的电压。该参数表示在阈值电压下,漏极电流可以达到多少毫安培,因此,器件工作在开与关的临界状态。阈值电压具有负温度系数,这意味着随着温度升高,阈值电压将降低。负温度系数会影响开关延时时间,因此电桥电路对于死时间有要求。
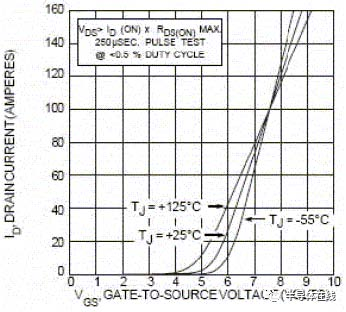
图5:传输特性。
a传输特性
图5为APT50M75B2LL MOSFET的传输特性。传输特性依赖于温度和漏极电流。从中可以发现,100安培以下,栅-源电压是负温度系数(给定漏极电流,随着温度升高,栅-源电压降低)。而在100安培以上,温度系数为正。栅-源电压温度系数和漏极电流何时从负值变为正值对于线性区操作十分重要。
击穿电压
击穿电压具有正的温度系数,我们将在后面的章节讨论。
短路能力
数据表中通常不会列出抗短路能力。这是因为常规功率MOSFET的抗短路能力无法与工作于高电流密度下的IGBT或者其他器件相提并论。这样,我们通常不认为MOSFET和FREDFET具有抗短路的能力。
数据表浏览
通常使用先进探针技术(advanced probe technology,ATP)获得的测试数据来选择合适的器件并预测器件的性能。通过测试曲线,可以从一组工作状态外推到另一组工作状态。值得注意的是:测试曲线代表的是典型性能,而非最大或者最小的极端情况。测试得到的性能有时也或多或少的依赖于测试电路;采用不同的测试电路,得到的结果会有些许差别。
额定最大值
VDSS ?C漏-源电压
在栅源短接,工作温度为25℃时,漏-源额定电压(VDSS)是指漏-源未发生雪崩击穿前所能施加的最大电压。根据温度的不同,实际雪崩击穿电压可能低于额定VDSS。关于V(BR)DSS的详细描述请参见静电学特性。
开关速度
由于电容不受温度的影响,因此开关速度和开关损耗也同样不受温度影响。然而,二极管反向恢复电流却随着温度提高而增大,因此,温度效应会对大功率电路中的外部二极管(可以是分立二极管和MOSFET或者FREDFET体二极管)造成影响,从而影响开关损耗。
阈值电压
阈值电压,即VGS(th),表示晶体管关断时的电压。该参数表示在阈值电压下,漏极电流可以达到多少毫安培,因此,器件工作在开与关的临界状态。阈值电压具有负温度系数,这意味着随着温度升高,阈值电压将降低。负温度系数会影响开关延时时间,因此电桥电路对于死时间有要求。
PD -总功耗
总功耗标定了器件可以消散的最大功耗,可以表示为最大结温和管壳温度为25℃时热阻的函数。

式4
线性降低因子与RθJC的倒数成正比。
TJ, TSTG-工作温度和存储环境温度的范围
这两个参数标定了器件工作和存储环境所允许的结温区间。设定这样的温度范围是为了满足器件最短工作寿命的要求。如果确保器件工作在这个温度区间内,将极大地延长其工作寿命。
EAS-单脉冲雪崩击穿能量
如果电压过冲值(通常由于漏电流和杂散电感造成)未超过击穿电压,则器件不会发生雪崩击穿,因此也就不需要消散雪崩击穿的能力。雪崩击穿能量标定了器件可以容忍的瞬时过冲电压的安全值,其依赖于雪崩击穿需要消散的能量。
定义额定雪崩击穿能量的器件通常也会定义额定EAS。额定雪崩击穿能量与额定UIS具有相似的意义。EAS标定了器件可以安全吸收反向雪崩击穿能量的高低。
测试电路的条件在标注中标明,EAS等于

式5
L是电感值,iD为电感上流过的电流峰值,其会突然转换为测量器件的漏极电流。电感上产生的电压超过MOSFET击穿电压后,将导致雪崩击穿。雪崩击穿发生时,即使MOSFET处于关断状态,电感上的电流同样会流过MOSFET器件。电感上所储存的能量与杂散电感上存储,由MOSFET消散的能量类似。
MOSFET并联后,不同器件之间的击穿电压很难完全相同。通常情况是:某个器件率先发生雪崩击穿,随后所有的雪崩击穿电流(能量)都从该器件流过。
EAR -重复雪崩能量
重复雪崩能量已经成为“工业标准”,但是在没有设定频率,其它损耗以及冷却量的情况下,该参数没有任何意义。散热(冷却)状况经常制约着重复雪崩能量。对于雪崩击穿所产生的能量高低也很难预测。
额定EAR的真实意义在于标定了器件所能承受的反复雪崩击穿能量。该定义的前提条件是:不对频率做任何限制,从而器件不会过热,这对于任何可能发生雪崩击穿的器件都是现实的。在验证器件设计的过程中,最好可以测量处于工作状态的器件或者热沉的温度,来观察MOSFET器件是否存在过热情况,特别是对于可能发生雪崩击穿的器件。
IAR - 雪崩击穿电流
对于某些器件,雪崩击穿过程中芯片上电流集边的倾向要求对雪崩电流IAR进行限制。这样,雪崩电流变成雪崩击穿能量规格的“精细阐述”;其揭示了器件真正的能力。
静态电特性
V(BR)DSS:漏-源击穿电压
V(BR)DSS(有时候叫做BVDSS)是指在特定的温度和栅源短接情况下,流过漏极电流达到一个特定值时的漏源电压。这种情况下的漏源电压为雪崩击穿电压。
如图8所示,V(BR)DSS是正温度系数,温度高时的MOSFET漏源击穿电压比温度低时要大,实际上,温度低时V(BR)DSS小于25℃时的漏源电压的最大额定值。例如图18,在-50℃, V(BR)DSS大约是25℃时最大漏源额定电压的90%。

图8. 归一化后的雪崩击穿电压随温度的变化
VGS(th):阈值电压
VGS(th)是指加的栅源电压能使漏极开始有电流或者关断MOSFET时停止流过电流时的电压,测试的条件(漏极电流,漏源电压,结温)也是有规格的。正常情况下,所有的MOS栅极器件的阈值电压都会有所不同。因此,VGS(th)的变化范围是规定好的。正如前面所讨论过在温度的影响下,VGS(th)是负温度系数,这就意味着当温度上升时,MOSFET将会在比较低的栅源电压下开启。
RDS(on):导通电阻
RDS(on)是指在特定的漏电流(通常为ID电流的一半)、栅源电压和25℃的情况下测得的漏-源电阻,除非另有规定。
IDSS:零栅压漏极电流
IDSS是指在当栅源电压为零时,在特定的漏源电压下的漏源之间泄漏电流。既然泄漏电流随着温度的增加而增大,IDSS在室温和高温下都有规定。漏电流造成的功耗可以用IDSS乘以漏源之间的电压计算,通常这部分功耗可以忽略不计。
IGSS —栅源漏电流
IGSS是指在特定的栅源电压情况下流过栅极的漏电流
动态特性
从图九可以看出功率管的寄生电容分布情况,电容的大小由功率管的结构,材料和所加的电压决定。这些电容和温度无关,所以功率管的开关速度对温度不敏感(除阈值电压受温度影响产生的次生效应外)
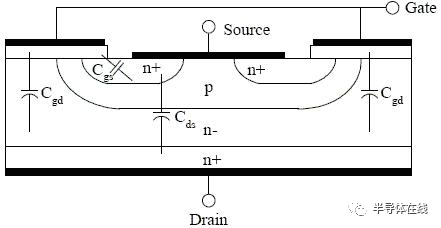
图9. 功率管的电容分布图
由于器件里的耗尽层受到了电压影响,电容Cgs和Cgd随着所加电压的变化而变化。然而相对于Cgd,Cgs受电压的影响非常小,Cgd受电压影响程度是Cgs的100倍以上。
如图10所示为一个从电路角度所看到的本征电容。受栅漏和栅源电容的影响,感应到的dv/dt会导致功率管开启。

图10. 功率管的本征电容
简单的说,Cgd越小对由于dv/dt所导致的功率管开启的影响越少。同样Cgs 和Cgd形成了电容分压器,当Cgs 与Cgd比值大到某个值的时候可以消除dv/dt所带来的影响,阈值电压乘以这个比值就是可以消除dv/dt所导致功率管开启的最佳因数,APT功率MOSFET在这方面领先这个行业。
Ciss :输入电容
将漏源短接,用交流信号测得的栅极和源极之间的电容就是输入电容。Ciss是由栅漏电容Cgd和栅源电容Cgs并联而成,或者
Ciss = Cgs +Cgd
当输入电容充电致阈值电压时器件才能开启,放电致一定值时器件才可以关断。因此驱动电路和Ciss对器件的开启和关断延时有着直接的影响。
Coss :输出电容
将栅源短接,用交流信号测得的漏极和源极之间的电容就是输出电容。Coss是由漏源电容Cds和栅漏电容Cgd并联而成,或者
Coss = Cds +?Cgd
对于软开关的应用,Coss非常重要,因为它可能引起电路的谐振
Crss :反向传输电容
在源极接地的情况下,测得的漏极和栅极之间的电容为反向传输电容。反向传输电容等同于栅漏电容。
Cres =?Cgd
反向传输电容也常叫做米勒电容,对于开关的上升和下降时间来说是其中一个重要的参数,他还影响这关断延时时间。
图11是电容的典型值随漏源电压的变化曲线.
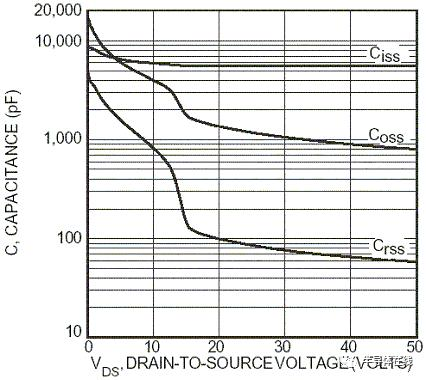
图11. APT50M75B2LL的电容VS电压曲线
电容随着漏源电压的增加而减小,尤其是输出电容和反向传输电容。
Qgs, Qgd, 和 Qg :栅电荷
栅电荷值反应存储在端子间电容上的电荷,既然开关的瞬间,电容上的电荷随电压的变化而变化,所以设计栅驱动电路时经常要考虑栅电荷的影响。
请看图12,Qgs从0电荷开始到第一个拐点处,Qgd是从第一个拐点到第二个拐点之间部分(也叫做“米勒”电荷),Qg是从0点到vGS等于一个特定的驱动电压的部分。
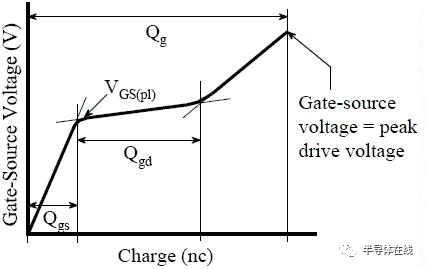
图12. 栅源电压和栅电荷的函数曲线
漏电流和漏源电压的变化对栅电荷值影响比较小,而且栅电荷不随温度的变化。测试条件是规定好的。栅电荷的曲线图体现在数据表中,包括固定漏电流和变化漏源电压情况下所对应的栅电荷变化曲线。在图12中平台电压VGS(pl)随着电流的增大增加的比较小(随着电流的降低也会降低)。平台电压也正比于阈值电压,所以不同的阈值电压将会产生不同的平台电压。
开关电阻时间
完全是因为历史原因,这个指标才会包括在数据表中。
td(on) :导通延时时间
导通延时时间是从当栅源电压上升到10%栅驱动电压时到漏电流升到规定电流的10%时所经历的时间。
td(off) :关断延时时间
关断延时时间是从当栅源电压下降到90%栅驱动电压时到漏电流降至规定电流的90%时所经历的时间。这显示电流传输到负载之前所经历的延迟。
tr :上升时间
上升时间是漏极电流从10%上升到90%所经历的时间。
tf :下降时间
下降时间是漏极电流从90%下降到10%所经历的时间。
开关感应能量
在现实的功率变换器中,由于开关电阻数据难以反应开关能量,ATP很多的MOSFET和FREDFET包含了开关感应能量的数据。这样对于电源设计人员来说非常方便,他们可以直接对比MOSFET或FREDFET与另外晶体管,甚至是另一种技术的例如IGBT,或者大多数成功应用的功率管在这方面性能。
图13为开关电感测试电路图。是一种低占空比的脉冲测试,这样可以在下一个周期来临之前使电感的能量完全泄放,自身发热也就可以被忽略。被测器件和嵌位二极管的温度可以由温度强制系统来调节。

图13. 开关电感损耗的测试电路
下面的测试条件在一个动态特性表格中被定义:VDD如图13,测试电流,栅驱动电压,栅电阻,还有结温。注意的是门极电阻包括驱动栅极IC的阻抗。大部分原因是由于测试电路中二极管的存在,开关时间和开关能耗会随温度变化,所以在室温和高温的情况下分别进行了数据测试,高温测试时要将二极管和被测器件一起加热。曲线图也会提供开关时间和开关能耗与漏电流和门极电阻的关系曲线。延迟时间和电流上升下降时间与开关电阻的定义一样。
数据表中的实际开关波形用于解释被测参数的变化情况,图14为导通时的波形及定义,由于实际应用电压和数据表中开关能量的测试电压之间的不同,开关能量也会不同。例如,如果测试电压为330伏,而应用电压为400伏,那么实际的开关能量就是用数据表中的开关能量值乘以400/330。
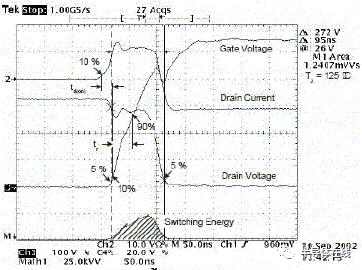
图14. 导通波形及定义
开关时间和能量与电路的其他器件和漏感有很大关系。二极管尤其对导通能量产生很多影响。串联进源极的漏感对开关时间和能量有明显的影响。因此在数据表中的开关时间和开关能量的值和曲线只是典型情况,这些曲线有可能与实际的电源电路或马达驱动电路的测试结果有所不同。
Eon :存在二极管情况下的开关导通能量
Eon为嵌位电感导通能量包含被测器件整流二极管的反向恢复电流产生的导通损耗。注意的是FREDFET,在桥式开关电路应用中,由于体二极管的影响使其不能迅速关断,所以这种情况下的导通能量是使用快速恢复二极管的的5倍,测试电路和图13类似。
开关导通能量是对漏电流和漏源电压的积分,积分范围是从漏电流上升到测试电流的5%或10%到电压下降到测试电压的5%区间。出于仪器分辨率的考虑,在不影响精度和可靠性前提下将积分区间设置在5%到10%的上升电流到5%的下降电压之间,如图14。
Eoff :开关关断能量
这是嵌位电感关断能量,图13为测试电路,图15为关断波形和定义。Eoff是对漏电流和漏源电压的积分,积分范围是从栅源电源降至90%到漏电流达到0这个区间。测试关断能量的方法与JEDEC(全球半导体标准组织)的24-1号标准一致。

图15. 关断波形及定义
热-机械特性
RθJC:结到管壳的热阻
热阻是从芯片的表面到器件外部之间的电阻,功率损失的结果是使器件自身产生热量,热阻就是要将芯片产生的热量和功耗联系起来。注意ATP的热阻测试显示管壳的塑料部分与金属部分的温度相同。
最大的RθJC值留有一定的裕度以应对生产工艺的变化。由于制作工艺的提高,工业上趋向于减小最大R?JC和典型值之间的裕度。通常情况下这个裕度的值不会公布。
ZθJC :结到管壳瞬态热阻抗
瞬态热阻抗主要考虑的是器件的热容,所以它可以用做评估由于瞬态功率损失所产生的当前的温度。
热阻测试仪给被测器件提供不同占空比的脉冲,等待结温在各脉冲之间稳定下来。这种测试‘单脉冲’瞬态热阻抗响应。用这种方法我们可以拟合出电阻-电容的模型。图16为瞬态热阻抗RC模型。其他一些数据表中电阻电容是以并联的形式体现的,但这种表示方法是错误的。在图16中,这些电容被接地,器件的值没有变化。在这个模型中,对于中间级节点没有实际的物理意义。不同的电阻电容对主要是为了更好的与实际测量的热阻数据相对应。

图16. 瞬态热阻抗RC模型
为了用RC模型对温度上升时进行仿真,可以提供一个电流源,电流源的幅度就是MOSFET消耗的大小,于是就可以用PSPICE或其他电子仿真软件随意设置输入消耗的功率大小。如图16所示,通过调节ZEXT(由ZEXT调节到短路),就可以估算结-壳温度上升情况。
数据表中的瞬态热阻抗的‘全家福曲线’是根据RC热阻抗模型用简单的矩形脉冲仿真得到。图17为所举的一个例子。对于一个矩形功率脉冲,你可以用‘全家福曲线’去估算温度上升的峰值,这种方法在电源中非常常见。然而,由于最小脉冲宽度是10微秒,所以图标中只是开关频率小于100 kHz的情况。在更高的频率可以简单用热阻RθJC

图17 热阻抗的‘全家福曲线
数据表中的例子推导
假设在一个开关电源的应用中,我们想在200KHz、400V、35%平均占空比的情况下,硬开关电流为15安培,门极电压为15V,导通时门极电阻为15Ω,关断时的门极电阻为5Ω。假设我们想让结温最大达到112 ℃,保持壳的温度维持在75℃。用一个耐压500V的器件,在应用电压和VDSS之间只有100V的裕度。在400V的总线上面,这么小的裕度是足够的,因为MOSFET很大的雪崩击穿能力可以使这条总线是安全的。它是一种连续升压模式,因此没必要用有更快反向恢复体二极管的FREDFET;用MOSFET的效果也将会很好。你会选那种器件呢?

既然是一个关于高频的应用,功率MOS 7型将是最好的选择,让我们看一下APT50M75B2LL,它的电流能力为57A,比所需开关电流的3倍还多,在高频开关和硬开关的考虑中应该是优先考虑的。我们将会估算传输损耗,开关损耗,和要看是否产生的热量可以快速散发掉。总功耗的计算公式为

在112℃时的RDS(on)是室温下的1.8倍(参照图3)。所以传输损耗为Pconduction =1.8-0.075Ω:15A
对于开关损耗,我们可以在图18中看到在125℃下开关损耗和电流的关系图。即使我们应用的要求最大值为112℃结温,这个图表已经足够能满足需要,因为电路中除了二极管对温度比较敏感外,MOSFET的开关能量受温度影响比较小,所以在112℃ 和 125℃之间将不会发生大的变化。在任何情况下,我们都是在进行保守的估算。
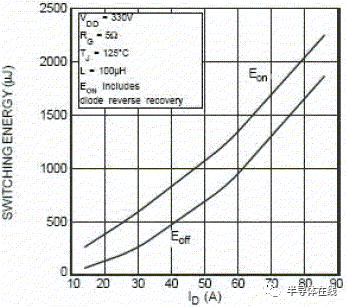
图18. APT50M75B2LL的感应开关损耗
从图18可以看出,在15A时,Eon大约为300 μJ, Eoff大约为100 μJ。这些是在330V的情况下测试得到。而我们的应用电压为400V。所以开关能量可以计算为:

图18中的数据是在导通时门极电阻为15Ω和关断时的门极电阻为5Ω的情况下测得。所以我们可以得到开关能量随门极电阻变化曲线。如图19.
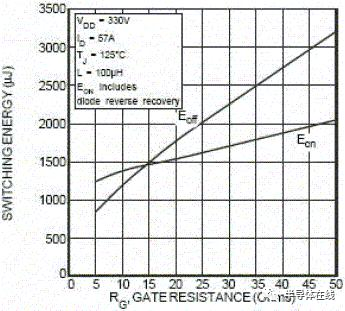
图19. 开关能量 VS 门极电阻
即使图19中测试电流比我们应用电流要大,对于我们的情况,开关能量可以从图19中按一定比例得到。从5Ω 到 15 Ω,Eon变化的系数为1.2(大约1500μJ / 1250μJ,在图19中可以看到)。电压的修正数据可以查看图18,我们得到Eon =1.2-364μJ = 437μJ
开关损耗为
Pswitch = fswitch:( Eon + Eoff) = 200kHz-(437μJ +121μJ) = 112W
Pconduction +Pswitch = 123W ,这个数据在要求结温小于112℃,壳温75℃的范围之内。所以APT50M70B2LL满足这个应用例子的要求。用同样的计算方法可以看看是否小一点的MOSFET可以满足要求。实际应用中的开关损耗要比单个器件的损耗要高的多。为了保持壳温为75℃,可以在壳和散热片之间使用用陶瓷结构(用于电隔离)。MOSFET的优势在于它的谐振缓冲特性技术,可以不用担心电压和温度对MOSFET的影响,减小开关损耗。
审核编辑:汤梓红
-
MOSFET参数解读2024-12-30 613
-
功率MOSFET基本结构:平面结构2023-06-05 2608
-
简单认识功率MOSFET的结构特点2023-02-16 3612
-
全面解读MOSFET结构及设计详解2023-01-26 3054
-
功率MOSFET重要参数2022-07-26 4635
-
功率MOSFET特性参数的理解2022-07-13 928
-
MOSFET规格书解读与参数详解2021-06-23 1965
-
功率MOSFET的参数怎么看?教你在实际应用选择功率MOSFET2019-11-17 4770
-
电子书:功率MOSFET管的选型和电路设计方案2019-03-06 10002
-
SiC-MOSFET功率晶体管的结构与特征比较2018-11-30 5577
-
桥式拓扑结构功率MOSFET驱动电路设计2018-08-27 2560
-
功率MOSFET结构及特点2016-10-10 7572
-
功率Mosfet参数介绍2009-11-21 9427
全部0条评论

快来发表一下你的评论吧 !

