

微电子封装技术简介
制造/封装
描述
微电子封装基本类型每15年左右变更一次。
1955年开始主流TO封装,到1965年转变为双列直插式封装;1980年开始,表面贴装技术逐步取代了通孔插装技术,这是封装技术的第一次重大变革;1995年之后,BGA封装形式兴起,成为封装技术的第二次重大变革;2010年起,晶圆级封装、芯片尺寸封装、3D封装等等成为封装技术的第三次重大变革;最近几年来,随着移动通信和信息处理技术的快速发展,先进封装技术得到了广泛应用。本期主要结合微盟电子产品浅要介绍微电子封装技术,欢迎大家各抒己见,互相讨论交流。
微盟电子产品结合传统封装和先进技术,致力于开发电源管理类项目,目前有多个产品系列,包括LDO系列,DC/DC系列、LED DRIVER、AC/DC系列、锂电管理、电压检测系列、数模混合芯片、音频功放IC系列等。已广泛应用于电器、手机、充电器、适配器、安防监控、智能电网、工控设备等领域,多年的专业深耕获得了客户的认可。
对传统封装而言,由于工艺成熟、成本低廉、产量高,在集成电路封装市场上依然占有约一半的份额。以SOT、DIP、SOP、DFN、QFN为主的传统封装,几乎涵盖了微盟电子所有的产品系列。
下图1以DFN为例,对传统封装构造进行简要介绍,传统封装主要由5个部分组成,包括:①芯片;②引线框架;③胶体黏结;④焊线;⑤塑封成型。利用胶体将芯片固定在框架上,通过焊线实现芯片与外部管脚的电连接,通过塑封成型对内部进行保护并实现热传递。
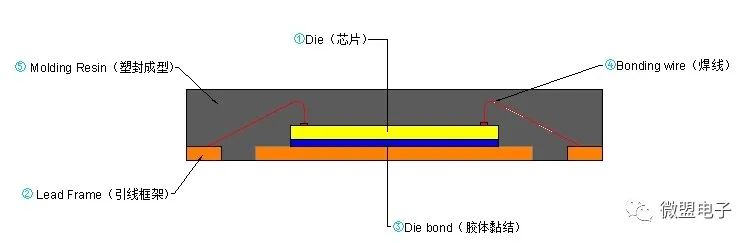
图1:传统封装构造
随着芯片产业竞争越来越激烈,先进封装已成为半导体创新、增强功能、性能和成本效益的关键。
对先进封装而言,微盟电子产品融合Flip chip、FOPLP等先进技术,进一步缩小封装尺寸,提升产品性能,不断推动产品往深化方向发展,应用在微盟电子ME3114系列等产品上。以Flip chip为例(倒装工艺有多种,本文只选取铜柱Sn帽工艺进行分析),对其组成结构进行简单介绍。
倒装芯片技术是通过芯片上的凸点直接将元器件朝下互连到基板、载体或者电路板上。图2(a)是封装成品,其主要组成部分是:①塑封成型;②引线框架;③带凸点的芯片。可以看出与传统封装相比,没有焊线和胶体;但这部分的功能并没有缺少,只是用铜柱凸点替代焊线实现电连接,利用回流焊实现铜柱凸点上的焊帽与框架黏结,从而替代胶体黏结;
图2(b)是图2(a)红色圆圈处部分放大图,是采用铜柱Sn帽(Copper Pillar with Solder Cap,C2)的铜柱凸点的结构示意图,主要是在PAD开口处沉积UBM层,在PAD的金属化层与凸点金属化层之间充当过渡层,使得两者有效兼容。 随后通过光刻和电镀工艺构造铜柱,再将焊料电镀在铜柱顶部,回流形成焊帽。
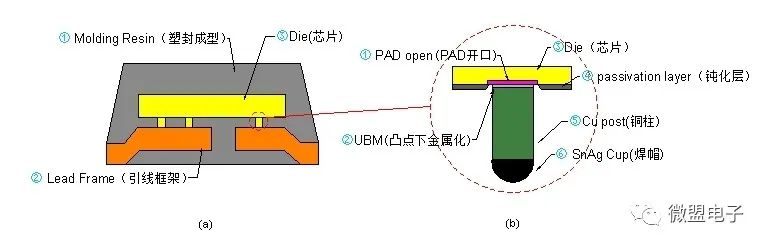
图2:Flip chip封装构造
与传统封装相比,先进封装的互连线短,有更低的电阻和寄生电容和电感,有更好的频率特性和更低的功耗,且封装利用率更高。
对于电子产品而言,封装虽是制作工艺的后道工序,却起着至关重要的作用。封装工艺技术的进步推动着新一代器件和电路的发展,牵动着整机系统的小型化和整体性能水平的升级换代。
审核编辑:汤梓红
-
微电子封装及微连接技术.pdf2012-08-19 5440
-
微电子封装技术2013-12-24 6540
-
微电子技术2017-11-20 3410
-
新型微电子封装技术的发展和建议2018-09-12 3713
-
关于新型微电子封装技术介绍的太仔细了2021-04-23 3211
-
探讨新型微电子封装技术2011-01-28 4666
-
微电子焊接与封装2017-10-18 1330
-
微电子封装的概述和技术要求2018-06-10 19506
-
微电子封装技术的发展趋势2020-05-26 4154
-
现阶段封装技术在微电子中的应用概述2020-06-08 1906
-
微电子器件封装——封装材料与封装技术2022-06-22 645
-
微电子封装技术探讨2022-11-28 2443
-
微电子封装用主流键合铜丝半导体封装技术2023-06-06 1411
-
揭秘微电子制造与封装技术的融合之路2023-12-18 1534
-
微电子制造和封装技术发展研究2023-12-19 1619
全部0条评论

快来发表一下你的评论吧 !

