

光刻可制造性检查如何检测掩模版质量
制造/封装
描述
在上一期小讲堂中,我们介绍了光学邻近效应修正技术(Optical Proximity Correction,OPC)是如何修正掩模版来确保曝光后图形满足设计要求。这一期我们将主要探索光刻可制造性检查(Lithography Manufacture Check, LMC)是如何检查掩模版质量,确保光刻工艺窗口的。
为何需要光刻可制造性检查
在计算光刻大量应用与普及之前,掩模版的修正主要靠的是工程师的经验。工程师们直接将掩模版制造出来,在晶圆上检查曝光后电路图形的畸变,然后在下一次掩模版生产前修正有畸变的地方。
随着工艺节点不断变小,掩模版制造难度日益增加,耗费的资金成本从数十万到上亿,呈指数级增长,同时生产掩模版的时间成本也大幅增加。如果不能在制造掩模版前就保证其设计有足够高的品质,重新优化设计并再次制造一批掩模版将增加巨大的资金成本和时间成本。
划重点
计算光刻正是因为可以通过仿真模拟来避免重复制造掩模版,而逐渐普及成为掩模版生产前的必备流程。同样在计算光刻应用中,当我们使出浑身解数将掩模版优化完成后,一定要使用光刻可制造性检查,来确保这张掩模版的品质,才可以送去掩模工厂制造。否则一旦有哪怕一星半点的问题,都有可能导致整块掩模版报废无法使用,带来巨大损失。
如何进行光刻可制造性检查
正如前面几篇小讲堂中介绍的,计算光刻会对光刻过程进行建模,通过仿真来预测曝光后晶圆上的情况。所以当光学邻近效应修正技术(OPC)过程结束时,我们得到了修正之后的掩模版。接下来就可以使用光刻可制造性检查(LMC)对它进行再次仿真,并且将仿真的结果与最开始的版图设计进行比较来检查潜在的缺陷。
值得注意的是,即便经过了非常周全的修正,曝光后的结果也不可能和原始设计一模一样。因此,光刻可制造性检查(LMC)的目的并不是检查出所有和原始设计的偏差,而是从可制造性的角度,去探测可能会最终影响器件性能的坏点(Hot spot)。
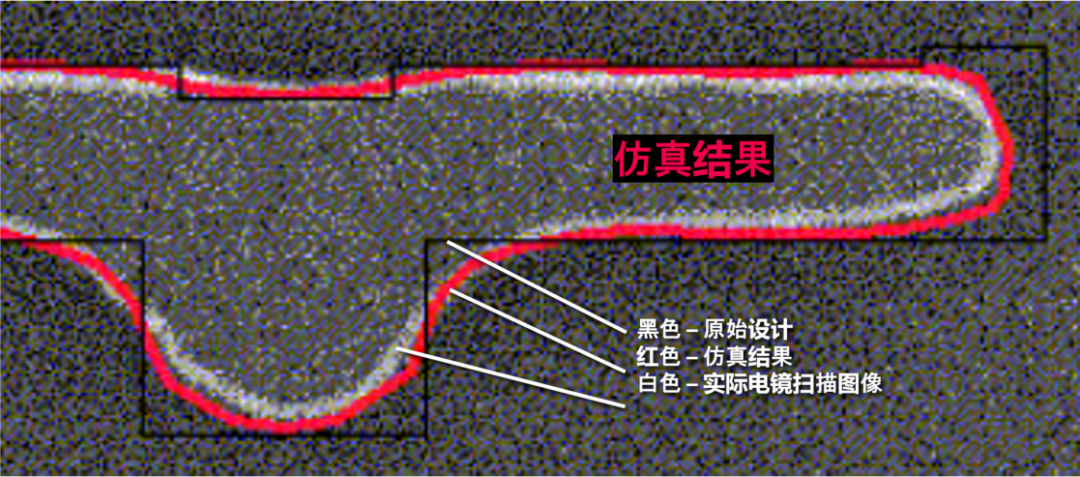
图二: 典型的曝光结果与原始设计的对比
那么该如何找到对光刻可制造性有潜在影响的地方呢?为此,光刻可制造性检查(LMC)准备了大量的探测器,不同的探测器会出于不同的目的,针对性地检查某一种趋势。比如说,桥连(Bridging)探测器会针对线条中线宽非正常变宽产生的局域靠近部分进行测量。在实际曝光中,这样的桥连行为可能导致后续的电路图形在晶圆上短路。于是在仿真上,桥连探测器会专注地过滤出所有桥连区域进行测量,并且将测量的结果和一个预设的标准值进行比对。如果量测出的线宽低于标准值,那么就会生成一个标记,把这个潜在坏点给报告出来。
这就好比说,当我们对一辆汽车检修的时候,我们可以从头到尾地将汽车和一辆相同型号崭新出厂的标准车辆对比。但是这样做会发现大量无关紧要的差异,既会干扰我们的判断而且效率极低。实际上检修人员会配置专门的检修流程,对某些特定功能特定部位去做针对性检查,把真正对汽车性能有危害的隐患检测出来。而在光刻领域,我们则会配置各种不同的探测器去检查掩模版质量。
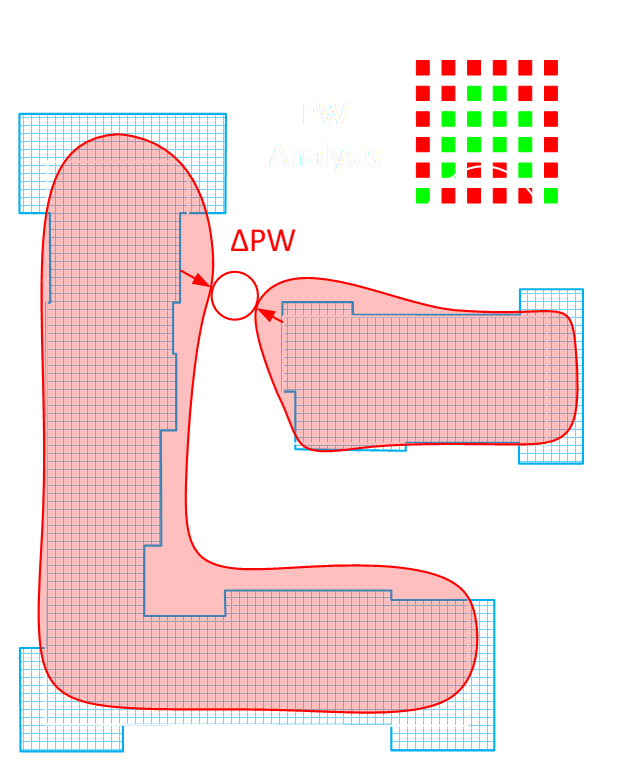
图三: 桥连探测器搜寻到潜在的桥连区域
除开桥连探测器,光刻可制造性检查(LMC)预设了数十种探测器,针对性地处理各种可能会影响最终电路质量的潜在坏点。如果工程师们在工艺研发的过程中,在晶圆上发现了全新类型的坏点,光刻可制造性检查(LMC)软件同样也能模块化地组装出一个新的自定义探测器,用以灵活地调节探测模式。

图四: 光刻可制造性检查(LMC)
提供大量的检测器以应对不同的检测需求
1:拐角平滑;2:线端缩短;3:颈缩,4:桥连,
5:线条均匀性;6:图样缺失;7:额外显影;
8:波纹效应;9:边缘放置误差
实际上,得益于高质量的光学邻近效应修正技术,修正后的掩模版在最佳曝光条件下一般是不会存在任何坏点的,光刻可制造性检查(LMC)更大的责任是为了确保足够大的工艺窗口。
//工艺窗口
涨知识
虽然***的控制十分精准,可是对于精度达到纳米级别的光刻工艺来说,一些极其微小的参数波动可能会对光刻结果产生巨大干扰。因此我们不仅仅需要掩模版在最佳曝光条件下完美无缺,还需要它在一定程度的参数波动下也仍然能够成功曝光出高质量图形。而这个可以被容忍的参数波动就被称为工艺窗口。
打个比方,一个合格的轮胎可以保证车辆行驶的时候既静音又不打滑。但是当我们检测轮胎质量的时候,不仅仅要检测它在高质量平整路面上的表现,还需要检测草地泥地雨雪路面的表现。只有确保轮胎能够容忍各种复杂路况后,我们才能信任轮胎的质量。
这种对复杂情况的容忍度在光刻领域就是工艺窗口。
如何保证工艺窗口
在光刻可制造性检查(LMC)中,探测工艺窗口其实很简单,我们只要在仿真的时候对某些工艺参数故意加入一些偏差就好了。比如说,一根线条在最佳曝光条件下质量很高,如果我们将曝光时的进光量削减2%,那这跟线条可能就会出现无法容忍的颈缩坏点。
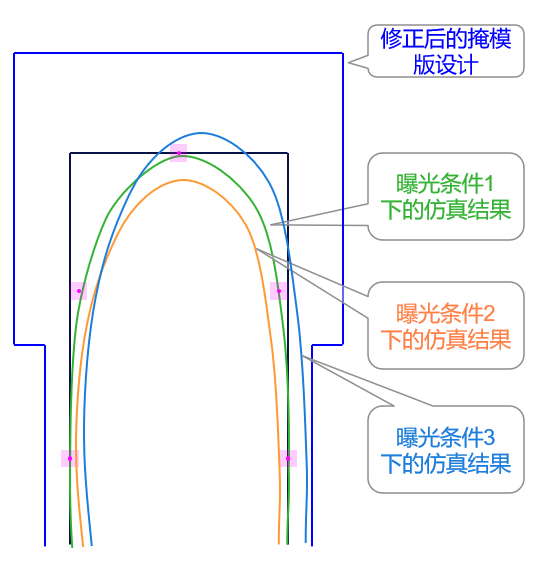
图 a

图 b
图五:
a)工艺窗口内的不同曝光条件下,曝光结果大不相同
b) 高质量掩模版在一个足够大的工艺窗口内均没有坏点
在实际的光刻可制造性检查(LMC)使用中,我们会基于期望的工艺窗口设置多种不同的工艺偏差,并且在每种偏差下都针对性地设置大量合适的探测器。而一旦我们发现了不可忽视的严重坏点,光刻可制造性检查会将坏点的详细信息记录下来,反馈给光学邻近效应修正工程师。工程师会选择调试参数重新进行掩模版修正,或者在坏点周围进行局部优化。重新调整后的掩模版设计也会需要重新进行光刻可制造性检查。通过这样的光学邻近效应修正技术到光刻可制造性检查的多次迭代,我们会修复掉所有坏点。最终,当我们确保在一个足够大的工艺窗口下均无法探测到坏点时,我们才能放心地签发这张掩模版给到掩模版生产厂。
编辑:黄飞
-
什么是掩模版?掩模版(光罩MASK)—半导体芯片的母板设计2023-12-25 84585
-
华大九天Empyrean GoldMask平台重构掩模版数据处理方案2025-08-26 2864
-
龙图光罩90nm掩模版量产,已启动28nm制程掩模版的规划2025-07-30 12745
-
【「芯片通识课:一本书读懂芯片技术」阅读体验】了解芯片怎样制造2025-03-27 1708
-
光刻图形转化软件免费试用2025-05-02 6904
-
光刻技术原理及应用2012-01-12 10852
-
LCD段码屏铬版掩模版2018-11-22 2017
-
掩模版主要厂商市场份额包括国外企业和国内企业2018-08-18 15262
-
集成电路制造的光刻与刻蚀工艺2021-04-09 2322
-
***的简易工作原理图 掩模版都有哪些种类?2023-02-13 3671
-
一文解析EUV掩模版缺陷分类、检测、补偿2023-06-07 4180
-
解析光刻芯片掩模的核心作用与设计2024-01-18 2643
-
晶合集成成功生产首片半导体光刻掩模版,计划2024年Q4量产2024-07-23 1578
-
晶合集成迎来半导体光刻掩模版量产,推动半导体产业发展2024-07-24 2247
-
光刻技术中的掩模形貌效应详解2026-03-24 498
全部0条评论

快来发表一下你的评论吧 !

