

T8~T10超微焊粉助力微间距芯片封装
电子说
描述
焊锡粉是一种用于电子工业的连接材料,主要由Sn和其他金属(如Pb、Ag、Cu等)组成的合金粉末。焊锡粉可以用来制备锡膏,用于表面贴装技术(SMT)中的电子元件焊接。焊锡粉的质量要求包括化学成分、形貌、粒度分布、氧含量等方面。
焊锡粉根据粒径可分为常规焊锡粉(T6以下)和超微焊锡粉(T6-T10)。目前常规焊锡粉的主流制备方法有离心雾化法和超声雾化法。然而,这两种方法在制备T6以上的超微焊锡粉时,都存在一些问题和局限性。
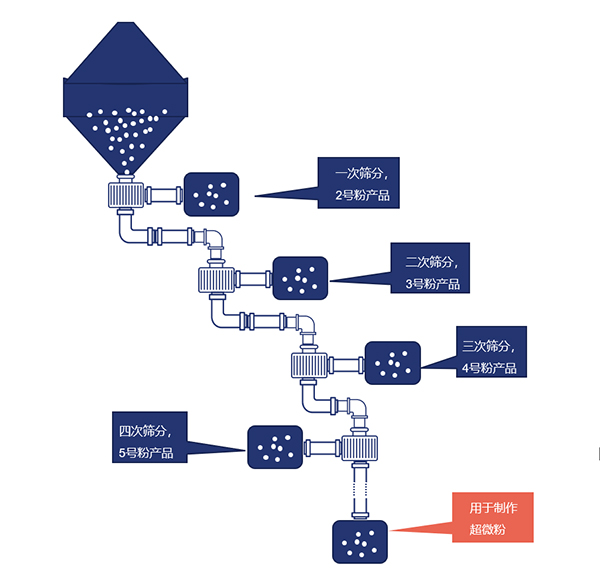
图1.常规焊锡粉制备工艺
离心雾化法工艺成熟,其产量大,获得锡粉粒径范围广,从Type3、Type4至Type5、Type6锡粉均有一定生产比率。但当用于制备T6以上超微粉时,会面临以下问题:
1. 尺寸难以控制,粒度分散,无法精确分析,质量不稳定,影响应用性能;
2. 氧含量难以控制,进而影响焊料的润湿性和可焊性;
3. 球形度差、合金粉末表面破损,容易引起氧化、焊剂腐蚀,导致锡膏的流变性差、重现性差,可靠性差。
超声波雾化法制备的焊锡粉具有优良的品质,如球形度好、氧含量低等,是目前欧洲国家主流的制粉工艺。但当用于制备T6以上超微粉时,有以下痛点:
1. 超声雾化法的设备成本较高,且对原料锡锭的质量要求较高,制粉效率低,不适合大规模生产;
2. T6以上的超微粉收获率低,难以满足T6以上焊锡粉的大量需求;
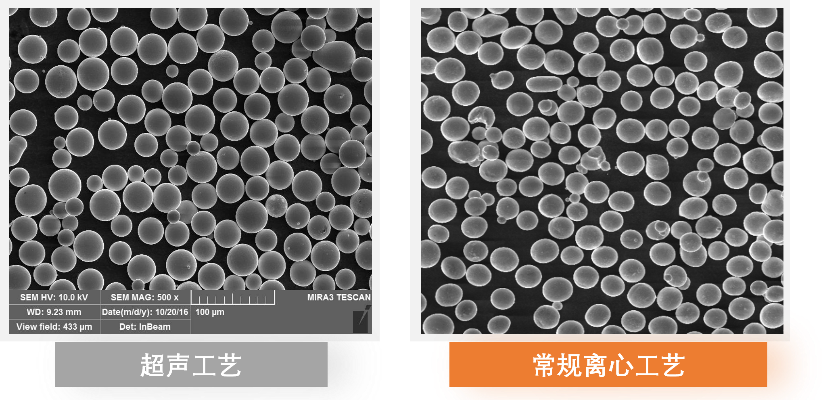
图2.超声雾化和常规离心雾化工艺制备的焊锡粉形貌(SEM)
随着微电子与半导体封装技术的发展,芯片焊盘尺寸和间距也越来越小,焊盘的精度和密度不断提高,焊接的难度和要求不断增加。比如,现在手机,手表上最小的元器件是01005,0.35pitch,继续往更微,更细,更密的方向发展,下一代产品就是008004,即公制0201,03015只是一个过渡产品。0.35pitch的焊盘只有0.2mm,更有裸芯片的贴装要求0.15pitch,bump焊盘只有0.08mm。这些超微间距的芯片,给焊接带来了巨大的挑战。因此,除了满足常规芯片尺寸的封装要求,锡膏还须适用于越来越多的微型化封装场景。
为了适应更微小间距的芯片封装需求,深圳福英达推出了T8~T10超微焊粉。该焊粉采用了福英达专利制粉技术——液相成型球形合金粉末制备技术,该技术运用了超声波空化效应原理,可用于T6(5~15μm)以上超微焊粉制备,并已规模量产(每个小时产能达40kg,年产能可达160t)。
运用液相成型技术制备的T8~T10超微焊粉产品,具有以下优势:
1. 多种型号尺寸超细焊粉量产, T7 (2-11μm), T8 (2-8μm), T9 (1-5μm) and T10 (1-3μm);
2. 合金焊粉粒径可控,粒度分布高度集中;
3. 真圆度高达到100%,下锡更流畅,保证印刷和点胶性能的稳定性。
4. 焊粉表面coating 技术,氧含量低,拥有优秀的可靠性;
5. 可制备多种合金型号、低温 (熔点温度139°C) & 中高温 (219~245°C) 超微焊粉。

图3.福英达液相成型技术制备的超微焊粉形貌(SEM)
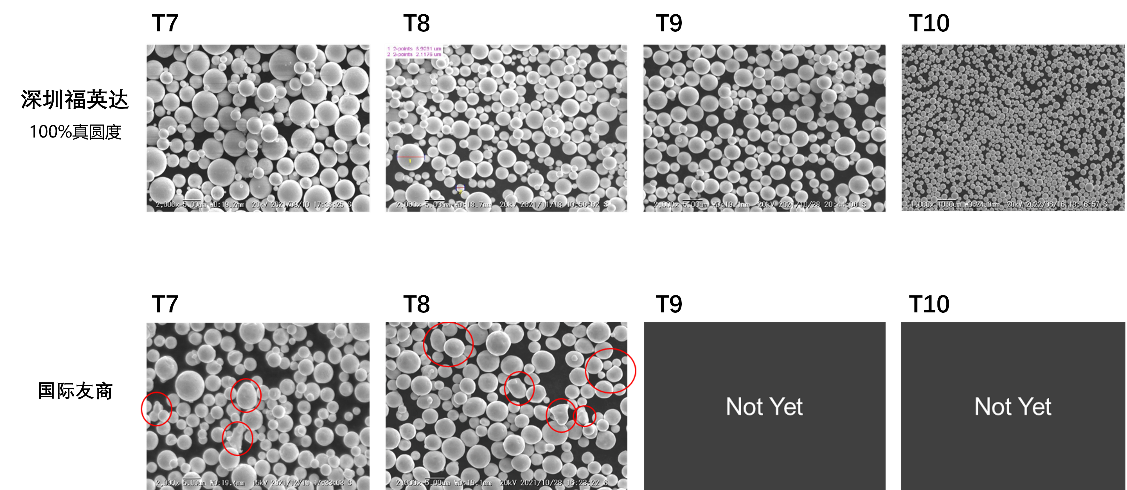
图4.深圳福英达与国际友商超微焊粉形貌对比
由此可见,福英达的T8~T10超微焊粉在粒径、形貌、性能方面,具有明显的优势,能够满足微间距芯片封装的高要求。
福英达的T8~T10超微焊粉已广泛应用在SMT、固晶、微凸点、窄间距、点胶、喷印、激光焊接等锡膏产品中,随着微电子与半导体封装技术的发展,其应用领域也越来越广泛,目前已在微光电显示、汽车电子、物联网、手机通讯等消费类电子、SiP系统级封装等领域得到快速发展,获得了业内用户的一致好评,受到了全球SMT电子化学品制造商、微光电制造商和半导体封装测试商的普遍认可。
审核编辑:汤梓红
-
谁用过SA7527和A433做T8 T10日光灯管电源的恒流源吗?2011-03-15 0
-
在万利达T8五一促销活动买来的T8终于到手了2011-04-30 0
-
T8日光灯电源设计2015-03-06 0
-
非隔离LIS8921S 莱士雷达感应方案T8/T5方案2016-05-04 0
-
一个SOT23-6封装的6脚元件 丝印代码 T8,请问其真实元件名2018-04-06 0
-
用于 T8 管的 LED 驱动器PMP8449技术参考资料及物料清单下载2018-07-23 0
-
Keysight T10 SAS链接培训用户指南2018-10-16 0
-
亚成微芯片RM9033GC 应用北美市场 110V筒灯15W应用 效率可达90%2019-09-24 0
-
高压线性恒流芯片RM9012低成本来袭2019-12-24 0
-
cob超微间距显示屏2020-07-11 0
-
单通道恒流 LED 控制芯片 RM9003B2021-11-05 0
-
6750的T10脚如果输入有源晶振,请问电压多少V?2023-05-26 0
全部0条评论

快来发表一下你的评论吧 !

