

凸点键合技术的主要特征
描述
自从IBM于20世纪60年代开发出可控塌陷芯片连接(Controlled Collapse Chip Connect,C4)技术,或称倒装芯片技术,凸点键合在微电子封装领域特别是芯片与封装基板的键合中得到了广泛的应用。随着3D封装技术的发展,凸点键合技术也被应用于芯片-芯片、芯片-圆片键合及封装体的3D叠层封装。凸点键合技术的主要特征包括:
(1)凸点键合技术通常使用焊料(如Sn或SnAg)或其他低熔点共晶组合作为凸点材料,并在加热过程中使其熔化或相互扩散以达到键合的目的;
(2)凸点键合过程经常涉及金属间化合物(Intermetallic Compounds,IMC)的形成;
(3)在凸点键合技术中,一般需要制作凸点下金属(Under Bump Metal,UBM)层,以增加凸点的黏附性,并限制低熔点金属向芯片金属布线层的扩散,以及过多IMC的形成。
随着近年来高密度互连的需求,凸点键合技术向着超小节距(Ulltra-Fine Pitch)方向发展出了铜柱和固态键合等技术。如图1所示,随着凸点节距的缩小,要求凸点中所使用的焊料量也减少,甚至无焊料键合(Solder-Less Bonding)或无凸点键合(Bump-Less Bonding),以避免在焊料熔化过程中产生键合凸点之间的桥接等风险。表1列举了几种金属键合方法及其键合温度。
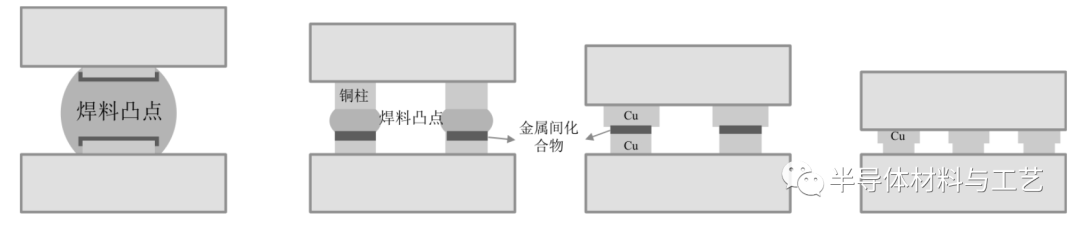
图1 焊料凸点、铜柱微凸点、微凸点固态键合及无凸点键合结构示意图
表1 几种金属键合方法及其键合温度

无凸点金属键合可采用的金属包括铝、金、铜、银等。与其他金属键合相比,铜-铜键合可实现更小的电阻、更小的功率损耗、更好的抗电迁移特性、更好的散热和热可靠性。因此,铜-铜键合是实现高性能高密度3D芯片的理想3D互连技术。随着IBM在1997年宣布采用铜互连技术,研究人员开始了铜-铜键合技术的研究。目前铜-铜键合有两种主要的键合方法,即热压键合(TCB)与表面活化键合(Surface Activated Bonding,SAB)。接下来主要介绍铜-铜热压键合与表面活化键合的基本机理。
文章来源:功率半导体生态圈
审核编辑:汤梓红
-
晶圆键合中使用的主要技术2022-07-21 4099
-
FLASH的主要特征是什么2022-02-16 1213
-
ADC的主要特征有哪些呢?如何对ADC的时钟进行配置2022-01-20 1616
-
STM32_USB硬件模块有哪些主要特征2021-10-29 2249
-
ADC的主要特征2021-08-05 1259
-
ADC是什么 ADC的主要特征2021-08-02 2241
-
你知道蓝牙规范5.1版本的主要特征是什么吗?2021-06-16 1507
-
汽车LED有哪些分类?有什么主要特征?2021-05-25 2712
-
YS4004芯片的主要特征2021-02-01 2218
-
物联网智能电网主要特征2017-01-24 714
-
基于主要特征抽取的重现概念漂移处理算法2017-01-07 695
-
芯片封装键合技术各种微互连方式简介教程2012-01-13 39517
-
[求助]电磁学与电气、电子技术互动的基本线索与主要特征2010-04-07 2314
全部0条评论

快来发表一下你的评论吧 !

