

GaN基单片电子器件的集成互补金属氧化物半导体D模和E模高电子迁移率晶体管
描述
近日,第九届国际第三代半导体论坛(IFWS)&第二十届中国国际半导体照明论坛(SSLCHINA)于厦门召开。期间,“氮化镓功率电子器件技术分论坛”上,台湾元智大学前副校长、台湾成功大学特聘教授李清庭做了“GaN基单片电子器件的集成互补金属氧化物半导体D模和E模高电子迁移率晶体管”的主题报告。
报告分享了光电化学蚀刻法和氧化物法,D模和E模GaN基MOSHEMT的制备工艺,采用LiNbO3铁电栅极氧化物层的D模和E模MOSHEMT集成的单片反相器,采用LiNbO3/HfO2/Al2O3铁电电荷陷阱栅堆叠结构的D模和E模MOSHEMT集成的单片反相器等相关研究进展。
研究采用PEC氧化法在低界面态密度的AlGaN表面直接生长氧化膜,制备出高性能MOS器件。研究显示,氧化的AlGaN膜与AlGaN接触时具有低界面态密度。对于栅极凹陷的MOS HEMT,直流性能得到改善,关态击穿电压大于100V,Hooge’s系数约为10-4,PEC方法可以产生无损伤表面的浇口凹陷过程。

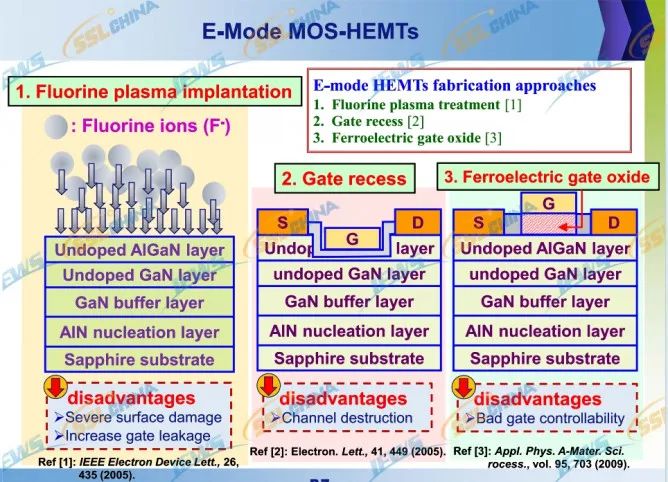
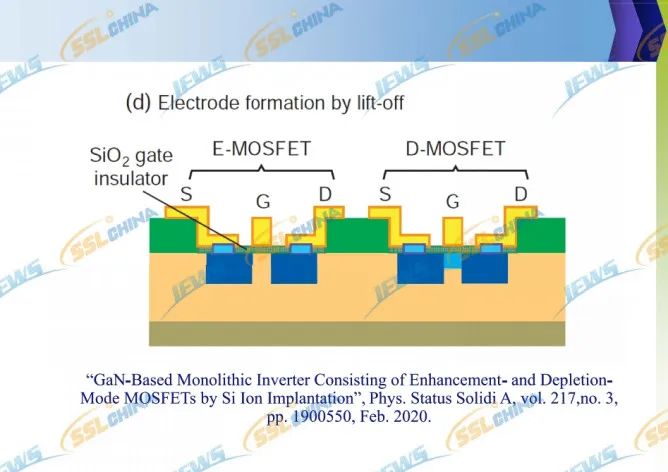
PEC刻蚀与PEC氧化的结合技术该方法是制备高性能GaN基MOS器件的一种很有前途的方法。表面处理的MOS HEMT的输出性能优于那些未经处理的MOS HEMT。
通过使用氯表面处理,氯处理的MOS HEMT表现出更高的输出性能。(NH4)2Sx处理的MOS HEMT的性能得到了改善归因于表面态密度的降低,导致Al和Ga悬空键的减少与Al-S的钝化和Ga-S键。
氯处理的MOS HEMT的性能得到了改善归因于表面态密度的降低Al和Ga悬空键的减少以及GaOx和AlOx的N空位。ZnO栅极介电层与表面的结合技术处理是制备高性能MOS的一种很有前途的方法装置。
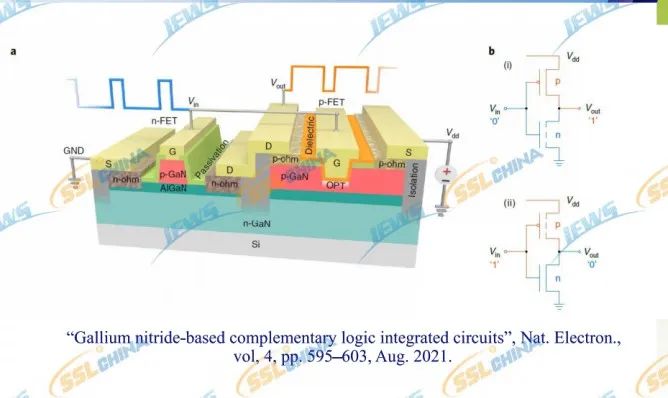
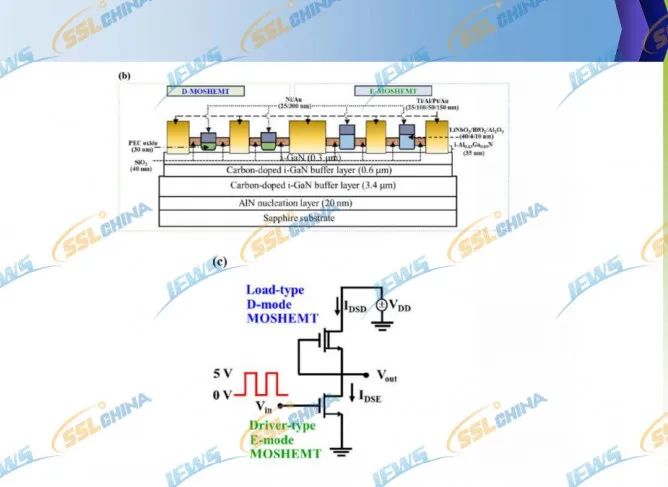
AlGaN上的LiNbO3薄膜具有c+极化特性后退火处理后的极化强度。铁电体LNO薄膜的特性可以有效地补偿压电特性和AlGaN层与GaN层。采用组合栅技术成功地制备了E型MOS-HEMT凹陷结构和150nm厚的LiNbO3栅极氧化物。阈值晶体管的电压(Vth)和跨导(Gmmax)约为+0.4V和89.7mS/mm成功地制备了具有E/D型晶体管的CMOS HEMT带电流比(β)共10个。当输入信号为5Vp-p时,输出摆幅为4.7Vp-p,并且噪声裕度高和低分别为约1.8V和1.6V。
审核编辑:刘清
-
三种功率器件的应用区别2024-07-18 14145
-
CGHV96050F1卫星通信氮化镓高电子迁移率晶体管CREE2024-01-19 11464
-
【科普小贴士】金属氧化物半导体场效应晶体管(MOSFET)2023-12-13 2540
-
MXene范德华接触在氮化镓高电子迁移率晶体管中的应用2023-05-25 2586
-
什么是氮化镓(GaN)?什么是高电子迁移率晶体管?2023-02-10 6259
-
用于大功率和频率应用的舍入 GaN 基晶体管2022-06-15 9284
-
薄膜氧化物半导体评估系统的系统概述2021-12-20 2393
-
CGHV60040D-GP4高电子迁移率晶体管2021-04-07 895
-
CMPA801B025F氮化镓(GaN)高电子迁移率 基于晶体管2020-12-03 1058
-
什么是GaN透明晶体管?2020-11-27 2945
-
CGHV40030氮化镓(GaN)高电子迁移率晶体管2020-02-24 1364
-
高电子迁移率晶体管在通信行业的应用2019-12-28 6204
-
第三代半导体材料盛行,GaN与SiC如何撬动新型功率器件2017-06-16 3793
全部0条评论

快来发表一下你的评论吧 !

