

EV集团将层转移技术引入大批量制造
电子说
描述
来源:Silicon Semiconductor
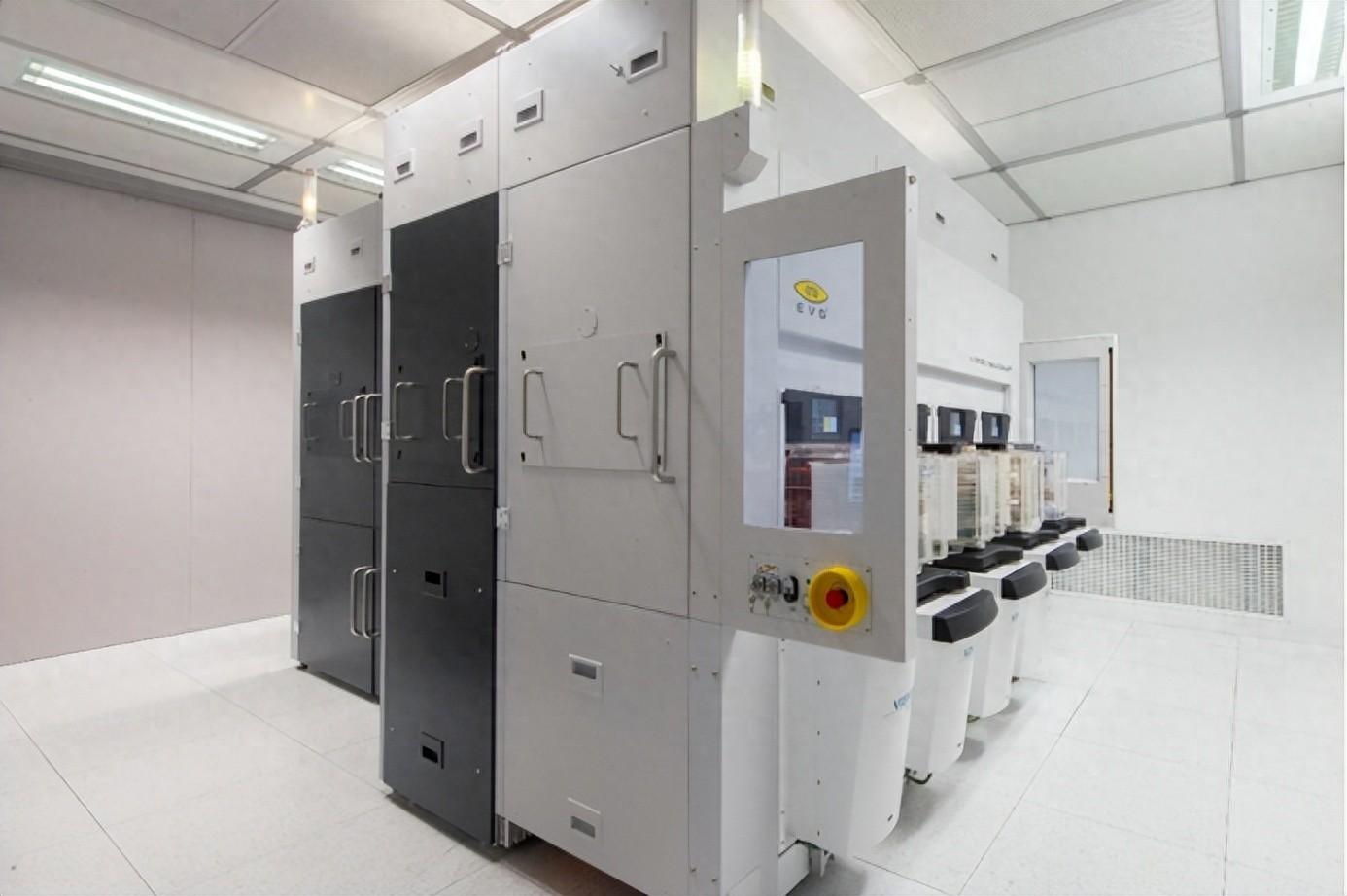
红外激光切割技术能够以纳米精度从硅衬底上进行超薄层转移,彻底改变了先进封装和晶体管缩放的3D集成。
EV集团(EVG)推出了EVG®850 NanoCleave™ 层释放系统,这是第一个采用EVG革命性NanoCleave技术的产品平台。EVG850 NanoCleave系统采用红外(IR)激光,在经过验证的大批量制造(HVM)平台上结合专门配制的无机脱模材料,能够以纳米级精度从硅载体衬底上脱模键合、沉积或生长的层。因此,EVG850 NanoCleave 消除了对玻璃载体的需求,从而实现了用于先进封装的超薄小芯片堆叠,以及用于前端处理的超薄3D层堆叠,包括先进逻辑、存储器和功率器件形成,以实现支持未来的3D集成路线图。
首个EVG850 NanoCleave系统已安装在客户设施中,并且在客户现场和EVG总部,与客户和合作伙伴进行近两打产品演示。
硅载体有利于3D堆叠和后端处理
在3D集成中,玻璃衬底已成为通过与有机粘合剂临时键合来构建器件层的既定方法,使用紫外(UV)波长激光溶解粘合剂并释放器件层,随后将器件层永久键合到最终产品上晶圆。然而,玻璃衬底很难用主要围绕硅设计的半导体制造设备进行加工,并且需要昂贵的升级才能进行玻璃衬底加工。此外,有机粘合剂的加工温度一般限制在300℃以下,限制了其在后端加工中的使用。
使硅载体具有无机脱模层可以避免这些温度和玻璃载体兼容性问题。此外,红外激光引发切割的纳米精度允许在不改变记录工艺的情况下加工极薄的器件晶圆。随后堆叠如此薄的器件层可实现更高带宽的互连,并为下一代高性能器件设计和分割芯片提供新的机会。
下一代晶体管节点需要薄层转移工艺
此同时,亚3纳米节点的晶体管路线图需要新的架构和设计创新,例如埋入式电源轨、背面供电网络、互补场效应晶体管(CFET)和2D原子通道,所有这些都需要极薄材料的层转移。硅载体和无机脱模层支持前端制造流程的工艺清洁度、材料兼容性和高加工温度要求。然而,到目前为止,硅载体必须通过研磨、抛光和蚀刻工艺完全去除,这会导致工作器件层表面出现微米范围的变化,因此该方法不适合先进节点的薄层堆叠。
“可释放”熔接
EVG850 NanoCleave利用红外激光和无机脱模材料,能够在生产环境中以纳米精度对硅载体进行激光切割。该创新工艺消除了对玻璃衬底和有机粘合剂的需求,从而实现了超薄层转移和下游工艺的前端工艺兼容性。EVG850 NanoCleave的高温兼容性(高达1000°C)支持要求最严苛的前端处理,而室温红外切割步骤可确保器件层和载体衬底的完整性。层转移工艺还消除了与载体晶圆研磨、抛光和蚀刻相关的昂贵溶剂的需要。
EVG850 NanoCleave与EVG业界领先的EVG850系列自动临时键合/解键合和绝缘体上硅(SOI)键合系统基于同一平台,具有紧凑的设计和经过HVM验证的晶圆处理系统。
EV集团企业研发项目经理Bernd Thallner博士表示:“EVG自40多年前成立以来,公司的愿景始终坚定不移,率先探索新技术,服务下一代微纳加工技术应用。最近,3D和异构集成作为新一代半导体器件性能改进的关键驱动因素而受到关注。这反过来又使晶圆键合成为持续扩展PPACt(功率、性能、面积、成本和上市时间)的关键工艺。借助我们新的EVG850 NanoCleave系统,EVG将临时键合和熔合键合的优势融合到一个多功能平台中,支持我们的客户在先进封装和下一代规模晶体管设计和制造方面扩展其未来路线图的能力。”
审核编辑 黄宇
-
东风新能源车大批量签约交付2025-07-31 1174
-
小批量SMT加工的“定制化”与大批量生产的“标准化”:差异全解析2025-07-16 1367
-
岚图汽车获TÜV南德大批量WVTA证书,加速全球化进程2025-01-02 1322
-
EVASH Ultra EEPROM和Microchip 32位MCU在功放产品中的大批量应用2024-06-24 1411
-
线路板生产该选大批量还是小批量?2023-12-13 2044
-
电动汽车推动 SiC 器件的大批量制造需求2022-08-08 1322
-
MEMS封装推向市场大批量生产2022-06-20 1746
-
如何简化从原型向大批量PCB生产的过渡2020-10-12 2136
-
蓝牙大批量制造测试系统2019-06-10 1323
-
未来大批量PCB胜在规模 小批量PCB以毛利率取胜2019-05-09 7495
-
面向大批量应用的的Artix-7 FPGA的能耗优势演示2018-06-04 3979
-
CC2640怎么大批量测试FR性能2016-03-24 3489
-
赛灵思针对大批量应用大幅提升设计生产力2013-02-20 1262
-
三星大批量生产移动4GB DRAM内存芯片2011-03-25 1098
全部0条评论

快来发表一下你的评论吧 !

